The Numerical Simulations and Experimental Study of an 8-Inch SiC Single Crystal with Reduced BPD Density
Abstract
:1. Introduction
2. Method
3. Results and Discussion
3.1. Simulation of 4H-SiC Crystal Growth
3.2. Experiments on 8-Inch N-Type 4H-SiC Crystal Growth
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Feng, S.; Huang, C.; Wang, J.; Jia, Z. Surface quality evaluation of single crystal 4H-SiC wafer machined by hybrid-waterjet: Comparing with laser machining. Mater. Sci. Semicond. Process. 2019, 93, 238–251. [Google Scholar] [CrossRef]
- Homa, M.; Sobczak, N.; Sobczak, J.J.; Kudyba, A.; Bruzda, G.; Nowak, R.; Pietrzak, K.; Chmielewski, M.; Strupinski, W. Interaction between graphene-coated SiC single crystal and liquid copper. J. Mater. Eng. Perform. 2018, 27, 2317–2329. [Google Scholar] [CrossRef]
- Wei, W.; Mo, Y.; Yu, S.; Zheng, J.; Peng, D. Influence of SiC hetero-polytype barriers on the performance of IMPATT terahertz diodes. Superlattices Microstruct. 2021, 152, 106844. [Google Scholar] [CrossRef]
- Cheng, L.; Palmour, J.W.; Agarwal, A.K.; Allen, S.T.; Brunt, E.V.; Wang, G.; Pala, V.; Sung, W.; Huang, A.Q.; O’Loughlin, M.; et al. Strategic overview of high-voltage SiC power device development aiming at global energy savings. Mater. Sci. Forum 2014, 778–780, 1089–1095. [Google Scholar] [CrossRef]
- Morvan, E.; Kerlain, A.; Dua, C.; Brylinski, C. Influence of material properties on wide-bandgap microwave power device characteristics. Mater. Sci. Forum 2003, 433–436, 731–736. [Google Scholar] [CrossRef]
- Sardi, B.; Uno, I.; Pasila, F.; Altway, A.; Mahfud, M. Low rank coal for fuel production via microwave-assisted pyrolysis: A review. FirePhysChem 2023, 3, 106–120. [Google Scholar] [CrossRef]
- Tairov, Y.; Tsvetkov, V. Investigation of growth progresses of ingots of silicon carbide single crystals. J. Cryst. Growth 1978, 43, 209–212. [Google Scholar] [CrossRef]
- Kamei, K.; Kusunoki, K.; Yashiro, N.; Okada, N.; Tanaka, T.; Yauchi, A. Solution growth of single crystalline 6H, 4H-SiC using Si-Ti-C melt. J. Cryst. Growth 2009, 311, 855–858. [Google Scholar] [CrossRef]
- Zhang, J.; Peng, Y.; Chen, X.; Xie, X.; Yang, X.; Hu, X.; Xu, X. Research progress of dislocations in SiC single crystal. J. Synth. Cryst. 2022, 51, 1973–1982. [Google Scholar]
- Alao, A.A.; Wu, W.-N.; Hsu, W.-D. Sticking coefficient and Si/C ratio of silicon carbide growth species on reconstructed 4H-SiC(0001) surface by ab-initio calculations. Vacuum 2022, 205, 111414. [Google Scholar] [CrossRef]
- Shao, C.; Guo, F.; Chen, X.; Li, X.; Yu, W.; Yang, X.; Xie, X.; Hu, X.; Xu, X. Effect of basal plane bending on the atomic step morphology of the 4H–SiC substrate surface. Vacuum 2023, 212, 112013. [Google Scholar] [CrossRef]
- Xue, L.; Feng, G.; Wu, G.; Gao, B.; Li, R.; Liu, S. Effect of texture on 4H–SiC substrate surface on film growth: A molecular dynamics study. Vacuum 2023, 214, 112180. [Google Scholar] [CrossRef]
- Agarwal, A.; Fatima, H.; Haney, S.; Ryu, S.H. A new degradation mechanism in high-voltage sic power MOSFETs. IEEE Electron Device Lett. 2007, 28, 587–589. [Google Scholar] [CrossRef]
- Veliadis, V.; Hearne, H.; Stewart, E.J.; Snook, M.; Chang, W.; Caldwell, J.D.; Ha, H.C.; El-Hinnawy, N.; Borodulin, P.; Howell, R.S.; et al. Degradation and full recovery in high-voltage implanted-gate SiC JFETs subjected to bipolar current stress. IEEE Electron Device Lett. 2012, 33, 952–954. [Google Scholar] [CrossRef]
- Jordan, A.S.; Caruso, R.; Von Neida, A.R. A thermoelastic analysis of dislocation generation in pulled GaAs crystals. Bell Syst. Tech. J. 1980, 59, 593–637. [Google Scholar] [CrossRef]
- Gao, B.; Kakimoto, K. Three-dimensional modeling of basal plane dislocations in 4H-SiC single crystals grown by the physical vapor transport method. Cryst. Growth Des. 2014, 14, 1272–1278. [Google Scholar] [CrossRef]
- Gao, B.; Kakimoto, K. Numerical investigation of the influence of cooling flux on the generation of dislocations in cylindrical mono-like silicon growth. J. Cryst. Growth 2013, 384, 13–20. [Google Scholar] [CrossRef]
- Gao, B.; Kakimoto, K. Dislocation-density-based modeling of the plastic behavior of 4H-SiC single crystals using the Alexander-Haasen model. J. Cryst. Growth 2014, 386, 215–219. [Google Scholar] [CrossRef]
- Steiner, J.; Roder, M.; Nguyen, B.D.; Sandfeld, S.; Danilewsky, A.; Wellmann, P.J. Analysis of the basal plane dislocation density and thermo mechanical stress during 100 mm PVT Growth of 4H-SiC. Materials 2019, 12, 2207. [Google Scholar] [CrossRef]
- Selder, M.; Kadinski, L.; Durst, F.; Straubinger, T.L.; Wellmann, P.J.; Hofmann, D. Numerical simulation of thermal stress formation during PVT-growth of SiC bulk crystals. Mater. Sci. Forum 2001, 353–356, 65–68. [Google Scholar] [CrossRef]
- Ma, R.; Zhang, H.; Vish, P.; Dudley, M. Growth kinetics and thermal stress in the sublimation growth of silicon carbide. Cryst. Growth Des. 2002, 2, 213–220. [Google Scholar] [CrossRef]
- Meng, D.; Li, L.; Zhang, Z. Thermal stress analysis of SiC crystal growth by PVT method. Mater. Res. Appl. 2020, 14, 179–183. [Google Scholar]
- Yang, Y.; Wang, J.; Wang, Y. Thermal stress simulation of optimized SiC single crystal growth crucible structure. J. Cryst. Growth 2018, 504, 31–36. [Google Scholar] [CrossRef]
- Meng, D.; Wang, Y.; Xue, H.; Ying, L.; Wang, Z. Stress simulation of 6-inch SiC single crystal. Vacuum 2023, 213, 112081. [Google Scholar] [CrossRef]
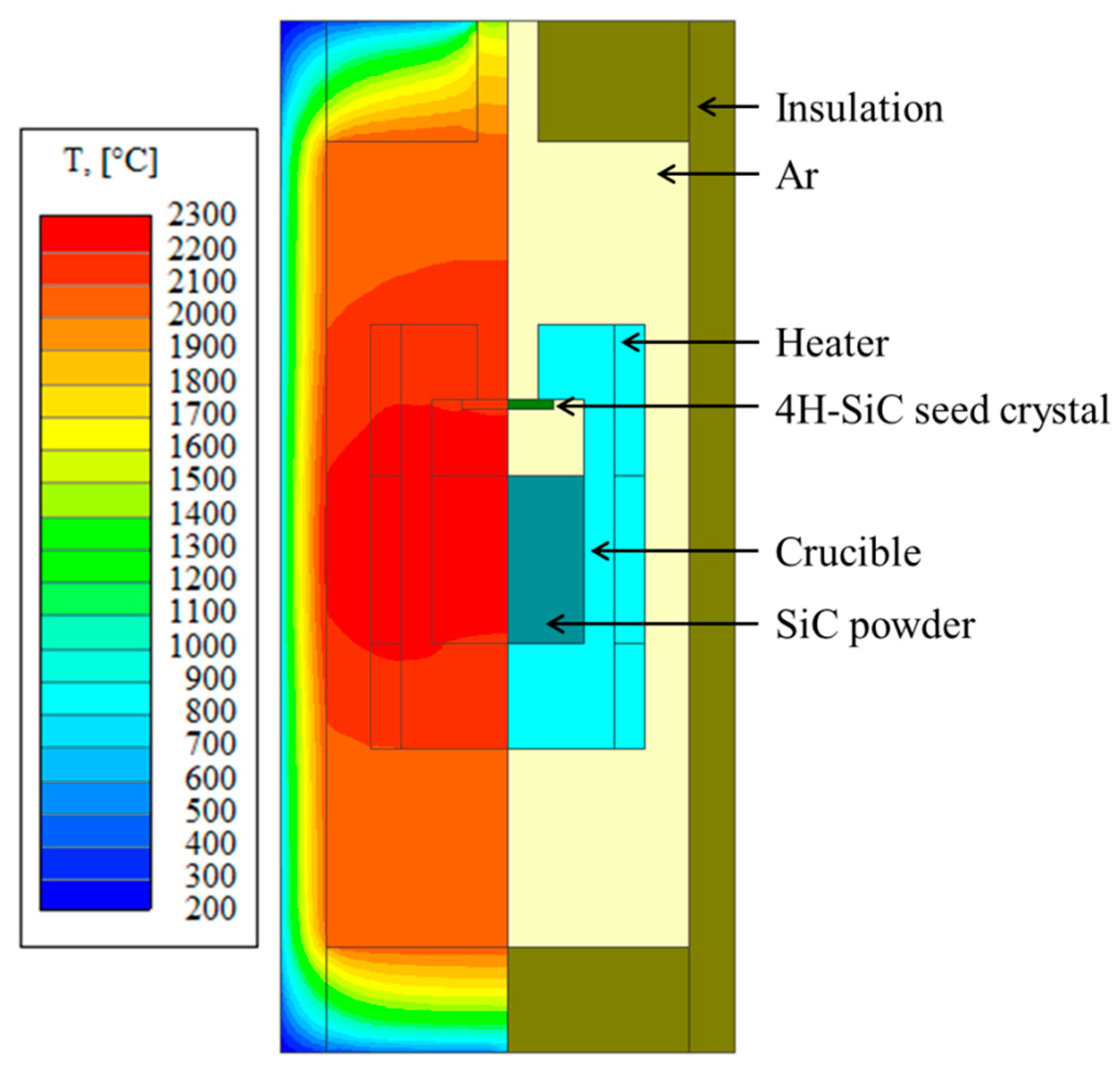







| Simulation Cases | Stress Boundary Conditions | CTE of Graphite Crucible (1/K) | Cooling Rate (°C/h) |
|---|---|---|---|
| A | Fixed | 7 × 10−6 | 50 |
| B | Fixed | 7 × 10−6 | 200 |
| C | Slipping | 7 × 10−6 | 50 |
| D | Slipping | 4.5 × 10−6 | 50 |
| Experiment Cases | Seed-Bonding Method | CTE of Graphite Crucible (1/K) | Cooling Rate (°C/h) |
|---|---|---|---|
| A | Bonding | 7 × 10−6 | Basal cooling |
| B | Bonding | 7 × 10−6 | Fast cooling |
| C | Non-bonding | 7 × 10−6 | Basal cooling |
| D | Non-bonding | 4.5 × 10−6 | Basal cooling |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2024 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Sun, C.; Shang, Y.; Lei, Z.; Wang, Y.; Xue, H.; Yang, C.; Wang, Y. The Numerical Simulations and Experimental Study of an 8-Inch SiC Single Crystal with Reduced BPD Density. Materials 2024, 17, 2192. https://doi.org/10.3390/ma17102192
Sun C, Shang Y, Lei Z, Wang Y, Xue H, Yang C, Wang Y. The Numerical Simulations and Experimental Study of an 8-Inch SiC Single Crystal with Reduced BPD Density. Materials. 2024; 17(10):2192. https://doi.org/10.3390/ma17102192
Chicago/Turabian StyleSun, Chengyuan, Yunfei Shang, Zuotao Lei, Yujian Wang, Hao Xue, Chunhui Yang, and Yingmin Wang. 2024. "The Numerical Simulations and Experimental Study of an 8-Inch SiC Single Crystal with Reduced BPD Density" Materials 17, no. 10: 2192. https://doi.org/10.3390/ma17102192





