Improvement Breakdown Voltage by a Using Crown-Shaped Gate
Abstract
:1. Introduction
2. Analysis of The Structure and Fabrication Method
2.1. Structure of the IGBT
2.2. Applied Model in Simulation
2.3. Comparison Method
2.4. Fabrication Method
3. Results and Discussion
3.1. On-State Characteristics
3.2. Breakdown Characteristics
3.3. Trend in Breakdown Voltage
3.4. Turn-Off Characteristics
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Sheng, K.; Williams, B.W.; Finney, S.J. A Review of IGBT Models. IEEE Trans. Power Electron. 2000, 15, 1250–1266. [Google Scholar] [CrossRef]
- Callavik, M.; Blomberg, A.; Häfner, J.; Jacobson, B. The Hybrid HVDC Breaker. ABB Grid Syst. Tech. Pap. 2012, 361, 143–152. [Google Scholar]
- Wang, H.; Ma, K.-W. IGBT Technology for Future High-Power VSC-HVDC Applications. In Proceedings of the 12th IET International Conference on AC and DC Power Transmission (ACDC 2016), Beijing, China, 28–29 May 2016. [Google Scholar]
- Trainer, D.R.; Davidson, C.C.; Oates, C.D.M.; Macleod, N.M.; Critchley, D.R.; Crookes, R.W. A New Hybrid Voltage-Sourced Converter for HVDC Power Transmission. In Proceedings of the CIGRÉ Session; CIGRE: Paris, France, 2010. [Google Scholar]
- Krein, P.T.; Roethemeyer, T.G.; White, R.A.; Masterson, B.R. Packaging and Performance of an IGBT-Based Hybrid Electric Vehicle. In Proceedings of the 1994 IEEE Workshop on Power Electronics in Transportation, Dearborn, MI, USA, 20–21 October 1994; pp. 47–52. [Google Scholar]
- Rosu, S.G.; Khalilian, M.; Cirimele, V.; Guglielmi, P. A Dynamic Wireless Charging System for Electric Vehicles Based on DC/AC Converters with SiC MOSFET-IGBT Switches and Resonant Gate-Drive. In Proceedings of the IECON 2016—42nd Annual Conference of the IEEE Industrial Electronics Society, Florence, Italy, 23–26 October 2016; pp. 4465–4470. [Google Scholar]
- Dimitrov, B.; Hayatleh, K.; Barker, S.; Collier, G.; Sharkh, S.; Cruden, A. A Buck-Boost Transformerless Dc–Dc Converter Based on IGBT Modules for Fast Charge of Electric Vehicles. Electronics 2020, 9, 397. [Google Scholar] [CrossRef] [Green Version]
- Ogura, T. Recent Technical Trends and Future Prospects of IGBTs and Power MOSFETs. In Proceedings of the 2014 International Power Electronics Conference (IPEC-Hiroshima 2014 ECCE-ASIA), Hiroshima, Japan, 18–21 May 2014; pp. 2068–2073. [Google Scholar]
- Rahimo, M. Future Trends in High-power Bipolar Metal-oxide Semi-conductor Controlled Power Semi-conductors. IET Circuits Devices Syst. 2014, 8, 155–167. [Google Scholar] [CrossRef]
- Liu, G.; Li, K.; Wang, Y.; Luo, H.; Luo, H. Recent Advances and Trend of HEV/EV-oriented Power Semiconductors—An Overview. IET Power Electron. 2020, 13, 394–404. [Google Scholar] [CrossRef]
- Baliga, B.J. Trends in Power Semiconductor Devices. IEEE Trans. Electron. Devices 1996, 43, 1717–1731. [Google Scholar] [CrossRef]
- Mueller, C.W.; Hilibrand, J. The “Thyristor”—A New High-Speed Switching Transistor. IRE Trans. Electron Devices 1958, 5, 2–5. [Google Scholar] [CrossRef]
- Liang, Y.C.; Samudra, G.S.; Huang, C.F. Insulated-Gate Bipolar Transistor. Power Microelectron. 2017, 191–248. [Google Scholar] [CrossRef]
- Aghdam, M.G.H.; Thiringer, T. Comparison of SiC and Si Power Semiconductor Devices to Be Used in 2.5 KW DC/DC Converter. In Proceedings of the 2009 International Conference on Power Electronics and Drive Systems (PEDS), Taipei, Taiwan, 2–5 November 2009; pp. 1035–1040. [Google Scholar]
- Shimizu, H.; Harada, J.; Bland, C. The Role of Optimized Vehicle Design and Power Semiconductor Devices to Improve the Performance of an Electric Vehicle. In Proceedings of the International Symposium on Power Semiconductor Devices and IC’s: ISPSD’95, Yokohama, Japan, 23–25 May 1995; pp. 8–12. [Google Scholar]
- Raj, J.S.S.S.; Sivaraman, P.; Prem, P.; Matheswaran, A. Wide Band Gap Semiconductor Material for Electric Vehicle Charger. Mater. Today Proc. 2021, 45, 852–856. [Google Scholar]
- Skibinski, G.; Evon, S.; Kempke, D.; Saunders, L. IGBT Drive Technology Demands New Motor and Cable Considerations. In Proceedings of the IEEE IAS Petroleum and Chemical Industry Conference, Philadelphia, PA, USA, 23–25 September 1996. [Google Scholar]
- Harada, M.; Minato, T.; Takahashi, H.; Nishihara, H.; Inoue, K.; Takata, I. 600 V Trench IGBT in Comparison with Planar IGBT-an Evaluation of the Limit of IGBT Performance. In Proceedings of the 6th International Symposium on Power Semiconductor Devices and ICs, Davos, Switzerland, 31 May–2 June 1994; pp. 411–416. [Google Scholar]
- Zhang, L.; Zhu, J.; Zhao, M.; Liu, S.; Sun, W.; Shi, L. Low-Loss SOI-LIGBT with Triple Deep-Oxide Trenches. IEEE Trans. Electron. Devices 2017, 64, 3756–3761. [Google Scholar] [CrossRef]
- Lee, J.-S.; Kang, E.-G.; Sung, M.-Y. Improvement of Electrical Characteristics of Vertical NPT Trench Gate IGBT Using Trench Emitter Electrode. J. Korean Inst. Electr. Electron. Mater. Eng. 2006, 19, 912–917. [Google Scholar] [CrossRef]
- Song, Q.; Yang, S.; Tang, G.; Han, C.; Zhang, Y.; Tang, X.; Zhang, Y.; Zhang, Y. 4H-SiC Trench MOSFET with L-Shaped Gate. IEEE Electron. Device Lett. 2016, 37, 463–466. [Google Scholar] [CrossRef]
- Lee, J.-S.; Kang, E.-G.; Sung, M.Y. Shielding Region Effects on a Trench Gate IGBT. Microelectron. J. 2008, 39, 57–62. [Google Scholar] [CrossRef]
- Park, D.-G.; Kim, J.-H. Improvement Breakdown Voltage by using Crown Shape Gate in IGBT. In Proceedings of the NanoKorea Symposium, Seoul, Republic of Korea, 6–8 July 2022; p. 578. [Google Scholar]
- Lee, J.I.; Choi, J.; Bae, Y.; Sung, M.Y. A Novel Trench IGBT with a Rectangular Oxide beneath the Trench Gate. In Proceedings of the 2009 1st Asia Symposium on Quality Electronic Design, Kuala Lumpur, Malaysia, 15–16 July 2009; pp. 370–373. [Google Scholar]
- Wu, Y.-C.; Jhan, Y.-R. Introduction of Synopsys Sentaurus TCAD Simulation. In 3D TCAD Simulation for CMOS Nanoeletronic Devices; Wu, Y.-C., Jhan, Y.-R., Eds.; Springer: Singapore, 2018; pp. 1–17. ISBN 978-981-10-3066-6. [Google Scholar]
- Watanabe, M.; Shigyo, N.; Hoshii, T.; Furukawa, K.; Kakushima, K.; Satoh, K.; Matsudai, T.; Saraya, T.; Takakura, T.; Itou, K. Impact of Three-Dimensional Current Flow on Accurate TCAD Simulation for Trench-Gate IGBTs. In Proceedings of the 2019 31st International Symposium on Power Semiconductor Devices and ICs (ISPSD), Shanghai, China, 19–23 May 2019; pp. 311–314. [Google Scholar]
- Lutze, J.W.; Perera, A.H.; Krusius, J.P. Field Oxide Thinning in Poly Buffer LOCOS Isolation with Active Area Spacings to 0.1 Μm. J. Electrochem. Soc. 1990, 137, 1867. [Google Scholar] [CrossRef]
- Abdolvand, R.; Ayazi, F. An Advanced Reactive Ion Etching Process for Very High Aspect-Ratio Sub-Micron Wide Trenches in Silicon. Sens. Actuators A Phys. 2008, 144, 109–116. [Google Scholar] [CrossRef]
- Abe, H.; Yoneda, M.; Fujiwara, N. Developments of Plasma Etching Technology for Fabricating Semiconductor Devices. Jpn. J. Appl. Phys. 2008, 47, 1435. [Google Scholar] [CrossRef]
- Kao, D.-B.; Mcvittie, J.P.; Nix, W.D.; Saraswat, K.C. Two-Dimensional Thermal Oxidation of Silicon: II. Modeling Stress Effects in Wet Oxides. IEEE Trans. Electron Devices 1988, 35, 25–37. [Google Scholar] [CrossRef]
- Dhong, S.H.; Petrillo, E.J. Sidewall Spacer Technology for MOS and Bipolar Devices. J. Electrochem. Soc. 1986, 133, 389. [Google Scholar] [CrossRef]
- Rodder, M.; Yeakley, D. Raised Source/Drain MOSFET with Dual Sidewall Spacers. IEEE Electron Device Lett. 1991, 12, 89–91. [Google Scholar] [CrossRef]
- Nam, K.S.; Lee, J.W.; Kim, S.-G.; Roh, T.M.; Park, H.S.; Koo, J.G.; Cho, K.I. A Novel Simplified Process for Fabricating a Very High Density P-Channel Trench Gate Power MOSFET. IEEE Electron Device Lett. 2000, 21, 365–367. [Google Scholar]
- Tsang, P.J.; Ogura, S.; Walker, W.W.; Shepard, J.F.; Critchlow, D.L. Fabrication of High-Performance LDDFET’s with Oxide Sidewall-Spacer Technology. IEEE J. Solid-State Circuits 1982, 17, 220–226. [Google Scholar] [CrossRef]
- Depp, S.W.; Juliana, A.; Huth, B.G. Polysilicon FET Devices for Large Area Input/Output Applications. In Proceedings of the 1980 International Electron Devices Meeting, Washington, DC, USA, 8–10 December 1980; pp. 703–706. [Google Scholar]
- Chang, H.R.; Baliga, B.J.; Kretchmer, J.W.; Piacente, P.A. Insulated Gate Bipolar Transistor (IGBT) with a Trench Gate Structure. In Proceedings of the 1987 International Electron Devices Meeting, Washington, DC, USA, 6–9 December 1987; pp. 674–677. [Google Scholar]
- Chang, H.-R.; Baliga, B.J. 500-V n-Channel Insulated-Gate Bipolar Transistor with a Trench Gate Structure. IEEE Trans. Electron Devices 1989, 36, 1824–1829. [Google Scholar] [CrossRef]
- Bartolf, H.; Mihaila, A.; Nistor, I.; Jurisch, M.; Leibold, B.; Zimmermann, M. Development of a 60 µm Deep Trench and Refill Process for Manufacturing Si-Based High-Voltage Super-Junction Structures. IEEE Trans. Semicond. Manuf. 2013, 26, 529–541. [Google Scholar] [CrossRef]
- Udrea, F.; Amaratunga, G.A.J. An On-State Analytical Model for the Trench Insulated Gate Bipolar Transistor (TIGBT). Solid State Electron. 1997, 41, 1111–1118. [Google Scholar] [CrossRef]
- Udrea, F.; Chan, S.S.M.; Thomson, J.; Keller, S.; Amaratunga, G.A.J.; Millington, A.D.; Waind, P.R.; Crees, D.E. Development of the next Generation of Insulated Gate Bipolar Transistors Based on Trench Technology. In Proceedings of the ESSDERC’97: 27th European Solid-State Device Research Conference, Stuttgart, Germany, 22–24 September 1997; pp. 504–507. [Google Scholar]
- Bauer, F.D. The Super Junction Bipolar Transistor: A New Silicon Power Device Concept for Ultra Low Loss Switching Applications at Medium to High Voltages. Solid-State Electron. 2004, 48, 705–714. [Google Scholar] [CrossRef]
- Kim, K.Y.; Noh, J.S.; Yoon, T.Y.; Kim, J.H. Improvement in Turn-Off Loss of the Super Junction IGBT with Separated n-Buffer Layers. Micromachines 2021, 12, 1422. [Google Scholar] [CrossRef]
- Chen, W.; Cheng, J. Study on the IGBT Using a Deep Trench Filled with SiO2 and High-k Dielectric Film. IEEE J. Electron Devices Soc. 2020, 8, 1025–1030. [Google Scholar] [CrossRef]
- Xu, X.; Chen, W.; Zhang, S.; Liu, C.; Sun, R.; Li, Z.; Zhang, B. Numerical Analysis for a P-Drift Region N-IGBT With Enhanced Dynamic Electric Field Modulation Effect. IEEE Trans. Electron. Devices 2022, 69, 3277–3282. [Google Scholar] [CrossRef]
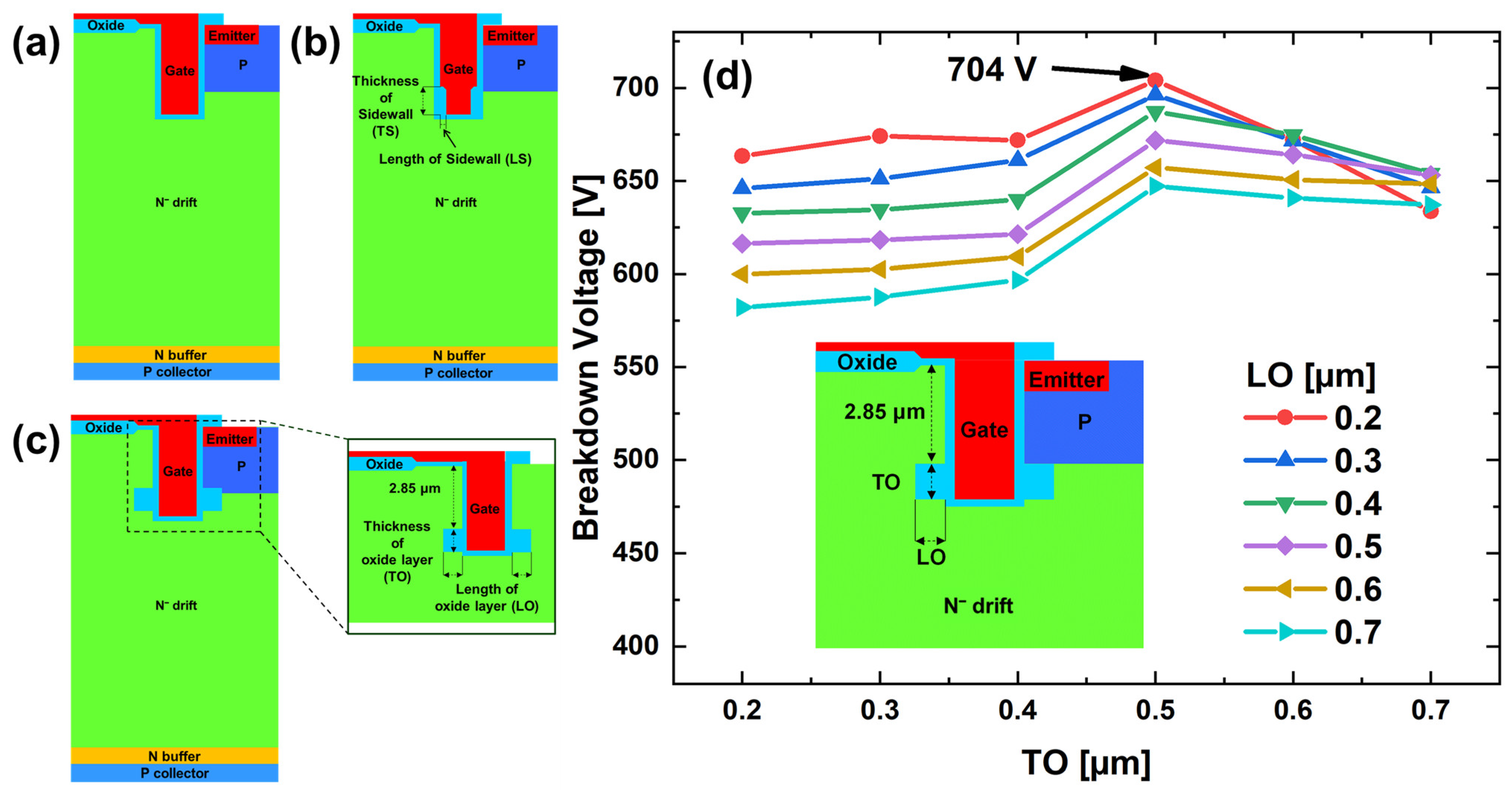





| Parameter | C-IGBT | S-IGBT | O-IGBT |
|---|---|---|---|
| Width/Length | 4.8 µm | 4.8 µm | 4.8 µm |
| Length | 70.0 µm | 70.0 µm | 70.0 µm |
| Gate depth | 3.24 µm | 3.24 µm | 3.24 µm |
| Gate width | 0.8 µm | 0.8 µm | 0.8 µm |
| Depth of P-base | 2.5 µm | 2.5 µm | 2.5 µm |
| Depth of N+ emitter | 0.25 µm | 0.25 µm | 0.25 µm |
| Thickness of oxide | 0.02 µm | 0.02 µm | 0.02 µm |
| N buffer length | 2.5 µm | 2.5 µm | 2.5 µm |
| P-collector length | 0.5 µm | 0.5 µm | 0.5 µm |
| Length of sidewall | - | 0.1 µm | - |
| Thickness of sidewall | - | 0.7 µm | - |
| Depth of oxide layer | - | - | 2.85 µm |
| Oxide layer length | - | - | 0.2 µm |
| Oxide layer thickness | - | - | 0.5 µm |
| N+ emitter doping | 1 × 1021 cm−3 | 1 × 1021 cm−3 | 1 × 1021 cm−3 |
| P-base doping | 1 × 1018 cm−3 | 1 × 1018 cm−3 | 1 × 1018 cm−3 |
| P-collector doping | 1 × 1018 cm−3 | 1 × 1018 cm−3 | 1 × 1018 cm−3 |
| N− drift region doping | 3 × 1014 cm−3 | 3 × 1014 cm−3 | 3 × 1014 cm−3 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Park, D.G.; Kim, H.; Kim, J.H. Improvement Breakdown Voltage by a Using Crown-Shaped Gate. Electronics 2023, 12, 474. https://doi.org/10.3390/electronics12030474
Park DG, Kim H, Kim JH. Improvement Breakdown Voltage by a Using Crown-Shaped Gate. Electronics. 2023; 12(3):474. https://doi.org/10.3390/electronics12030474
Chicago/Turabian StylePark, Dong Gyu, Hyunwoo Kim, and Jang Hyun Kim. 2023. "Improvement Breakdown Voltage by a Using Crown-Shaped Gate" Electronics 12, no. 3: 474. https://doi.org/10.3390/electronics12030474






