Nanopatterning via Self-Assembly of a Lamellar-Forming Polystyrene-block-Poly(dimethylsiloxane) Diblock Copolymer on Topographical Substrates Fabricated by Nanoimprint Lithography
Abstract
:1. Introduction
2. Results and Discussion
2.1. DBCP Self-Assembly on PDMS-OH Brush Coated Substrate
2.2. Effect of POSS Type on DBCP Self-Assembly on Planar POSS Coated Substrates
2.3. Effect of POSS Topography on DBCP Self-Assembly
2.4. Pattern Transfer to Underlying Substrate for Nanopatterning
3. Materials and Methods
3.1. Synthesis of Polymers and Molecular Characteristics
3.2. POSS Materials and Synthesis of POSS-C6
3.3. Resist Preparation and Fabrication of POSS Templates by UV-NIL
3.4. Deposition of PDMS-OH Brush on Silicon Substrates
3.5. Deposition of PS-b-PDMS and Solvent Annealing
3.6. Plasma Etching of PS-b-PDMS Films and Pattern Transfer
3.7. Material Characterization
4. Conclusions
Supplementary Materials
Acknowledgments
Author Contributions
Conflicts of Interest
References
- Morris, M.A. Directed self-assembly of block copolymers for nanocircuitry fabrication. Microelectron. Eng. 2015, 132, 207–217. [Google Scholar] [CrossRef]
- Wissen, M.; Bogdanski, N.; Moellenbeck, S.; Scheer, H.C. Strategies for hybrid techniques of UV lithography and thermal nanoimprint. In Proceedings of the 2008 24th European Mask and Lithography Conference (EMLC), Dresden, Germany, 21–24 January 2008; pp. 1–11. [Google Scholar]
- Xia, Y.; Whitesides, G.M. Soft lithography. Annu. Rev. Mater. Sci. 1998, 28, 153–184. [Google Scholar] [CrossRef]
- Chung, S.; Felts, J.R.; Wang, D.; King, W.P.; Yoreo, J.J.D. Temperature-dependence of ink transport during thermal dip-pen nanolithography. Appl. Phys. Lett. 2011, 99, 193101. [Google Scholar] [CrossRef]
- Grigorescu, A.E.; Hagen, C.W. Resists for sub-20-nm electron beam lithography with a focus on HSQ: State of the art. Nanotechnology 2009, 20, 292001. [Google Scholar] [CrossRef] [PubMed]
- Namatsu, H.; Watanabe, Y.; Yamazaki, K.; Yamaguchi, T.; Nagase, M.; Ono, Y.; Fujiwara, A.; Horiguchi, S. Influence of oxidation temperature on Si-single electron transistor characteristics. J. Vac. Sci. Technol. B 2003, 21, 2869–2873. [Google Scholar] [CrossRef]
- Hirai, Y.; Hafizovic, S.; Matsuzuka, N.; Korvink, J.G.; Tabata, O. Validation of X-ray lithography and development simulation system for moving mask deep X-ray lithography. J. Microelectromech. Syst. 2006, 15, 159–168. [Google Scholar] [CrossRef]
- Hamley, I.W. Nanotechnology with Soft Materials. Angew. Chem. Int. Ed. 2003, 42, 1692–1712. [Google Scholar] [CrossRef] [PubMed]
- Kumar, P. Directed Self-Assembly: Expectations and Achievements. Nanoscale Res. Lett. 2010, 5, 1367–1376. [Google Scholar] [CrossRef] [PubMed]
- Katsuhiko, A.; Jonathan, P.H.; Michael, V.L.; Ajayan, V.; Richard, C.; Somobrata, A. Challenges and breakthroughs in recent research on self-assembly. Sci. Technol. Adv. Mater. 2008, 9, 014109. [Google Scholar]
- Hawker, C.J.; Russell, T.P. Block copolymer lithography: Merging “bottom-up” with “top-down” processes. MRS Bull. 2005, 30, 952–966. [Google Scholar] [CrossRef]
- Michele Perego, G.S. Self-assembly strategies for the synthesis of functional nanostructured materials. Nuovo Cimento Riv. Ser. 2016, 39, 279–312. [Google Scholar]
- Bang, J.; Jeong, U.; Ryu, D.Y.; Russell, T.P.; Hawker, C.J. Block copolymer nanolithography: Translation of molecular level control to nanoscale patterns. Adv. Mater. 2009, 21, 4769–4792. [Google Scholar] [CrossRef] [PubMed]
- Kim, B.H.; Kim, J.Y.; Kim, S.O. Directed self-assembly of block copolymers for universal nanopatterning. Soft Matter 2013, 9, 2780–2786. [Google Scholar] [CrossRef]
- Kim, E.; Ahn, H.; Park, S.; Lee, H.; Lee, M.; Lee, S.; Kim, T.; Kwak, E.-A.; Lee, J.H.; Lei, X.; et al. Directed Assembly of High Molecular Weight Block Copolymers: Highly Ordered Line Patterns of Perpendicularly Oriented Lamellae with Large Periods. ACS Nano 2013, 7, 1952–1960. [Google Scholar] [CrossRef] [PubMed]
- Choi, E.; Park, S.; Ahn, H.; Lee, M.; Bang, J.; Lee, B.; Ryu, D.Y. Substrate-Independent Lamellar Orientation in High-Molecular-Weight Polystyrene-b-poly(methyl methacrylate) Films: Neutral Solvent Vapor and Thermal Annealing Effect. Macromolecules 2014, 47, 3969–3977. [Google Scholar] [CrossRef]
- Cummins, C.; Ghoshal, T.; Holmes, J.D.; Morris, M.A. Strategies for Inorganic Incorporation using Neat Block Copolymer Thin Films for Etch Mask Function and Nanotechnological Application. Adv. Mater. 2016, 28, 5586–5618. [Google Scholar] [CrossRef] [PubMed]
- Guo, L.J. Nanoimprint Lithography: Methods and Material Requirements. Adv. Mater. 2007, 19, 495–513. [Google Scholar] [CrossRef]
- Gates, B.D.; Xu, Q.; Stewart, M.; Ryan, D.; Willson, C.G.; Whitesides, G.M. New Approaches to Nanofabrication: Molding, Printing, and Other Techniques. Chem. Rev. 2005, 105, 1171–1196. [Google Scholar] [CrossRef] [PubMed]
- Mårtensson, T.; Carlberg, P.; Borgström, M.; Montelius, L.; Seifert, W.; Samuelson, L. Nanowire Arrays Defined by Nanoimprint Lithography. Nano Lett. 2004, 4, 699–702. [Google Scholar] [CrossRef]
- Austin, M.D.; Ge, H.; Wu, W.; Li, M.; Yu, Z.; Wasserman, D.; Lyon, S.A.; Chou, S.Y. Fabrication of 5 nm linewidth and 14 nm pitch features by nanoimprint lithography. Appl. Phys. Lett. 2004, 84, 5299–5301. [Google Scholar] [CrossRef]
- Li, H.-W.; Huck, W.T.S. Ordered Block-Copolymer Assembly Using Nanoimprint Lithography. Nano Lett. 2004, 4, 1633–1636. [Google Scholar] [CrossRef]
- Park, S.-M.; Liang, X.; Harteneck, B.D.; Pick, T.E.; Hiroshiba, N.; Wu, Y.; Helms, B.A.; Olynick, D.L. Sub-10 nm Nanofabrication via Nanoimprint Directed Self-Assembly of Block Copolymers. ACS Nano 2011, 5, 8523–8531. [Google Scholar] [CrossRef] [PubMed]
- Salaun, M.; Zelsmann, M.; Archambault, S.; Borah, D.; Kehagias, N.; Simao, C.; Lorret, O.; Shaw, M.T.; Sotomayor Torres, C.M.; Morris, M.A. Fabrication of highly ordered sub-20 nm silicon nanopillars by block copolymer lithography combined with resist design. J. Mater. Chem. C 2013, 1, 3544–3550. [Google Scholar] [CrossRef]
- Politakos, N.; Ntoukas, E.; Avgeropoulos, A.; Krikorian, V.; Pate, B.D.; Thomas, E.L.; Hill, R.M. Strongly segregated cubic microdomain morphology consistent with the double gyroid phase in high molecular weight diblock copolymers of polystyrene and poly(dimethylsiloxane). J. Polym. Sci. Pol. Phys. 2009, 47, 2419–2427. [Google Scholar] [CrossRef]
- Jung, Y.S.; Ross, C.A. Orientation-Controlled Self-Assembled Nanolithography Using a Polystyrene−Polydimethylsiloxane Block Copolymer. Nano Lett. 2007, 7, 2046–2050. [Google Scholar] [CrossRef] [PubMed]
- O’Driscoll, B.M.D.; Kelly, R.A.; Shaw, M.; Mokarian-Tabari, P.; Liontos, G.; Ntetsikas, K.; Avgeropoulos, A.; Petkov, N.; Morris, M.A. Achieving structural control with thin polystyrene-b-polydimethylsiloxane block copolymer films: The complex relationship of interface chemistry, annealing methodology and process conditions. Eur. Polym. J. 2013, 49, 3445–3454. [Google Scholar] [CrossRef]
- Winesett, D.A.; Story, S.; Luning, J.; Ade, H. Tuning Substrate Surface Energies for Blends of Polystyrene and Poly(methyl methacrylate). Langmuir 2003, 19, 8526–8535. [Google Scholar] [CrossRef]
- Bracic, M.; Mohan, T.; Kargl, R.; Griesser, T.; Hribernik, S.; Kostler, S.; Stana-Kleinschek, K.; Fras-Zemljic, L. Preparation of PDMS ultrathin films and patterned surface modification with cellulose. RSC Adv. 2014, 4, 11955–11961. [Google Scholar] [CrossRef]
- Harrison, C.; Chaikin, P.M.; Huse, D.A.; Register, R.A.; Adamson, D.H.; Daniel, A.; Huang, E.; Mansky, P.; Russell, T.P.; Hawker, C.J.; et al. Reducing Substrate Pinning of Block Copolymer Microdomains with a Buffer Layer of Polymer Brushes. Macromolecules 2000, 33, 857–865. [Google Scholar] [CrossRef]
- Ly, D.Q.; Honda, T.; Kawakatsu, T.; Zvelindovsky, A.V. Kinetic Pathway of Gyroid-to-Cylinder Transition in Diblock Copolymer Melt under an Electric Field. Macromolecules 2007, 40, 2928–2935. [Google Scholar] [CrossRef]
- Simao, C.; Francone, A.; Borah, D.; Lorret, O.; Salaun, M.; Kosmala, B.; Shaw, M.T.; Dittert, B.; Kehagias, N.; Zelsmann, M.; et al. Soft Graphoepitaxy of Hexagonal PS-b-PDMS on Nanopatterned POSS Surfaces fabricated by Nanoimprint Lithography. J. Photopolym. Sci. Technol. 2012, 25, 239–244. [Google Scholar] [CrossRef]
- Borah, D.; Senthamaraikannan, R.; Rasappa, S.; Kosmala, B.; Holmes, J.D.; Morris, M.A. Swift Nanopattern Formation of PS-b-PMMA and PS-b-PDMS Block Copolymer Films Using a Microwave Assisted Technique. ACS Nano 2013, 7, 6583–6596. [Google Scholar] [CrossRef] [PubMed]
- Borah, D.; Shaw, M.T.; Holmes, J.D.; Morris, M.A. Sub-10 nm Feature Size PS-b-PDMS Block Copolymer Structures Fabricated by a Microwave-Assisted Solvothermal Process. ACS Appl. Mater. Interfaces 2013, 5, 2004–2012. [Google Scholar] [CrossRef] [PubMed]
- Borah, D.; Simao, C.D.; Senthamaraikannan, R.; Rasappa, S.; Francone, A.; Lorret, O.; Salaun, M.; Kosmala, B.; Kehagias, N.; Zelsmann, M.; et al. Soft-graphoepitaxy using nanoimprinted polyhedral oligomeric silsesquioxane substrates for the directed self-assembly of PS-b-PDMS. Eur. Polym. J. 2013, 49, 3512–3521. [Google Scholar] [CrossRef]
- Borah, D.; Rasappa, S.; Senthamaraikannan, R.; Kosmala, B.; Shaw, M.T.; Holmes, J.D.; Morris, M.A. Orientation and Alignment Control of Microphase-Separated PS-b-PDMS Substrate Patterns via Polymer Brush Chemistry. ACS Appl. Mater. Interfaces 2012, 5, 88–97. [Google Scholar] [CrossRef] [PubMed]
- Borah, D.; Ozmen, M.; Rasappa, S.; Shaw, M.T.; Holmes, J.D.; Morris, M.A. Molecularly Functionalized Silicon Substrates for Orientation Control of the Microphase Separation of PS-b-PMMA and PS-b-PDMS Block Copolymer Systems. Langmuir 2013, 29, 2809–2820. [Google Scholar] [CrossRef] [PubMed]
- Hobbs, R.G.; Farrell, R.A.; Bolger, C.T.; Kelly, R.A.; Morris, M.A.; Petkov, N.; Holmes, J.D. Selective Sidewall Wetting of Polymer Blocks in Hydrogen Silsesquioxane Directed Self-Assembly of PS-b-PDMS. ACS Appl. Mater. Interfaces 2012, 4, 4637–4642. [Google Scholar] [CrossRef] [PubMed]
- Jung, Y. S; Jung, W.; Tuller, H.L.; Ross, C.A. Nanowire Conductive Polymer Gas Sensor Patterned Using Self-Assembled Block Copolymer Lithography. Nano Lett. 2008, 8, 3776–3780. [Google Scholar] [CrossRef] [PubMed]
- Son, J.G.; Gotrik, K.W.; Ross, C.A. High-Aspect-Ratio Perpendicular Orientation of PS-b-PDMS Thin Films under Solvent Annealing. ACS Macro Lett. 2012, 1, 1279–1284. [Google Scholar] [CrossRef]
- Bai, W.; Gadelrab, K.; Alexander-Katz, A.; Ross, C.A. Perpendicular Block Copolymer Microdomains in High Aspect Ratio Templates. Nano Lett. 2015, 15, 6901–6908. [Google Scholar] [CrossRef] [PubMed]
- Borah, D.; Rasappa, S.; Salaun, M.; Zellsman, M.; Lorret, O.; Liontos, G.; Ntetsikas, K.; Avgeropoulos, A.; Morris, M.A. Soft Graphoepitaxy for Large Area Directed Self-Assembly of Polystyrene-block-Poly(dimethylsiloxane) Block Copolymer on Nanopatterned POSS Substrates Fabricated by Nanoimprint Lithography. Adv. Funct. Mater. 2015, 25, 3425–3432. [Google Scholar] [CrossRef]
- Crivello, J.V.; Malik, R. Synthesis and photoinitiated cationic polymerization of monomers with the silsesquioxane core. J. Polym. Sci. Pol. Chem. 1997, 35, 407–425. [Google Scholar] [CrossRef]
- Żenkiewicz, M. Comparative study on the surface free energy of a solid calculated by different methods. Polym. Test. 2007, 26, 14–19. [Google Scholar] [CrossRef]

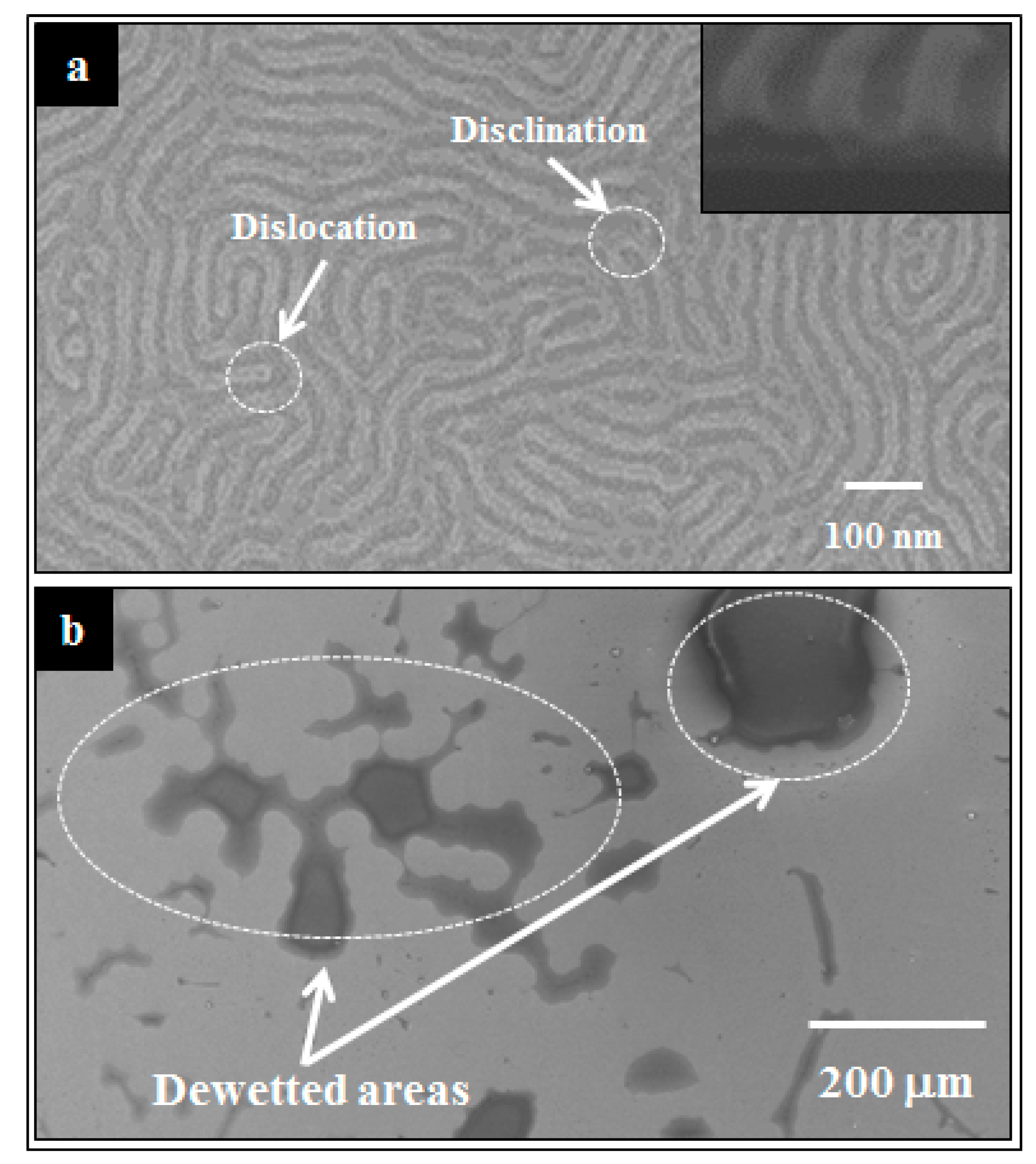

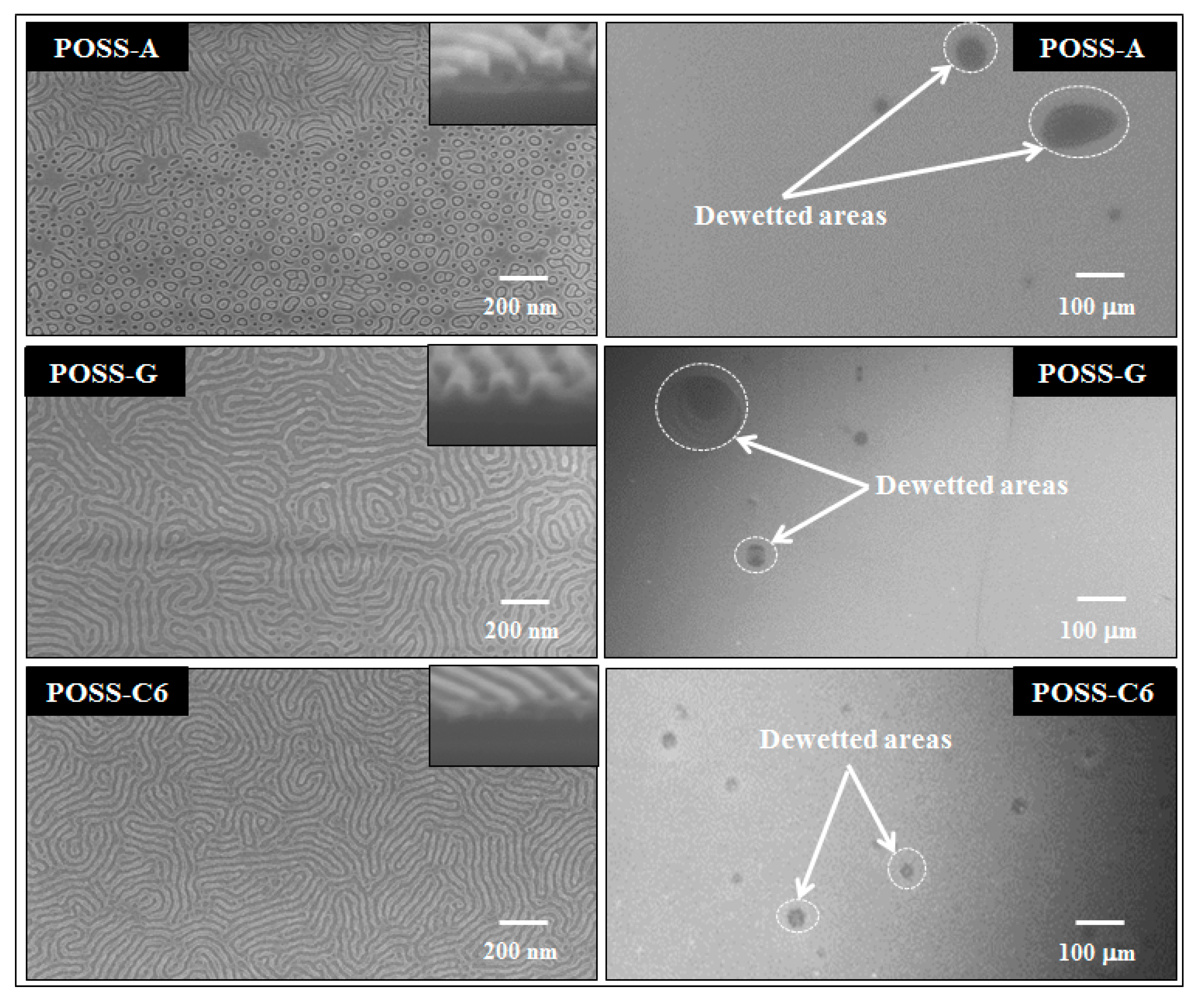
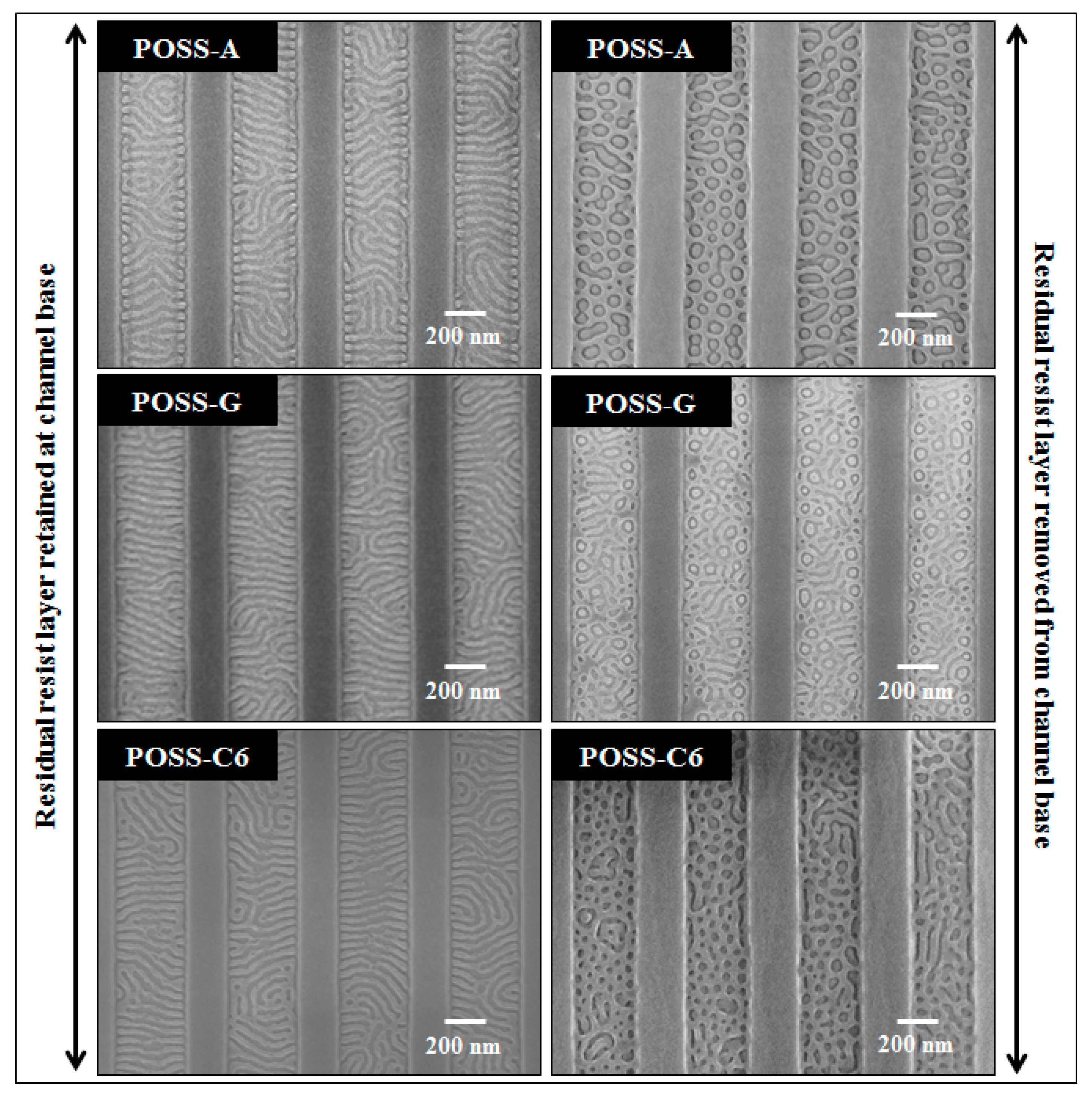
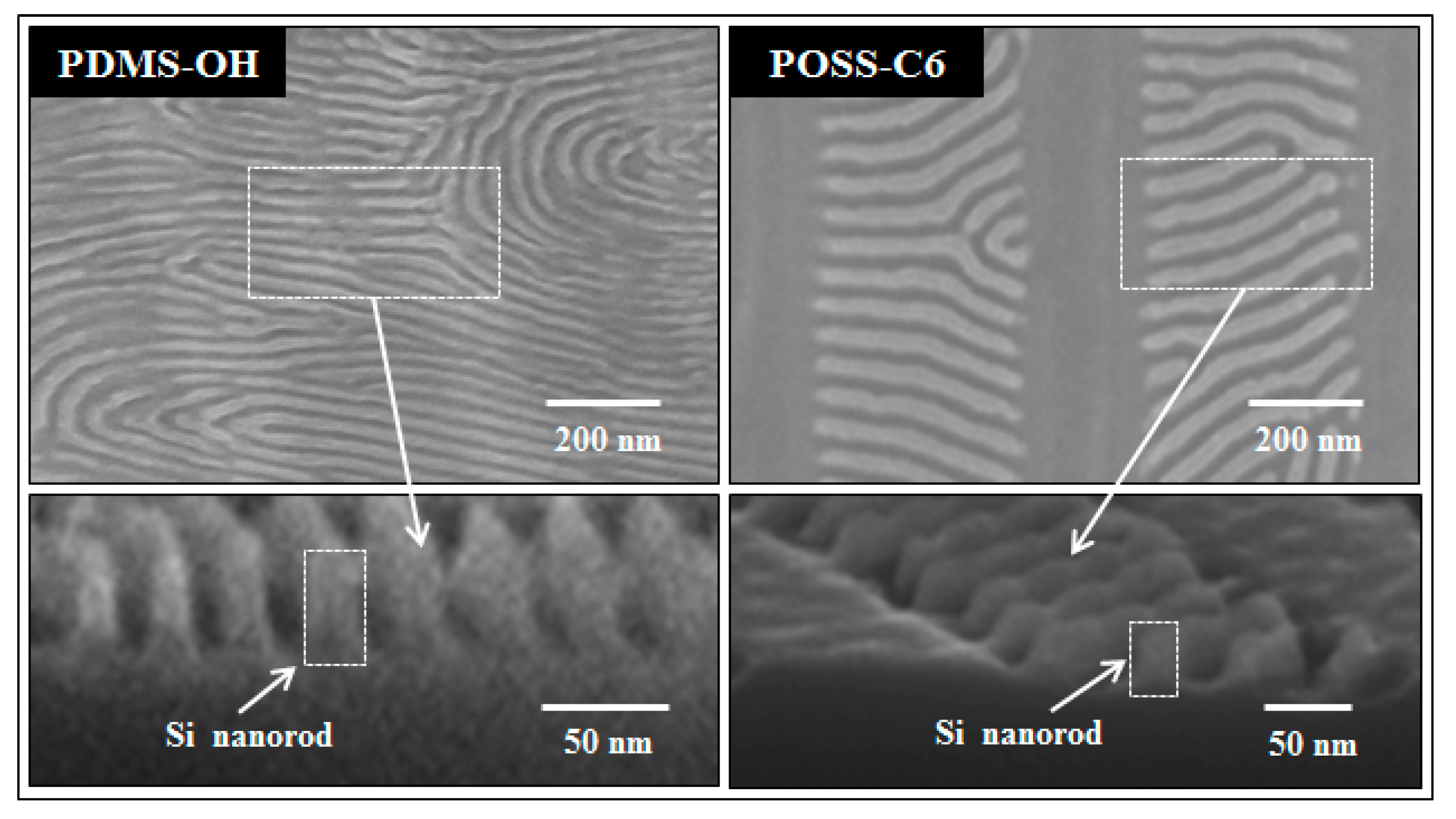
| POSS Type | θDI (°) | θDIM (°) | θEG (°) | SFE (mN/m) |
|---|---|---|---|---|
| POSS-A | 59.3 | 42.7 | 33.9 | 47.5 |
| POSS-G | 68.1 | 43.0 | 44.9 | 42.7 |
| POSS-C6 | 83.6 | 57.3 | 65.1 | 31.1 |
© 2018 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Borah, D.; Cummins, C.; Rasappa, S.; Senthamaraikannan, R.; Salaun, M.; Zelsmann, M.; Liontos, G.; Ntetsikas, K.; Avgeropoulos, A.; Morris, M.A. Nanopatterning via Self-Assembly of a Lamellar-Forming Polystyrene-block-Poly(dimethylsiloxane) Diblock Copolymer on Topographical Substrates Fabricated by Nanoimprint Lithography. Nanomaterials 2018, 8, 32. https://doi.org/10.3390/nano8010032
Borah D, Cummins C, Rasappa S, Senthamaraikannan R, Salaun M, Zelsmann M, Liontos G, Ntetsikas K, Avgeropoulos A, Morris MA. Nanopatterning via Self-Assembly of a Lamellar-Forming Polystyrene-block-Poly(dimethylsiloxane) Diblock Copolymer on Topographical Substrates Fabricated by Nanoimprint Lithography. Nanomaterials. 2018; 8(1):32. https://doi.org/10.3390/nano8010032
Chicago/Turabian StyleBorah, Dipu, Cian Cummins, Sozaraj Rasappa, Ramsankar Senthamaraikannan, Mathieu Salaun, Marc Zelsmann, George Liontos, Konstantinos Ntetsikas, Apostolos Avgeropoulos, and Michael A. Morris. 2018. "Nanopatterning via Self-Assembly of a Lamellar-Forming Polystyrene-block-Poly(dimethylsiloxane) Diblock Copolymer on Topographical Substrates Fabricated by Nanoimprint Lithography" Nanomaterials 8, no. 1: 32. https://doi.org/10.3390/nano8010032