TSV Technology and High-Energy Heavy Ions Radiation Impact Review
Abstract
:1. Introduction
2. Silicon Interposers and TSV Technology
2.1. Silicon Interposer Production
2.2. Silicon Interposer Structure
2.3. The Silicon Interposer Testing Technology
2.4. Thermal Design of Silicon Interposer
2.5. Micro-Bump Electromigration and Heat Transfer
2.6. The TSV and Interposer Technology Conclusion
3. Influence of High-Energy Particle Radiation on Semiconductor Devices
3.1. Influence of High-Energy Particles on Semiconductor Devices
3.2. The High-Energy Heavy Ions Radiation Simulator
3.3. Mathematical Simulation and Optimization of Single Particle Effect
3.4. How to Reduce the Influence of High-Energy Particles on Semiconductor Devices
3.5. Summary of the Impact of High-Energy Heavy Ions on Semiconductor Devices
4. Effect of High-Energy Heavy Ions on Silicon Interposer (Discussion)
4.1. Prediction of Failure of the Silicon Interposer Caused by High-Energy Heavy Ions
4.2. Research Method for High-Energy Heavy Ion Influence on Silicon Interposer
Author Contributions
Funding
Conflicts of Interest
References
- William, S. Semiconductive Wafer and Method of Making the Same. U.S. Patent 3,044,909, 17 July 1962. [Google Scholar]
- Smith, M.G.; Emanuel, S. Methods of Making Thru-Connections in Semiconductor Wafers. U.S. Patent 3,343,256, 26 September 1967. [Google Scholar]
- Lau, J.H.; Lee, C.K.; Premachandran, C.S.; Yu, A. Advanced MEMS Packaging; McGraw-Hill: New York, NY, USA, 2010. [Google Scholar]
- Lau, J.H. Reliability of RoHS Compliant 2D & 3D IC Interconnects; McGraw-Hill: New York, NY, USA, 2011. [Google Scholar]
- Pares, G.; Karoui, C.; Zaid, A.; Dosseul, F.; Feron, M.; Attard, A.; Klug, G.; Luesebrink, H.; Martinschitz, K.; Launay, N.; et al. Full integration of a 3D demonstrator with TSV first interposer, ultra thin die stacking and wafer level packaging. In Proceedings of the 2013 IEEE 63rd Electronic Components and Technology Conference (ECTC), Las Vegas, NV, USA, 28–31 May 2013. [Google Scholar]
- Kim, J.; Cho, J.; Kim, J. TSV modeling and noise coupling in 3D IC. In Proceedings of the 2010 IEEE 3rd Electronics System Integration Technology Conference (ESTC), Berlin, Germany, 13–16 September 2010. [Google Scholar]
- Ferrandon, C.; Jouve, A.; Joblot, S.; Lamy, Y.; Schreiner, A.; Montmeat, P.; Pellat, M.; Argoud, M.; Fournel, F.; Simon, G.; et al. Innovative wafer-level encapsulation underfill material for silicon interposer application. In Proceedings of the 2013 IEEE 63rd Electronic Components and Technology Conference (ECTC), Las Vegas, NV, USA, 28–31 May 2013. [Google Scholar]
- Diehl, D.; Kitada, H.; Maeda, N.; Fujimoto, K.; Ramaswami, S.; Sirajuddin, K.; Yalamanchili, R.; Eaton, B.; Rajagopalan, N.; Ding, R.; et al. Formation of TSV for the stacking of advanced logic devices utilizing bumpless wafer-on-wafer technology. Microelectron. Eng. 2012, 92, 3–8. [Google Scholar] [CrossRef]
- Detalle, M.; La Manna, A.; De Vos, J.; Nolmans, P.; Daily, R.; Civale, Y.; Beyer, G.; Beyne, E. Interposer technology for high band width interconnect applications. In Proceedings of the 2013 IEEE 63rd Electronic Components and Technology Conference (ECTC), Las Vegas, NV, USA, 28–31 May 2013. [Google Scholar]
- Zhang, W. Fine pitch Cu/Sn solid state diffusion bonding for advanced three-dimensional chip stacking. Jpn. J. Appl. Phys. 2015, 54, 1–7. [Google Scholar] [CrossRef]
- Civale, Y.; Van Huylenbroeck, S.; Redolfi, A.; Guo, W.; Gavan, K.B.; Jaenen, P.; La Manna, A.; Beyer, G.; Swinnen, B.; Beyne, E. Via-middle through silicon via with integrated airgap to zero TSV induced stress impact on device performance. In Proceedings of the 2013 IEEE 63rd Electronic Components and Technology Conference (ECTC), Las Vegas, NV, USA, 28–31 May 2013. [Google Scholar]
- Tezcan, D.S.; Duval, F.; Philipsen, H.; Luhn, O.; Soussan, P.; Swinnen, B. Scalable through silicon via with polymer deep trench isolation for 3D wafer level packaging. In Proceedings of the 2009 IEEE 59th Electronic Components and Technology Conference (ECTC), San Diego, CA, USA, 26–29 May 2009. [Google Scholar]
- Lim, J.; Cho, J.; Jung, D.H.; Kim, J.J.; Choi, S.; Kim, D.H.; Lee, M.; Kim, J. Modeling and Analysis of TSV Noise Coupling Effects on RF LC-VCO and Shielding Structures in 3D IC. IEEE Trans. Electromagn. Compat. 2018, PP, 1–9. [Google Scholar] [CrossRef]
- Wang, Y.; Han, Y.H.; Zhang, L. Economizing TSV Resources in 3-D Network-on-Chip Design. IEEE Trans. VLSI Syst. 2015, 23, 493–506. [Google Scholar] [CrossRef]
- Yook, J.M.; Kim, J.C.; Park, S.H.; Ryu, J.I.; Park, J.C. High density and low-cost silicon interposer using thin-film and organic lamination processes. In Proceedings of the 2012 IEEE 62nd Electronic Components and Technology Conference (ECTC), San Diego, CA, USA, 29 May–1 June 2012. [Google Scholar]
- Nakahira, K.; Tago, H.; Endo, F.; Suzuki, K.; Miura, H. Minimization of the local residual stress in 3D flip chip structures by optimizing the mechanical properties of electroplated materials and the alignment structure of TSVs and fine bumps. ASME J. Electron. Packag. 2011, 134, 19–25. [Google Scholar]
- Heryanto, A.; Putra, W.N.; Trigg, A.; Gao, S.; Kwon, W.S.; Che, F.X.; Ang, X.F.; Wei, J.; Made, R.I.; Gan, C.L.; Pey, K.L. Effect of copper TSV annealing on via protrusion for TSV wafer fabrication. J. Electron. Mater. 2012, 41, 2533–2542. [Google Scholar] [CrossRef]
- Sun, X.; Cui, Q.; Zhu, Y.; Zhu, Z.; Miao, M.; Chen, J.; Jin, Y. Electrical characterization of cylindrical and annular TSV for combined application thereof. In Proceedings of the 2011 IEEE 12th International Conference on Electronic Packaging Technology and High Density Packaging (ICEPT-HDP), Shanghai, China, 8–11 August 2011. [Google Scholar]
- Xie, B.; Shi, X.Q.; Chung, C.H.; Lee, S.W.R. Novel sequential electro-chemical and thermomechanical simulation methodology for annular through-silicon-via (TSV) design. In Proceedings of the 2010 IEEE 60th Electronic Components and Technology Conference (ECTC), Las Vegas, NV, USA, 1–4 June 2010. [Google Scholar]
- Wang, F.; Zhu, Z.; Yang, Y.; Liu, X.; Ding, R. Analytical models for the thermal strain and stress induced by annular through-silicon-via (TSV). IEICE Electron. 2013, 10, 666–672. [Google Scholar] [CrossRef]
- Xu, X.L.; Zhao, W.S.; Yin, W.Y. Modeling of a pair of annular through silicon vias (TSV). In Proceedings of the 2011 IEEE Electrical Design of Advanced Packaging and Systems Symposium (EDAPS), Hanzhou, China, 12–14 December 2011. [Google Scholar]
- El Bouayadi, O.; Dussopt, L.; Lamy, Y.; Dehos, C.; Ferrandon, C.; Siligaris, A.; Soulier, B.; Simon, G.; Vincent, P. Silicon interposer: A versatile platform towards full-3D integration of wireless systems at millimeter-wave frequencies. In Proceedings of the 2015 IEEE 65th Electronic Components and Technology Conference (ECTC), San Diego, CA, USA, 26–29 May 2015. [Google Scholar]
- Zhang, Y.; Ding, G.; Wang, H.; Cheng, P. Effect of external factors on copper filling in 3D integrated through-silicon-vias (TSVs). J. Electrochem. Soc. 2015, 162, 427–434. [Google Scholar] [CrossRef]
- Guan, Y.; Ma, S.; Zeng, Q.; Chen, J.; Jin, Y. Fabrication and characterization of annular copper through-silicon via for passive interposer applications. IEEE Trans. Semicond. Manuf. 2018, 31, 270–276. [Google Scholar] [CrossRef]
- PD, S.M.; Lin, J.; Zhu, S.; Yin, Y.; Liu, X.; Huang, X.; Song, C.; Zhang, W.; Yan, M.; Yu, H.; et al. A scalable network-on-chip microprocessor with 2.5 D integrated memory and accelerator. IEEE Trans. Circuits Syst. Regul. Pap. 2017, 64, 1432–1443. [Google Scholar]
- Jeon, Y.; Kim, H.; Kim, J.; Je, M. Design of an on-silicon-interposer passive equalizer for next generation high bandwidth memory with data rate up to 8 gb/s. IEEE Trans. Circuits Syst. Regul. Pap. 2018, 65, 1–11. [Google Scholar] [CrossRef]
- Zhang, Y.; Wang, H.; Sun, Y.; Wu, K.; Wang, H.; Cheng, P.; Ding, G. Copper electroplating technique for efficient manufacturing of low-cost silicon interposers. Microelectron. Eng. 2016, 65, 39–42. [Google Scholar] [CrossRef]
- Laurila, M.M.; Khorramdel, B.; Mantysalo, M. Combination of E-jet and inkjet printing for additive fabrication of multilayer high-density RDL of silicon interposer. IEEE Trans. Electron. Devices 2017, 64, 1217–1224. [Google Scholar] [CrossRef]
- Zhang, W.; Song, C.; Xue, K.; Yang, S.; Yong, Z.; Li, H. Silicon interposer process development for advanced system integration. Microelectron. Eng. 2016, 156, 50–54. [Google Scholar] [CrossRef]
- Ko, Y.K.; Kang, M.S.; Kokawa, H.; Sato, Y.S. Advanced TSV filling method with Sn alloy and its reliability. In Proceedings of the 2011 IEEE International 3D Systems Integration Conference (3DIC), Osaka, Japan, 31 January–2 February 2011. [Google Scholar]
- Ogawa, S.; Soda, S.; Lee, S.S.; Izuo, S.; Yoshida, Y. Rf-mems switch with through-silicon via by the molten solder ejection method. Sens. Actuators A 2012, 181, 77–80. [Google Scholar] [CrossRef]
- Jee, Y.K.; Yu, J.; Park, K.W.; Oh, T.S. Zinc and tin-zinc via-filling for the formation of through-silicon vias in a system-in-package. J. Electron. Mater. 2009, 38, 685–690. [Google Scholar] [CrossRef]
- Khorramdel, B.; Mantysalo, M. Inkjet filling of TSVs with silver nanoparticle ink. In Proceedings of the 2014 IEEE 5th Electronics System-integration Technology Conference (ESTC), Helsinki, Finland, 16–18 September 2014. [Google Scholar]
- Schröder, S.; Fischer, A.C.; Stemme, G.; Niklaus, F. Very high aspect ratio through silicon vias (TSVs) using wire bonding. In Proceedings of the 2013 IEEE 17th International Conference on Solid-State Sensors, Actuators and Microsystems (TRANSDUCERS & EUROSENSORS XXVII), Barcelona, Spain, 16–20 June 2013. [Google Scholar]
- Qiu, Y.; Yue, S.; Moussa, W.A.; Mousavi, P. Development of embedded redistribution layer-based silicon interposer for 3-d integration. IEEE Trans. Compon. Packag. Manuf. Technol. 2018, 8, 399–409. [Google Scholar] [CrossRef]
- Choi, S.K.; Eom, S.Y.; Bae, C.H.; Moon, S.H.; Lee, J.H. Characterization of transmission lines with through-silicon-vias and bump joints on high-resistivity Si interposers for RF three-dimensional modules. Jpn. J. Appl. Phys. 2016, 55, 06JC01. [Google Scholar] [CrossRef]
- Kim, Y.; Cho, K.; Kim, S.; Park, G.; Kim, J. Power/ground noise coupling comparison and analysis in silicon, organic and glass interposers. In Proceedings of the 2016 IEEE Electrical Design of Advanced Packaging and Systems Symposium (EDAPS), Honolulu, HI, USA, 16 December 2016. [Google Scholar]
- Wang, W.; He, K.; Wang, P. Fabrication of Through-Silicon-Vias Filled with Polysilicon. Chin. J. Sens. Actuators 2017, 30, 59–63. [Google Scholar]
- Qian, L.; Xia, Y.; Shi, G.; Wang, J.; Ye, Y.; Du, S. Electrical-Thermal Characterization of Through Packaging Vias in Glass Interposer. IEEE Trans. Nanotechnol. 2017, 16, 901–908. [Google Scholar] [CrossRef]
- Erdmann, C.; Lowney, D.; Lynam, A.; Keady, A.; Mcgrath, J.; Cullen, E.; Breathnach, D.; Keane, D.; Lynch, P.; De La Torre, M.; et al. A heterogeneous 3D-IC consisting of two 28 nm FPGA die and 32 reconfigurable high-performance data converters. IEEE J. Solid-State Circuits 2015, 50, 258–269. [Google Scholar] [CrossRef]
- Chen, Y.G.; Wen, W.Y.; Shi, Y.; Hon, W.K.; Chang, S.C. Novel spare TSV deployment for 3-D ICs considering yield and timing constraints. IEEE Trans. Comput. Aided Des. Integr. Circuits Syst. 2015, 34, 577–588. [Google Scholar] [CrossRef]
- Wang, H.; Ren, X.; Zhou, J.; Pang, C.; Song, C.; Dai, F.; Xue, K.; Jiang, F.; Yu, D.; Wan, L. High frequency characterization and analysis of through silicon vias and coplanar waveguides for silicon interposer. Microsyst. Technol. 2016, 22, 337–347. [Google Scholar] [CrossRef]
- Yang, D.C.; Xie, J.; Swaminathan, M.; Wei, X.C.; Li, E.P. A rigorous model for through-silicon vias with ohmic contact in silicon interposer. IEEE Microw. Wirel. Compon. Lett. 2013, 23, 385–387. [Google Scholar] [CrossRef]
- Li, Y.S.; Xu, Y.L.; Yang, D.C.; Li, J.; Wei, X.C.; Li, E.P. A Shielding Structure for Crosstalk Reduction in Silicon Interposer. IEEE Microw. Wirel. Compon. Lett. 2016, 26, 246–248. [Google Scholar] [CrossRef]
- Dahl, D.; Reuschel, T.; Preibisch, J.B.; Duan, X.; Ndip, I.; Lang, K.D.; Schuster, C. Efficient total crosstalk analysis of large via arrays in silicon interposers. IEEE Trans. Compon. Packag. Manuf. Technol. 2016, 6, 1889–1898. [Google Scholar] [CrossRef]
- Lee, W.C.; Min, B.W.; Kim, J.C.; Yook, J.M. Silicon-core coaxial through silicon via for low-loss RF Si-interposer. IEEE Microw. Wirel. Compon. Lett. 2017, 27, 428–430. [Google Scholar] [CrossRef]
- Liu, Y.; Luo, L. Design on integrated passive devices and silicon interposer integration. Electron. Des. Engin. 2017, 25, 95–98. (In Chinese) [Google Scholar]
- Dieng, K.; Artillan, P.; Bermond, C.; Guiller, O.; Lacrevaz, T.; Joblot, S.; Houzet, G.; Farcy, A.; Perrier, A.L.; Lamy, Y.; et al. Modeling and Frequency Performance Analysis of Through Silicon Capacitors in Silicon Interposers. Trans. Compon. Packag. Manuf. Technol. 2017, 7, 477–484. [Google Scholar] [CrossRef]
- Zhang, Z.; Kleinert, M.; Maese-Novo, A.; Irmscher, G. Multicore polymer waveguides and multistep 45° mirrors for 3D photonic integration. IEEE Photon. Technol. Lett. 2016, 26, 1986–1989. [Google Scholar] [CrossRef]
- Luo, Y.; Chamanzar, M.; Apuzzo, A.; Salasmontiel, R.; Nguyen, K.N.; Blaize, S. On-chip hybrid photonic–plasmonic light concentrator for nanofocusing in an integrated silicon photonics platform. Nano Lett. 2015, 15, 849–856. [Google Scholar] [CrossRef] [PubMed]
- Chen, H.; Fontaine, N.K.; Ryf, R.; Guan, B.; Yoo, S.J.B.; Koonen, T. Design constraints of photonic-lantern spatial multiplexer based on laser-inscribed 3D-waveguide technology. J. Lightwave Technol. 2015, 33, 1147–1154. [Google Scholar] [CrossRef]
- Guan, B.; Scott, R.P.; Qin, C.; Fontaine, N.K.; Su, T.; Ferrari, C. Free-space coherent optical communication with orbital angular momentum multiplexing/demultiplexing using a hybrid 3D photonic integrated circuit. Opt. Express 2014, 22, 145–156. [Google Scholar] [CrossRef] [PubMed]
- Noriki, A.; Amano, T.; Shimura, D.; Onawa, Y.; Sasaki, H.; Yamada, K. Broadband and polarization-independent efficient vertical optical coupling with Si integrated 45 degree mirror. J. Lightw. Technol. 2015, 34, 3012–3018. [Google Scholar] [CrossRef]
- Chen, H.W.; Kuo, Y.H.; Bowers, J.E. A hybrid silicon-AlGaInAs phase modulator. IEEE Photon. Technol. Lett. 2008, 20, 1920–1922. [Google Scholar] [CrossRef]
- Dong, P.; Hu, T.C.; Liow, T.Y.; Chen, Y.K.; Xie, C.; Luo, X. Novel integration technique for silicon/III-V hybrid laser. Opt. Express 2014, 22, 26854–26861. [Google Scholar] [CrossRef] [PubMed]
- Zhang, Y.; Ling, Y.C.; Zhang, Y.; Shang, K.; Yoo, S.J.B. High-density wafer-scale 3d silicon-photonic integrated circuits. IEEE J. Sel. Top. Quantum Electron. 2018, 24, 1–10. [Google Scholar]
- Wang, R.; Chakrabarty, K.; Eklow, B. Post-bond Testing of the Silicon Interposer and Micro-bumps in 2.5D ICs. In Proceedings of the 2013 IEEE 22nd Asian Test Symposium, Jiaosi Township, Taiwan, 18–21 November 2013. [Google Scholar]
- Chi, C.C.; Marinissen, E.J.; Goel, S.K.; Wu, C.W. Low-cost post-bond testing of 3-D ICs containing a passive silicon interposer base. IEEE Trans. Very Large Scale Integr. VLSI Syst. 2014, 22, 2388–2401. [Google Scholar] [CrossRef]
- Christo, M.A.; Maldonado, J.A.; Weekly, R.D.; Zhou, T. Silicon Interposer Testing for Three Dimensional Chip Stack. U.S. Patent 7,863,106, 4 April 2011. [Google Scholar]
- Li, K.; Wang, S.; Ku, R.; Chen, B.C. Layout-Aware Optimized Prebond Silicon Interposer Test Synthesis. IEEE Des. Test Comput. 2017, 34, 77–83. [Google Scholar]
- Wang, R.; Li, Z.; Kannan, S.; Chakrabarty, K. Pre-Bond Testing and Test-Path Design for the Silicon Interposer in 2.5D ICs. In Proceedings of the 2016 IEEE Transactions on Computer-Aided Design of Integrated Circuits and Systems, Dresden, Germany, 14–18 March 2016. [Google Scholar]
- Williams, D.F.; Miers, T.H. De-embedding coplanar probes with planar distributed standards. IEEE Trans. Microw. Theory Tech. 1988, 36, 1876–1880. [Google Scholar] [CrossRef]
- Tiemeijer, L.F.; Pijper, R.M.T.; Van Der Heijden, E. Two multiport de-embedding methods for accurate on-wafer characterization of 60-GHz differential amplifiers. IEEE Trans. Microw. Theory Tech. 2011, 59, 763–771. [Google Scholar] [CrossRef]
- Tiemeijer, L.F.; Pijper, R.M.T.; Van Steenwijk, J.A.; Van Der Heijden, E. A new 12-term open–short–load de-embedding method for accurate on-wafer characterization of RF MOSFET structures. IEEE Trans. Microw. Theory Tech. 2010, 58, 419–433. [Google Scholar] [CrossRef]
- Wang, Q.; Cho, J.; Erickson, N.; Hwang, C.; De Paulis, F.; Piersanti, S.; Orlandi, A.; Achkir, B.; Fan, J. Novel de-embedding methodology and broadband microprobe measurement for through-silicon via pair in silicon interposer. IEEE Trans. Electromagn. Compat. 2017, 59, 1565–1575. [Google Scholar] [CrossRef]
- Kim, J.J.; Kim, H.; Jung, D.H.; Choi, S.; Lim, J.; Kim, Y.; Park, J.; Kim, H.; Ha, D.; Bae, M.; Kim, J. Signal integrity design and analysis of a multilayer test interposer for LPDDR4 memory test with silicone rubber-based sheet contact. IEEE Trans. Electromagn. Compat. 2017, 59, 1239–1251. [Google Scholar] [CrossRef]
- Oh, H.; Zhang, Y.; Zheng, L.; May, G.S.; Bakir, M.S. Fabrication and Characterization of Electrical Interconnects and Microfluidic Cooling for 3D ICS With Silicon Interposer. Heat Transf. Eng. 2016, 37, 903–911. [Google Scholar] [CrossRef]
- Zhang, Y.; Zhang, Y.; Bakir, M.S. Thermal design and constraints for heterogeneous integrated chip stacks and isolation technology using air gap and thermal bridge. IEEE Trans. Compon. Packag. Manuf. Technol. 2014, 4, 1914–1924. [Google Scholar] [CrossRef]
- Emma, P.G.; Kursun, E. Is 3D chip technology the next growth engine for performance improvement? IBM J. Res. Dev. 2008, 52, 541–552. [Google Scholar] [CrossRef]
- Li, C.; Smalbrugge, B.; Li, T.; Stabile, R.; Raz, O. 3D packaging of embedded opto-electronic die and CMOS IC based on wet etched silicon interposer. In Proceedings of the 2017 IEEE 67th Electronic Components and Technology Conference (ECTC), Orlando, FL, USA, 30 May–2 June 2017. [Google Scholar]
- Li, C.; Stabile, R.; Li, T.; Smalbrugge, B.; de Villota, G.G.; Raz, O. Wet-etched three-level silicon interposer for 3-D embedding and connecting of optoelectronic dies and CMOS ICs. IEEE Trans. Compon. Packag. Manuf. Technol. 2018, 8, 570–577. [Google Scholar] [CrossRef]
- Ding, M. Investigation of Electromigration Reliability of Solder Joint in Flip-Chip Packages. Ph.D. Thesis, The University of Texas at Austin, Austin, TX, USA, August 2007. [Google Scholar]
- Johnson, R.W.; Shen, Y.L. Analysis of misalignment-induced deformation in three-dimensional semiconductor chip stacks. Microelectron. Int. 2014, 31, 61–70. [Google Scholar] [CrossRef]
- Shen, Y.L.; Johnson, R.W. Misalignment induced shear deformation in 3D chip stacking: A parametric numerical assessment. Microelectron. Reliab. 2013, 53, 79–89. [Google Scholar] [CrossRef]
- Shen, Y.L.; Flores, G.C.; Guthrie, J. Numerical study of microbump failure in 3D microelectronic structures. Microelectron. Reliab. 2016, 61, 48–55. [Google Scholar] [CrossRef]
- Zou, H.F.; Zhang, Z.F. Application of electron backscatter diffraction to the study on orientation distribution of intermetallic compounds at heterogeneous interfaces (Sn/Ag and Sn/Cu). J. Appl. Phys. 2010, 108, 103518. [Google Scholar] [CrossRef]
- Wang, S.J.; Hsu, L.H.; Wang, N.K.; Ho, C.E. Ebsd investigation of Cu-Sn IMC microstructural evolution in Cu/Sn-Ag/Cu microbumps during isothermal annealing. J. Electron. Mater. 2014, 43, 219–228. [Google Scholar] [CrossRef]
- Chen, D.; Ho, C.E.; Kuo, J.C. Current stressing-induced growth of Cu3Sn in Cu/Sn/Cu solder joints. Mater. Lett. 2011, 65, 1276–1279. [Google Scholar] [CrossRef]
- Suh, J.O.; Tu, K.N.; Wu, A.T.; Tamura, N. Preferred orientation relationships with large misfit interfaces between Ni3Sn4 and Ni in reactive wetting of eutectic SnPb on Ni. J. Appl. Phys. 2011, 109, 063511. [Google Scholar] [CrossRef]
- Wang, C.H.; Liu, J.L. Effects of Sn thickness on morphology and evolution of Ni3Sn4, grains formed between molten Sn and Ni substrate. Intermetallics 2015, 61, 9–15. [Google Scholar] [CrossRef]
- Huang, Y.T.; Chen, C.H.; Chakroborty, S.; Wu, A.T. Crystallographic Orientation Effect on Electromigration in Ni-Sn Microbump. JOM 2017, 69, 1717–1723. [Google Scholar] [CrossRef] [Green Version]
- Li, M.; Kim, D.W.; Gu, S.; Parkinson, D.Y.; Barnard, H.; Tu, K.N. Joule heating induced thermomigration failure in un-powered microbumps due to thermal crosstalk in 2. 5D IC technology. J. Appl. Phys. 2016, 120, 075105. [Google Scholar] [CrossRef]
- Chen, K.N.; Tu, K.N. Materials challenges in three-dimensional integrated circuits. Mater. Challenges 3D IC Technol. 2015, 40, 219–222. [Google Scholar] [CrossRef] [Green Version]
- Wang, Y.; De Rosa, I.M.; Tu, K.N. IEEE Components, Packaging, and Manufacturing Technology Society. In Proceedings of the 2015 IEEE 65th Electronic Components and Technology Conference (ECTC), San Diego, CA, USA, 26–29 May 2015. [Google Scholar]
- Ouyang, F.Y.; Jhu, W.C.; Chang, T.C. Thermal-gradient induced abnormal Ni3Sn4 interfacial growth at cold side in Sn2.5Ag alloys for three-dimensional integrated circuits. J. Alloys Compd. 2013, 580, 114–119. [Google Scholar] [CrossRef]
- Ouyang, F.Y.; Hao, H.; Su, Y.P. Electromigration induced failure on lead-free micro bumps in three–dimensional integrated circuits packaging. J. Appl. Phys. 2012, 112, 023505. [Google Scholar] [CrossRef]
- Chu, Y.C.; Chen, C.; Kao, N.; Jiang, D.S. Effect of Sn grain orientation and strain distribution in 20-µm-diameter microbumps on crack formation under thermal cycling tests. Electron. Mater. Lett. 2017, 13, 457–462. [Google Scholar] [CrossRef]
- Stassinopoulos, E.G.; Raymond, J.P. The Space radiation environment for electronics. Proc. IEEE 1988, 76, 1423–1442. [Google Scholar] [CrossRef]
- Fleetwood, D.M.; Winokur, P.S.; Dodd, P.E. Overview of radiation effects on electronics in the space telecommunications environment. Microelectron. Reliab. 2000, 40, 17–26. [Google Scholar] [CrossRef]
- Musseau, O. Effets des Ions Lourds Energetiques sur les Circuits Integres: Application au cas de Circuits Mos, Mos sur Isolants et Gaas. Ph.D. Thesis, Université Paris 11 Paris Sud, Orsay, Paris, 1991. [Google Scholar]
- Adams, L. Cosmic ray effects in microelectronics. Microelectron. J. 1985, 16, 17–29. [Google Scholar] [CrossRef]
- Luo, Y.-H.; Guo, X.Q.; Chen, W.; Guo, G.; Fan, H. Energy and angular dependence of single event upsets in ESA SEU Monitor. Acta Phys. Sin. 2016, 65, 206103. [Google Scholar] [CrossRef]
- Luo, J.; Liu, J.; Sun, Y.; Hou, M.; Xi, K.; Liu, T.; Wang, B.; Ye, B. Influence of heavy ion flux on single event effect testing in memory devices. Nucl. Instrum. Method Phys. Res. Sect. B 2017, 406, 431–436. [Google Scholar] [CrossRef]
- Hu, C.; Chen, S.; Wu, Z.; Song, R.; Chi, Y. Single event effect experiment on SoC using pulsed laser. J. National Univ. Defense Tech. 2017, 39, 134–139. [Google Scholar]
- Ikeda, N.; Shindou, H.; Iide, Y.; Asai, H.; Kuboyama, S.; Matsuda, S. Evaluation of the errors of commercial semiconductor devices in a space radiation environment. IEICE. Trans. Commun. 2005, 88, 108–116. [Google Scholar]
- Titus, J.L. An updated perspective of single event gate rupture and single event burnout on power MOSFETs. IEEE Trans. Nucl. Sci. 2013, 60, 1912–1928. [Google Scholar] [CrossRef]
- Sexton, F.W.; Fleetwood, D.M.; Shaneyfelt, M.R.; Dodd, P.E. Precursor ion damage and angular dependence of single event gate rupture in thin oxides. IEEE Trans. Nucl. Sci. 1998, 45, 2509–2518. [Google Scholar] [CrossRef]
- Lauenstein, J.M.; Goldsman, N.; Liu, S.; Titus, J.L.; Ladbury, R.L.; Kim, H.S. Effects of ion atomic number on single-event gate rupture (SEGR) susceptibility of power MOSFET. IEEE Trans. Nucl. Sci. 2011, 58, 2628–2636. [Google Scholar] [CrossRef]
- He, C.; Li, Y.; Yang, H. Research progress of single particle radiation simulation experiments. Nucl. Technol. 2007, 30, 347–351. [Google Scholar]
- Sometani, M.; Okamoto, M.; Hatakeyama, T. Accurate evaluation of fast threshold voltage shift for SiC MOS devices under various gate bias stress conditions. Jpn. J. Appl. Phys. 2018, 57, 04FA07. [Google Scholar] [CrossRef] [Green Version]
- Loveless, T.D.; Massengill, L.W.; Bhuva, B.L.; Holman, W.T.; Reed, R.A.; Mcmorrow, D. A single-event-hardened phase-locked loop fabricated in 130 nm CMOS. IEEE Trans. Nucl. Sci. 2007, 54, 2012–2020. [Google Scholar] [CrossRef]
- Wrobel, F.; Touboul, A.D.; Pouget, V.; Dilillo, L.; Boch, J.; Saigne, F. A calculation method to estimate single event upset cross section. Microelectron. Reliab. 2017, 76, 644–649. [Google Scholar] [CrossRef]
- Shen, D.J.; Fan, H.; Guo, G.; Liu, JC.; Shi, S.T.; Chen, Q.; Hajdas, W.; Luo, Y.H.; Guo, X.-Q. Single event effect calibration experiment with ESA single event upset monitor on Beijing HI-13 tandem accelerator. Acta Phys. Sin. 2017, 51, 555–560. [Google Scholar]
- Luo, Y.H.; Zhang, F.Q.; Wang, Y.P.; Wang, Y.M.; Guo, X.Q.; Guo, H.X. Single event upsets sensitivity of low energy proton in nanometer static random access memory. Acta Phys. Sin. 2016, 65, 068501. [Google Scholar] [CrossRef]
- Emeliyanov, V.V.; Vatuev, A.S.; Useinov, R.G. New insight into heavy ion induced segr: Impact of charge yield. IEEE Trans. Nucl. Sci. 2016, 63, 2176–2182. [Google Scholar] [CrossRef]
- Emeliyanov, V.V.; Vatuev, A.S.; Useinov, R.G. New insight into heavy ion induced SEGR: Impact of charge yield. In Proceedings of the 2015 IEEE 15th European Conference on Radiation and Its Effects on Components and Systems (RADECS), Moscow, Russia, 18 September 2015. [Google Scholar]
- Chen, Z.; Lin, M.; Ding, D.; Zheng, Y.; Sang, Z.; Zou, S. Analysis of Single-Event Effects in a Radiation-Hardened Low-Jitter PLL under Heavy Ion and Pulsed Laser Irradiation. IEEE Trans. Nucl. Sci. 2017, 64, 106–112. [Google Scholar] [CrossRef]
- Cressler, J.D. Radiation effects in SiGe technology. IEEE Trans. Nucl. Sci. 2013, 60, 1992–2014. [Google Scholar] [CrossRef]
- Marshall, P.W.; Carts, M.A.; Campbell, A.; Mcmorrow, D. Single event effects in circuit-hardened SiGe HBT logic at gigabit per second data rates. IEEE Trans. Nucl. Sci. 2000, 47, 2669–2674. [Google Scholar] [CrossRef]
- Fleetwood, Z.E.; Lourenco, N.E.; Ildefonso, A.; Warner, J.H.; Wachter, M.T.; Hales, J.M.; Tzintzarov, G.N.; Roche, N.J.H.; Khachatrian, A.; Buchner, S.P.; et al. Using TCAD modeling to compare heavy-ion and laser-induced single event transients in SiGe HBTs. IEEE Trans. Nucl. Sci. 2017, 64, 398–405. [Google Scholar] [CrossRef]
- Zerarka, M.; Austin, P.; Bensoussan, A.; Morancho, F.; Durier, A. TCAD simulation of the single event effects in normally-OFF GaN transistors after heavy ion radiation. IEEE Trans. Nucl. Sci. 2017, 64, 2242–2249. [Google Scholar] [CrossRef]
- Barnaby, H.J.; Smith, S.K.; Schrimpf, R.D.; Fleetwood, D.M.; Pease, R.L. Analytical model for proton radiation effects in bipolar devices. IEEE Trans. Nucl. Sci. 2002, 49, 2643–2649. [Google Scholar] [CrossRef]
- Li, X.J.; Liu, C.M.; Rui, E.M.; Geng, H.B.; Yang, J.Q. Simultaneous and sequential radiation effects on NPN transistors induced by protons and electrons. IEEE Trans. Nucl. Sci. 2012, 59, 625–633. [Google Scholar] [CrossRef]
- Li, X.; Liu, C.; Yang, J.; Ma, G. Research on the combined effects of ionization and displacement defects in NPN transistors based on deep level transient spectroscopy. IEEE Trans. Nucl. Sci. 2015, 62, 555–564. [Google Scholar] [CrossRef]
- Mizuta, E.; Kuboyama, S.; Abe, H.; Iwata, Y.; Tamura, T. Investigation of single-event damages on silicon carbide (SiC) power MOSFETs. IEEE Trans. Nucl. Sci. 2014, 61, 1924–1928. [Google Scholar] [CrossRef]
- Kuboyama, S.; Kamezawa, C.; Satoh, Y.; Hirao, T.; Ohyama, H. Single-event burnout of silicon carbide schottky barrier diodes caused by high energy protons. IEEE Trans. Nucl. Sci. 2007, 54, 2379–2383. [Google Scholar] [CrossRef]
- Kuboyama, S.; Kamezawa, C.; Ikeda, N.; Hirao, T.; Ohyama, H. Anomalous charge collection in silicon carbide schottky barrier diodes and resulting permanent damage and single-event burnout. IEEE Trans. Nucl. Sci. 2006, 53, 3343–3348. [Google Scholar] [CrossRef]
- Casey, M.C.; Lauenstein, J.M.; Ladbury, R.L.; Wilcox, E.P.; Topper, A.D.; Label, K.A. Schottky diode derating for survivability in a heavy ion environment. IEEE Trans. Nucl. Sci. 2015, 62, 2482–2489. [Google Scholar] [CrossRef]
- Olson, B.D.; Ingalls, J.D.; Rice, C.H.; Hedge, C.C. Leakage current degradation of gallium nitride transistors due to heavy ion tests. In Proceedings of the 2015 IEEE Radiation Effects Data Workshop (REDW), Boston, MA, USA, 13–17 July 2015. [Google Scholar]
- Javanainen, A.; Galloway, K.F.; Ferlet-Cavrois, V.; Lauenstein, J.-M.; Pintacuda, F.; Schrimpf, R.D.; Reed, R.A.; Virtanen, A. Charge transport mechanisms in heavy-ion driven leakage current in silicon carbide schottky power diodes. IEEE Trans. Device Mater. Reliab. 2016, 16, 208–212. [Google Scholar] [CrossRef]
- Javanainen, A.; Galloway, K.F.; Nicklaw, C.; Bosser, A.L.; Ferlet-Cavrois, V.; Lauenstein, J.M.; Pintacuda, F.; Reed, R.A.; Schrimpf, R.D.; Weller, R.A.; et al. Heavy ion induced degradation in SiC schottky diodes: Bias and energy deposition dependence. IEEE Trans. Nucl. Sci. 2017, 64, 415–420. [Google Scholar] [CrossRef]
- Javanainen, A.; Turowski, M.; Galloway, K.F.; Nicklaw, C.; Ferlet-Cavrois, V.; Bosser, A.; Lauenstein, J.M.; Muschitiello, M.; Pintacuda, F.; Reed, R.A.; et al. Heavy-ion-induced degradation in sic schottky diodes: Incident angle and energy deposition dependence. IEEE Trans. Nucl. Sci. 2017, 64, 2031–2037. [Google Scholar] [CrossRef]
- Moise, T.S.; Summerfelt, S.R.; McAdams, H.; Aggarwal, S.; Udayakumar, K.R.; Celii, F.G.; Martin, J.S.; Xing, G.; Hall, L.; Taylor, K.J.; et al. Demonstration of a 4 mb high density ferroelectric memory embedded within a 130 nm 5 LM Cu/FSG logic process. In Proceedings of the 2002 IEEE International Electron Devices Meeting, San Francisco, CA, USA, 8–11 December 2002. [Google Scholar]
- Gupta, V.; Bosser, A.; Tsiligiannis, G.; Zadeh, A.; Javanainen, A.; Virtanen, A.; Puchner, H.; Saigné, F.; Wrobel, F.; Dilillo, L. Heavy-Ion radiation impact on a 4 Mb FRAM under different test modes and conditions. IEEE Trans. Nucl. Sci. 2016, 63, 2010–2015. [Google Scholar] [CrossRef]
- Virtanen, A.; Harboe-Sorensen, R.; Javanainen, A.; Kettunen, H.; Koivisto, H.; Riihimaki, I. Upgrades for the RADEF facility. In Proceedings of the 2007 IEEE Radiation Effects Data Workshop, Honolulu, HI, USA, 23–27 July 2007. [Google Scholar]
- Oldham, T.R.; Friendlich, M.R.; Sanders, A.B.; Seidleck, C.M. TID and SEE response of advanced samsung and micron 4G NAND flash memories for the NASA MMS mission. In Proceedings of the 2009 IEEE Radiation Effects Data Workshop, Quebec City, QC, Canada, 20–24 July 2009. [Google Scholar]
- Chen, D.; Wilcox, E.; Ladbury, R.L.; Kim, H.; Phan, A.; Seidleck, C.; Label, K.A. Heavy ion irradiation fluence dependence for single-event upsets in a NAND flash memory. IEEE Trans. Nucl. Sci. 2017, 64, 332–337. [Google Scholar] [CrossRef]
- Zhang, H.; Jiang, H.; Assis, T.R.; Ball, D.R.; Narasimham, B.; Anvar, A.; Massengill, L.W.; Bhuva, B.L. Angular effects of heavy-ion strikes on single-event upset response of flip-flop designs in 16-nm bulk FinFET Technology. IEEE Trans. Nucl. Sci. 2017, 64, 491–496. [Google Scholar] [CrossRef]
- Tonfat, J.; Kastensmidt, F.L.; Artola, L.; Hubert, G.; Medina, N.H.; Added, N.; Aguiar, V.A.P.; Aguirre, F.; Macchione, E.L.A.; Silveira, M.A.G. Analyzing the influence of the angles of incidence and rotation on MBU events induced by low LET heavy ions in a 28-nm SRAM-Based FPGA. IEEE Trans. Nucl. Sci. 2017, 64, 2161–2168. [Google Scholar] [CrossRef]
- Kan, C.X.; Hu, Y.M.; Bao, Y.W.; Fan, H.S. Annual report of HI-13 tandem accelerator in 2013. Annu. Rep. Chin. Inst. At. Energ. 2015, 1, 278–279. (In Chinese) [Google Scholar]
- Qu, G.F.; Chai, W.P.; Xia, J.W.; Yang, J.C.; Du, H.; Li, Z.S.; Ge, W.W.; Zheng, W.H. Two-plane painting injection scheme for BRing of HIAF. Nucl. Sci. Technol. 2017, 28, 47–56. [Google Scholar] [CrossRef]
- Hwang, J.G.; Kim, E.S.; Kim, H.J.; Jang, H.; Kim, H.J.; Jeon, D.O. Beam dynamics for high-power superconducting heavy-ion linear accelerator of RAON. IEEE Trans. Nucl. Sci. 2016, 63, 992–1000. [Google Scholar] [CrossRef]
- Hwang, J.G.; Kim, E.S.; Kim, H.J.; Jang, H.; Kim, H.J.; Jeon, D.O. Beam dynamics issues for a superconducting linear accelerator-based high power heavy ion machine. In Proceedings of the 2014 5th International Particle Accelerator Conference (IPAC), Dresden, Germany, 20 June 2014. [Google Scholar]
- Zhang, Z.; Lee, S.; Jo, H.C.; Kim, D.G.; Kim, J. A study on the optimization of an HTS quadrupole magnet system for a heavy ion accelerator through evolution strategy. IEEE Trans. Appl. Supercond. 2016, 26, 1001304. [Google Scholar] [CrossRef]
- Wei, S.; Lee, S.; Choi, S. A study on the design of full-LTS 18-GHz ECR ion source for heavy ion accelerator. IEEE Trans. Appl. Supercond. 2016, 26, 4100404. [Google Scholar] [CrossRef]
- Spiller, P. FAIR at GSI. In Proceedings of the 39th ICFA Advanced Beam Dynamics Workshop on High Intensity High Brightness Hadron Beams (HB), Tsukuba, Japan, 29 May–2 June 2006. [Google Scholar]
- Ceballos Velasco, J.; Meier, J.P.; Bleile, A.; Sugita, K.; Schnizer, P.; Fischer, E.; Spiller, P. Design of the superconducting extraction and injection quadrupole doublet modules for the SIS100 heavy ion synchrotron. IEEE Trans. Appl. Supercond. 2016, 26, 4004404. [Google Scholar] [CrossRef]
- Kramer, D. Baseline design for the facility for Antiproton and Ion Reseach (FAIR) finalized. In Proceedings of the 2006 10th European Particle Accelerator Conference (EPAC), Edinburgh, Scotland, 26–30 June 2006. [Google Scholar]
- Heuser, J.M. A Silicon Vertex Tracker upgrade for the PHENIX experiment at RHIC. Methods Phys. Res. A 2005, 546, 60–66. [Google Scholar] [CrossRef]
- Heuser, J.M. Vertex detector upgrade plans for the PHENIX experiment at RHIC. Nucl. Instrum. Methods Phys. Res. A 2003, 511, 210–214. [Google Scholar] [CrossRef]
- Hahn, H.; Forsyth, E.; Foelsche, H.; Harrison, M.; Kewisch, J.; Parzen, G.; Peggs, S.; Raka, E.; Ruggiero, A.; Stevens, A.; et al. The RHIC design overview. Nucl. Instrum. Methods Phys. Res. A 2003, 499, 245–263. [Google Scholar] [CrossRef]
- Okuno, H.; Tominaka, T.; Fujishima, S.; Mitsumoto, T.; Kubo, T.; Kawaguchi, T.; Kim, J.W.; Ikegami, K.; Sakamoto, N.; Yokouchi, S.; et al. Design study of the injection and extraction systems for the RIKEN superconducting ring cyclotron. In Proceedings of the 1998 IEEE Particle Accelerator Conference, Caen, France, 14–19 June 1998. [Google Scholar]
- Aguiar, V.A.P.; Added, N.; Medina, N.H.; Macchione, E.L.A.; Tabacniks, M.H.; Aguirre, F.R.; Silveira, M.A.G.; Santos, R.B.B.; Seixas, L.E., Jr. Experimental setup for Single Event Effects at the São Paulo 8UD Pelletron Accelerator. Nucl. Instrum. Methods Phys. Res. B 2014, 332, 397–400. [Google Scholar] [CrossRef]
- Hiemstra, D.M. Guide to the 2015 IEEE radiation effects data workshop record. In Proceedings of the 2016 IEEE Radiation Effects Data Workshop (REDW), Portland, OR, USA, 11–15 July 2016. [Google Scholar]
- Zhang, H.Q.; Zhou, P.; Zhang, Q.; Liu, Z.; Guan, S.; Chen, X. Geant4 simulation of transmission of ions through insulating nanocapillaries. In Proceedings of the 2013 28th International Conference on Photonic, Electronic and Atomic Collisionsz (ICPEAC), Lanzhou, Chinese, 24–30 July 2013. [Google Scholar]
- Hauf, S.; Kuster, M.; Batic, M.; Bell, Z.W.; Hoffmann, D.H.H.; Lang, P.M.; Neff, S.; Pia, M.G.; Weidenspointner, G.; Zoglauer, A. Radioactive decays in Geant4. IEEE Trans. Nucl. Sci. 2013, 60, 2966–2983. [Google Scholar] [CrossRef]
- Garnier, L. Geant4 application in a web browser. In Proceedings of the 20th International Conference on Computing in High Energy and Nuclear Physics (CHEP) 2013, Amsterdam, The Netherlands, 14–18 October 2013. [Google Scholar]
- Asai, M. A roadmap for Geant4. In Proceedings of the 20th International Conference on Computing in High Energy and Nuclear Physics (CHEP) 2012, New York, NY, USA, 21–25 May 2012. [Google Scholar]
- Pinsky, L.S.; Andersen, V.; Empl, A.; Lee, K.; Smirnov, G.; Zapp, N.; Ferrari, A.; Roesler, S.; Vlachoudis, V.; Battistoni, G.; et al. Event generators for simulating heavy ion interactions to evaluate the radiation risks in spaceflight. In Proceedings of the 2005 IEEE Aerospace Conference, Big Sky, MT, USA, 5–23 March 2005. [Google Scholar]
- Zebrev, G.I.; Galimov, A.M. Compact modeling and simulation of heavy Ion-induced soft error rate in space environment: Principles and validation. IEEE Trans. Nucl. Sci. 2017, 64, 2129–2135. [Google Scholar] [CrossRef]
- Tian, W.; Li, W.; Yu, W.; Liu, X. A review on lattice defects in graphene: Types generation effects and regulation. Micromachines 2017, 8, 163. [Google Scholar] [CrossRef]
- Tian, W.; Ji, H. Recent research of electromagnetic characteristics in wire bonding. Rec. Pat. Mec. Eng. 2016, 9, 102–111. [Google Scholar] [CrossRef]
- Alayan, M.; Bagatin, M.L.; Gerardin, S.; Paccagnella, A.; Larcher, L.; Vianello, E.; Nowak, E.; De Salvo, B.; Perniola, L. Experimental and simulation studies of the effects of heavy-ion irradiation on HfO2-based RRAM cells. IEEE Trans. Nucl. Sci. 2017, 64, 2038–2045. [Google Scholar] [CrossRef]





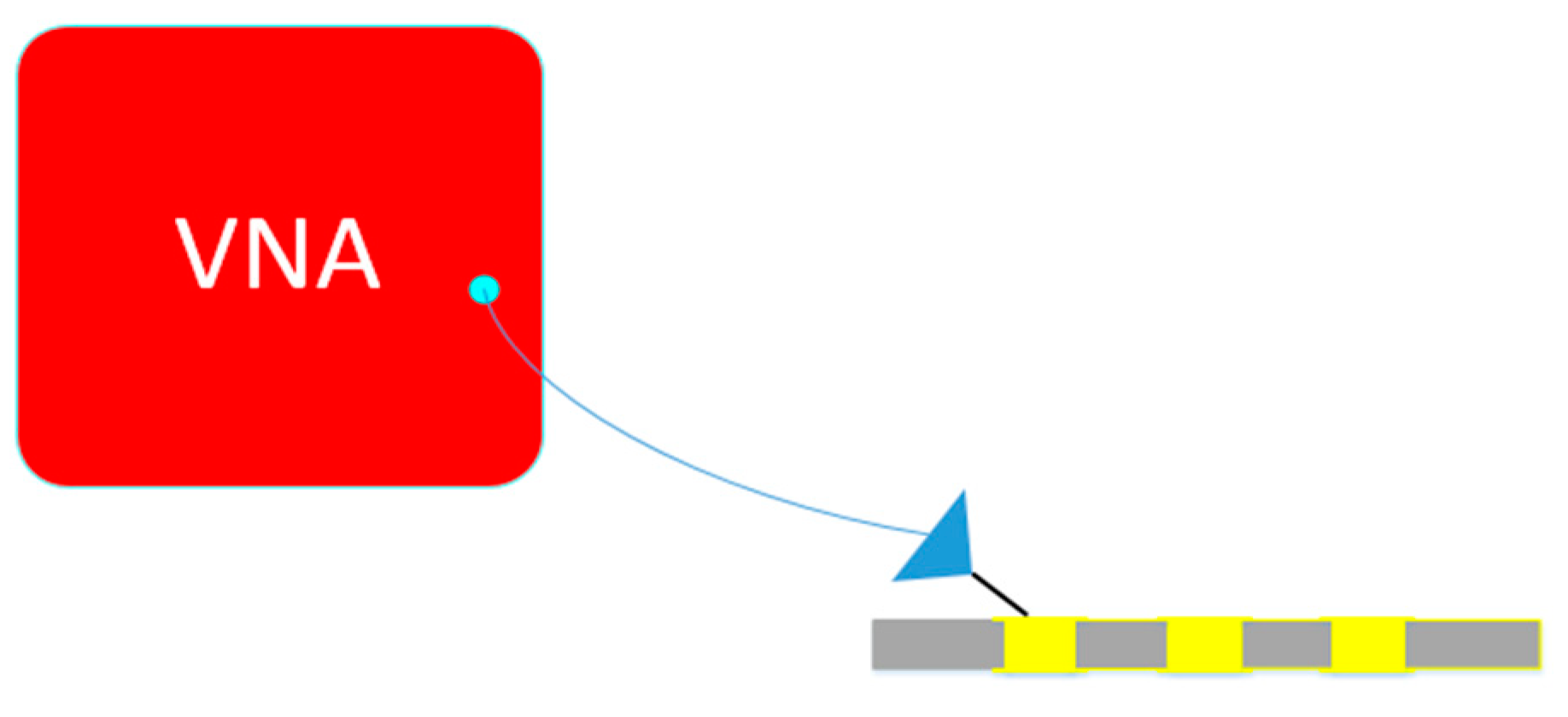


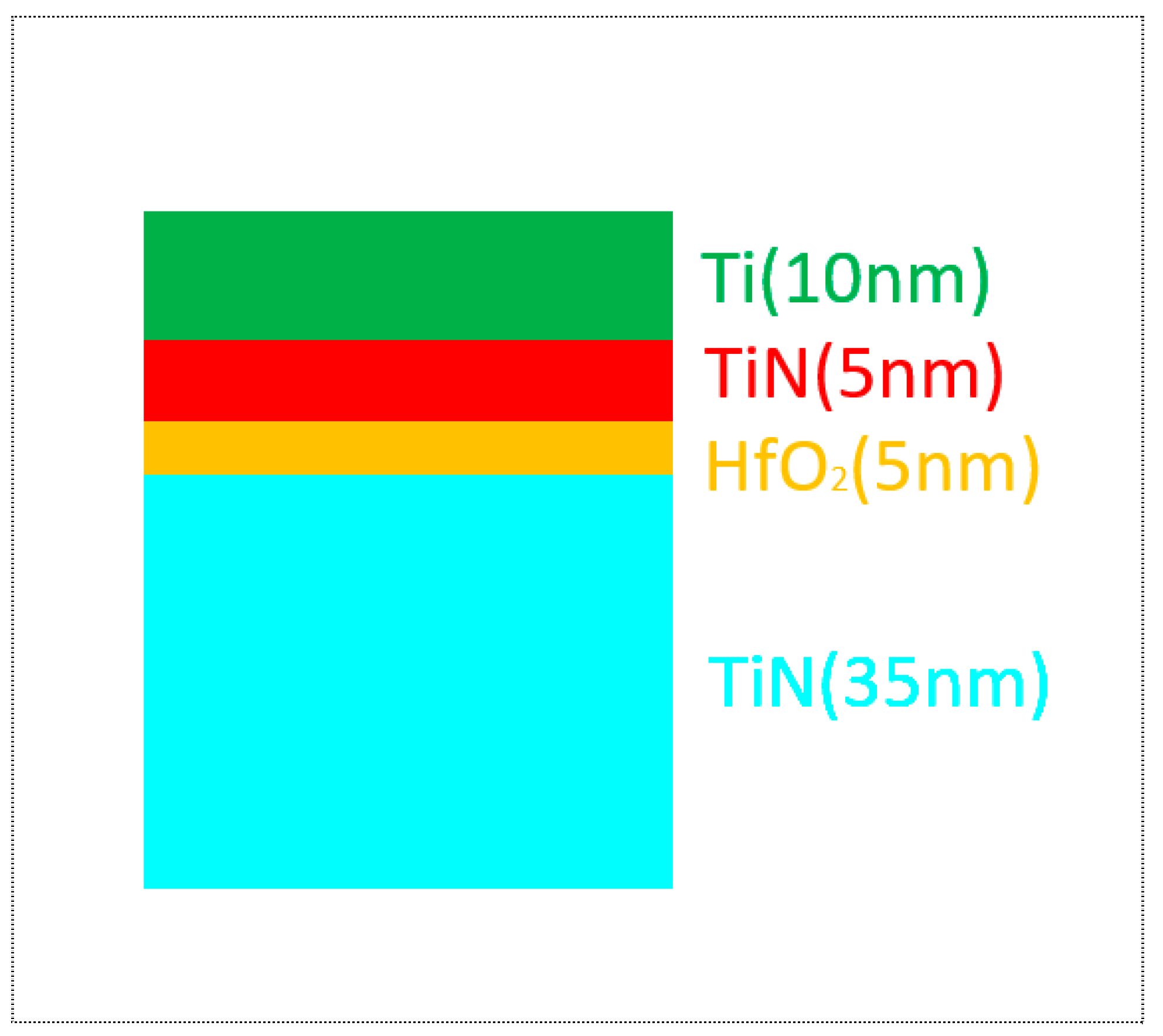
| Application | Via Depth/Diameter | Cost | Performance | Reference |
|---|---|---|---|---|
| 3D ASIC and memory integration | 220/50 μm | High | A total of 3000 cycles with 10 min ramps and dwell from 0 to 100 °C | [14] |
| Passive Interposer | 230/80 μm | Low | High density | [15] |
| RF wireless devices | 120/60 μm | N/A | The loss of 0.6 dB/mm at 60 GHz. | [22] |
| Passive Interposer | 130/50 μm | N/A | No electrical failure occurred in all samples after 500 MSTs (moisture sensitivity testing) and 1000 TCTs (thermal cycling testing from −40 °C to 125 °C). Only two of them failed after 3000 TCTs. | [24] |
| On-silicon-interposer | N/A | N/A | Four times higher than the data rate of HBM generation 2 | [26] |
| 3D integration | 100/40 μm | Lower | Simplified the integrated process flows, enhanced the reliability | [27] |
| high-density RDLs of silicon interposers | -/10 μm | Lower | reduce the amount of waste materials | [28] |
| Mechanism/Material | Via Depth/Diameter | Duration | Reference |
|---|---|---|---|
| Cu | 100/10 μm | Coverage of near 100% and lower leakage current | [29] |
| Vacuum pressure/Molten 1SAC305 solder | 220/30 μm | The filling time is 4 s; The wetting layer deposition may take more than 1 h. | [30] |
| RF-MEMS switch/Molten Sn-Ag solder | 300/150 μm | The wetting layer deposition may take more than 1 h. | [31] |
| N2 gas pressure/Molten Zn-Sn alloy | 150/50 μm | The wetting layer deposition and Zn electroplating may take more than 3 h. | [32] |
| Inkjet printer/Ag-based ink | 115/80 μm | N/A | [33] |
| Very high aspect ratio TSVs/Gold | 625/30 μm | Adapt standard wire bonding technology to fill the through via holes | [34] |
| 3-D integration/Ag-based conductive polymers | 500/150 μm | The resistance is between 30 and 55 Ω | [35] |
| Waveguides Material | Waveguides Thickness | Performance | Reference |
|---|---|---|---|
| Si | 500 nm | Promoting light coupling to other materials for efficient electro-optical modulation | [54] |
| Si | 220 μm | Negligible loss | [55] |
| SiN | 100 μm | power variation less than 0.1 dB | [56] |
| Classification | Research Content | Conclusion | Reference |
|---|---|---|---|
| The interposer production | A passive silicon interposer | Cost and performance-effective. | [14] |
| The interposer production | A passive silicon interposer | High density and low-cost. | [15] |
| The interposer production | A passive silicon interposer with annular TSVs. | The loss of 0.6 dB/mm at 60 GHz. | [22] |
| The interposer production | An annular copper through-silicon via (TSV) integration process. | No electrical failure occurred in all samples after 500 MSTs. | [24] |
| The interposer production | A new on-silicon-interposer passive equalizer for HBM. | Higher performance. | [26] |
| The interposer production | Through-hole filled with micro-bump integration production. | Simplify the production process, save costs and enhance its reliability. | [27] |
| The interposer production | Redistribution layers were fabricated using Combination of E-Jet and Inkjet Printing. | Simplify the production process and save costs. | [28] |
| The interposer production | TSVs filled with void-free copper. | Nearly 100% coverage and lower leakage current. | [29] |
| The interposer production | TSVs filled with the molten solder. | The 100% filling ratio for vias. | [30] |
| The interposer production | A radio frequency MEMS. | Short filling time. | [31] |
| The interposer production | Fill vias with the Sn Zn. | Higher performance. | [32] |
| The interposer production | Print blind vias using an inkjet printer. | Avoid the filling material melting process. | [33] |
| The interposer production | A new concept for the quick metallization of TSVs. | Super high aspect ratio. | [34] |
| The interposer production | Ag-based and C-based conductive polymers. | Accelerate the metallization process and enhance the electrical connection quality. | [35] |
| The interposer production | High-resistance silicon instead of p-type low-resistance silicon as a Interposer material. | High-resistance -silicon interposer can be well suited to high-frequency circuits. | [36] |
| The interposer production | Glass interposer instead of Silicon interposer. | Reduce costs. | [37] |
| The interposer production | TSV vias filled with Cu metal are converted to fill with polysilicon for use in MEMS devices. | It is more compatible with high temperature process, without metal, and suitable for the special requirements of MEMS technology | [38] |
| The interposer production | Nano-carbon filled glass adapter plate | Reduce the maximum temperature of the interposer in a large extent. | [39] |
| The interposer structure | Ohm contact CPW RDL structure with ground directly in contact with the silicon substrate | Reduce signal crosstalk to some extent. | [44] |
| The interposer structure | The silicon-interposer structure composed of a thin metal substrate | The far-end crosstalk can be reduced to a certain degree when the center distance of the via hole is greater than or equal to the thickness of the silicon substrate. | [45] |
| The interposer structure | A novel silicon-core coaxial TSV structure. | The structure has the characteristics of low loss, high performance and simple production process. | [46] |
| The interposer structure (TSC) | Integrate 3D deep on silicon interposer. | Increase the capacitance density and improve the chip package performance. | [47] |
| The interposer structure (TSC) | Production of axial TSC and radial TSC. | The using of radial TSC can reduce the ESL and increase the SER. | [48] |
| The interposer structure (3D PICs) | Efficient electro-optical modulation. | Promote light coupling to other materials. | [54] |
| The interposer structure (3D PICs) | 220 nm-thick silicon waveguides. | With negligible loss. | [55] |
| The interposer structure (3D PICs) | A high-density wafer-scale 3-D silicon-photonic integrated circuits. | Lower power variation. | [56] |
| The interposer testing | E-fuse, a new test framework, was proposed based on the plug-in structure of integrated circuit test. | Connect the test system and the circuit to be tested and separated. | [61] |
| The interposer testing | Propose a novel de-embedding methodology and broadband microprobe measurement | There is a transition to resistance around 1 GHz due to the property of the silicon substrate, and then dominated by capacitive behavior when frequency goes up to 4 GHz | [65] |
| The interposer testing | Designed a test interposer for POP | Signal integrity issues can be tested without contact with solder joints, reducing errors due to the solder-joints damage and the poor contact | [66] |
| The interposer thermal design | Designed and fabricated a silicon interposer embedded with microfluidic channels. | Thermal conductivity increased significantly. | [67] |
| The interposer thermal design | 3-D embedding concept of optical and electrical dies. | Address the thermal issues based on wet-etched silicon interposer with low cost | [70] |
| The interposer thermal design | Wet-etched three-level Silicon Interposer | Only a 0.1and 0.8-dB additional penalty. | [71] |
| Micro-bump | Micro-bump failure | Sensitive to the loading mode | [75] |
| Micro-bump | Examine the reliability of Ni/Sn3.5Ag (15 μm)/Ni micro-bumps. | The orientation affects the electromigration reliability. | [81] |
| Micro-bump | Power one daisy chain of the micro-bumps. | The latter failed due to thermomigration | [82] |
| Micro-bump | The thermo-mechanical properties of SnAg micro-bumps | Significantly weaken its mechanical and electrical properties. | [87] |
| Part Number | Technology | Active Area | CMOS | Reference |
|---|---|---|---|---|
| MSO9104A | PPL | N/A | 130 nm | [107] |
| N/A | HBT | N/A | N/A | [110] |
| EPC2019ENG | GaN | N/A | N/A | [111] |
| 3DG110 | BJT | N/A | N/A | [114] |
| STPSC1006D | SiC Schottky diodes | 2.31 mm2 | N/A | [121,122] |
| STPSC10H065DY | SiC Schottky diodes | 2.62 mm2 | N/A | [121,123] |
| FM22L16 | FRAM | N/A | 130 nm | [125] |
| MT29F128G08CBECBH6 | NAND | N/A | 16 nm | [128] |
| N/A | FinFET | N/A | 16 nm | [52] |
| Artix-7 | SRAM-FPGA | N/A | 28 nm | [53] |
| ION | ENERGY (MeV) | Material | LET (MeV/(mg/cm2))/Tilt (°) | Projected Range (μm) | Facility | Reference |
|---|---|---|---|---|---|---|
| Kr | 480 | Si | 37.6 | N/A | HIRFL | [107] |
| Kr | 768 | SiC | 33.8/0 | 63 | RADEF | [121,122] |
| Fe | 523 | SiC | 20.1/0 | 64 | RADEF | [122] |
| Ar | 372 | SiC | 10.9/0; 11.7/30; 14.3/45; 15.7/50 | 78 | RADEF | [123] |
| N | 139 | Si | 1.8/0 | 202 | RADEF | [126] |
| Fe | 523 | Si | 18.5/0 | 97 | RADEF | [126] |
| Kr | 768 | Si | 32.1/0; 45.4/45 | 94 | RADEF | [126] |
| Ne | 186 | Si | 3.6/0; 4.2/30; 5.1/45 | 146 | RADEF | [126] |
| Xe | 1217 | Si | 60/0; 69.3/30; 84.8/45 | 89 | RADEF | [126] |
| Xe | 466 | Si | 64.3/0 | 37 | GANIL | [126] |
| Xe | 1790 | Si | 50.2/0 | 137 | GANIL | [126] |
| B | 108 | Si | 0.9/0 | 306 | BASE | [126] |
| Ne | 216 | Si | 3.5/0 | 175 | BASE | [126] |
| Si | 292 | Si | 6.1/0 | 142 | BASE | [126] |
| Ar | 400 | Si | 9.7/0 | 130 | BASE | [128] |
| Cu | 659 | Si | 21.2/0 | 108 | BASE | [128] |
| Xe | 1232 | Si | 49.3/0 | 148 | BASE | [128] |
| C | 50 | Si | 3/0; 5.21/45; 9.13/60 | N/A | 1LAFN-USP | [130] |
| Object/Methods | Content | Conclusion | Reference |
|---|---|---|---|
| SiO2/The high-energy heavy ions radiation simulator | Deduced the dependence of breakdown voltage on the deposition energy. | The breakdown voltage is a linear function of the residual charge after ion orbital recombination | [99,100] |
| PLL/HIRFL | The radiation hardening of PLL (low-jitter phase-locked loop) | The SEE of hardened PLL are an order of magnitude higher than unhardened one | [107] |
| SiGe HBT/TCAD | The SEE caused by heavy ions and lasers in SiGe HBT | There is a moderately high LET threshold for heavy ion radiation changing the decay mechanism observed in SiGe HBTs from exponential to fast exponential decay with significant diffusion tail | [110] |
| GaN/TCAD | The SEE of GaN transistors after heavy-ion radiation | The self-polarization of the gate caused by the hole current originating from the ion beam leads to a momentary turn-on of the device. | [111] |
| NPN transistor/EN Tandem Accelerator | The defect characteristics of the displacement caused by the irradiation of various heavy ions in an NPN transistor | The degradation of device electrical performance is NIEL independent. | [114] |
| SiC Schottky power diodes/TCAD | The charge transport mechanism (current-voltage characteristics) of heavy-ion-causing damages in SiC structures. | The charge transport is controlled by space-limited charge flow | [121] |
| SiC Schottky power diodes/TCAD | The SEB of SiC Schottky power diodes caused by the heavy ion. | The increment of the reverse leakage current induced by the heavy ion in the SiC-based device is caused by the synergistic effect of the energy deposition of the ions and the bias voltage. | [122] |
| SiC Schottky power diodes/TCAD | The dependence of heavy ion-induced degradation on the incident angle and energy deposition in SiC Schottky diodes. | The heavy ion-induced degradation in SiC Schottky diodes is strongly dependent on incident angle. | [123] |
| FRAMs/RADEF& GANIL | The effect of heavy ion on commercial FRAMs | The static flip-up cross section in FRAM devices is very low due to the intrinsic radiation hardness of the ferroelectric layer-based memory cells. | [126] |
| 16 nm NAND flash/BASE | The SEE of a Micron 16 nm NAND flash | The SEU cross-section is inversely proportional to the cumulative effect which in turn leads to unsteady rollover rates and contrary to the traditional assumption. | [128] |
| 16 nm FinFET/TCAD | The effects of heavy ion impact angles on the SEE of a 16-nm FinFET 3D TCAD model D-latch. | The probability of failure and the SEU cross-section increase with the increase of the tilt angle, but will decrease with the increase of the angle when heavy LET heavy ions are incident. | [129] |
| 28 nm SRAM/SRIM | The effect of the incidence and rotation angle of heavy LET ions on the MBU effect of an FPGA based on 28 nm SRAM. | The MUSCA SEP tool was used to highlight the angular configuration as a function of memory cell layout strongly influences sensitivity of CRAM and BRAM in FPGA Artix-7. | [130] |
| Heavy Ion Accelerator Name | Conversion from Gaussian and CGS EMU to SI Accelerators | The Type of Particles Provided | The Energy of Particles Provided | Reference |
|---|---|---|---|---|
| HI-13 | Chinese Department of Nuclear Physics. | H~F, Al~Cl, Ca, Ag, Ti, Fe, Cu, Ge, Br, Nb, I, Hf, Au | ~100 MeV/u | [131] |
| HIRFL | Chinese National Laboratory of Heavy Ion Accelerator of Lanzhou. | C~Ta | 1.22 MeV/u (238U72+) ~ 1100 (12C6+) MeV/u | [107] |
| BNL-RHIC | Brookhaven National Laboratory in the United States. | Proton ~ Au | ~100 GeV(Au) | [140,142] |
| BASE | Lawrence Berkeley National Laboratory in the United States. | B, Ne, Si, Ar, Cu, Xe et al. | ~10 MeV/ u(electron) | [128] |
| RADEF | Jyväskylä in Finland. | N, Fe, Kr, Ne, Ar, Xe et al. | ~1217 MeV/u (Xe) | [126] |
| GANIL | The University of Caen in France. | Xe, Kr et al. | 466/1217/1790 MeV/u (Xe)768 MeV/u (Kr) | [126] |
| RIKEN-RIBF | Japan’s RIKEN | Proton ~ U | 440 MeV/u(Light ions) 350 MeV/u (Heavy ions) | [142,143] |
| 8UD | São Paulo | 12C, 16O, 28Si, 35Cl, 63Cu | ~32 MeV/u | [144] |
| Heavy Ion Accelerator Name | Country & Affiliation | The Type of Particles Provided | The Energy of Particles Provided | Reference |
|---|---|---|---|---|
| FAIR | German heavy ion research center GSI. | Proton ~ U | ~9.7 GeV/u (238U28+) | [137,139] |
| HIAF | Institute of modern physics, Chinese Academy | Proton ~ U | ~100 MeV/u (238U34) | [128] |
© 2018 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Tian, W.; Ma, T.; Liu, X. TSV Technology and High-Energy Heavy Ions Radiation Impact Review. Electronics 2018, 7, 112. https://doi.org/10.3390/electronics7070112
Tian W, Ma T, Liu X. TSV Technology and High-Energy Heavy Ions Radiation Impact Review. Electronics. 2018; 7(7):112. https://doi.org/10.3390/electronics7070112
Chicago/Turabian StyleTian, Wenchao, Tianran Ma, and Xiaohan Liu. 2018. "TSV Technology and High-Energy Heavy Ions Radiation Impact Review" Electronics 7, no. 7: 112. https://doi.org/10.3390/electronics7070112




