Investigating the Efficiency Droop of Nitride-Based Blue LEDs with Different Quantum Barrier Growth Rates
Abstract
:1. Introduction
2. Experimental
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Kim, M.H.; Schubert, M.F.; Dai, Q.; Kim, J.K.; Schubert, E.F.; Piprek, J.; Park, Y. Origin of efficiency droop in GaN-based light-emitting diodes. Appl. Phys. Lett. 2007, 91, 183507. [Google Scholar] [CrossRef] [Green Version]
- Schubert, M.F.; Xu, J.; Kim, J.K.; Schubert, E.F.; Kim, M.H.; Yoon, S.; Lee, S.M.; Sone, C.; Sakong, T.; Park, Y. Polarization-matched GaInN/AlGaInN multi-quantum-well light emitting diodes with reduced efficiency droop. Appl. Phys. Lett. 2008, 93, 041102. [Google Scholar] [CrossRef]
- Zhao, H.P.; Liu, G.Y.; Zhang, J.; Arif, R.A.; Tansu, N. Analysis of internal quantum efficiency and current injection efficiency in III nitride light-emitting diodes. J. Disp. Technol. 2013, 9, 212. [Google Scholar] [CrossRef]
- Ni, X.; Fan, Q.; Shimada, R.; Özgür, Ü.; Morkoç, H. Reduction of efficiency droop in InGaN light emitting diodes by coupled quantum wells. Appl. Phys. Lett. 2008, 93, 171113. [Google Scholar] [CrossRef] [Green Version]
- Wang, C.H.; Chang, S.P.; Chang, W.T.; Li, J.C.; Lu, Y.S.; Li, Z.Y.; Yang, H.C.; Kuo, H.C.; Lu, T.C.; Wang, S.C. Efficiency droop alleviation in InGaN/GaN light emitting diodes by graded-thickness multiple quantum wells. Appl. Phys. Lett. 2010, 97, 181101. [Google Scholar] [CrossRef]
- Iveland, J.; Martinelli, L.; Peretti, J.; Speck, J.S.; Weisbuch, C. Direct measurement of Auger electrons emitted from a semiconductor light-emitting diode under electrical injection: Identification of the dominant mechanism for efficiency droop. Phys. Rev. Lett. 2013, 110, 177406. [Google Scholar] [CrossRef]
- Galler, B.; Lugauer, H.J.; Binder, M.; Hollweck, R.; Folwill, Y.; Nirschl, A.; Gomez-Iglesias, A.; Hahn, B.; Wagner, J.; Sabathil, M. Experimental determination of the dominant type of auger recombination in InGaN quantum wells. Appl. Phys. Express 2013, 6, 112101. [Google Scholar] [CrossRef]
- Delaney, K.T.; Rinke, P.; van de Walle, C.G. Auger recombination rates in nitrides from first principles. Appl. Phys. Lett. 2009, 94, 191109. [Google Scholar] [CrossRef] [Green Version]
- Yang, Y.; Cao, X.A.; Yan, C. Investigation of the nonthermal mechanism of efficiency rolloff in InGaN light-emitting diodes. IEEE Trans. Electron. Device 2008, 55, 1771. [Google Scholar] [CrossRef]
- Harder, J.; Moloney, J.V.; Koch, S.W. Temperature-dependence of the internal efficiency droop in GaN-based diodes. Appl. Phys. Lett. 2011, 99, 181127. [Google Scholar] [CrossRef]
- Chow, W.W.; Crawford, M.H.; Tsao, J.Y.; Kneissl, M. Internal efficiency of InGaN light-emitting diodes: Beyond a quasi-equilibrium model. Appl. Phys. Lett. 2010, 97, 121105. [Google Scholar] [CrossRef]
- Liu, H.H.; Chen, P.R.; Lee, G.Y.; Chyi, J.I. Efficiency Enhancement of InGaN LEDs with an n-Type AlGaN/GaN/InGaN Current Spreading Layer. IEEE Electron. Device Lett. 2011, 32, 1409. [Google Scholar] [CrossRef]
- Zhang, Y.Y.; Yin, Y.A. Performance enhancement of blue light emitting diodes with a special designed AlGaN/GaN superlattice electron-blocking layer. Appl. Phys. Lett. 2011, 99, 221103. [Google Scholar] [CrossRef]
- Lin, B.C.; Chen, K.J.; Han, H.V.; Lan, Y.P.; Chiu, C.H.; Lin, C.C.; Shih, M.H.; Lee, P.T.; Kuo, H.C. Advantages of Blue LEDs With Graded-Composition AlGaN/GaN Superlattice EBL. IEEE Photonics Technol. Lett. 2013, 25, 2062. [Google Scholar] [CrossRef]
- Park, J.H.; Kim, D.Y.; Hwang, S.; Meyaard, D.; Schubert, E.F.; Han, Y.D.; Choi, J.W.; Cho, J.; Kim, J.K. Enhanced overall efficiency of GaInN-based light-emitting diodes with reduced efficiency droop by Al-composition-graded AlGaN/GaN superlattice electron blocking layer. Appl. Phys. Lett. 2013, 103, 061104. [Google Scholar] [CrossRef] [Green Version]
- Choi, S.; Kim, H.J.; Kim, S.S.; Liu, J.; Kim, J.; Ryou, J.H.; Dupuis, R.D.; Fischer, A.C.; Ponce, F.A. Improvement of peak quantum efficiency and efficiency droop in III-nitride visible light-emitting diodes with an InAlN electron-blocking layer. Appl. Phys. Lett. 2010, 96, 221105. [Google Scholar] [CrossRef]
- Keller, S.; Chichibu, S.F.; Minsky, M.S.; Hu, E.; Mishra, U.K.; Den Baars, S.P. E¤ect of the growth rate and the barrier doping on the morphology and the properties of InGaN/GaN quantum wells. J. Cryst. Growth 1998, 195, 258. [Google Scholar] [CrossRef]
- Schubert, E.F. Light-Emitting Diodes, 2nd ed.; Cambridge Univ. Press: Cambridge, UK, 2006. [Google Scholar]
- Lee, S.W.; Oh, D.C.; Goto, H.; Ha, J.S.; Lee, H.J.; Hanada, T.; Cho, M.W.; Yao, T.; Hong, S.K.; Lee, H.Y.; et al. Origin of forward leakage current in GaN-based light-emitting devices. Appl. Phys. Lett. 2006, 89, 132117. [Google Scholar] [CrossRef]
- Bandić, Z.Z.; Bridger, P.M.; Piquette, E.C.; McGill, T.C. Minority carrier diffusion length and lifetime in GaN. Appl. Phys. Lett. 1998, 72, 3166. [Google Scholar] [CrossRef]
- Ino, N.; Yamamoto, N. Low temperature diffusion length of excitons in gallium nitride measured by cathodoluminescence technique. Appl. Phys. Lett. 2008, 93, 232103. [Google Scholar] [CrossRef]
- Brooksby, J.C.; Mei, J.; Ponce, F.A. Correlation of spectral luminescence with threading dislocations in green-light-emitting InGaN quantum wells. Appl. Phys. Lett. 2007, 90, 231901. [Google Scholar] [CrossRef]
- Yang, T.J.; Shivaraman, R.; Speck, J.S.; Wu, Y.R. The influence of random indium alloy fluctuations in indium gallium nitride quantum wells on the device behavior. J. Appl. Phys. 2014, 116, 113104. [Google Scholar] [CrossRef]
- Islam, A.; Shim, J.I.; Shin, D.S. Optoelectronic Performance Variations in InGaN/GaN Multiple-Quantum-Well Light-Emitting Diodes: Effects of Potential Fluctuation. Materials 2018, 11, 743. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Han, D.P.; Zheng, D.G.; Oh, C.H.; Kim, H.; Shim, J.I.; Shin, D.S.; Kim, K.S. Nonradiative recombination mechanisms in InGaN/GaN-based light-emitting diodes investigated by temperature-dependent measurements. Appl. Phys. Lett. 2014, 104, 151108. [Google Scholar] [CrossRef]
- Otsuji, N.; Fujiwara, K.; Sheu, J.K. Electroluminescence efficiency of blue InGaN/GaN quantum-well diodes with and without an n-InGaN electron reservoir layer. J. Appl. Phys. 2006, 100, 113105. [Google Scholar] [CrossRef] [Green Version]
- Shahmohammadi, M.; Liu, W.; Rossbach, G.; Lahourcade, L.; Dussaigne, A.; Bougerol, C.; Butté, R.; Grandjean, N.; Deveaud, B.; Jacopin, G. Enhancement of Auger recombination induced by carrier localization in InGaN/GaN quantum wells. Phys. Rev. B 2017, 95, 125314. [Google Scholar] [CrossRef]
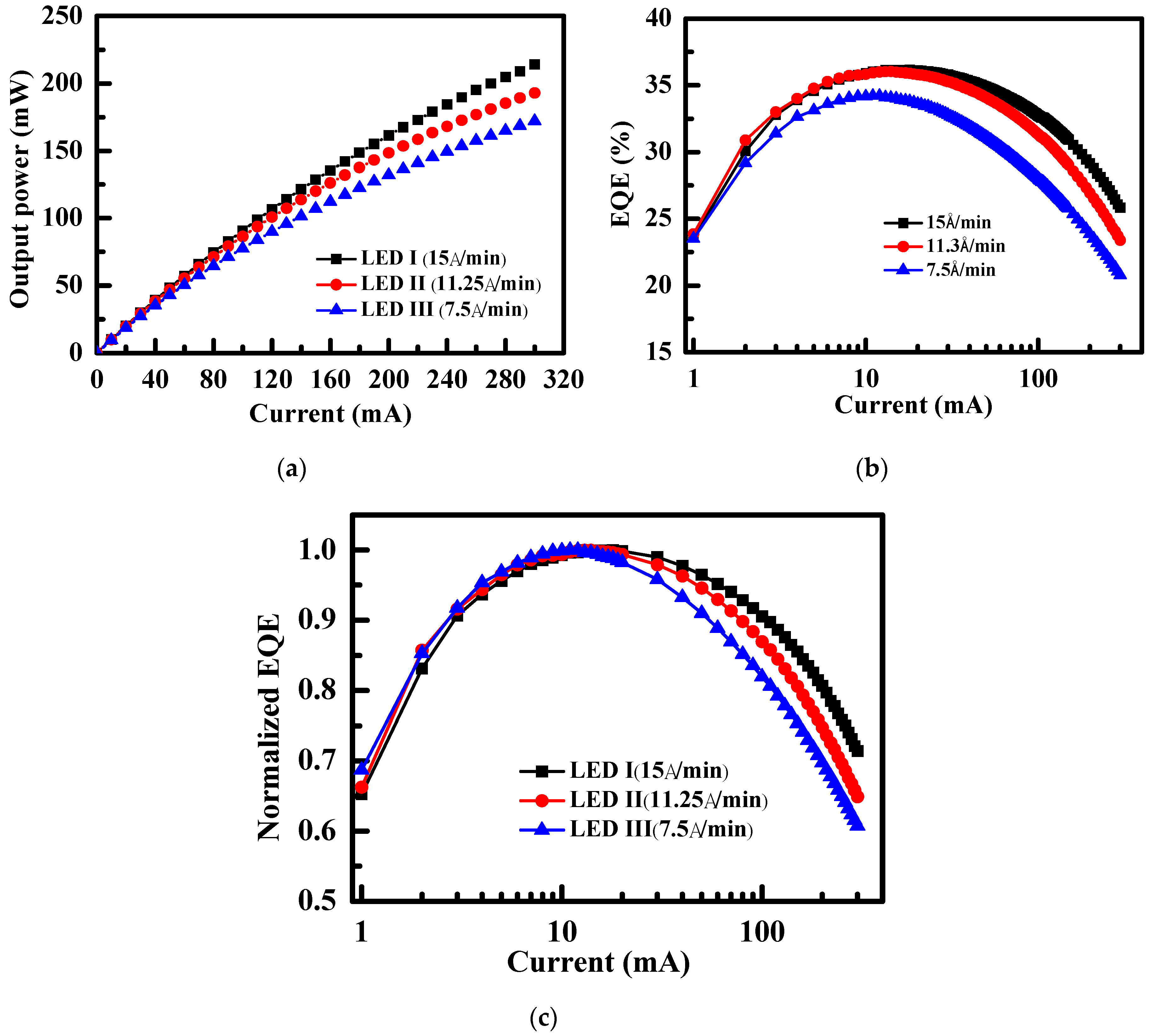





© 2019 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Wang, C.K.; Chiou, Y.Z.; Chang, H.J. Investigating the Efficiency Droop of Nitride-Based Blue LEDs with Different Quantum Barrier Growth Rates. Crystals 2019, 9, 677. https://doi.org/10.3390/cryst9120677
Wang CK, Chiou YZ, Chang HJ. Investigating the Efficiency Droop of Nitride-Based Blue LEDs with Different Quantum Barrier Growth Rates. Crystals. 2019; 9(12):677. https://doi.org/10.3390/cryst9120677
Chicago/Turabian StyleWang, C. K., Y. Z. Chiou, and H. J. Chang. 2019. "Investigating the Efficiency Droop of Nitride-Based Blue LEDs with Different Quantum Barrier Growth Rates" Crystals 9, no. 12: 677. https://doi.org/10.3390/cryst9120677



