Voltage Amplitude-Controlled Synaptic Plasticity from Complementary Resistive Switching in Alloying HfOx with AlOx-Based RRAM
Abstract
:1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Conflicts of Interest
References
- Graves, C.E.; Li, C.; Sheng, X.; Miller, D.; Ignowski, J.; Kiyama, L.; Strachan, J.P. Nater. In-Memory Computing with Memristor Content Addressable Memories for Pattern Matching. Adv. Mater. 2020, 32, 2003437. [Google Scholar] [CrossRef] [PubMed]
- Xia, Q.; Yang, J.J. Memristive crossbar arrays for brain-inspired computing. Nater. Mater. 2019, 18, 309–323. [Google Scholar] [CrossRef] [PubMed]
- Ryu, H.; Kim, S. Pseudo-Interface Switching of a Two-Terminal TaOx/HfO2 Synaptic Device for Neuromorphic Applications. Nanomaterials 2020, 10, 1550. [Google Scholar] [CrossRef] [PubMed]
- Mikhaylov, A.; Pimashkin, A.; Pigareva, Y.; Gerasimova, S.; Gryaznov, E.; Shchanikov, S.; Zuev, A.; Talanov, M.; Lavrov, I.; Demin, V.; et al. Neurohybrid Memristive CMOS-Integrated Systems for Biosensors and Neuroprosthetics. Front. Mol. Neurosci. 2020, 14, 358. [Google Scholar] [CrossRef]
- Emelyanov, A.V.; Nikiruy, K.E.; Serenko, A.V.; Sitnikov, A.V.; Presnyakov, M.Y.; Rybka, R.B.; Sboev, A.G.; Rylkov, V.V.; Kashkarov, P.K.; Kovalchuk, M.V.; et al. Self-adaptive STDP-based learning of a spiking neuron with nanocomposite memristive weights. Nanotechnology 2020, 31, 045201. [Google Scholar] [CrossRef]
- Cho, S.; Kim, S. Emulation of Biological Synapse Characteristics from Cu/AlN/TiN Conductive Bridge Random Access Memory. Nanomaterials 2020, 10, 1709. [Google Scholar] [CrossRef]
- Kim, S.; Jung, S.; Kim, M.-H.; Chen, Y.-C.; Chang, T.-C.; Ryoo, K.-C.; Cho, S.; Lee, J.-H.; Park, B.-G. Scaling Effect on Silicon Nitride Memristor with Highly Doped Si Substrate. Small 2018, 14, 1704062. [Google Scholar] [CrossRef]
- Mikhaylov, A.; Belov, A.; Korolev, D.; Antonov, I.; Kotomina, V.; Kotina, A.; Gryaznov, E.; Sharapov, A.; Koryazhkina, M.; Kryukov, R.; et al. Multilayer Metal-Oxide Memristive Device with Stabilized Resistive Switching. Adv. Mater. Technol. 2020, 5, 1900607. [Google Scholar] [CrossRef]
- Ryu, J.-H.; Kim, S. Improved Intrinsic Nonlinear Characteristics of Ta2O5/Al2O3-Based Resistive Random-Access Memory for High-Density Memory Applications. Materials 2020, 13, 4201. [Google Scholar] [CrossRef]
- Maikap, S.; Banergee, W. In Quest of Nonfilamentary Switching: A Synergistic Approach of Dual Nanostructure Engineering to Improve the Variability and Reliability of Resistive Random-Access-Memory Devices. Adv. Electron. Mater. 2020, 6, 2000209. [Google Scholar] [CrossRef]
- Kim, S.; Park, B.G. Nonlinear and multilevel resistive switching memory in Ni/Si3N4/Al2O3/TiN structures. Appl. Phys. Lett. 2016, 108, 212103. [Google Scholar] [CrossRef]
- Mahata, C.; Kim, S. Modified resistive switching performance by increasing Al concentration in HfO2 on transparent indium tin oxide electrode. Ceram. Int. 2020. [Google Scholar] [CrossRef]
- Linn, E.; Rosezin, R.; Kügeler, C.; Waser, R. Complementary resistive switches for passive nanocrossbar memories. Nat. Mater. 2010, 9, 403–406. [Google Scholar] [CrossRef] [PubMed]
- Lanza, M.; Wong, H.-S.P.; Pop, E.; Ielmini, D.; Strukov, D.; Regan, B.C.; Larcher, L.; Villena, M.A.; Yang, J.J.; Goux, L.; et al. Recommended Methods to Study Resistive Switching Devices. Adv. Electron. Mater. 2018, 5, 1800143. [Google Scholar] [CrossRef] [Green Version]
- Salaoru, I.; Prodromakis, T.; Khiat, A.; Toumazou, C. Resistive switching of oxygen enhanced TiO2 thin-fim devices. Appl. Phys. Lett. 2013, 102, 013506. [Google Scholar] [CrossRef]
- Yang, Y.; Sheridan, P.; Lu, W. Complementary resistive switching in tantalum oxide-based resistive memory devices. Appl. Phys. Lett. 2012, 100, 203112. [Google Scholar] [CrossRef]
- Lee, M.-J.; Lee, C.B.; Lee, D.; Lee, S.R.; Chang, M.; Hur, J.H.; Kim, Y.-B.; Kim, C.-J.; Seo, D.H.; Seo, S.; et al. A fast, high-endurance and scalable non-volatile memory device made from asymmetric Ta2O5−x/TaO2−x bilayer structures. Nat. Mater. 2011, 10, 625–630. [Google Scholar] [CrossRef]
- Chen, X.; Hu, W.; Li, Y.; Wu, S.; Bao, D. Complementary resistive switching behaviors evolved from bipolar TiN/HfO2/Pt device. Appl. Phys. Lett. 2016, 108, 053504. [Google Scholar] [CrossRef]
- Bricalli, A.; Ambrosi, E.; Laudato, M.; Maestro, M.; Rodriguez, R.; Ielmini, D. Resistive Switching Device Technology Based on Silicon Oxide for Improved ON–OFF Ratio—Part II: Select Devices. IEEE Trans. Electron Devices 2017, 65, 122–128. [Google Scholar] [CrossRef] [Green Version]
- Wu, L.; Liu, H.; Li, J.; Wang, S.; Wang, X. A Multi-level Memristor Based on Al-Doped HfO2 Thin Film. Nanoscale Res. Lett. 2019, 14, 177. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Choi, J.; Kim, S. Nonlinear Characteristics of Complementary Resistive Switching in HfAlOx-Based Memristor for High-Density Cross-Point Array Structure. Coatings 2020, 10, 765. [Google Scholar] [CrossRef]
- Zhang, L.; Liu, M.; Ren, W.; Zhou, Z.; Dong, G.; Zhang, Y.; Peng, B.; Hao, X.; Wang, C.; Jiang, Z.D.; et al. ALD preparation of high-k HfO2 thin films with enhanced energy density and efficient electrostatic energy storage. RSC Adv. 2017, 7, 8388. [Google Scholar] [CrossRef] [Green Version]
- Wang, L.G.; Qian, X.; Cao, Y.Q.; Cao, Z.Y.; Fang, G.Y.; Li, A.D.; Wu, D. Excellent resistive switching properties of atomic layer-deposited Al2O3/HfO2/Al2O3 trilayer structures for non-volatile memory applications. Nanoscale Res. Lett. 2015, 10, 135. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Ma, F.; Sun, J.; Zhang, G.; Liang, G.; Xin, Q.; Li, Y.; Song, A. Lowetemperature fabrication of HfAlO alloy dielectric usingatomicelayer deposition and its application in a lowepower device. J. Alloys Compd. 2019, 792, 543–549. [Google Scholar] [CrossRef]
- Jeon, H.; Park, J.; Jang, W.; Kim, H.; Kang, C.; Song, H.; Kim, H.; Seo, H.; Jeon, H. Stabilized resistive switching behaviors of a Pt/TaOx/TiN RRAM under different oxygen contents. Phys. Status Solidi (a) 2014, 9, 2189–2194. [Google Scholar] [CrossRef]
- Liu, Y.; Ouyang, S.; Yang, J.; Tang, M.; Wang, W.; Li, G.; Zou, Z.; Liang, Y.; Li, Y.; Xiao, Y.; et al. Effect of film thickness and temperature on the resistive switching characteristics of the Pt/HfO2/Al2O3/TiN structure. Solid State Electron. 2020, 173, 107880. [Google Scholar] [CrossRef]
- Ismail, M.; Kim, S. Negative differential resistance effect and dual resistive switching properties in a transparent Ce-based devices with opposite forming polarity. Appl. Surf. Sci. 2020, 530, 147284. [Google Scholar] [CrossRef]
- Zhou, F.; Chang, Y.F.; Fowler, B.; Byun, K.; Lee, J.C. Stabilization of multiple resistance levels by current-sweep in SiOx-based resistive switching memory. Appl. Phys. Lett. 2015, 106, 063508. [Google Scholar] [CrossRef] [Green Version]



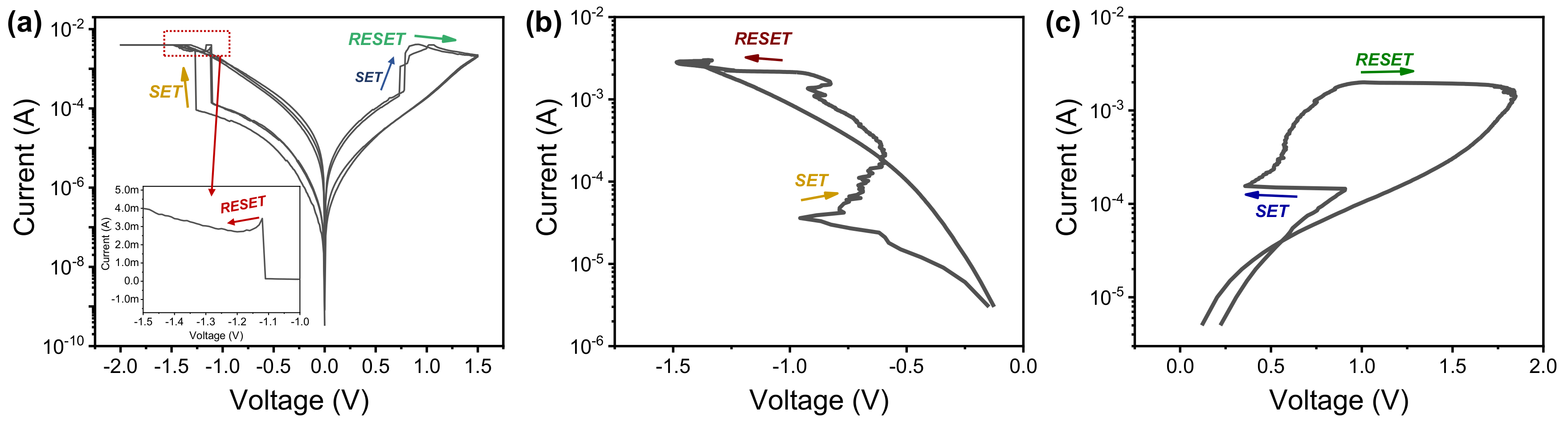




Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Ryu, H.; Choi, J.; Kim, S. Voltage Amplitude-Controlled Synaptic Plasticity from Complementary Resistive Switching in Alloying HfOx with AlOx-Based RRAM. Metals 2020, 10, 1410. https://doi.org/10.3390/met10111410
Ryu H, Choi J, Kim S. Voltage Amplitude-Controlled Synaptic Plasticity from Complementary Resistive Switching in Alloying HfOx with AlOx-Based RRAM. Metals. 2020; 10(11):1410. https://doi.org/10.3390/met10111410
Chicago/Turabian StyleRyu, Hojeong, Junhyeok Choi, and Sungjun Kim. 2020. "Voltage Amplitude-Controlled Synaptic Plasticity from Complementary Resistive Switching in Alloying HfOx with AlOx-Based RRAM" Metals 10, no. 11: 1410. https://doi.org/10.3390/met10111410



