Simulation for Cu Atom Diffusion Leading to Fluctuations in Solder Properties and Cu6Sn5 Growth during Multiple Reflows
Abstract
:1. Introduction
2. Materials and Methods
2.1. Materials and Experimental Procedure
2.2. Vickers Hardness Test
2.3. Melting Point Test
2.4. Numerical Simulation
3. Results and Discussion
4. Conclusions
- The concentration of Cu in solder fluctuates, increasing with the increase in reflow times, which is closely related to the continuous growth and dissolution of IMC.
- Not only does the size of Cu6Sn5 grains increase, but its morphology also changed from scallop-like to prismatic as the number of reflow cycles increased. The changes in the Cu concentration in solder during the multiple reflows resulted in fluctuation in the growth rate of the Cu6Sn5.
- The Vickers hardness and melting point of the solder fluctuated during the multiple reflow processes due to the fluctuation in the Cu concentration.
Supplementary Materials
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Koo, J.-M.; Jung, S.-B. Effect of substrate metallization on mechanical properties of Sn–3.5Ag BGA solder joints with multiple reflows. Microelectron. Eng. 2005, 82, 569–574. [Google Scholar] [CrossRef]
- Lai, Y.-S.; Kao, C.; Chang, H.-C. Effect of multiple reflow cycles on ball impact responses of Sn-Ag-Cu solder joints. Solder. Surf. Mt. Technol. 2009, 21, 4–9. [Google Scholar] [CrossRef]
- Bartels, F.; Muschik, T.; Gust, W. Mechanism of Intermetallic Phase Formation in Thin Solid-Liquid Diffusion Couples. J. Electron. Mater. 1994, 311, 23. [Google Scholar] [CrossRef]
- I Made, R.; Gan, C.L.; Yan, L.L.; Yu, A.; Yoon, S.W.; Lau, J.H.; Lee, C. Study of Low-Temperature Thermo-compression Bonding in Ag-In Solder for Packaging Applications. J. Electron. Mater. 2009, 38, 365–371. [Google Scholar] [CrossRef]
- Islam, M.N.; Sharif, A.; Chan, Y.C. Effect of volume in interfacial reaction between eutectic Sn-Pb solder and Cu metallization in microelectronic packaging. Mater. Sci. Eng. 2004, 106, 143–149. [Google Scholar] [CrossRef]
- Zhong, W.; Chan, Y.; Alam, M.; Wu, B.; Guan, J. Effect of multiple reflow processes on the reliability of ball grid array (BGA) solder joints. J. Alloys Compd. 2006, 414, 123–130. [Google Scholar] [CrossRef]
- Chen, S.; Zhou, W.; Wu, P. The structural, elastic, electronic and thermodynamic properties of hexagonal η-Cu6−xNixSn5 (x = 0, 0.5, 1, 1.5 and 2) intermetallic compounds. Intermetallics 2014, 54, 187–192. [Google Scholar] [CrossRef]
- Lau, J.H. Recent Advances and New Trends in Flip Chip Technology. J. Electron. Packag. 2016, 138, 030802. [Google Scholar] [CrossRef]
- Le, F.; Lee, S.W.R.; Zhang, Q. 3D chip stacking with through silicon-vias (TSVs) for vertical interconnect and underfill dispensing. J. Micromech. Microeng. 2017, 27, 045012. [Google Scholar] [CrossRef]
- Wang, Z. 3-D Integration and Through-Silicon Vias in MEMS and Microsensors. J. Microelectromech. Syst. 2015, 24, 1211–1244. [Google Scholar] [CrossRef]
- Jang, E.-J.; Hyun, S.; Lee, H.-J.; Park, Y.-B. Effect of wet pretreatment on interfacial adhesion energy of Cu-Cu thermocompression bond for 3D IC packages. J. Electron. Mater. 2009, 38, 2449–2454. [Google Scholar] [CrossRef]
- Chen, H.; Myhill, D. Children talking about writing: Investigating metalinguistic understanding. Linguist. Educ. 2016, 35, 100–108. [Google Scholar] [CrossRef] [Green Version]
- Sharif, A.; Chan, Y.C. Interfacial reactions of Sn-3.5% Ag and Sn-3.5% Ag-0.5% Cu solder with electroless Ni/Au metallization during multiple reflow cycles. J. Mater. Sci. Mater. Electron. 2005, 16, 153–158. [Google Scholar] [CrossRef]
- Haseeb, A.S.M.A.; Arafat, M.M.; Johan, M.R. Stability of molybdenum nanoparticles in Sn-3.8Ag-0.7Cu solder during multiple reflow and their influence on interfacial intermetallic compounds. Mater. Charact. 2012, 64, 27–35. [Google Scholar] [CrossRef]
- Lei, M.; Chen, T.-B. Response to “letter to the Editor regarding “first evidence on different transportation modes of arsenic and phosphorus in arsenic hyperaccumulator Pteris vittata”. Environ. Pollut. 2012, 165, 168. [Google Scholar] [CrossRef]
- Noh, B.I.; Koo, J.M.; Kim, J.W.; Kim, D.G.; Nam, J.D.; Joo, J.; Jung, S.B. Effects of number of reflows on the mechanical and electrical properties of BGA package. Intermetallics 2006, 14, 1375–1378. [Google Scholar] [CrossRef]
- Liu, P.; Yao, P.; Liu, J. Effects of multiple reflows on interfacial reaction and shear strength of SnAgCu and SnPb solder joints with different PCB surface finishes. J. Alloys Compd. 2009, 470, 188–194. [Google Scholar] [CrossRef]
- Mohd Salleh, M.A.A.; McDonald, S.D.; Gourlay, C.M.; Yasuda, H.; Nogita, K. Suppression of Cu6Sn5 in TiO2 reinforced solder joints after multiple reflow cycles. Mater. Des. 2016, 108, 418–428. [Google Scholar] [CrossRef] [Green Version]
- Liu, W.; Feng, Y.; Tang, H.; Yuan, H.; He, S.; Miao, S. Immobilization of silver nanocrystals on carbon nanotubes using ultra-thin molybdenum sulfide sacrificial layers for antibacterial photocatalysis in visible light. Carbon 2016, 96, 303–310. [Google Scholar] [CrossRef]
- Ma, H.; Ma, H.; Kunwar, A.; Shang, S.; Wang, Y.; Chen, J.; Huang, M.; Zhao, N. Effect of initial Cu concentration on the IMC size and grain aspect ratio in Sn–xCu solders during multiple reflows. J. Mater. Sci. Mater. Electron. 2018, 29, 602–613. [Google Scholar] [CrossRef]
- Ma, H.R.; Kunwar, A.; Shang, S.Y.; Jiang, C.R.; Wang, Y.P.; Ma, H.T.; Zhao, N. Evolution behavior and growth kinetics of intermetallic compounds at Sn/Cu interface during multiple reflows. Intermetallics 2018, 96, 1–12. [Google Scholar] [CrossRef]
- Shang, P.J.; Liu, Z.Q.; Pang, X.Y.; Li, D.X.; Shang, J.K. Growth mechanisms of Cu3Sn on polycrystalline and single crystalline Cu substrates. Acta Mater. 2009, 57, 4697–4706. [Google Scholar] [CrossRef]
- Gao, F.; Qu, J. Calculating the diffusivity of Cu and Sn in Cu 3Sn intermetallic by molecular dynamics simulations. Mater. Lett. 2012, 73, 92–94. [Google Scholar] [CrossRef]
- Huang, M.L.; Yang, F. Size effect model on kinetics of interfacial reaction between Sn-xAg-yCu solders and Cu substrate. Sci. Rep. 2014, 4, 7117. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Kunwar, A.; Malla, P.B.; Sun, J.; Qu, L.; Ma, H. Convolutional neural network model for synchrotron radiation imaging datasets to automatically detect interfacial microstructure: An in-situ process monitoring tool during solar PV ribbon fabrication. Sol. Energy 2021, 224, 230–244. [Google Scholar] [CrossRef]
- Kunwar, A.; Coutinho, Y.A.; Hektor, J.; Ma, H.; Moelans, N. Integration of machine learning with phase field method to model the electromigration induced Cu6Sn5 IMC growth at anode side Cu/Sn interface. J. Mater. Sci. Technol. 2020, 59, 203–219. [Google Scholar] [CrossRef]
- Kunwar, A.; Hektor, J.; Nomoto, S.; Coutinho, Y.A.; Moelans, N. Combining multi-phase field simulation with neural network analysis to unravel thermomigration accelerated growth behavior of Cu6Sn5 IMC at cold side Cu–Sn interface. Int. J. Mech. Sci. 2020, 184, 105843. [Google Scholar] [CrossRef]
- Kunwar, A.; An, L.; Liu, J.; Shang, S.; Råback, P.; Ma, H.; Song, X. A data-driven framework to predict the morphology of interfacial Cu6Sn5 IMC in SAC/Cu system during laser soldering. J. Mater. Sci. Technol. 2020, 50, 115–127. [Google Scholar] [CrossRef]
- Yakymovych, A.; Plevachuk, Y.; Švec, P.; Janičkovič, D.; Šebo, P.; Beronská, N.; Nosko, M.; Orovcik, L.; Roshanghias, A.; Ipser, H. Nanocomposite SAC solders: Morphology, electrical and mechanical properties of Sn–3.8Ag–0.7Cu solders by adding Co nanoparticles. J. Mater. Sci. Mater. Electron. 2017, 28, 10965–10973. [Google Scholar] [CrossRef] [Green Version]
- Tu, K. Interdiffusion and reaction in bimetallic Cu-Sn thin films. Acta Metall. 1973, 21, 347–354. [Google Scholar] [CrossRef]
- Guo, B.; Ma, H.; Jiang, C.; Wang, Y.; Kunwar, A. Formation mechanism and kinetic analysis of the morphology of Cu6Sn5 in the spherical solder joints at the Sn/Cu liquid–solid interface during soldering cooling stage. J. Mater. Sci. Mater. Electron. 2017, 28, 5398–5406. [Google Scholar] [CrossRef]
- Guo, B.; Kunwar, A.; Jiang, C.; Wang, Y.; Zhao, N.; Huang, M. Effect of the degree of supercooling on growth mechanism of Cu6Sn5 in Pure Sn/Cu solder joint. J. Mater. Sci. Mater. Electron. 2021, 135–140. [Google Scholar] [CrossRef] [PubMed]
- Zhang, Z.H.; Li, M.Y.; Liu, Z.Q.; Yang, S.H. Growth characteristics and formation mechanisms of Cu6Sn5 phase at the liquid-Sn0.7Cu/(111)Cu and liquid-Sn0.7Cu/(001)Cu joint interfaces. Acta Mater. 2016, 104, 1–8. [Google Scholar] [CrossRef]
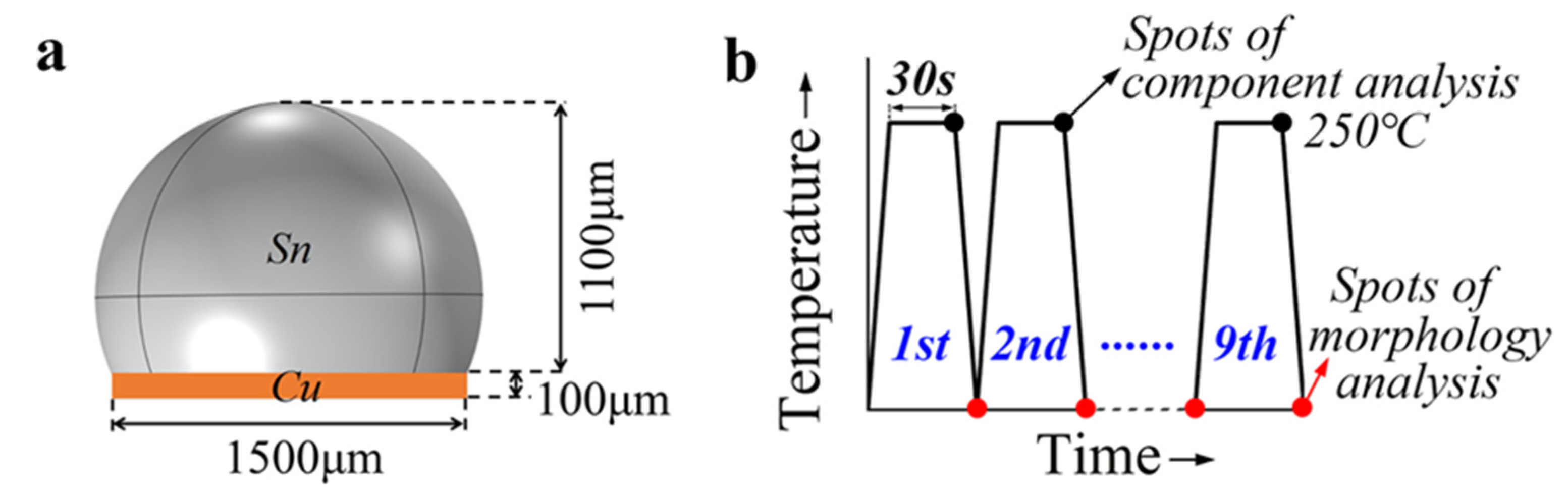
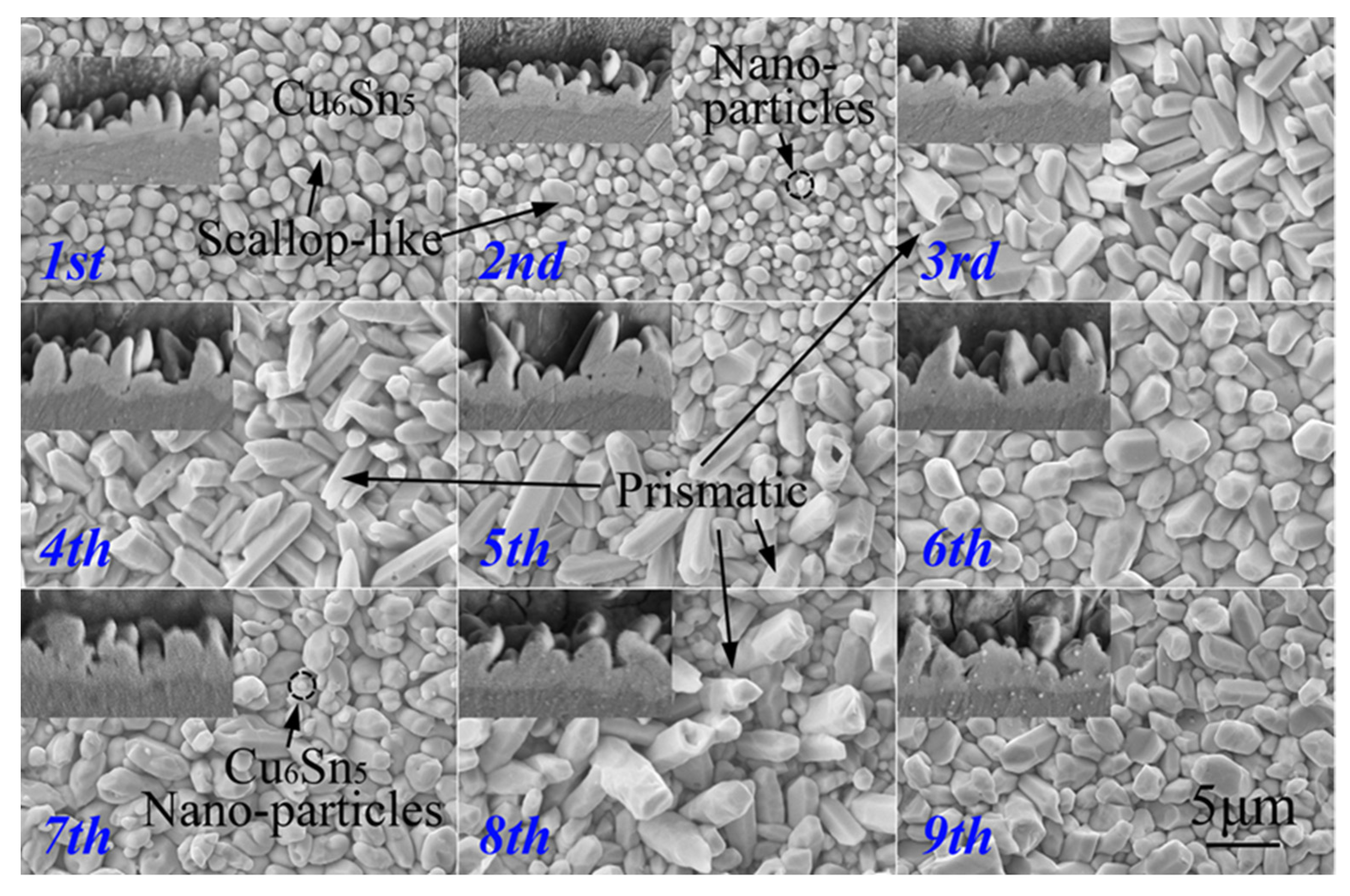



Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Shang, M.; Dong, C.; Ma, H.; Wang, Y.; Ma, H. Simulation for Cu Atom Diffusion Leading to Fluctuations in Solder Properties and Cu6Sn5 Growth during Multiple Reflows. Metals 2021, 11, 2041. https://doi.org/10.3390/met11122041
Shang M, Dong C, Ma H, Wang Y, Ma H. Simulation for Cu Atom Diffusion Leading to Fluctuations in Solder Properties and Cu6Sn5 Growth during Multiple Reflows. Metals. 2021; 11(12):2041. https://doi.org/10.3390/met11122041
Chicago/Turabian StyleShang, Min, Chong Dong, Haoran Ma, Yunpeng Wang, and Haitao Ma. 2021. "Simulation for Cu Atom Diffusion Leading to Fluctuations in Solder Properties and Cu6Sn5 Growth during Multiple Reflows" Metals 11, no. 12: 2041. https://doi.org/10.3390/met11122041





