Polarization-Induced Phase Transitions in Ultra-Thin InGaN-Based Double Quantum Wells
Abstract
:1. Introduction
2. Theoretical Model
3. Results and Discussion
3.1. InxGa1−xN/GaN DQWs
3.2. InN/InyGa1−yN DQWs
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Hasan, M.Z.; Kane, C.L. Colloquium: Topological insulators. Rev. Mod. Phys. 2010, 82, 3045. [Google Scholar] [CrossRef] [Green Version]
- Bansil, A.; Lin, H.; Das, T. Colloquium: Topological band theory. Rev. Mod. Phys. 2016, 88, 021004. [Google Scholar] [CrossRef] [Green Version]
- Sabater, C.; Gosálbez-Martínez, D.; Fernández-Rossier, J.; Rodrigo, J.G.; Untiedt, C.; Palacios, J.J. Topologically protected quantum transport in locally exfoliated bismuth at room temperature. Phys. Rev. Lett. 2013, 110, 176802. [Google Scholar] [CrossRef]
- Drozdov, I.K.; Alexandradinata, A.; Jeon, S.; Nadj-Perge, S.; Ji, H.; Cava, R.J.; Bernevig, B.A.; Yazdani, A. One-dimensional topological edge states of bismuth bilayers. Nat. Phys. 2014, 10, 664–669. [Google Scholar] [CrossRef] [Green Version]
- Wu, S.; Fatemi, V.; Gibson, Q.D.; Watanabe, K.; Taniguchi, T.; Cava, R.J.; Jarillo-Herrero, P. Observation of the quantum spin Hal effect up to 100 kelvin in a monolayer crystal. Science 2018, 359, 76–79. [Google Scholar] [CrossRef] [Green Version]
- Bernevig, B.A.; Hughes, T.L.; Zhang, S.C. Quantum spin Hall effect and topological phase transition in HgTe quantum wells. Science 2006, 314, 1757–1761. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Konig, M.; Wiedmann, S.; Brune, C.; Roth, A.; Buhmann, H.; Molenkamp, L.W.; Qi, X.L.; Zhang, S.C. Quantum spin Hall effect in HgTe quantum wells. Science 2007, 318, 766–770. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Liu, C.; Hughes, T.L.; Qi, X.L.; Wang, K.; Zhang, S.C. Quantum spin Hall effect in inverted type-II semiconductors. Phys. Rev. Lett. 2008, 100, 236601. [Google Scholar] [CrossRef]
- Knez, I.; Du, R.R.; Sullivan, G. Evidence for helical edge modes in inverted InAs/GaSb quantum wells. Phys. Rev. Lett. 2011, 107, 136603. [Google Scholar] [CrossRef] [Green Version]
- Kvon, Z.D.; Olshanetsky, E.B.; Novik, E.G.; Kozlov, D.A.; Mikhailov, N.N.; Parm, I.O.; Dvoretsky, S.A. Two-dimensional electron-hole system in HgTe-based quantum wells with surface orientation (112). Phys. Rev. B 2011, 83, 193304. [Google Scholar] [CrossRef]
- Prudkoglyad, V.A.; Olshanetsky, E.B.; Kvon, Z.D.; Pudalov, V.M.; Mikhailov, N.N.; Dvoretsky, S.A. Two-dimensional semimetal in HgTe quantum well under hydrostatic pressure. Phys. Rev. B 2018, 98, 155437. [Google Scholar] [CrossRef] [Green Version]
- Miao, M.; Yan, Q.; Van de Walle, C.G.; Lou, W.K.; Li, L.L.; Chang, K. Polarization-driven topological insulator transition in a GaN/InN/GaN quantum well. Phys. Rev. Lett. 2012, 109, 186803. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Łepkowski, S.P.; Bardyszewski, W. Topological insulator with negative spin-orbit coupling and transition between Weyl and Dirac semimetals in inGaN-based quantum wells. Sci. Rep. 2018, 8, 15403. [Google Scholar] [CrossRef] [PubMed]
- Leubner, P.; Lunczer, L.; Brune, C.; Buhmann, H.; Molenkamp, L.W. Strain engineering of the band gap of HgTe quantum wells using superlattice virtual substrates. Phys. Rev. Lett. 2016, 117, 086403. [Google Scholar] [CrossRef] [Green Version]
- Du, L.; Li, T.; Lou, W.; Wu, X.; Liu, X.; Han, Z.; Zhang, C.; Sullivan, G.; Ikhlassi, A.; Chang, K.; et al. R tuning edge states in strained-layer inAs/GaInSb quantum spin Hall insulators. Phys. Rev. Lett. 2017, 119, 056803. [Google Scholar] [CrossRef] [Green Version]
- Krishtopenko, S.S.; Ruffenach, S.; Gonzalez-posada, F.; Boissier, G.; Marcinkiewicz, M.; Fadeev, M.A.; Kadykov, A.M.; Rumyantsev, V.V.; Morozov, S.V.; Gavrilenko, V.I.; et al. Temperature-dependent terahertz spectroscopy of inverted-band three-layer InAs/GaSb/InAs quantum wells. Phys. Rev. B 2018, 97, 245419. [Google Scholar] [CrossRef]
- Olshanetsky, E.B.; Kvon, Z.D.; Gusev, G.M.; Levin, A.D.; Raichev, O.E.; Mikhailov, N.N.; Dvoretsky, S.A. Persistence of a two-dimensional topological insulator state in wide HgTe quantum wells. Phys. Rev. Lett. 2015, 114, 126802. [Google Scholar] [CrossRef] [Green Version]
- Bardyszewski, W.; Rodak, D.; Łepkowski, S.P. Magnetoconductance in InN/GaN quantum wells in topological insulator phase. EPL 2017, 118, 27001. [Google Scholar] [CrossRef]
- Łepkowski, S.P.; Bardyszewski, W.; Rodak, D. Polarization-induced band inversion in In-rich InGaN/GaN quantum wells. Acta Phys. Pol. A 2014, 126, 1154–1155. [Google Scholar] [CrossRef]
- Łepkowski, S.P.; Bardyszewski, W. Topological phase transition and evolution of edge states in In-rich InGaN/GaN quantum wells under hydrostatic pressure. J. Phys. Condens. Matter 2017, 29, 055702. [Google Scholar] [CrossRef]
- Kusakabe, K.; Hashimoto, N.; Itoi, T.; Wang, K.; Imai, D.; Yoshikawa, A. Growth kinetics and structural perfection of (InN)1/(GaN)1-20 short-period superlattices on +c-GaN template in dynamic atomic layer epitaxy. Appl. Phys. Lett. 2016, 108, 152107. [Google Scholar] [CrossRef]
- Dimitrakopulos, G.P.; Vasileiadis, I.G.; Smalc-Koziorowska, J.; Kret, S.; Dimakis, E.; Florini, N.; Kehagias, T.; Suski, T.; Karakostas, T.; Moustakas, T.D.; et al. Compositional and strain analysis of In(Ga)N/GaN short period superlattices. J. Appl. Phys. 2018, 123, 024304. [Google Scholar] [CrossRef]
- Vasileiadis, I.G.; Lymperakis, L.; Adikimenakis, A.; Gkotinakos, A.; Devulapalli, V.; Liebscher, C.H.; Androulidaki, M.; Hubner, R.; Karakostas, T.; Georgakilas, A.; et al. Substitutional synthesis of sub-nanometer InGaN/GaN quantum wells with high indium content. Sci. Rep. 2021, 11, 20606. [Google Scholar] [CrossRef] [PubMed]
- Łepkowski, S.P.; Bardyszewski, W. Anomalous Rashba spin-orbit interaction in electrically controlled topological insulator based on InN/GaN quantum wells. J. Phys. Condens. Matter 2017, 29, 195702, Corrigendum in J. Phys. Condens. Matter 2020, 33, 119501. [Google Scholar] [CrossRef]
- Hu, G.; Zhang, Y.; Li, L.; Wang, Z.L. Piezotronic transistor based on topological insulators. ACS Nano 2017, 12, 779–785. [Google Scholar] [CrossRef]
- Dan, M.; Hu, G.; Li, I.; Zhang, Y. High performance piezotronic logic nanodevices based on GaN/InN/GaN topological insulator. Nano Energy 2018, 50, 544–551. [Google Scholar] [CrossRef] [Green Version]
- Litvinov, V.I. Quantum anomalous Hall state with Chern number C = 2 in wurtzite quantum wells. Phys. Rev. B 2021, 104, 245304. [Google Scholar] [CrossRef]
- Michetti, P.; Budich, J.C.; Novik, E.G.; Recher, P. Tunable quantum spin Hall effect in double quantum wells. Phys. Rev. B 2012, 85, 125309. [Google Scholar] [CrossRef] [Green Version]
- Krishtopenko, S.S.; Knap, W.; Teppe, F. Phase transitions in two tunnel-coupled HgTe quantum wells: Bilayer graphene analogy and beyond. Sci. Rep. 2016, 6, 30755. [Google Scholar] [CrossRef] [Green Version]
- Gusev, G.M.; Olshanetsky, E.B.; Hernandez, F.G.G.; Raichev, O.E.; Mikhailov, N.N.; Dvoretsky, S.A. Two-dimensional topological insulator state in double HgTe quantum well. Phys. Rev. B 2020, 101, 241302. [Google Scholar] [CrossRef]
- Punya, A.; Lambrecht, W.R.L. Valence band effective-mass Hamiltonians for the group-III nitrides from quasiparticle self-consistent GW band structures. Phys. Rev. B 2012, 85, 195147. [Google Scholar] [CrossRef] [Green Version]
- Łepkowski, S.P.; Anwar, A.R. Third-order elastic constants and biaxial relaxation coefficient in wurtzite group-III nitrides by hybrid-density functional theory calculations. J. Phys. Condens. Matter 2021, 33, 355402. [Google Scholar] [CrossRef] [PubMed]
- Vurgaftman, I.; Meyer, J.R. Band parameters for nitrogen-containing semiconductors. J. Appl. Phys. 2003, 94, 3675. [Google Scholar] [CrossRef]
- Gorczyca, I.; Łepkowski, S.P.; Suski, T.; Christensen, N.E.; Svane, A. Influence of indium clustering on the band structure of semiconducting ternary and quaternary nitride alloys. Phys. Rev. B 2009, 80, 075202. [Google Scholar] [CrossRef]
- Łepkowski, S.P.; Anwar, A.R. Biaxial relaxation coefficient in group-III nitride quantum wells and thin films. Acta Phys. Pol. A 2022, 141, 130–134. [Google Scholar] [CrossRef]
- Łepkowski, S.P. Inapplicability of Martin transformation to elastic constants of zinc-blende and wurtzite group-III nitride alloys. J. Appl. Phys. 2015, 117, 105703. [Google Scholar] [CrossRef]
- Bernardini, F.; Fiorentini, V. Spontaneous versus piezoelectric polarization in III-V nitrides: Conceptual aspects and practical consequences. Phys. Stat. Sol. 1999, 216, 391–398. [Google Scholar] [CrossRef] [Green Version]
- Prodhomme, P.-Y.; Beya-Wakata, A.; Bester, G. Nonlinear piezoelectricity in wurtzite semiconductors. Phys. Rev. B 2013, 88, 121304. [Google Scholar] [CrossRef]
- Chuang, S.L.; Chang, C.S. k∙p method for strained wurtzite semiconductors. Phys. Rev. B 1996, 54, 2491–2504. [Google Scholar] [CrossRef]
- Łepkowski, S.P.; Gorczyca, I.; Stefańska-Skrobas, K.; Christensen, N.E.; Svane, A. Deformation potentials in AlGaN and InGaN alloys and their impact on optical polarization properties of nitride quantum wells. Phys. Rev. B 2013, 88, 081202. [Google Scholar] [CrossRef]
- Huebner, K.H.; Thornton, E.A. The Finite Element Method for Engineers; Wiley: New York, NY, USA, 1982; pp. 22–123. [Google Scholar]
- Fabien, C.A.M.; Gunning, B.P.; Doolittle, W.A.; Fischer, A.M.; Wei, Y.O.; Xie, H.; Ponce, F.A. Low-temperature growth of InGaN films over the entire composition range by MBE. J. Cryst. Growth 2015, 425, 115–118. [Google Scholar] [CrossRef] [Green Version]
- Daubler, J.; Passow, T.; Aidam, R.; Kohler, K.; Kirste, L.; Kunzer, M.; Wagner, J. Long wavelength emitting GaInN quantum wells on metamorphic GaInN buffer layers with enlarged in-plane lattice parameter. Appl. Phys. Lett. 2014, 105, 111111. [Google Scholar] [CrossRef]
- Even, A.; Laval, G.; Ledoux, O.; Ferret, P.; Sotta, D.; Guiot, E.; Levy, F.; Robin, I.C.; Dussaigne, A. Enhanced In incorporation in full InGaN heterostructure grown on relaxed InGaN pseudo-substrate. Appl. Phys. Lett. 2017, 110, 262103. [Google Scholar] [CrossRef]
- Anwar, A.R.; Sajjad, M.T.; Johar, M.A.; Hernandez-Gutierrez, C.A.; Usman, M.; Łepkowski, S.P. Recent progress in micro-LED based display technologies. Laser Photonics Rev. 2022, 16, 2100427. [Google Scholar] [CrossRef]
- Krishtopenko, S.S.; Yahniuk, I.; But, D.B.; Gavrilenko, V.I.; Knap, W.; Teppe, F. Pressure- and temperature-driven phase transitions in HgTe quantum wells. Phys. Rev. B 2016, 94, 245402. [Google Scholar] [CrossRef] [Green Version]
- Zhang, D.; Lou, W.; Miao, M.; Zhang, S.C.; Chang, K. Interface-induced topological insulator transition in GaAs/Ge/GaAs quantum wells. Phys. Rev. Lett. 2013, 111, 156402. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Liu, Q.; Zhang, X.; Abdalla, L.B.; Zunger, A. Transforming common III-V and II-VI semiconductor compounds into topological heterostructures: The case of CdTe/InSb superlattices. Adv. Funct. Mater. 2016, 26, 3259. [Google Scholar] [CrossRef] [Green Version]
- Hu, G.; Zhang, Y. Quantum piezotronic devices based on ZnO/CdO quantum well topological insulator. Nano Energy 2020, 77, 105154. [Google Scholar] [CrossRef]
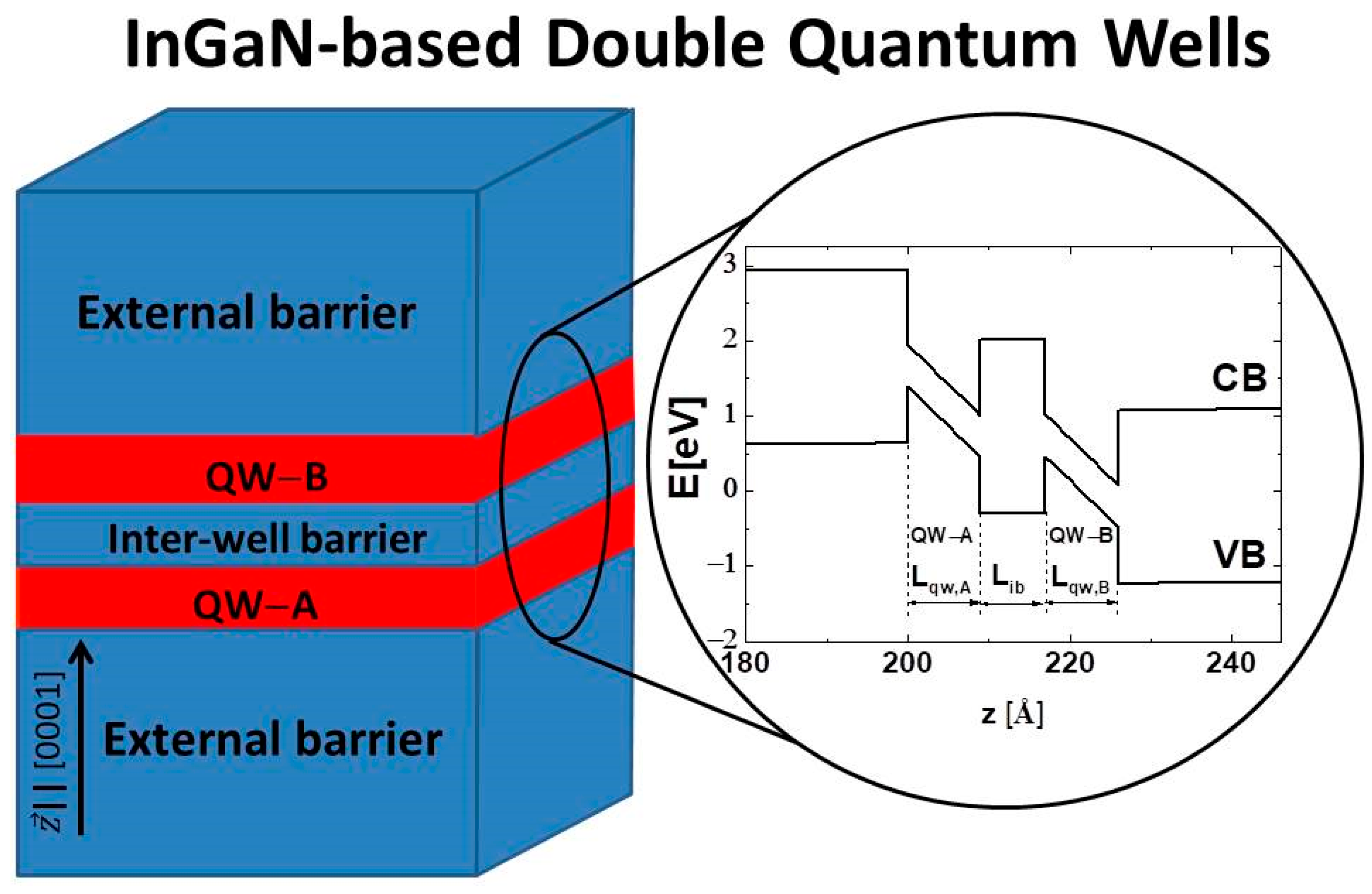









Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Łepkowski, S.P.; Anwar, A.R. Polarization-Induced Phase Transitions in Ultra-Thin InGaN-Based Double Quantum Wells. Nanomaterials 2022, 12, 2418. https://doi.org/10.3390/nano12142418
Łepkowski SP, Anwar AR. Polarization-Induced Phase Transitions in Ultra-Thin InGaN-Based Double Quantum Wells. Nanomaterials. 2022; 12(14):2418. https://doi.org/10.3390/nano12142418
Chicago/Turabian StyleŁepkowski, Sławomir P., and Abdur Rehman Anwar. 2022. "Polarization-Induced Phase Transitions in Ultra-Thin InGaN-Based Double Quantum Wells" Nanomaterials 12, no. 14: 2418. https://doi.org/10.3390/nano12142418





