Bistable Boron-Related Defect Associated with the Acceptor Removal Process in Irradiated p-Type Silicon—Electronic Properties of Configurational Transformations
Abstract
:1. Introduction
2. Materials and Methods
3. Results
3.1. Transformation from A to B Configuration
3.2. Transformation from B to A Configuration
4. Discussion
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Apollinari, G.; Béjar Alonso, I.; Brüning, O.; Fessia, P.; Lamont, M.; Rossi, L.; Tavian, L. High-Luminosity Large Hadron Collider (HL-LHC): Technical Design Report V.0.1; Technical Report CERN-2017-007-M; CERN: Genève, Switzerland, 2017. [Google Scholar] [CrossRef]
- European XFEL. Available online: https://www.xfel.eu/ (accessed on 5 May 2023).
- Klanner, R.; Becker, J.; Fretwurst, E.; Pintilie, I.; Pöhlsen, T.; Schwandt, J.; Zhang, J. Challenges for silicon pixel sensors at the European XFEL. Nucl. Instrum. Methods Phys. Res. A 2013, 730, 2–7. [Google Scholar] [CrossRef]
- Bermudez-Garcia, A.; Voarino, P.; Raccurt, O. Environments, needs and opportunities for future space photovoltaic power generation: A review. Appl. Energy 2021, 290, 116757. [Google Scholar] [CrossRef]
- Saliterman, S.S. Fundamentals of BioMEMS and Medical Microdevices; Wiley-Interscience: Bellingham, WA, USA, 2006; ISBN 9780819459770. [Google Scholar]
- Moll, M. Displacement Damage in Silicon Detectors for High Energy Physics. IEEE Trans. Nucl. Sci. 2018, 65, 1561–1582. [Google Scholar] [CrossRef]
- Wunstorf, R.; Benkert, M.; Fretwurst, E.; Lindstrom, G.; Schulz, T.; Croitoru, N.; Darvas, R.; Mudrik, M.; Böttger, R.; Schölermann, H. Radiation damage of silicon detectors by monoenergetic neutrons and electrons. Nucl. Phys. B—Proc. Suppl. 1991, 23, 324–332. [Google Scholar] [CrossRef]
- Pitzl, D.; Cartiglia, N.; Hubbard, B.; Hutchinson, D.; Leslie, J.; O’Shaughnessy, K.; Rowe, W.; Sadrozinski, H.F.-W.; Seiden, A.; Spencer, E.; et al. Type inversion in silicon detectors. Nucl. Instrum. Methods Phys. Res. A 1992, 311, 98–104. [Google Scholar] [CrossRef]
- Pagava, T.; Chkhartishvili, L.; Beridze, M.; Metskhvarishvili, M.; Kalandadze, I.; Khocholava, D.; Esiava, N.; Kevkhishvili, M.; Matcharashvili, M. Special mechanism of conduction type inversion in plastically deformed n-Si. EUREKA Phys. Eng. 2019, 4, 76–81. [Google Scholar] [CrossRef] [Green Version]
- Pintilie, I.; Fretwurst, E.; Lindström, G.; Stahl, J. Second-order generation of point defects in gamma-irradiated float-zone silicon, an explanation for “type inversion”. Appl. Phys. Lett. 2003, 82, 2169–2171. [Google Scholar] [CrossRef]
- Pintilie, I.; Fretwurst, E.; Lindström, G. Cluster related hole traps with enhanced-field-emission—The source for long term annealing in hadron irradiated Si diodes. Appl. Phys. Lett. 2008, 92, 024101. [Google Scholar] [CrossRef]
- Pintilie, I.; Lindstroem, G.; Junkes, A.; Fretwurst, E. Radiation-induced point- and cluster-related defects with strong impact on damage properties of silicon detectors. Nucl. Instrum. Methods Phys. Res. A 2009, 611, 52–68. [Google Scholar] [CrossRef] [Green Version]
- Gianotti, F.; Mangano, M.L.; Virdee, T. Physics potential and experimental challenges of the LHC luminosity upgrade. Eur. Phys. J. 2005, C 39, 293. [Google Scholar] [CrossRef]
- RD50 Collaboration. Available online: https://rd50.web.cern.ch (accessed on 5 May 2023).
- Moll, M.; Adey, J.; Al-Ajili, A.; Alfieri, G.; Allport, P.P.; Artuso, M.; Assouak, S.; Avset, B.S.; Barabash, L.; Barcz, A.; et al. Development of radiation tolerant semiconductor detectors for the Super-LHC. Nucl. Instrum. Methods Phys. Res. A 2005, 546, 99–107. [Google Scholar] [CrossRef]
- Pellegrini, G.; Fernández-Martínez, P.; Baselga, M.; Fleta, C.; Flores, D.; Greco, V.; Hidalgo, S.; Mandić, I.; Kramberger, G.; Quirion, D.; et al. Technology developments and first measurements of Low Gain Avalanche Detectors (LGAD) for highenergy physics applications. Nucl. Instrum. Methods Phys. Res. A 2014, 765, 12–16. [Google Scholar] [CrossRef]
- Sadrozinski, H.-W.; Seiden, A.; Cartiglia, N. 4D tracking with ultra-fast silicon detectors. Rep. Prog. Phys. 2017, 81, 026101. [Google Scholar] [CrossRef] [PubMed]
- Kramberger, G.; Baselga, M.; Cindro, V.; Fernandez-Martinez, P.; Flores, D.; Galloway, Z.; Gorišek, A.; Greco, V.; Hidalgo, S.; Fadeyev, V.; et al. Radiation effects in Low Gain Avalanche Detectors after hadron irradiations. J. Instrum. 2015, 10, P07006. [Google Scholar] [CrossRef]
- Kramberger, G.; Carulla, M.; Cavallaro, E.; Cindro, V.; Flores, D.; Galloway, Z.; Grinstein, S.; Hidalgo, S.; Fadeyev, V.; Lange, J.; et al. Radiation hardness of thin Low Gain Avalanche Detectors. Nucl. Instrum. Methods Phys. Res. A 2018, 891, 68–77. [Google Scholar] [CrossRef] [Green Version]
- Ferrero, M.; Arcidiacono, R.; Barozzi, M.; Boscardin, M.; Cartiglia, N.; Dalla Betta, G.F.; Galloway, Z.; Mandurrino, M.; Mazza, S.; Paternoster, G.; et al. Radiation resistant LGAD design. Nucl. Instrum. Methods Phys. Res. A 2019, 919, 16–26. [Google Scholar] [CrossRef]
- Snoeys, W. CMOS monolithic active pixel sensors for high energy physics. Nucl. Instrum. Methods Phys. Res. A 2014, 765, 167–171. [Google Scholar] [CrossRef] [Green Version]
- Turchetta, R.; Fant, A.; Gasiorek, P.; Esbrand, C.; Griffiths, J.A.; Metaxas, M.G.; Royle, G.J.; Speller, R.; Venanzi, C.; van der Stelt, P.F.; et al. CMOS Monolithic Active Pixel Sensors (MAPS): Developments and future outlook. Nucl. Instrum. Methods Phys. Res. A 2007, 582, 866–870. [Google Scholar] [CrossRef]
- Perić, I. A novel monolithic pixelated particle detector implemented in high-voltage CMOS technology. Nucl. Instrum. Methods Phys. Res. A 2007, 582, 876–885. [Google Scholar] [CrossRef]
- Pohl, D.L.; Hemperek, T.; Caicedo, I.; Gonella, L.; Hügging, F.; Janssen, J.; Krüger, H.; Macchiolo, A.; Owtscharenko, N.; Vigani, L.; et al. Radiation hard pixel sensors using high-resistive wafers in a 150 nm CMOS processing line. J. Instrum. 2017, 12, P06020. [Google Scholar] [CrossRef] [Green Version]
- Affolder, A.; Andelković, M.; Arndt, K.; Bates, R.; Blue, A.; Bortoletto, D.; Buttar, C.; Caragiulo, P.; Cindro, V.; Das, D.; et al. Charge collection studies in irradiated HV-CMOS particle detectors. J. Instrum. 2016, 11, P04007. [Google Scholar] [CrossRef]
- Cavallaro, E.; Casanova, R.; Förster, F.; Grinstein, S.; Lange, J.; Kramberger, G.; Mandić, I.; Puigdengoles, C.; Terzo, S. Studies of irradiated AMS H35 CMOS detectors for the ATLAS tracker upgrade. J. Instrum. 2017, 12, C01074. [Google Scholar] [CrossRef] [Green Version]
- Hiti, B.; Cindro, V.; Gorišek, A.; Hemperek, T.; Kishishita, T.; Kramberger, G.; Krüger, H.; Mandić, I.; Mikuž, M.; Wermes, N.; et al. Charge collection properties in an irradiated pixel sensor built in a thick-film HV-SOI process. J. Instrum. 2017, 12, P10020. [Google Scholar] [CrossRef] [Green Version]
- Mandic, I.; Cindro, V.; Gorišek, A.; Hiti, B.; Kramberger, G.; Mikuž, M.; Zavrtanik, M.; Hemperek, T.; Daas, M.; Hügging, F.; et al. Neutron irradiation test of depleted CMOS pixel detector prototype. J. Instrum. 2017, 12, P02021. [Google Scholar] [CrossRef] [Green Version]
- Hiti, B.; Affolder, A.; Arndt, K.; Bates, R.; Benoit, M.; Di Bello, F.; Blue, A.; Bortoletto, D.; Buckland, M.; Buttar, C.; et al. Charge collection in irradiated HV-CMOS detectors. Nucl. Instrum. Methods Phys. Res. A 2019, 924, 214–218. [Google Scholar] [CrossRef] [Green Version]
- Wunstorf, R.; Bugg, W.M.; Walter, J.; Garber, F.W.; Larson, D. Investigation of donor and acceptor removal and long term annealing in silicon with different boron/phosphorus ratios. Nucl. Instrum. Methods Phys. Res. A 1996, 377, 228–233. [Google Scholar] [CrossRef]
- Moll, M. Acceptor removal-Displacement damage effects involving the shallow acceptor doping of p-type silicon devices. In Proceedings of the Science (Vertex2019), Lopud Island, Croatia, 13–18 October 2019; p. 027. [Google Scholar] [CrossRef]
- Besleaga, C.; Kuncser, A.; Nitescu, A.; Kramberger, G.; Moll, M.; Pintilie, I. Bistability of the BiOi complex and its implications on evaluating the acceptor removal process in p-type silicon. Nucl. Instrum. Methods Phys. Res. A 2021, 1017, 165809. [Google Scholar] [CrossRef]
- Hartke, J.L. The three dimensional Pool-Frenkel effect. J. Appl. Phys. 1967, 39, 4871–4873. [Google Scholar] [CrossRef]
- Mooney, P.M.; Cheng, L.J.; Süli, M.; Gerson, J.D.; Corbett, J.W. Defects energy levels in boron-doped silicon irradiated with 1-MeV electrons. Phys. Rev. B 1977, 15, 3836–3843. [Google Scholar] [CrossRef]
- Drevinski, P.J.; Caefer, C.E.; Tobin, S.P.; Mikkelsen, J.C., Jr.; Kimerling, L.C. Influence of oxygen and boron on defect production in irradiated silicon. Mater. Res. Soc. Symp. Proc. 1988, 104, 167–172. [Google Scholar] [CrossRef]
- Kimerling, L.C.; Asom, M.T.; Benton, J.L.; Drevinsky, P.J.; Caefer, C.E. Interstitial defect reactions in silicon. Mater. Sci. Forum 1989, 38–41, 141–150. [Google Scholar] [CrossRef]
- Troxell, J.R.; Watkins, G.D. Interstitial boron in silicon: A negative-U system. Phys. Rev. B 1980, 22, 921. [Google Scholar] [CrossRef]
- Makarenko, L.F.; Lastovski, S.B.; Korshunov, F.P.; Murin, L.I.; Moll, M. Primary defect transformations in high-resistivity p-type silicon irradiated with electrons at cryogenic temperatures. Physica B 2009, 404, 4561–4564. [Google Scholar] [CrossRef]
- Makarenko, L.F.; Lastovskii, S.B.; Yakushevich, H.S.; Moll, M.; Pintilie, I. Forward current enhanced elimination of the radiation induced boron–oxygen complex in silicon n+–p diodes. Phys. Status Solidi A 2014, 211, 2558–2562. [Google Scholar] [CrossRef]
- Liao, C.; Fretwurst, E.; Garutti, E.; Schwandt, J.; Moll, M.; Himmerlich, A.; Gurimskaya, Y.; Pintilie, I.; Nitescu, A.; Li, Z.; et al. The Boron Oxygen (BiOi) Defect Complex Induced by Irradiation with 23 GeV Protons in p-Type Epitaxial Silicon Diodes. IEEE Trans. Nucl. Sci. 2022, 69, 576–586. [Google Scholar] [CrossRef]
- Feklisova, O.V.; Yarykin, N.A.; Weber, J. Annealing kinetics of boron-containing centers in electron-irradiated silicon. Semiconductors 2013, 47, 228–231. [Google Scholar] [CrossRef]
- Adey, J.; Jones, R. Formation of BiOi, BiCs, and BiBsHi defects in e-irradiated or ion-implanted silicon containing boron. Appl. Phys. Lett. 2003, 83, 665–667. [Google Scholar] [CrossRef]
- Watkins, G.D. EPR of trapped vacancy in boron-doped silicon. Phys. Rev. B 1976, 13, 2511–2518. [Google Scholar] [CrossRef]
- Adey, J.; Jones, R.; Palmer, D.W.; Briddon, P.R.; Öberg, S. Theory of boron-vacancy complexes in silicon. Phys. Rev. B 2005, 71, 165211. [Google Scholar] [CrossRef]
- Emtsev, V.; Abrosimov, N.; Kozlovski, V.; Lastovskii, S.; Oganesyan, G.; Poloskin, D. Electron- and proton irradiation of strongly doped silicon of p-type: Formation and annealing of boron-related defects. J. Appl. Phys. 2022, 131, 125705. [Google Scholar] [CrossRef]
- Pagava, T.; Chkhartishvili, L.; Maisuradze, N.; Esiava, R.; Dekanosidze, S.; Beridze, M.; Mamisashvili, N. Role of boron in formation of secondary radiation defects in silicon. East.-Eur. J. Ent. Technol. 2015, 4, 52–58. [Google Scholar] [CrossRef] [Green Version]
- Möller, C.; Lauer, K. Light-induced degradation in indium-doped silicon. Phys. Status Solidi RRL 2013, 7, 461. [Google Scholar] [CrossRef]
- Lauer, K.; Möller, C.; Tessmann, C.; Schulze, D.; Abrosimov, N.V. Activation energies of the InSi-Sii defect transitions obtained by carrier lifetime measurements. Phys. Status Solidi C 2017, 14, 1600033. [Google Scholar] [CrossRef]
- Gkougkousis, E.L.; Lounis, A.; Nellist, C. Neutron Irradiated Doping Profile Evaluation. In Proceedings of the 28th RD50 Workshop, Torino, Italy, 6–8 June 2016; Available online: https://agenda.infn.it/event/11109/contributions/7070/ (accessed on 5 May 2023).
- Lauer, K.; Peh, K.; Krischok, S.; Reis, S.; Hiller, E.; Ortlepp, T. Development of Low-Gain Avalanche Detectors in the frame of the acceptor removal phenomenon. Phys. Status Solidi A 2022, 219, 2200177. [Google Scholar] [CrossRef]
- Pintilie, I.; Pintilie, L.; Moll, M.; Fretwurst, E.; Lindstroem, G. Thermally stimulated current method applied on diodes with high concentration of deep trapping levels. Appl. Phys. Lett. 2001, 78, 550–552. [Google Scholar] [CrossRef]
- Pintilie, I.; Buda, M.; Fretwurst, E.; Lindström, G.; Stahl, J. Stable radiation-induced donor generation and its influence on the radiation tolerance of silicon diodes. Nucl. Instrum. Methods Phys. Res. A 2006, 556, 197–208. [Google Scholar] [CrossRef]
- Forbes, L.; Sah, C.T. Determination of deep level center energy and concentration by thermally stimulated conductivity measurements using reverse-biased p-n junctions. Solid-State Electron. 1971, 14, 182. [Google Scholar] [CrossRef]
- Schockley, W.; Read, W.T., Jr. Statistics of the Recombinations of Holes and Electrons. Phys. Rev. B 1952, 87, 835. [Google Scholar] [CrossRef]
- Hall, R.N. Electron-Hole Recombination in Germanium. Phys. Rev. B 1952, 87, 387. [Google Scholar] [CrossRef]
- Green, M.A. Intrinsic concentration, effective densities of states, and effective mass in silicon. J. Appl. Phys. 1990, 67, 2944–2954. [Google Scholar] [CrossRef]
- Sze, S.M. (Ed.) Physics of Semiconductor Devices, 2nd ed.; John Wiley and Sons Ltd.: Hoboken, NJ, USA, 1981; pp. 92–94. [Google Scholar]
- Lange, J.; Carulla, M.; Cavallaro, E.; Chytka, L.; Davis, P.M.; Flores, D.; Förster, F.; Grinstein, S.; Hidalgo, S.; Komarek, T.; et al. Gain and time resolution of 45 μm thin Low Gain Avalanche Detectors before and after irradiation up to a fluence of 1015 neq/cm2. J. Instrum. 2017, 12, P05003. [Google Scholar] [CrossRef] [Green Version]
- Levinson, M.; Benton, J.L.; Kimerling, L.C. Electronically controlled metastable defect reaction in InP. Phys. Rev. B 1983, 27, 6216. [Google Scholar] [CrossRef]
- Chantre, A. Introduction to Defect Bistability. Appl. Phys. A 1989, 48, 3–9. [Google Scholar] [CrossRef]
- Markevich, V.P.; Murin, L.I.; Lastovskii, S.B.; Medvedeva, I.F.; Komarov, B.A.; Lindström, J.L.; Peaker, A.R. Electrically active radiation-induced defects in Czochralski-grown Si with low carbon content. J. Phys. Condens. Mat. 2005, 17, S2331–S2340. [Google Scholar] [CrossRef]
- Fretwurst, E.; Honniger, F.; Kramberger, G.; Lindstrom, G.; Pintilie, I.; Roder, R. Radiation damage studies on MCz and standard and oxygen enriched epitaxial silicon devices. Nucl. Instrum. Methods Phys. Res. A 2007, 583, 58–63. [Google Scholar] [CrossRef]
- Markevich, V.P.; Peaker, A.R.; Lastovskii, S.B.; Murin, L.I.; Coutinho, J.; Torres, V.J.B.; Briddon, P.R.; Dobaczewski, L.; Monakhov, E.V.; Svensson, B.G. Trivacancy and trivacancy-oxygen complexes in silicon: Experiments and ab initio modeling. Phys. Rev. B 2009, 80, 235207. [Google Scholar] [CrossRef] [Green Version]
- Makarenko, L.F.; Markevich, V.P.; Murin, L.I. Modifiable thermal donors in silicon in the form of defects with U < 0. Sov. Phys.-Semicond. 1985, 19, 1192–1195. [Google Scholar]
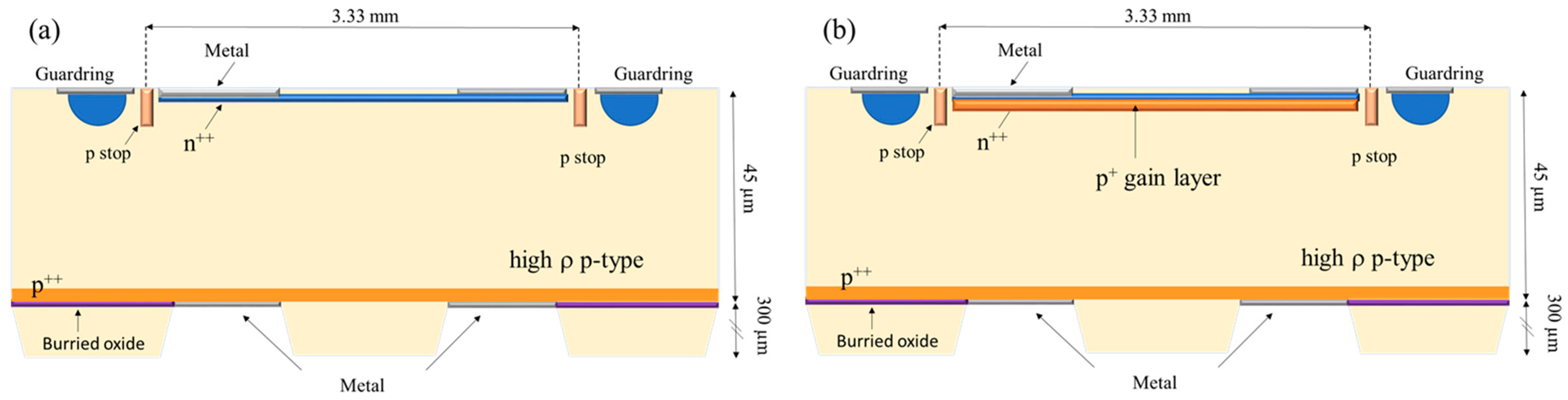
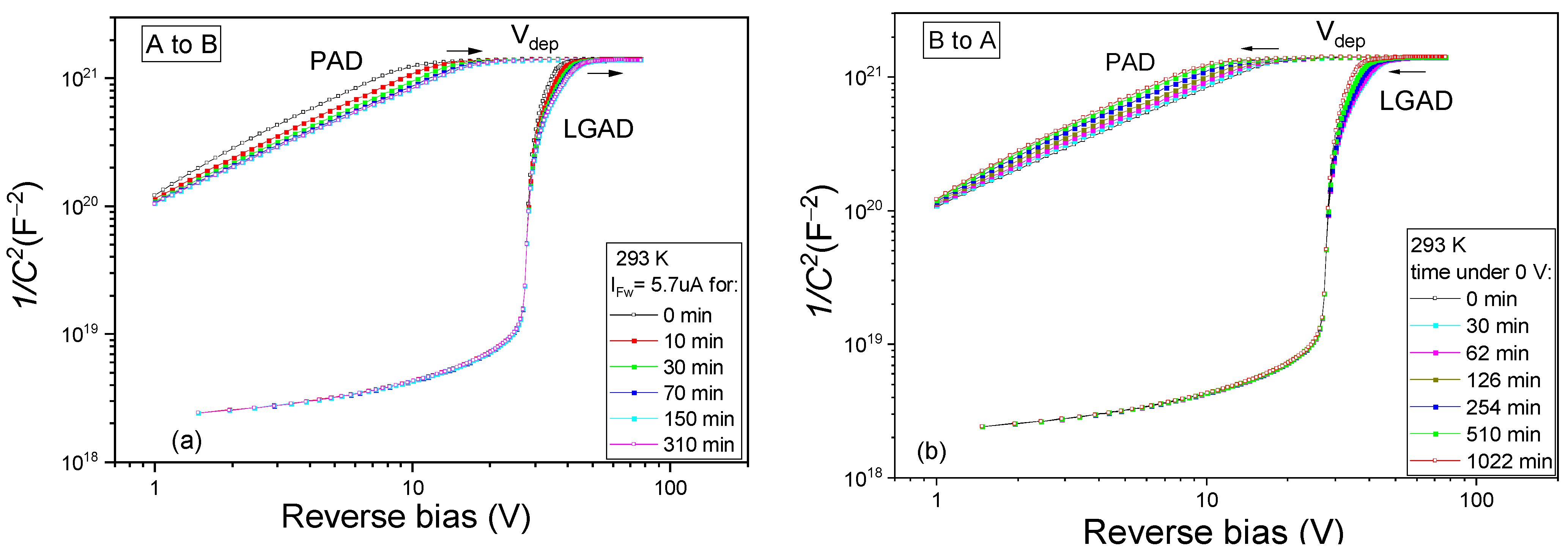









Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Nitescu, A.; Besleaga, C.; Nemnes, G.A.; Pintilie, I. Bistable Boron-Related Defect Associated with the Acceptor Removal Process in Irradiated p-Type Silicon—Electronic Properties of Configurational Transformations. Sensors 2023, 23, 5725. https://doi.org/10.3390/s23125725
Nitescu A, Besleaga C, Nemnes GA, Pintilie I. Bistable Boron-Related Defect Associated with the Acceptor Removal Process in Irradiated p-Type Silicon—Electronic Properties of Configurational Transformations. Sensors. 2023; 23(12):5725. https://doi.org/10.3390/s23125725
Chicago/Turabian StyleNitescu, Andrei, Cristina Besleaga, George Alexandru Nemnes, and Ioana Pintilie. 2023. "Bistable Boron-Related Defect Associated with the Acceptor Removal Process in Irradiated p-Type Silicon—Electronic Properties of Configurational Transformations" Sensors 23, no. 12: 5725. https://doi.org/10.3390/s23125725





