Seedless Cu Electroplating on Ru-W Thin Films for Metallisation of Advanced Interconnects
Abstract
:1. Introduction
2. Results and Discussion
3. Experimental
3.1. Ru-W Thin Film Deposition
3.2. Cu Electroplating
3.3. Structural and Chemical Characterisation of Substrate and Cu Films
4. Conclusions
- ▪
- Thin Cu films can be directly electroplated on near equimolar Ru-W thin films using a conventional acidic electrolyte.
- ▪
- Under the flat substrate configuration and electroplating conditions herein utilised, a minimum average current density between 3 and 5 mA·cm−2 was required to achieve substrate coverage, regardless of the current application mode.
- ▪
- A wide range of particle sizes formed on the substrate. A variable thickness, compact Cu film was partially interrupted by large star-like/dendritic Cu particles that prevented substrate coverage in their vicinity.
- ▪
- A pulse-reverse current effectively reduced the particle size, which contributed to a smoother film but appeared unable to eliminate large Cu particles. Hydrogen evolution was noticeable above 6 mA·cm−2.
- ▪
- Substrate coverage was not complete, and this requires improvement; however, a continuous interface between Cu and Ru-W was formed.
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Akolar, R. Current Status and Advances in Damascene Electrodeposition, Encyclopedia of Interfacial Chemistry. Surf. Sci. Electrochem. 2018, 5.1, 24–31. [Google Scholar] [CrossRef]
- Lin, Q.; Wu, H.; Jia, G. Review of the Global Trend of Interconnect Reliability for Integrated Circuit. Circ. Syst. 2018, 9, 9–21. [Google Scholar] [CrossRef] [Green Version]
- Li, Z.; Tian, Y.; Teng, C.; Cao, H. Recent Advances in Barrier Layer of Cu Interconnects. Materials 2020, 13, 5049. [Google Scholar] [CrossRef]
- Istratov, A.A.; Flink, C.; Hieslmair, H.; Weber, E.R. Intrinsic Diffusion Coefficient of Interstitial Copper in Silicon. Phys. Rev. Lett. 1998, 81, 1243–1246. [Google Scholar] [CrossRef]
- Cros, A.; Aboelfotoh, M.O.; Tu, K.N. Formation, oxidation, electronic, and electrical properties of copper silicides. J. Appl. Phys. 1990, 67, 3328. [Google Scholar] [CrossRef]
- Baklanov, M.; Ho, P.S.; Zschech, E. Advanced Interconnects for ULSI Technology, 1st ed.; John Wiley & Sons: Chichester, UK, 2012; pp. 193–221. [Google Scholar]
- Kang, S.M.; Yoon, S.G.; Suh, S.J.; Yoon, D.H. Control of electrical resistivity of TaN thin films by reactive sputtering for embedded passive resistors. Thin Solid Films 2008, 516, 3568–3571. [Google Scholar] [CrossRef]
- McCoy, A.P.; Bogan, J.; Walsh, L.; Byrne, C.; Casey, P.; Hughes, G. The addition of aluminium to ruthenium liner layers for use as copper diffusion barriers. Appl. Surf. Sci. 2014, 307, 677–681. [Google Scholar] [CrossRef]
- Kim, H.; Koseki, T.; Ohba, T.; Ohta, T.; Kojima, Y.; Sato, H.; Shimogaki, Y. Cu Wettability and Diffusion Barrier Property of Ru Thin Film for Cu Metallization. J. Electrochem. Soc. 2005, 152, G594–G600. [Google Scholar] [CrossRef]
- Ding, S.-F.; Deng, S.-R.; Lu, H.-S.; Jiang, Y.-L.; Ru, G.-P.; Zhang, D.W.; Qu, X.-P. Cu adhesion on tantalum and ruthenium surface: Density functional theory. J. Appl. Phys. 2010, 107, 103534. [Google Scholar] [CrossRef]
- Simpson, D.E.; Johnson, C.A.; Roy, D. Pulsed Galvanostatic Electrodeposition of Copper on Cobalt Using a pH-Neutral Plating Bath and Electroless Seeds. J. Electrochem. Soc. 2019, 166, D3142–D3154. [Google Scholar] [CrossRef]
- Santos, R.F.; Oliveira, B.M.C.; Chícharo, A.; Alpuim, P.; Ferreira, P.J.; Simões, S.; Viana, F.; Vieira, M.F. Seedless Cu Electroplating on Co-W Thin Films in Low pH Electrolyte: Early Stages of Formation. Nanomaterials 2021, 11, 1914. [Google Scholar] [CrossRef]
- Eom, T.-K.; Sari, W.; Cheon, T.; Kim, S.-H.; Kim, W.K. A bilayer diffusion barrier of Ru/WSixNy for advanced Cu interconnects. Thin Solid Films 2012, 521, 73–77. [Google Scholar] [CrossRef]
- Wu, K.C.; Tseng, J.Y.; Chen, W.J. Electroplated Ru and RuCo films as a copper diffusion barrier. Appl. Surf. Sci. 2020, 516, 146139. [Google Scholar] [CrossRef]
- Hsu, K.-C.; Perng, D.-C.; Yeh, J.-B.; Wang, Y.-C. Ultrathin Cr added Ru film as a seedless Cu diffusion barrier for advanced Cu interconnects. Appl. Surf. Sci. 2012, 258, 7225–7230. [Google Scholar] [CrossRef]
- Wojcik, H.; Kaltofen, R.; Merkel, U.; Krien, C.; Strehle, S.; Gluch, J.; Knaut, M.; Wenzel, C.; Preusse, A.; Bartha, J.W.; et al. Electrical Evaluation of Ru-W(-N), Ru-Ta(-N) and Ru-Mn films as Cu diffusion barriers. Microelectron. Eng. 2012, 92, 71–75. [Google Scholar] [CrossRef]
- Wojcik, H.; Krien, C.; Merkel, U.; Bartha, J.W.; Knaut, M.; Geidel, M.; Adolphi, B.; Neumann, V.; Wenzel, C.; Bendlin, M.; et al. Characterization of Ru-Mn composites for USLI interconnects. Microelectron. Eng. 2013, 112, 103–109. [Google Scholar] [CrossRef]
- Lee, H.-J.; Hong, T.E.; Kim, S.-H. Atomic layer deposited self-forming Ru-Mn diffusion barrier for seedless Cu interconnects. J. Alloy. Compd. 2016, 686, 1025–1031. [Google Scholar] [CrossRef]
- Mun, K.-Y.; Hong, T.E.; Cheon, T.; Jang, Y.; Lim, B.-Y.; Kim, S.; Kim, S.-H. The effects of nitrogen incorporation on the properties of atomic layer deposited Ru thin films as a direct-plateable diffusion barrier for Cu interconnect. Thin Solid Films 2014, 562, 118–125. [Google Scholar] [CrossRef]
- Perng, D.-C.; Yeh, J.-B.; Hsu, K.-C. Phosphorous doped Ru film for advanced Cu diffusion barriers. Appl. Surf. Sci. 2008, 254, 6059–6062. [Google Scholar] [CrossRef]
- Henderson, L.B.; Ekerdt, J.G. Time-to-failure analysis of 5 nm amourphous Ru(P) as a copper diffusion barrier. Thin Solid Films 2009, 517, 1645–1649. [Google Scholar] [CrossRef]
- Torazawa, N.; Hinumura, T.; Hirao, S.; Kobori, E.; Korogi, H.; Matsumoto, S. Effects of N Doping in Ru-Ta on Barrier Property and Reliability Performance for Cu Interconnects. ECS J. Solid State Sci. Technol. 2016, 5, P433–P437. [Google Scholar] [CrossRef] [Green Version]
- Torazawa, N.; Hirao, S.; Kanayama, S.; Korogi, H.; Matsumoto, S. The Development of Cu Filling and Reliability Performance with Ru-Ta Alloy Barrier for Cu Interconnects. J. Electrochem. Soc. 2016, 163, E173–E178. [Google Scholar] [CrossRef]
- Yeh, J.-B.; Perng, D.-C.; Hsu, K.-C. Amorphous RuW Film as a Diffusion Barrier for Advanced Cu Metallization. J. Electrochem. Soc. 2010, 157, H810–H814. [Google Scholar] [CrossRef]
- Kuo, T.-C.; Su, Y.-H.; Lee, W.-H.; Liao, W.-H.; Wang, Y.-S.; Hung, C.-C.; Wang, Y.-L. A study on the plating and wetting ability of ruthenium-tungsten multi-layers for advanced Cu metallization. Microelectron. Eng. 2016, 162, 27–33. [Google Scholar] [CrossRef]
- Chyan, O.; Arunagiri, T.N.; Ponnuswamy, T. Electrodeposition of Copper Thin Film on Ruthenium. J. Electrochem. Soc. 2003, 150, C347–C350. [Google Scholar] [CrossRef]
- Josell, D.; Wheeler, D.; Witt, C.; Moffat, T.P. Seedless Superfill: Copper Electrodeposition in Trenches with Ruthenium Barriers. Electrochem. Solid-State Lett. 2003, 6, C143–C145. [Google Scholar] [CrossRef] [Green Version]
- Kim, Y.-S.; Kim, H.-I.; Dar, M.A.; Seo, H.-K.; Kim, G.-S.; Ansari, S.G.; Senkevich, J.J.; Shin, H.-S. Electrochemically Deposited Ruthenium Seed Layer Followed by Copper Electrochemical Plating. Electrochem. Solid-State Lett. 2006, 9, C19–C23. [Google Scholar] [CrossRef]
- Kelly, J.; van der Straten, O.; Vo, T. Deposition of Copper on Ruthenium for Cu Metallization. ECS Trans. 2010, 33, 145–158. [Google Scholar] [CrossRef]
- Gebregziabiher, D.K.; Kim, Y.-G.; Thambidurai, C.; Ivanova, V.; Haumesser, P.-H.; Stickney, J.L. Electrochemical atomic layer deposition of copper nanofilms on ruthenium. J. Cryst. Growth 2010, 312, 1271–1276. [Google Scholar] [CrossRef]
- Nagar, M.; Radisic, A.; Strubbe, K.; Vereecken, P.M. The effect of cupric ion concentration on the nucleation and growth of copper on RuTa seeded substrates. Electrochim. Acta 2013, 92, 474–483. [Google Scholar] [CrossRef]
- Xue, J.; Liang, W.; Liu, X.; Shen, Q.; Xu, B. Crystallization behavior and formation mechanism of dendrite Cu2O crystals. Crystengcomm 2012, 14, 8017–8022. [Google Scholar] [CrossRef]
- Emekli, U.; West, A.C. Electrochemical Nucleation of Copper: The Effect of Poly(ethylene glycol). J. Electrochem. Soc. 2010, 157, D257–D263. [Google Scholar] [CrossRef]
- Rashidi, A.M.; Amadeh, A. The effect of current density on the grain size of electrodeposited nanocrystalline nickel coatings. Surf. Coat. Technol. 2008, 202, 3772–3776. [Google Scholar] [CrossRef]
- Santos, R.F.; Viana, F.; Ferreira, P.J. Microstructure Evolution with Direct Current Density on Electrodeposited Copper Films. Microsc. Microanal. 2015, 21, 45–46. [Google Scholar] [CrossRef] [PubMed]
- Chandrasekar, M.S.; Pushpavanam, M. Pulse and pulse reverse plating—Conceptual, advantages and applications. Electrochim. Acta 2008, 53, 3313–3322. [Google Scholar] [CrossRef]






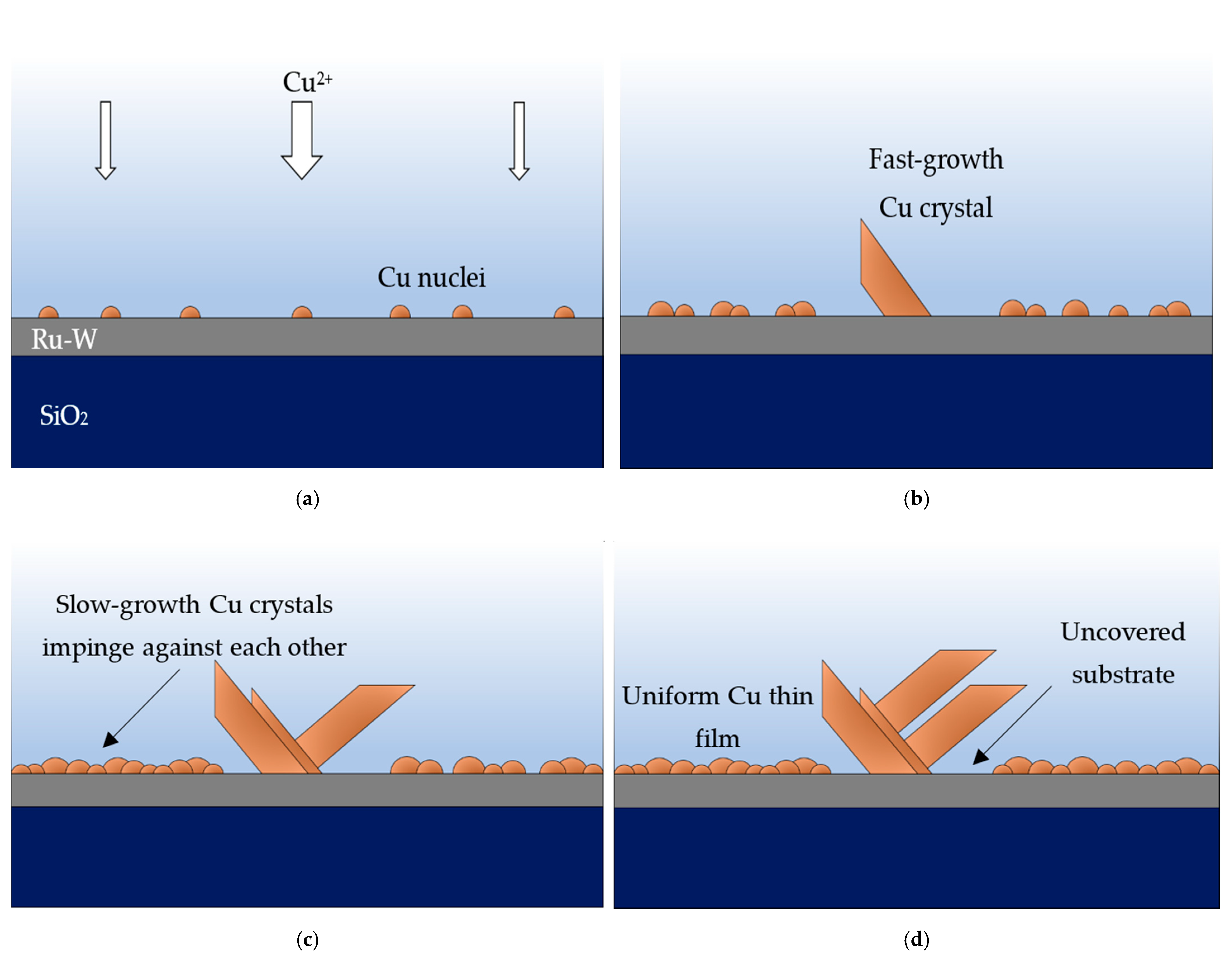





| Condition | mA·cm−2 | s | mC | mA·cm−2 | mA·cm−2 | ms | ms |
|---|---|---|---|---|---|---|---|
| DC-2 | 2 | 150 | 300 | - | - | - | - |
| DC-5 | 5 | 60 | 300 | - | - | - | - |
| DC-10 | 10 | 30 | 300 | - | - | - | - |
| PRC-5 | 3 | 100 | 300 | 5 | 5 | 20 | 5 |
| PRC-10 | 6 | 50 | 300 | 10 | 10 | 20 | 5 |
| PRC-20 | 12 | 25 | 300 | 20 | 20 | 20 | 5 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Santos, R.F.; Oliveira, B.M.C.; Savaris, L.C.G.; Ferreira, P.J.; Vieira, M.F. Seedless Cu Electroplating on Ru-W Thin Films for Metallisation of Advanced Interconnects. Int. J. Mol. Sci. 2022, 23, 1891. https://doi.org/10.3390/ijms23031891
Santos RF, Oliveira BMC, Savaris LCG, Ferreira PJ, Vieira MF. Seedless Cu Electroplating on Ru-W Thin Films for Metallisation of Advanced Interconnects. International Journal of Molecular Sciences. 2022; 23(3):1891. https://doi.org/10.3390/ijms23031891
Chicago/Turabian StyleSantos, Rúben F., Bruno M. C. Oliveira, Liliane C. G. Savaris, Paulo J. Ferreira, and Manuel F. Vieira. 2022. "Seedless Cu Electroplating on Ru-W Thin Films for Metallisation of Advanced Interconnects" International Journal of Molecular Sciences 23, no. 3: 1891. https://doi.org/10.3390/ijms23031891







