Modeling and Analysis of a SiC Microstructure-Based Capacitive Micro-Accelerometer
Abstract
1. Introduction
2. Working Principles
2.1. Design of a Comb-Type Capacitive Accelerometer
2.2. Modeling of the Capacitive Accelerometer
2.3. Parameter Setting of the Capacitive Accelerometer
3. Structural Design and Optimization
3.1. Modal Analysis
3.1.1. Modal Analysis of the Micro-Accelerometer
3.1.2. Optimization of the Structural Parameters
3.1.3. Modal Comparison between the SiC-Based Structure and the Si-Based Structure
3.2. Dynamic Characteristic Analysis
3.2.1. Squeeze-Film Air Damping
3.2.2. Analysis in the Frequency Domain
3.2.3. Analysis in the Time Domain
4. Performance Characterization
4.1. Scale Range
4.2. Sensitivity
4.3. High-Temperature Performances
5. Discussion
6. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- He, D. Testing Research of Pendulous Integrating Gyro Accelerometer on Low-Frequency Linear Vibrator. Ph.D. Thesis, The First Academy of China Aerospace Science and Technology Corporation, Beijing, China, 2019. [Google Scholar]
- Haeussermann, W.; Mueller, F.; Hopkins, R. The pendulous integrating gyroscope accelerometer (PIGA) from the V-2 to trident D5, the strategic instrument of choice. In AIAA Guidance, Navigation, and Control Conference and Exhibit; American Institute of Aeronautics and Astronautics: Reston, VA, USA, 2001. [Google Scholar]
- Keating, G.M.; Bougher, S.W.; Zurek, R.W.; Tolson, R.H.; Cancro, G.J.; Noll, S.N.; Parker, J.S.; Schellenberg, T.J.; Shane, R.W.; Wilkerson, B.L.; et al. The structure of the upper atmosphere of Mars: In Situ accelerometer measurements from Mars global surveyor. Science 1998, 279, 1672–1676. [Google Scholar] [CrossRef]
- Bacon, B.; Ostroff, A.; Joshi, S. Reconfigurable NDI controller using inertial sensor failure detection & isolation. IEEE Trans. Aerosp. Electron. Syst. 2001, 37, 1373–1383. [Google Scholar] [CrossRef]
- Wang, C.; Chen, F.; Wang, Y.; Sadeghpour, S.; Wang, C.; Baijot, M.; Esteves, R.; Zhao, C.; Bai, J.; Liu, H.; et al. Micromachined accelerometers with sub-μg/√Hz noise floor: A review. Sensors 2020, 20, 4054. [Google Scholar] [CrossRef]
- Lowrie, C.; Desmulliez, M.P.; Hoff, L.; Elle, O.J.; Fosse, E. Fabrication of a MEMS accelerometer to detect heart bypass surgery complications. Sens. Rev. 2009, 29, 319–325. [Google Scholar] [CrossRef]
- Wang, C.-K.; Chen, C.-S.; Wen, K.-A. A monolithic CMOS MEMS accelerometer with chopper correlated double sampling readout circuit. In Proceedings of the 2011 IEEE International Symposium of Circuits and Systems (ISCAS), Rio de Janeiro, Brazil, 15–18 May 2011; pp. 2023–2026. [Google Scholar]
- Li, Z.; Yang, W.; Xiong, X.; Wang, Z.; Zou, X. Viaxl: A solution of a low-cost real-time visual accelerometer based on laser speckle optical flow detection. Sensors 2020, 20, 7033. [Google Scholar] [CrossRef] [PubMed]
- Barlian, A.A.; Park, W.-T.; Mallon, J.R.; Rastegar, A.J.; Pruitt, B.L. Review: Semiconductor piezoresistance for microsystems. Proc. IEEE 2009, 97, 513–552. [Google Scholar] [CrossRef]
- Zhang, G.J.; Xu, J.; Li, J.; Wang, X.Y.; Zhang, W.D. Design of double t-shape accelerometer based on MEMS. In Proceedings of the 2nd International Conference on Material and Manufacturing Technology (ICMMT 2011) Progress Meeting of the Royal-Society-of-Tropical-Medicine-and-Hygiene’s Annual Research, Xiamen, China, 8–10 July 2011. [Google Scholar]
- Culhane, K.M.; O’Connor, M.; Lyons, D.; Lyons, G.M. Accelerometers in rehabilitation medicine for older adults. Age Ageing 2005, 34, 556–560. [Google Scholar] [CrossRef]
- Chang, H.; Xie, J.; Fu, Q.; Shen, Q.; Yuan, W. Micromachined inertial measurement unit fabricated by a SOI process with selective roughening under structures. Micro Nano Lett. 2011, 6, 486–489. [Google Scholar] [CrossRef]
- Chen, L.; Li, L.; Zhan, L.; Chen, Q.; He, X.; Yu, H.; Zhou, W. Investigation of drift phenomena in closed-loop capacitive micro accelerometers. J. Micromechanics Microengineering 2020, 30, 095009. [Google Scholar] [CrossRef]
- Liu, S.Q.; Zhang, J.C.; Zhu, R. A Wearable human motion tracking device using micro flow sensor incorporating a micro accelerometer. IEEE Trans. Biomed. Eng. 2020, 67, 940–948. [Google Scholar] [CrossRef]
- Roylance, L.; Angell, J. A batch-fabricated silicon accelerometer. IEEE Trans. Electron Devices 1979, 26, 1911–1917. [Google Scholar] [CrossRef]
- Dong, J. Introduction. In Inertial Instruments: Micromachined Accelerometer; Tsinghua University Press: Beijing, China, 2003; pp. 1–20. [Google Scholar]
- Edmonds, L.; Swift, G.; Lee, C. Radiation response of a MEMS accelerometer: An electrostatic force. IEEE Trans. Nucl. Sci. 1998, 45, 2779–2788. [Google Scholar] [CrossRef]
- Seo, A.; Uda, S. Trunk rotation monitor using angular velocity sensors. Ind. Health 1997, 35, 222–228. [Google Scholar] [CrossRef]
- Tosserams, S.; Etman, L.F.P.; Rooda, J.E. A micro-accelerometer MDO benchmark problem. Struct. Multidiscip. Optim. 2010, 41, 255–275. [Google Scholar] [CrossRef][Green Version]
- Zhang, H.; Wang, Y.; Wang, Y.; Soon, P.L. Design and realization of two-wheel micro-mouse diagonal dashing. J. Intell. Fuzzy Syst. 2016, 31, 2299–2306. [Google Scholar] [CrossRef]
- Warren, K. Electrostatically force-balanced silicon accelerometer. Navig. J. Inst. Navig. 1991, 38, 91–99. [Google Scholar] [CrossRef]
- Wang, Y.; Zhao, X.; Wen, D. Fabrication and characteristics of a three-axis accelerometer with double L-shaped beams. Sensors 2020, 20, 1780. [Google Scholar] [CrossRef] [PubMed]
- Chen, Z.-H.; Li, C.-Y.; Chu, S.-Y.; Tsai, C.-C.; Wang, Y.-H.; Kao, H.-Y.; Wei, C.-L.; Huang, Y.-H.; Hsiao, P.-Y.; Liu, Y.-H. The design of aluminum nitride-based lead-free piezoelectric MEMS accelerometer system. IEEE Trans. Electron Devices 2020, 67, 4399–4404. [Google Scholar] [CrossRef]
- Zhang, H.; Chen, D.; Pandit, M.; Sun, J.; Zhao, C.; Seshia, A. Amplitude-modulated resonant accelerometer employing parametric pump. Appl. Phys. Lett. 2020, 117, 163504. [Google Scholar] [CrossRef]
- Chen, D.; Yin, L.; Fu, Q.; Zhang, Y.; Liu, X. Measuring and calibrating of the parasitic mismatch in MEMS accelerometer based on harmonic distortion self-test. Sens. Actuators A Phys. 2020, 313, 112159. [Google Scholar] [CrossRef]
- Song, X.; Liu, H.; Fang, Y.; Zhao, C.; Qu, Z.; Wang, Q.; Tu, L.-C. An integrated gold-film temperature sensor for In Situ temperature measurement of a high-precision MEMS accelerometer. Sensors 2020, 20, 3652. [Google Scholar] [CrossRef] [PubMed]
- Solai, K.; Rathnasami, J.D.; Koilmani, S. Superior performance area changing capacitive MEMS accelerometer employing additional lateral springs for low frequency applications. Microsyst. Technol. 2020, 26, 2353–2370. [Google Scholar] [CrossRef]
- Tavakoli, H.; Momen, H.G.; Sani, E.A. Designing a new high performance 3-axis MEMS capacitive accelerometer. In Proceedings of the 2017 Iranian Conference on Electrical Engineering (ICEE), Tehran, Iran, 2–4 May 2017; pp. 519–522. [Google Scholar]
- Momen, H.G.; Tavakoli, H.; Sani, E.A. A 3-axis MEMS capacitive accelerometer free of cross axis sensitivity. In Proceedings of the 2016 24th Iranian Conference on Electrical Engineering (ICEE), Shiraz, Iran, 10–12 May 2016; pp. 1491–1494. [Google Scholar]
- Xiao, D.B.; Li, Q.S.; Hou, Z.Q.; Wang, X.H.; Chen, Z.H.; Xia, D.W.; Wu, X.Z. A novel sandwich differential capacitive accelerometer with symmetrical double-sided serpentine beam-mass structure. J. Micromechanics Microengineering 2015, 26, 025005. [Google Scholar] [CrossRef]
- Nguyen, T.; Phan, H.-P.; Dowling, K.M.; Yalamarthy, A.S.; Dinh, T.; Balakrishnan, V.; Liu, T.; Chapin, C.A.; Truong, Q.-D.; Dau, V.T.; et al. Lithography and etching-free microfabrication of silicon carbide on insulator using direct UV laser ablation. Adv. Eng. Mater. 2020, 22, 1901173. [Google Scholar] [CrossRef]
- Middelburg, L.; Van Zeijl, H.; Vollebregt, S.; Morana, B.; Zhang, G. Toward a self-sensing piezoresistive pressure sensor for all-sic monolithic integration. IEEE Sens. J. 2020, 20, 1. [Google Scholar] [CrossRef]
- Fraga, M.; Pessoa, R. Progresses in synthesis and application of SiC films: From CVD to ALD and from MEMS to NEMS. Micromachines 2020, 11, 799. [Google Scholar] [CrossRef] [PubMed]
- Wu, C.; Fang, X.; Liu, F.; Guo, X.; Maeda, R.; Jiang, Z. High speed and low roughness micromachining of silicon carbide by plasma etching aided femtosecond laser processing. Ceram. Int. 2020, 46, 17896–17902. [Google Scholar] [CrossRef]
- Wu, C.; Fang, X.; Guo, X.; Zhao, L.; Tian, B.; Jiang, Z. Optimal design of SiC piezoresistive pressure sensor considering material anisotropy. Rev. Sci. Instrum. 2020, 91, 015004. [Google Scholar] [CrossRef]
- Yonenaga, I.; Suzuki, T. Indentation hardnesses of semiconductors and a scaling rule. Philos. Mag. Lett. 2002, 82, 535–542. [Google Scholar] [CrossRef]
- Yu, X.; Wang, Q.; Nagasawa, H.; Kanezashi, M.; Tsuru, T. SiC mesoporous membranes for sulfuric acid decomposition at high temperatures in the iodine-sulfur process. RSC Adv. 2020, 10, 41883–41890. [Google Scholar] [CrossRef]
- Sarro, P.M. Silicon carbide as a new MEMS technology. Sens. Actuators A Phys. 2000, 82, 210–218. [Google Scholar] [CrossRef]
- Lagosh, A.V.; Korlyakov, A.V. Design and technology optimization of SiC-based RF MEMS switch. In Proceedings of the 4th International School and Conference on Optoelectronics, Photonics, Engineering and Nanostructures, Saint Petersburg, Russia, 3–6 April 2017. [Google Scholar]
- Sugiura, T.; Takahashi, N.; Nakano, N. The piezoresistive mobility modeling for cubic and hexagonal silicon carbide crystals. J. Appl. Phys. 2020, 127, 245113. [Google Scholar] [CrossRef]
- Senesky, D.G. Wide bandgap semiconductors for sensing within extreme harsh environments. ECS Trans. 2012, 50, 233–238. [Google Scholar] [CrossRef]
- Teker, K.; Ali, Y.A.; Uzun, A. UV-induced photosensing characteristics of SiC and GaN nanowires. Sens. Rev. 2019, 39, 488–494. [Google Scholar] [CrossRef]
- Sankar, A.R.; Bindu, V.S.S.; Das, S. Coupled effects of gold electroplating and electrochemical discharge machining processes on the performance improvement of a capacitive accelerometer. Microsyst. Technol. 2011, 17, 1661–1670. [Google Scholar] [CrossRef]
- Han, K.-H.; Cho, Y.-H. Self-balanced navigation-grade capacitive microaccelerometers using branched finger electrodes and their performance for varying sense voltage and pressure. J. Microelectromechanical Syst. 2003, 12, 11–20. [Google Scholar] [CrossRef]
- Benmessaoud, M.; Nasreddine, M.M. Optimization of MEMS capacitive accelerometer. Microsyst. Technol. 2013, 19, 713–720. [Google Scholar] [CrossRef]
- Tian, X.; Sheng, W.; Tian, F.; Lu, Y.; Wang, L. Simulation study on squeeze film air damping. Micro Nano Lett. 2020, 15, 576–581. [Google Scholar] [CrossRef]
- Bao, M.; Yang, H. Squeeze film air damping in MEMS. Sens. Actuators A Phys. 2007, 136, 3–27. [Google Scholar] [CrossRef]
- Wang, S.B. Research of Young’s Modulus and Damping Mechanism of SiC/Al Composites. Master’s Thesis, Southwest University, Chongqing, China, 2009. [Google Scholar]
- Shi, G.C. MEMS materials. In Micro Electro Mechanical Systems; National Defense Industry Press: Beijing, China, 2002; pp. 10–23. [Google Scholar]
- Munro, R.G. Material properties of a sintered α-SiC. J. Phys. Chem. Ref. Data 1997, 26, 1195–1203. [Google Scholar] [CrossRef]



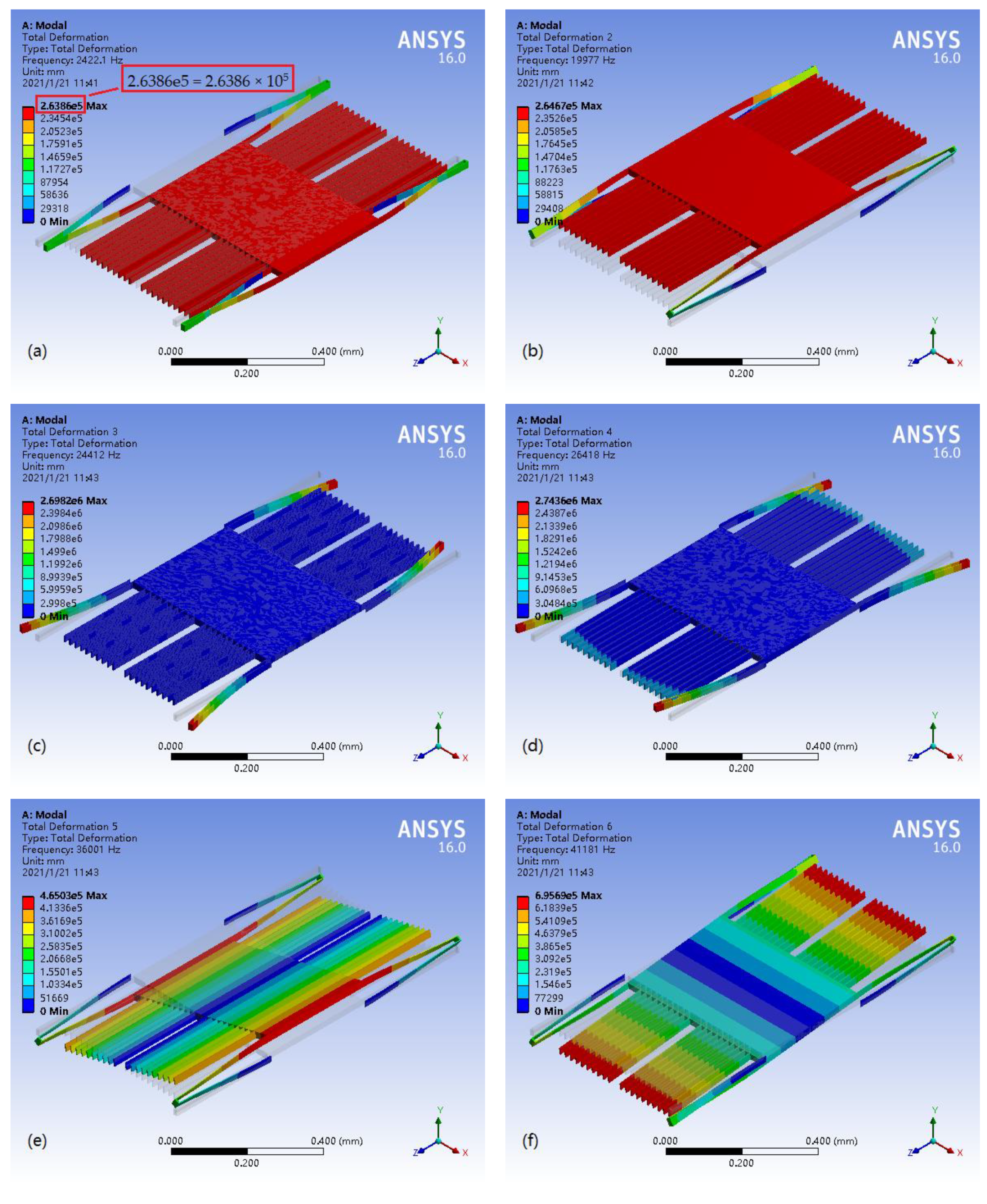



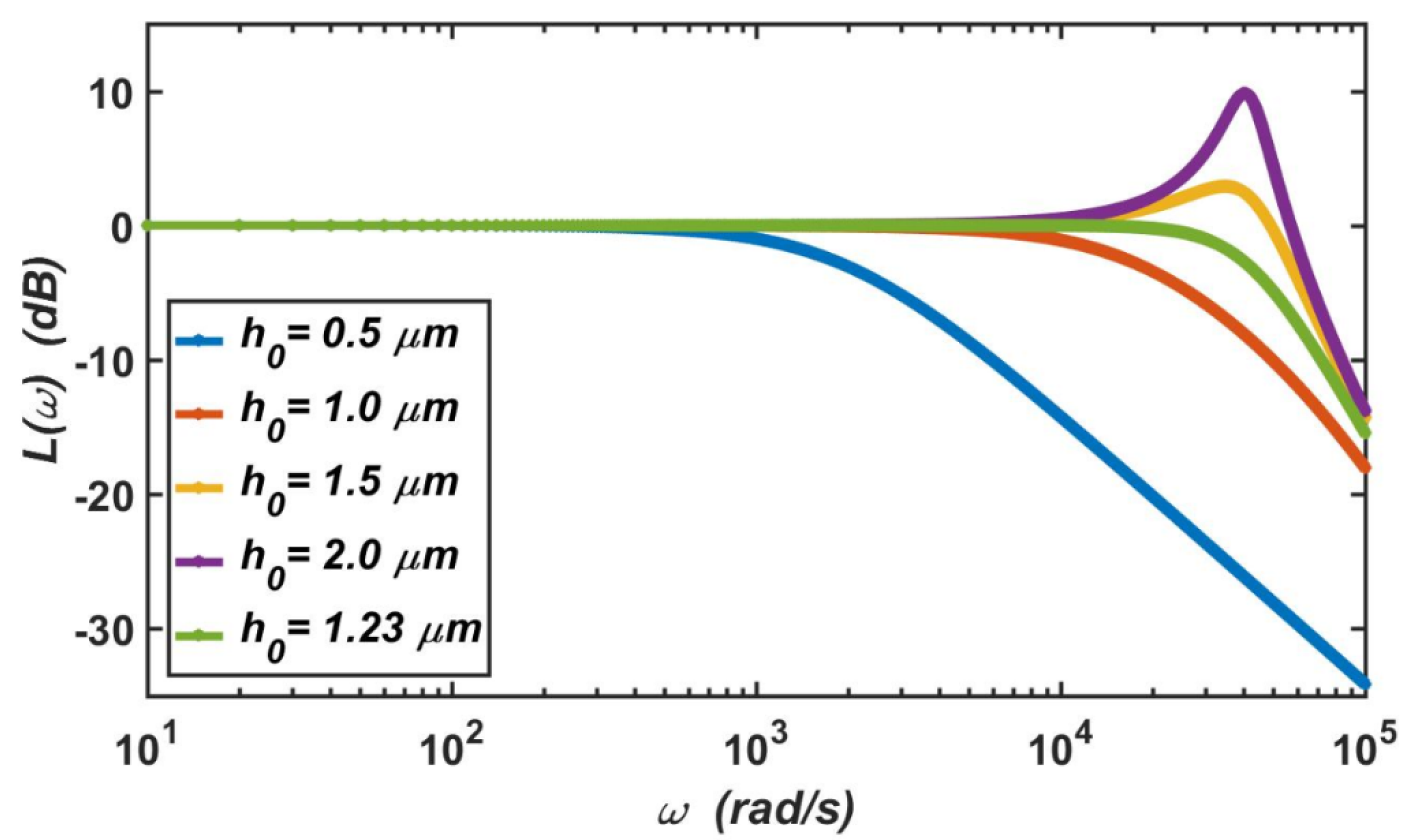







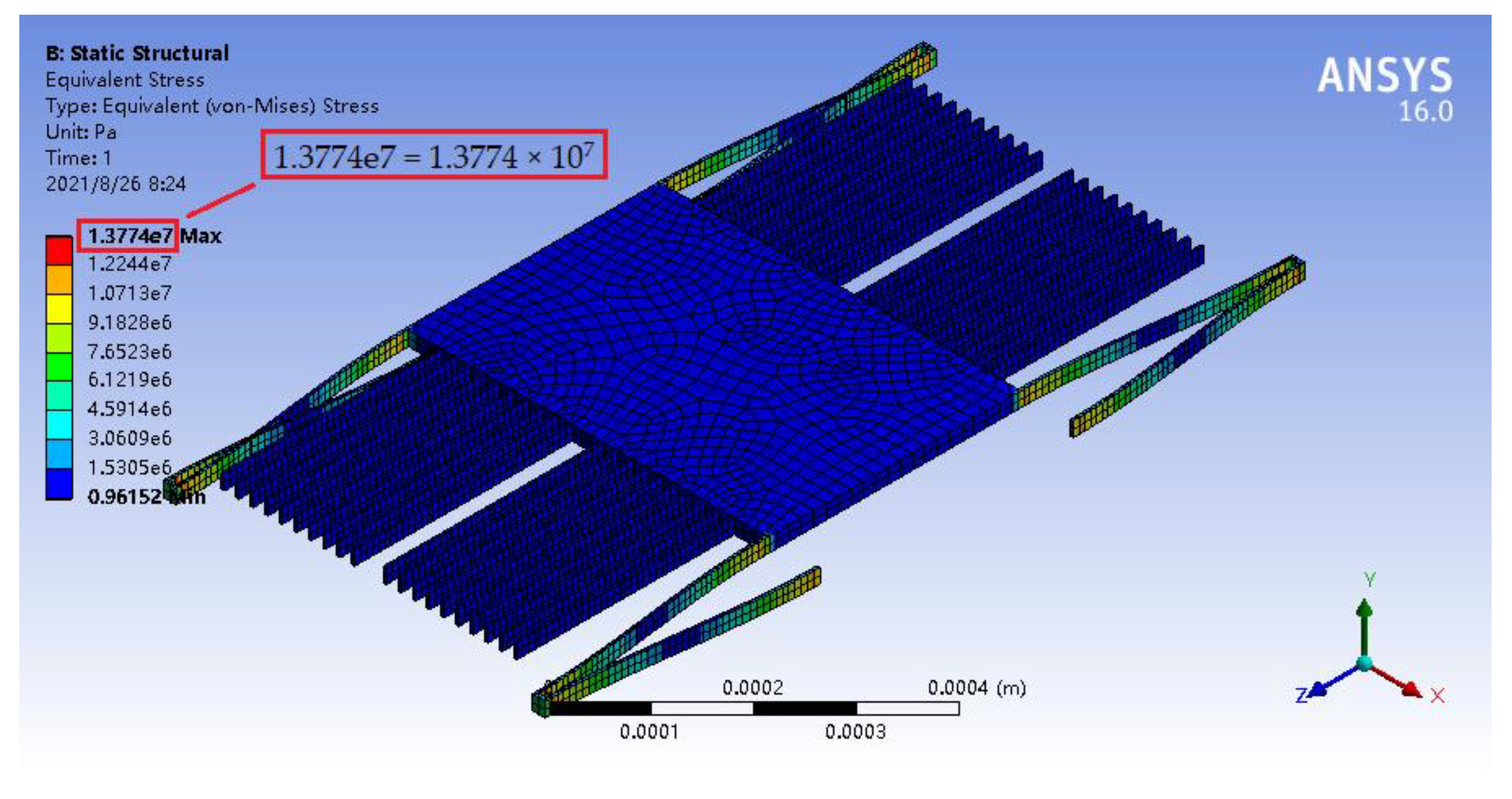

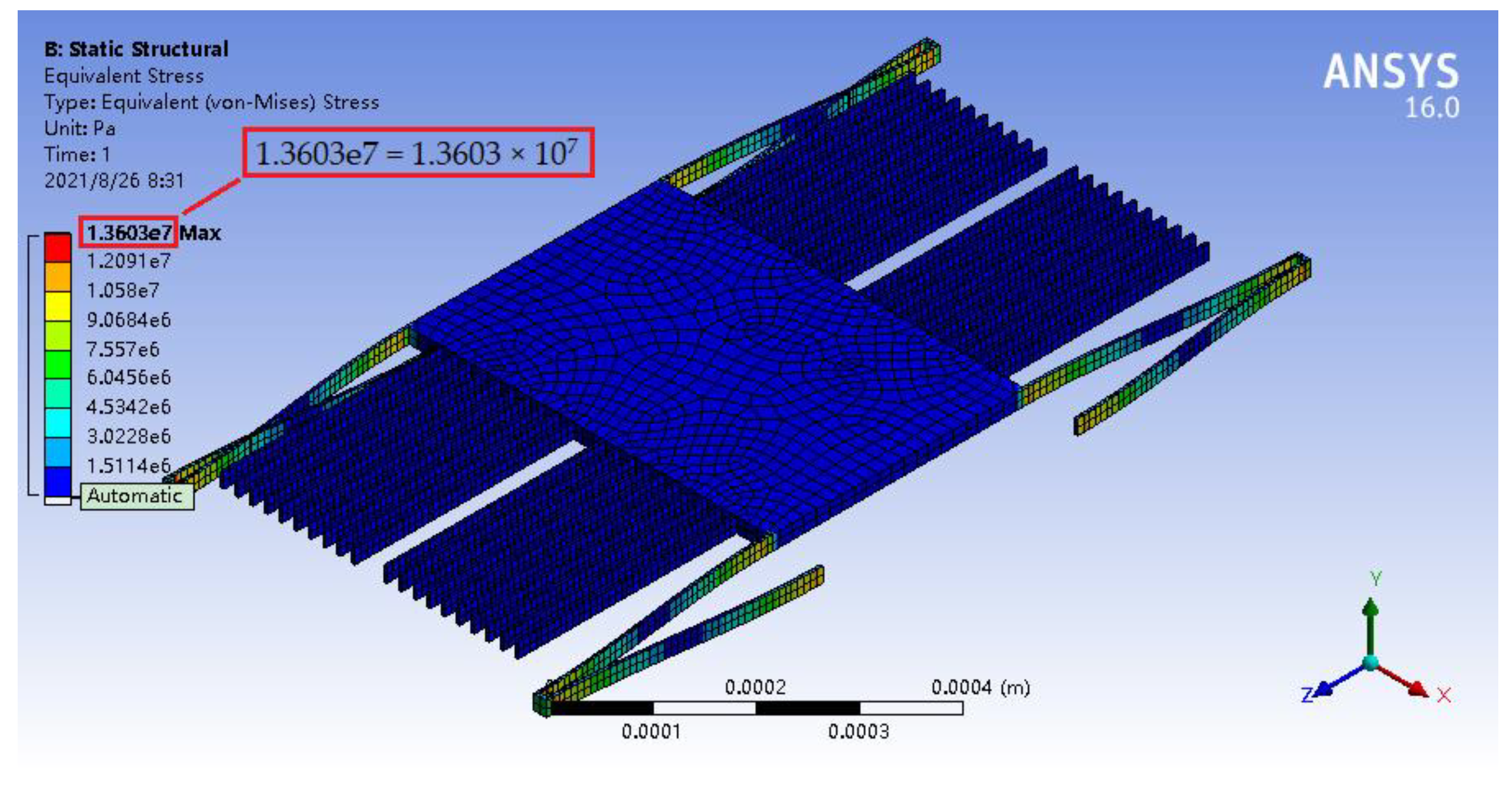
| Accelerometer | Length (μm) | Width (μm) | Thickness (μm) |
|---|---|---|---|
| Mass block | 500 | 350 | 20 |
| Movable electrode plates | 300 | 4 | 20 |
| Fixed electrode plates | 300 | 4 | 20 |
| Folded support beams | 350 | 2 | 20 |
| External Acceleration | Displacement |
|---|---|
| 10 g | 5.5947 × 10−2 μm |
| 20 g | 1.1189 × 10−1 μm |
| 30 g | 1.6784 × 10−1 μm |
| 40 g | 2.2379 × 10−1 μm |
| 50 g | 2.7973 × 10−1 μm |
| 60 g | 3.3568 × 10−1 μm |
| 70 g | 3.9163 × 10−1 μm |
| 80 g | 4.4757 × 10−1 μm |
| 90 g | 5.0352 × 10−1 μm |
| 100 g | 5.5947 × 10−1 μm |
| Property | 500 °C | 1000 °C | 1200 °C |
|---|---|---|---|
| Density (g/cm3) | 3.14 | 3.11 | 3.10 |
| Elastic modulus (GPa) | 404 | 392 | 387 |
| Poisson’s ratio | 0.159 | 0.157 | 0.157 |
| Flexural strength (MPa) | 359 | 397 | 437 |
| Thermal expansion coefficient (10−6 K−1) | 4.4 | 5 | 5.2 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Tian, X.; Sheng, W.; Guo, Z.; Xing, W.; Tang, R. Modeling and Analysis of a SiC Microstructure-Based Capacitive Micro-Accelerometer. Materials 2021, 14, 6222. https://doi.org/10.3390/ma14206222
Tian X, Sheng W, Guo Z, Xing W, Tang R. Modeling and Analysis of a SiC Microstructure-Based Capacitive Micro-Accelerometer. Materials. 2021; 14(20):6222. https://doi.org/10.3390/ma14206222
Chicago/Turabian StyleTian, Xiang, Wei Sheng, Zhanshe Guo, Weiwei Xing, and Runze Tang. 2021. "Modeling and Analysis of a SiC Microstructure-Based Capacitive Micro-Accelerometer" Materials 14, no. 20: 6222. https://doi.org/10.3390/ma14206222
APA StyleTian, X., Sheng, W., Guo, Z., Xing, W., & Tang, R. (2021). Modeling and Analysis of a SiC Microstructure-Based Capacitive Micro-Accelerometer. Materials, 14(20), 6222. https://doi.org/10.3390/ma14206222






