Growth of Pseudomorphic GeSn at Low Pressure with Sn Composition of 16.7%
Abstract
:1. Introduction
2. Experimental Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Wirths, S.; Buca, D.; Mantl, S. Si–Ge–Sn alloys: From growth to applications. Prog. Cryst. Growth Charact. Mater. 2016, 62, 1–39. [Google Scholar] [CrossRef]
- Kouvetakis, J.; Chizmeshya, A.V.G. New classes of Si-based photonic materials and device architectures via designer molecular routes. J. Mater. Chem. 2007, 17, 1649. [Google Scholar] [CrossRef]
- Soref, R. Mid-infrared photonics in silicon and germanium. Nat. Photonics 2010, 4, 495–497. [Google Scholar] [CrossRef]
- Ghetmiri, S.A.; Du, W.; Margetis, J.; Mosleh, A.; Cousar, L.; Conley, B.R.; Domulevicz, L.; Nazzal, A.; Sun, G.; Soref, R.; et al. Direct-bandgap GeSn grown on Silicon with 2230 nm photoluminescence. Appl. Phys. Lett. 2014, 105, 151109. [Google Scholar] [CrossRef]
- Wirths, S.; Geiger, R.; von den Driesch, N.; Mussler, G.; Stoica, T.; Mantl, S.; Ikonic, Z.; Luysberg, M.; Chiussi, S.; Hartmann, J.M.; et al. Lasing in direct-bandgap GeSn alloy grown on Si. Nat. Photon. 2015, 9, 88–92. [Google Scholar] [CrossRef] [Green Version]
- Margetis, J.; Al-Kabi, S.; Du, W.; Dou, W.; Zhou, Y.; Pham, T.; Grant, P.; Ghetmiri, S.; Mosleh, A.; Li, B.; et al. Si-based GeSn lasers with wavelength coverage of 2–3 μm and operating temperatures up to 180 K. ACS Photonics 2017, 5, 827–833. [Google Scholar] [CrossRef]
- Stange, D.; von den Driesch, N.; Zabel, T.; Armand-Pilon, F.; Rainko, D.; Marzban, B.; Zaumseil, P.; Hartmann, J.M.; Ikonic, Z.; Capellini, G.; et al. GeSn/SiGeSn Heterostructure and Multi Quantum Well Lasers. ACS Photonics 2018, 5, 4628–4636. [Google Scholar] [CrossRef] [Green Version]
- Zhou, Y.; Miao, Y.; Ojo, S.; Tran, H.; Abernathy, G.; Grant, J.M.; Amoah, S.; Salamo, G.; Du, W.; Liu, J.; et al. Electrically injected GeSn lasers on Si operating up to 100 K. Optica 2020, 7, 924–928. [Google Scholar] [CrossRef]
- Chrétien, J.; Pauc, N.; Armand-Pilon, F.; Bertrand, M.; Thai, Q.-M.; Casiez, L.; Bernier, N.; Dansas, H.; Gergaud, P.; Delamadeleine, E.; et al. GeSn Lasers Covering a Wide Wavelength Range Thanks to Uniaxial Tensile Strain. ACS Photonics 2019, 6, 2462–2469. [Google Scholar] [CrossRef]
- Zhou, Y.; Dou, W.; Du, W.; Pham, T.; Ghetmiri, S.; Al-Kabi, S.; Mosleh, A.; Alher, M.; Margetis, J.; Tolle, J.; et al. Systematic study of GeSn heterostructure-based light-emitting diodes towards mid-infrared applications. J. Appl. Phys. 2016, 120, 023102. [Google Scholar] [CrossRef]
- Tran, H.; Pham, T.; Margetis, J.; Zhou, Y.; Dou, W.; Grant, P.C.; Grant, J.M.; Al-kabi, S.; Du, W.; Sun, G.; et al. Si-based GeSn photodetectors towards mid-infrared imaging applications. ACS Photonics 2019, 6, 2807–2815. [Google Scholar] [CrossRef] [Green Version]
- Wang, W.; Dong, Y.; Lee, S.-Y.; Loke, W.-K.; Lei, D.; Yoon, S.-F.; Liang, G.; Gong, X.; Yeo, Y.-C. Floating-base germanium-tin heterojunction phototransistor for high-efficiency photodetection in short-wave infrared range. Opt. Express 2017, 25, 18502. [Google Scholar] [CrossRef]
- Soref, R.; Buca, D.; Yu, S.-Q. Group IV Photonics: Driving Integrated Optoelectronics. Opt. Photonics News 2016, 27, 32–39. [Google Scholar] [CrossRef]
- Wang, X.; Liu, J. Emerging technologies in Si active photonics. J. Semicond. 2018, 39, 061001. [Google Scholar] [CrossRef]
- Zheng, J.; Liu, Z.; Xue, C.; Li, C.; Zuo, Y.; Cheng, B.; Wang, Q. Recent progress in GeSn growth and GeSn-based photonic devices. J. Semicond. 2018, 39, 061006. [Google Scholar] [CrossRef]
- Lin, H.; Chen, R.; Lu, W.; Huo, Y.; Kamins, T.I.; Harris, J.S. Structural and optical characterization of SixGe1−x−ySny alloys grown by molecular beam epitaxy. Appl. Phys. Lett. 2012, 99, 141908. [Google Scholar] [CrossRef]
- Kasper, E.; Werner, J.; Oehme, M.; Escoubas, S.; Burle, N.; Schulze, J. Growth of silicon based germanium tin alloys. Thin Solid Films 2012, 520, 3195. [Google Scholar] [CrossRef]
- Kim, S.; Bhargava, N.; Gupta, J.; Coppinger, M.; Kolodzey, J. Infrared photoresponse of GeSn/n-Ge heterojunctions grown by molecular beam epitaxy. Opt. Express 2014, 22, 11029–11034. [Google Scholar] [CrossRef]
- Taraci, J.; Zollner, S.; McCartney, M.R.; Menendez, J.; Santana-Aranda, M.A.; Smith, D.J.; Haaland, A.; Tutukin, A.V.; Gundersen, G.; Wolf, G.; et al. Synthesis of silicon-based infrared semiconductors in the Ge-Sn system using molecular chemistry methods. J. Am. Chem. Soc. 2001, 123, 10980. [Google Scholar] [CrossRef]
- Margetis, J.; Mosleh, A.; Al-Kabi, S.; Ghetmiri, S.A.; Du, W.; Dou, W.; Benamara, M.; Li, B.; Mortazavi, M.; Naseem, H.A.; et al. Study of low-defect and strain-relaxed GeSn growth via reduced pressure CVD in H2 and N2 carrier gas. J. Cryst. Growth 2017, 463, 128. [Google Scholar] [CrossRef]
- Wirths, S.; Buca, D.; Tiedemann, A.T.; Hollander, B.; Bernardy, P.; Stoica, T.; Grutzmacher, D.; Mantl, S. Reduced Pressure CVD Epitaxial Growth of Ge1-xSnx Using SnCl4 and Ge2H6. Meeting Abstracts (Electrochemical Society). In Proceedings of the ECS PRiME, Honolulu, HI, USA, 11 October 2012. Abstract Number 3214. [Google Scholar]
- Senaratne, C.L.; Gallagher, J.D.; Jiang, L.; Aoki, T.; Smith, D.J.; Menendez, J.; Kouvetakis, J. Ge1-ySny (y = 0.01-0.10) alloys on Ge-buffered Si: Synthesis, microstructure, and optical properties. J. Appl. Phys. 2014, 116, 133509. [Google Scholar] [CrossRef]
- Beeler, R.T.; Grzybowski, G.J.; Roucka, R.; Jiang, L.; Mathews, J.; Smith, D.J.; Menendez, J.; Chizmeshya, A.V.G.; Kouvetakis, J. Synthesis and Materials Properties of Sn/P-Doped Ge on Si(100): Photoluminescence and Prototype Devices. Chem. Mater. 2011, 23, 4480–4486. [Google Scholar] [CrossRef]
- Margetis, J.; Yu, S.-Q.; Bhargava, N.; Li, B.; Du, W.; Tolle, J. Strain engineering in epitaxial Ge1−xSnx: A path towards low-defect and high Sn-content layers. Semicond. Sci. Technol. 2017, 32. [Google Scholar] [CrossRef]
- Grant, P.C. GeSn Thin Film Epitaxy and Quantum Wells for Optoelectronic Devices. Ph.D. Dissertation, University of Arkansas, Fayetteville, AR, USA, December 2018. [Google Scholar]
- Assali, S.; Attiaoui, A.; Atalla, M.R.M.; Dijkstra, A.; Kumar, A.; Mukherjee, S.; Abdi, S.; Moutanabbir, O. Epitaxial GeSn and its integration in MIR optoelectronics. In Proceedings of the 2020 Conference on Lasers and Electro-Optics (CLEO), San Jose, CA, USA, 10–15 May 2020. [Google Scholar]
- Kim, Y.; Assali, S.; Burt, D.; Jung, Y.; Joo, H.-J.; Chen, M.; Ikonic, Z.; Moutanabbir, O.; Nam, D. Enhanced GeSn Microdisk Lasers Directly Released on Si. arXiv 2106, arXiv:08874.2021. [Google Scholar] [CrossRef]
- Margetis, J. RPCVD Growth of Epitaxial Si-Ge-Sn Alloys for Optoelectronics Applications. Ph.D. Dissertation, Arizona State University, Phoenix, AR, USA, January 2018. [Google Scholar]
- Wirths, S.; Buca, D.; Mussler, G.; Tiedemann, A.T.; Holländer, B.; Bernard, P.; Stoica, T.; Grützmacher, D.; Mantl, S. Reduced Pressure CVD Growth of Ge and Ge 1−x Sn x Alloys. ECS J. Solid State Sci. Technol. 2013, 2, 99–102. [Google Scholar] [CrossRef]
- Von Den Driesch, N.; Stange, D.; Wirths, S.; Mussler, G.; Holländer, B.; Ikonic, Z.; Hartmann, J.M.; Stoica, T.; Mantl, S.; Grützmacher, D.; et al. Direct Bandgap Group IV Epitaxy on Si for Laser Applications. Chem. Mater. 2015, 27, 4693–4702. [Google Scholar] [CrossRef] [Green Version]
- Loo, R.; Shimura, Y.; Ike, S.; Vohra, A.; Stoica, T.; Stange, D.; Buca, D.; Kohen, D.; Margetis, J.; Tolle, J. Epitaxial GeSn: Impact of process conditions on material quality. Semicond. Sci. Technol. 2018, 33, 114010. [Google Scholar] [CrossRef]
- Aubin, J.; Hartmann, J.M.; Gassenq, A.; Milord, L.; Pauc, N.; Reboud, V.; Calvo, V. Impact of thickness on the structural properties of high tin content GeSn layers. J. Cryst. Growth 2017, 473, 20–27. [Google Scholar] [CrossRef]
- Aubin, J.; Hartmann, J.M.; Gassenq, A.; Rouviere, J.L.; Robin, E.; Delaye, V.; Cooper, D.; Mollard, N.; Reboud, V.; Calvo, V. Growth and structural properties of step-graded, high Sn content GeSn layers on Ge. Semicond. Sci. Technol. 2017, 32, 94006. [Google Scholar] [CrossRef]
- Dou, W.; Alharthi, B.; Grant, P.C.; Grant, J.M.; Mosleh, A.; Tran, H.; Du, W.; Mortazavi, M.; Li, B.; Naseem, H.; et al. Crystalline GeSn growth by plasma enhanced chemical vapor deposition. Opt. Mater. Express 2018, 8, 3220–3229. [Google Scholar] [CrossRef]
- Tran, H.; Du, W.; Ghetmiri, S.A.; Mosleh, A.; Sun, G.; Soref, R.A.; Margetis, J.; Tolle, G.; Li, B.; Yu, S.Q.; et al. Systematic study of Ge1−xSnx absorption coefficient and refractive index for the device applications of Si-based optoelectronics. J. Appl. Phys. 2016, 119, 103106. [Google Scholar] [CrossRef]
- Grant, P.C.; Dou, W.; Alharthi, B.; Grant, J.M.; Tran, H.; Abernathy, G.; Mosleh, A.; Du, W.; Li, B.; Mortazavi, M.; et al. UHV-CVD Growth of High Quality GeSn Using SnCl4: From Growth Optimization to Prototype Devices. Opt. Mater. Express. 2019, 9, 3277–3291. [Google Scholar] [CrossRef]
- Tseng, H.H.; Wu, K.Y.; Li, H.; Mashanov, V.; Cheng, H.H. Mid-infrared electroluminescence from a Ge/Ge0.922Sn0.078/Ge double heterostructure p-i-n diode on a Si substrate. Appl. Phys. Lett. 2013, 102, 182106. [Google Scholar] [CrossRef]
- Kim, H.-W.; Shin, K.W.; Lee, G.-D.; Yoon, E. High quality Ge epitaxial layers on Si by ultrahigh vacuum chemical vapor deposition. Thin Solid Films 2009, 517, 3990–3994. [Google Scholar] [CrossRef]
- Ye, H.; Yu, J. Germanium epitaxy on silicon. Sci. Technol. Adv. Mater. 2014, 15, 024601. [Google Scholar] [CrossRef] [Green Version]


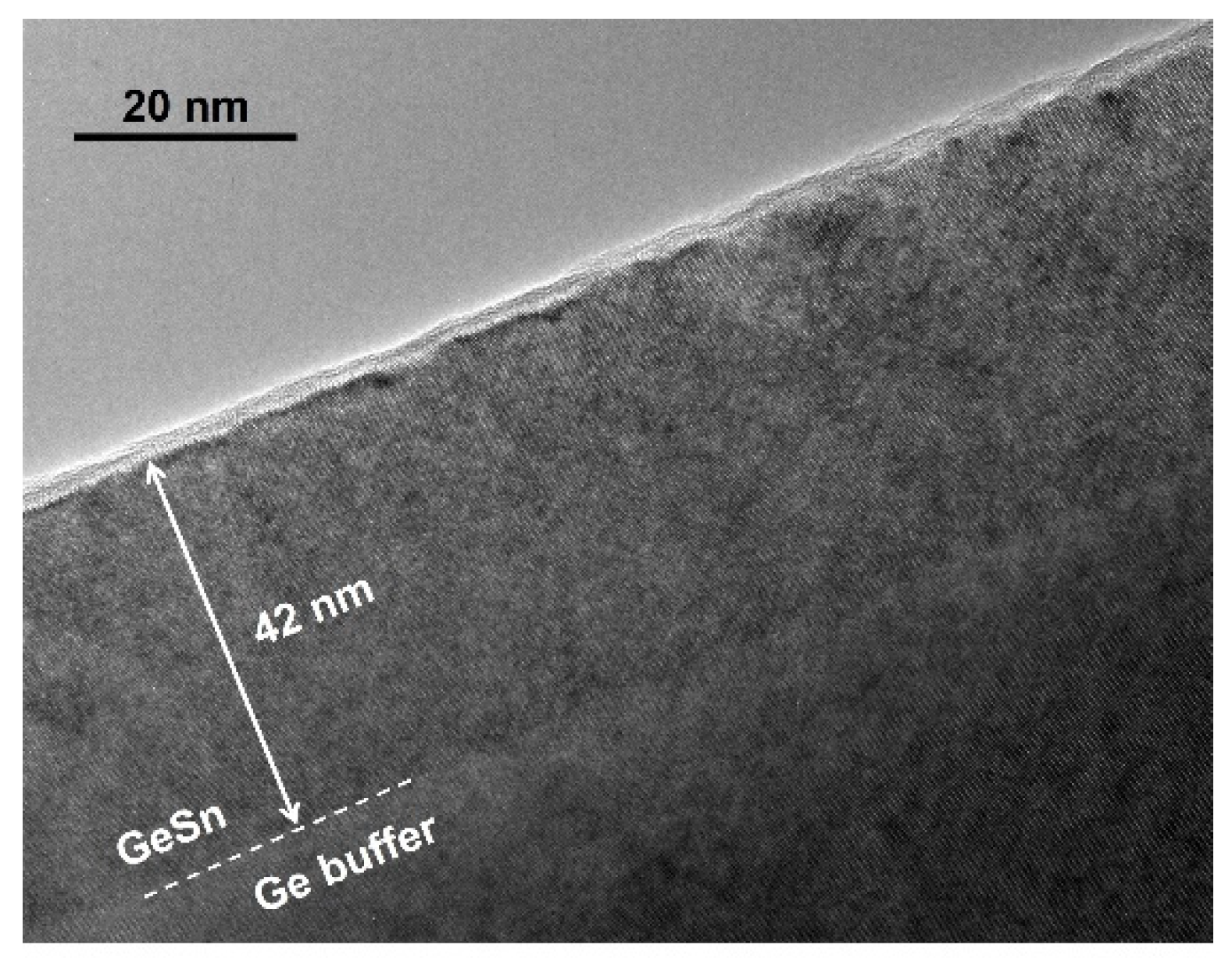


| Ge Precursor | Pressure (Torr) | SnCl4 Flow Ratio | Temperature (°C) 1 | Sn Incorporation | Ref. |
|---|---|---|---|---|---|
| GeH4 | 2 | 0.0025 | 250–270 | 2.1–8.7% | [25] |
| 0.005 | 270 | 6.0% | [25] | ||
| 0.01 | 240–350 | 1.5–7.9% | [25] | ||
| 40 | 0.0085 | 290–350 | 2.5–9.1% | [28] | |
| 0.012 | 290–350 | 3.0–10.0% | [28] | ||
| 50 | 0.0006 | 325–335 | 6.0–7.0% | [27] | |
| 0.0008 | 335 | 5.0% | [27] | ||
| 120 | 0.0007 | 280–320 | 8.0–18.0% | [26] | |
| Ge2H6 | N.A. | 0.0045 | 340–400 | 5.0–14.0% | [30] |
| 45 | 0.01 | 375–475 | 3.5–10.0% | [29] | |
| 100 | 0.02–0.04 | 300 | 9.9–10.6% | [31] | |
| 0.027–0.05 | 320 | 5.8–7.8% | [31] | ||
| 0.0532 | 301–349 | 6.0–15.0% | [32,33] | ||
| 760 | 0.04 | 320 | 6.6% | [31] | |
| This work GeH4 | 12 | 0.0025 | 260 | 16.7% |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Grant, J.; Abernathy, G.; Olorunsola, O.; Ojo, S.; Amoah, S.; Wanglia, E.; Saha, S.K.; Sabbar, A.; Du, W.; Alher, M.; et al. Growth of Pseudomorphic GeSn at Low Pressure with Sn Composition of 16.7%. Materials 2021, 14, 7637. https://doi.org/10.3390/ma14247637
Grant J, Abernathy G, Olorunsola O, Ojo S, Amoah S, Wanglia E, Saha SK, Sabbar A, Du W, Alher M, et al. Growth of Pseudomorphic GeSn at Low Pressure with Sn Composition of 16.7%. Materials. 2021; 14(24):7637. https://doi.org/10.3390/ma14247637
Chicago/Turabian StyleGrant, Joshua, Grey Abernathy, Oluwatobi Olorunsola, Solomon Ojo, Sylvester Amoah, Emmanuel Wanglia, Samir K. Saha, Abbas Sabbar, Wei Du, Murtadha Alher, and et al. 2021. "Growth of Pseudomorphic GeSn at Low Pressure with Sn Composition of 16.7%" Materials 14, no. 24: 7637. https://doi.org/10.3390/ma14247637






