Improved Uniformity of TaOx-Based Resistive Switching Memory Device by Inserting Thin SiO2 Layer for Neuromorphic System
Abstract
:1. Introduction
2. Experiments
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Wang, Z.; Wu, H.; Hwang, C.S.; Wang, K.L.; Xia, Q.; Yang, J.J. Resistive switching materials for information processing. Nat. Rev. Mater. 2020, 5, 173–195. [Google Scholar] [CrossRef]
- Marković, D.; Mizrahi, A.; Querlioz, D.; Grollier, J. Physics for neuromorphic computing. Nat. Rev. Phys. 2020, 2, 499–510. [Google Scholar] [CrossRef]
- Kim, K.M.; Jeong, D.S.; Hwang, C.S. Nanofilamentary resistive switching in binary oxide system; a review on the present status and outlook. Nanotechnology 2011, 22, 254002. [Google Scholar] [CrossRef]
- Jeong, D.S.; Thomas, R.; Katiyar, R.S.; Scott, J.F.; Kohlstedt, H.; Petraru, A.; Hwang, C.S. Emerging memories: Resistive switching mechanisms and current status. Rep. Prog. Phys. 2012, 75, 076502. [Google Scholar] [CrossRef]
- Waser, R.; Aono, M. Nanoionics-based resistive switching memorie. Nat. Mater. 2007, 6, 833–840. [Google Scholar] [CrossRef]
- Pan, F.; Gao, S.; Chen, C.; Song, C.; Zeng, F. Recent progress in resistive random access memories: Materials, switching mechanisms, and performance. Mater. Sci. Eng. R-Rep. 2014, 83, 1–59. [Google Scholar] [CrossRef]
- Lee, Y.; Mahata, C.; Kang, M.; Kim, S. Short-term and long-term synaptic plasticity in Ag/HfO2/SiO2/Si stack by controlling conducting filament strength. Appl. Surf. Sci. 2021, 565, 150563. [Google Scholar] [CrossRef]
- Wang, R.; Yang, J.Q.; MaO, J.Y.; Wang, Z.P.; Wu, S.; Zhou, M.; Chen, T.; Zhou, Y.; Han, S.T. Recent advances of volatile memristors: Devices, mechanisms, and applications. Adv. Intell. Syst. 2020, 2, 2000055. [Google Scholar] [CrossRef]
- Shen, Z.; Zhao, C.; Qi, Y.; Xu, W.; Liu, Y.; Mitrovic, I.Z.; Yang, L.; Zhao, C. Advances of RRAM devices: Resistive switching mechanisms, materials and bionic synaptic application. Nanomaterials 2020, 10, 1437. [Google Scholar] [CrossRef]
- Kim, D.; Kim, S.; Kim, S. Logic-in-memory application of CMOS compatible silicon nitride memristor. Chaos Solitions Fractals 2021, 153, 111540. [Google Scholar] [CrossRef]
- Park, J.; Kim, S. Improving endurance and reliability by optimizing the alternating voltage in Pt/ZnO/TiN RRAM. Result Phys. 2022, 39, 105731. [Google Scholar] [CrossRef]
- Patil, S.R.; Chougale, M.Y.; Rane, T.D.; Knot, S.S.; Patil, A.A.; Bagal, O.S.; Jadhav, S.D.; Sheikh, A.D.; Kim, S.; Dongalem, T.D. Solution-processable ZnO thin film memristive device for resistive random access memory application. Electronics 2018, 7, 445. [Google Scholar] [CrossRef]
- Mahata, C.; Ghosh, S.; Chakrabotry, S.; Patro, L.N.; Tripathi, A.; Thapa, R.; Ramakrishna, S.; Kim, S.; Dalapati, G.K. Charge trapping characteristics of sputter-AlOx/ALD Al2O3/Epitaxial-GaAs-based non-volatile memory. J. Mater. Sci. Mater. Electron. 2021, 32, 4157–4165. [Google Scholar] [CrossRef]
- Kim, W.; Park, S.; Zhang, Z.; Wong, S. Current Conduction Mechanism of Nitrogen-Doped RRAM. IEEE Trans. Electron Devices 2014, 61, 2158–2163. [Google Scholar] [CrossRef]
- Yang, J.; Cho, H.; Ryu, H.; Ismail, M.; Mahata, C. Tunable Synaptic Characteristics of a Ti/TiO2/Si Memory Device for Reservoir Computing. ACS Appl. Mater. Interfaces 2021, 13, 33244–33252. [Google Scholar] [CrossRef]
- Sun, B.; Liu, Y.X.; Liu, L.F.; Xu, N.; Wang, Y.; Liu, X.Y.; Han, R.Q.; Kang, J.F. Highly uniform resistive switching characteristics of TiN/ZrO2/Pt memory devices. J. Appl. Phys. 2009, 105, 061630. [Google Scholar] [CrossRef]
- Huang, C.H.; Tang, Y.; Matsuzaki, K.; Nomura, K. Resistive switching memory effects in p-type hydrogen-treated CuO nanowire. Appl. Phys. Lett. 2020, 117, 043502. [Google Scholar] [CrossRef]
- Yang, F.; Deng, N.; Shih, C.; Tseng, Y.; Chang, T.; Chang, K.; Wang, M.; Chen, W.; Zheng, H.; Wu, H.; et al. Conduction Mechanism and Improved Endurance in HfO2-Based RRAM with Nitridation Treatment. Nanoscale Res. Lett. 2017, 12, 1–6. [Google Scholar]
- Lee, S.; Kim, T.; Jang, B.; Lee, W.; Song, K.C.; Kim, H.S.; Do, G.Y.; Hwang, S.B.; Chung, S.; Jang, J. Impact of Device Area and Film Thickness on Performance of Sol-Gel Processed ZrO2 RRAM. IEEE Electron Device Lett. 2018, 39, 668–671. [Google Scholar] [CrossRef]
- Zhang, H.; Gao, B.; Sun, B.; Chen, G.; Zeng, L.; Liu, L.; Liu, X.; Lu, J.; Han, R.; Kang, J.; et al. Ionic doping effect in ZrO2 resistive switching memory. Appl. Phys. Lett. 2010, 96, 123502. [Google Scholar] [CrossRef]
- Lübben, M.; Wiefels, S.; Waser, R.; Valov, I. Processes and Effects of Oxygen and Moisture in Resistively Switching TaOx and HfOx. Adv. Electron. Mater. 2018, 4, 1700458. [Google Scholar] [CrossRef]
- Hwang, H.G.; Woo, J.; Lee, T.; Park, S.M.; Lee, T.; Lee, W.; Nahm, S. Synaptic plasticity and preliminary-spike-enhanced plasticity in a CMOS-compatible Ta2O5 memristor. Mater. Des. 2020, 187, 108400. [Google Scholar] [CrossRef]
- Yang, J.J.; Zhang, M.X.; Strachan, J.P.; Miao, F.; Pickett, M.D.; Kelley, R.D.; Riberio, G.D.; Williams, R.S. High switching endurance in TaOx memristive devices. Appl. Phys. Lett. 2010, 97, 232102. [Google Scholar] [CrossRef]
- Torrezan, A.C.; Strachan, J.P.; Riberio, G.D.; Williams, R.S. Sub-nanosecond switching of a tantalum oxide memristor. Nanotechnology 2011, 22, 485203. [Google Scholar] [CrossRef] [PubMed]
- Lee, M.; Lee, C.B.; Lee, D.; Lee, S.R.; Chang, M.; Hur, J.H.; Kim, Y.B.; Kim, C.J.; Seo, D.H.; Seo, S.; et al. A fast, high-endurance and scalable non-volatile memory device made from asymmetric Ta2O5−x/TaO2−x bilayer structures. Nat. Mater. 2011, 10, 625–630. [Google Scholar] [CrossRef]
- Yang, S.; Park, J.; Cho, Y.; Lee, Y.; Kim, S. Enhanced Resistive Switching and Synaptic Characteristics of ALD Deposited AlN-Based RRAM by Positive Soft Breakdown Process. Int. J. Mol. Sci. 2022, 23, 13249. [Google Scholar] [CrossRef]
- Chen, Y.C.; Chung, Y.; Chen, B.; Chen, W.; Chen, J.J. Revelation on the Interrelated Mechanism of Polarity-Dependent and Multilevel Resistive Switching in TaOx-Based Memory Devices. Phys. Chem. C 2013, 117, 5758–5764. [Google Scholar] [CrossRef]
- Ju, D.; Kim, J.; Kim, S. Highly uniform resistive switching characteristics of Ti/TaOx/ITO memristor devices for neuromorphic system. J. Alloys Compd. 2023, 961, 170920. [Google Scholar] [CrossRef]
- Yuchao, Y.; Lu, W.D. Progress in the characterizations and understanding of conducting filaments in resistive switching devices. IEEE Trans. Nanotechnol. 2016, 15, 465–472. [Google Scholar]
- Waser, R.; Dittmann, R.; Staikow, G.; Szot, K. Redox-based resistive switching memories–nanoionic mechanisms, prospects, and challenges. Adv. Mater. 2009, 21, 2632–2663. [Google Scholar] [CrossRef]
- Sadaf, S.M.; Liu, X.; Son, M.; Choudhury, S.H.; Cha, E.; Siddik, M.; Shin, J.; Hwang, H. Highly uniform and reliable resistance switching properties in bilayer WOx/NbOx RRAM devices. Phys. Status Solidi A-Appl. Res. 2012, 209, 1179–1183. [Google Scholar] [CrossRef]
- Wang, Z.; Zhu, W.G.; Du, A.Y.; Wu, L.; Fang, Z.; Tran, X.A.; Liu, W.J.; Zhang, K.L.; Yu, H.Y. Highly Uniform, Self-Compliance, and Forming-Free ALD-Based RRAM With Ge Doping. IEEE Trans. Electron Devices 2012, 59, 1203–1208. [Google Scholar] [CrossRef]
- Mahata, C.; Park, J.; Ismail, M.; Kim, D.H.; Kim, S. Improved Resistive Switching with Low-Power Synaptic Behaviors of ZnO/Al2O3 Bilayer Structure. Materials 2022, 15, 6663. [Google Scholar] [CrossRef] [PubMed]
- Chae, S.C.; Lee, J.S.; Kim, S.; Lee, S.B.; Chang, S.H.; Liu, C.; Kahng, B.; Shin, H.; Kim, D.W.; Jung, C.; et al. Random circuit breaker network model for unipolar resistance switching. Adv. Mater. 2008, 20, 1154–1159. [Google Scholar] [CrossRef]
- Kim, S.; Abbas, Y.; Jeon, Y.R.; Sokolov, A.S.; Ku, B.; Choi, C. Engineering synaptic characteristics of TaOx/HfO2 bi-layered resistive switching device. Nanotechnology 2018, 29, 415204. [Google Scholar] [CrossRef] [PubMed]
- Park, M.; Jeon, B.; Park, J.; Kim, S. Memristors with Nociceptor Characteristics Using Threshold Switching of Pt/HfO2/TaOx/TaN Devices. Nanomaterials 2022, 12, 4206. [Google Scholar] [CrossRef] [PubMed]
- Woo, J.; Moon, K.; Song, J.; Lee, S.; Kwak, M.; Park, J.; Hwang, H. Improved Synaptic Behavior Under Identical Pulses Using AlOx/HfO2 Bilayer RRAM Array for Neuromorphic Systems. IEEE Electron Device Lett. 2016, 37, 994–997. [Google Scholar] [CrossRef]
- Wang, Z.; Yin, M.; Zhang, T.; Cai, Y.; Wang, Y.; Yang, Y.; Huang, R. Engineering incremental resistive switching in TaOx based memristors for brain-inspired computing. Nanoscale 2016, 8, 14015–14022. [Google Scholar] [CrossRef]
- Wang, Q.; Itoh, Y.; Tsuruoka, T.; Ohtsuka, S.; Shimizu, T.; Shingubara, S.; Hasegawa, T.; Aono, M. Dynamic moderation of an electric field using a SiO2 switching layer in TaOx-based ReRAM. Phys. Status Solidi-Rapid Res. Lett. 2015, 9, 166–170. [Google Scholar] [CrossRef]
- Yu, A.; Ma, Y.; Wang, Z.; Ding, X.; Feng, Y.; Liu, L. Low-Power Resistive Switching Characteristics in TiN/TaON/SiO2/Pt RRAM devices for Neuromorphic Applications. In Proceedings of the IEEE International Workshop on Future Computing, Hangzhou, China, 14–15 December 2019; IEEE: New York, NY, USA, 2019. [Google Scholar]
- Lee, Y.; Park, J.; Chung, D.; Lee, K.; Kim, S. Multi-level Cells and Quantized Conductance Characteristics of Al2O3-Based RRAM Device for Neuromorphic System. Nanoscale Res. Lett. 2022, 17, 84. [Google Scholar] [CrossRef]
- Jiang, J.; Hu, W.; Xie, D.; Yang, J.; He, J.; Gao, Y.; Wan, Q. 2D electric-double-layer phototransistor for photoelectronic and spatiotemporal hybrid neuromorphic integration. Nanoscale 2019, 11, 1360–1369. [Google Scholar] [CrossRef]
- Ismail, M.; Mahata, C.; Kim, S. Forming-free Pt/Al2O3/HfO2/HfAlOx/TiN memristor with controllable multilevel resistive switching and neuromorphic characteristics for artificial synapse. J. Alloys Compd. 2022, 892, 162141. [Google Scholar] [CrossRef]
- Lin, J.; Wang, S.; Liu, H. Multi-Level Switching of Al-Doped HfO2 RRAM with a Single Voltage Amplitude Set Pulse. Electronics 2021, 10, 731. [Google Scholar] [CrossRef]
- Wu, J.J.; Ye, C.; Zhang, J.; Deng, T.; He, P.; Wang, H. Multilevel characteristics for bipolar resistive random access memory based on hafnium doped SiO2 switching layer. Mater. Sci. Semicond. Process 2016, 43, 144–148. [Google Scholar] [CrossRef]
- Zahoor, F.; Zulkifli, T.Z.; Khanday, F.A. Resistive Random Access Memory (RRAM): An Overview of Materials, Switching Mechanism, Performance, Multilevel Cell (mlc) Storage, Modeling, and Applications. Nanoscale Res. Lett. 2020, 15, 90. [Google Scholar] [CrossRef]
- Sedghi, N.; Brunell, I.F.; Dawson, K.; Potter, R.J.; Guo, Y.; Gibbon, J.T.; Dhanak, V.R.; Zhang, W.D.; Zhang, F.H.; Robertson, J.; et al. The role of nitrogen doping in ALD Ta2O5 and its influence on multilevel cell switching in RRAM. Appl. Phys. Lett. 2017, 110, 102902. [Google Scholar] [CrossRef]
- Amit, P.; Hwang, H. Multilevel cell storage and resistance variability in resistive random access memory. Phys. Sci. Rev. 2016, 1, 20160010. [Google Scholar]
- Feng, G.; Jiang, J.; Zhao, Y.; Wang, S.; Liu, B.; Niu, K.Y.D.; Li, X.; Chen, Y.; Duan, H.; Yang, J.; et al. A sub-10 nm vertical organic/inorganic hybrid transistor for pain-perceptual and sensitization-regulated nociceptor emulation. Adv. Mater. 2020, 32, 1906171. [Google Scholar] [CrossRef]
- Li, Y.; Yin, K.; Diao, Y.; Fang, M.; Yang, J.; Zhang, J.; Cao, H.; Liu, X.; Jiang, J. A biopolymer-gated ionotronic junctionless oxide transistor array for spatiotemporal pain-perception emulation in nociceptor network. Nanoscale 2022, 14, 2316–2326. [Google Scholar] [CrossRef]


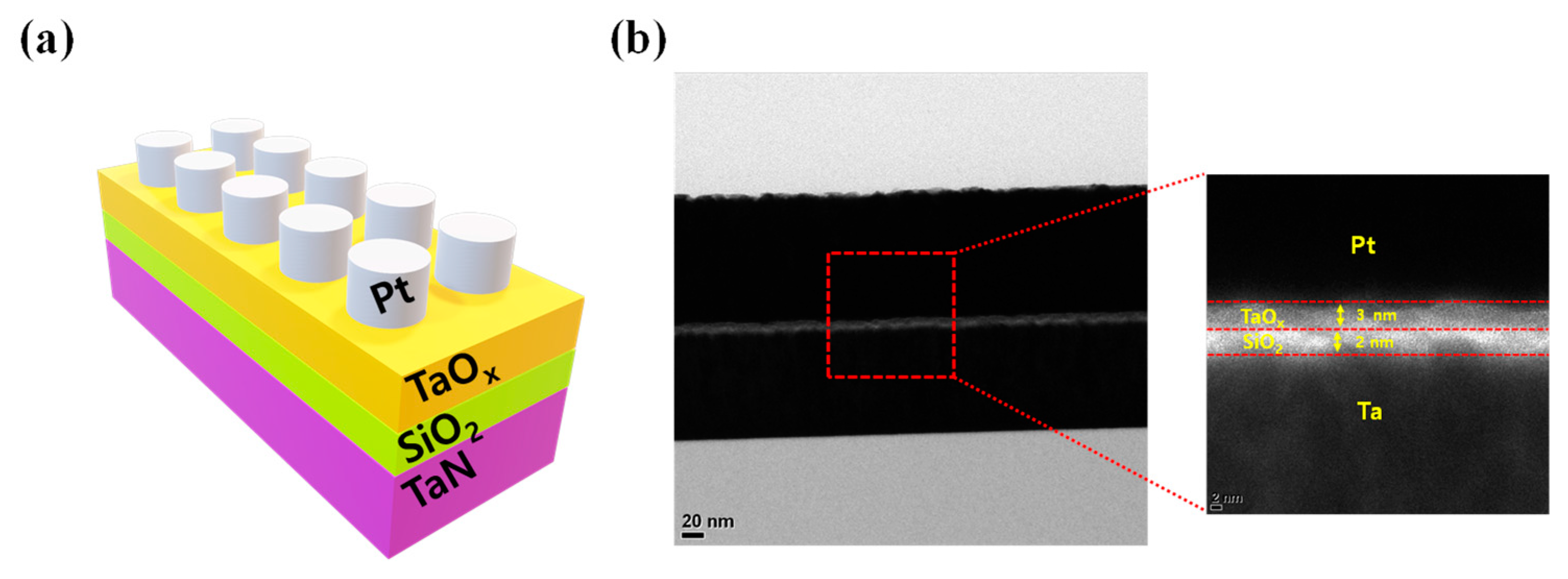





Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Ju, D.; Kim, S.; Jang, J.; Kim, S. Improved Uniformity of TaOx-Based Resistive Switching Memory Device by Inserting Thin SiO2 Layer for Neuromorphic System. Materials 2023, 16, 6136. https://doi.org/10.3390/ma16186136
Ju D, Kim S, Jang J, Kim S. Improved Uniformity of TaOx-Based Resistive Switching Memory Device by Inserting Thin SiO2 Layer for Neuromorphic System. Materials. 2023; 16(18):6136. https://doi.org/10.3390/ma16186136
Chicago/Turabian StyleJu, Dongyeol, Sunghun Kim, Junwon Jang, and Sungjun Kim. 2023. "Improved Uniformity of TaOx-Based Resistive Switching Memory Device by Inserting Thin SiO2 Layer for Neuromorphic System" Materials 16, no. 18: 6136. https://doi.org/10.3390/ma16186136



