Pull-In Voltage and Stress in Fixed-Fixed Beams of RF MEMS Switches †
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Deng, K.; Yang, F.; Deng, Z.; Wang, X.; Han, K. Analysis and design of a novel high capacitance ratio and low actuation voltage RF MEMS switch. Microsyst. Technol. 2021, 27, 2803–2813. [Google Scholar] [CrossRef]
- Bansal, D.; Bajpai, A.; Kumar, P.; Kaur, M.; Kumar, A. Effect of Stress on Pull-in Voltage of RF MEMS SPDT Switch. IEEE Trans. Electron Dev. 2020, 67, 2147–2152. [Google Scholar] [CrossRef]
- Persano, A.; Quaranta, F.; Capoccia, G.; Proietti, E.; Lucibello, A.; Marcelli, R.; Bagolini, A.; Iannacci, J.; Taurino, A.; Siciliano, P. Influence of design and fabrication on RF performance of capacitive RF MEMS switches. Microsyst. Technol. 2016, 22, 1741–1746. [Google Scholar] [CrossRef]

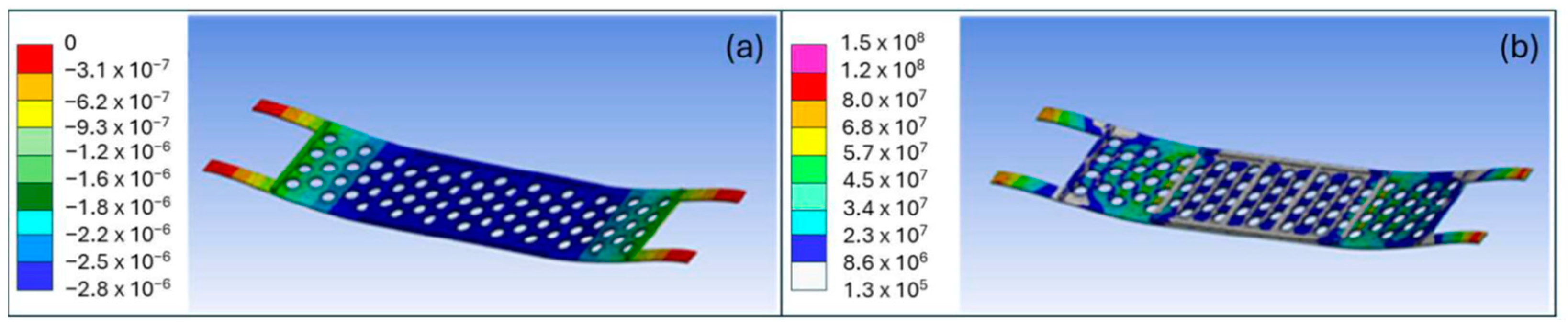
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2024 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Persano, A.; Tagliapietra, G.; Iannacci, J.; Bagolini, A.; Quaranta, F.; Siciliano, P. Pull-In Voltage and Stress in Fixed-Fixed Beams of RF MEMS Switches. Proceedings 2024, 97, 174. https://doi.org/10.3390/proceedings2024097174
Persano A, Tagliapietra G, Iannacci J, Bagolini A, Quaranta F, Siciliano P. Pull-In Voltage and Stress in Fixed-Fixed Beams of RF MEMS Switches. Proceedings. 2024; 97(1):174. https://doi.org/10.3390/proceedings2024097174
Chicago/Turabian StylePersano, Anna, Girolamo Tagliapietra, Jacopo Iannacci, Alvise Bagolini, Fabio Quaranta, and Pietro Siciliano. 2024. "Pull-In Voltage and Stress in Fixed-Fixed Beams of RF MEMS Switches" Proceedings 97, no. 1: 174. https://doi.org/10.3390/proceedings2024097174
APA StylePersano, A., Tagliapietra, G., Iannacci, J., Bagolini, A., Quaranta, F., & Siciliano, P. (2024). Pull-In Voltage and Stress in Fixed-Fixed Beams of RF MEMS Switches. Proceedings, 97(1), 174. https://doi.org/10.3390/proceedings2024097174








