Noble Infrared Optical Thickness Monitoring System Based on the Algorithm of Phase-Locked Output Current–Reflectivity Coefficient
Abstract
:1. Introduction
2. Experiment
2.1. Construction of the Hardware Part
2.2. Construction of the Software Part
2.3. Savitsky–Golay Smoothing Filter
2.4. Photoelectrode Value Method
- (1)
- E is the electric field intensity vector, H is the magnetic field intensity vector, B is the magnetic induction intensity vector, is the angular frequency of the plane wave, λ is the wavelength of the electromagnetic wave, r is the coordinate vector, N is the complex refractive index, and l is the extinction coefficient;
- (2)
- E., H, and l0 are perpendicular to each other and conform to the right-handed law—the light wave is an electromagnetic shear wave;
- (3)
- (1)
- When the electromagnetic wave is vertically incident on an interface, there isandso,
- (2)
- When the electromagnetic wave is obliquely incident on an interface,for a TE wave and s-polarized wave, e is parallel to the interface, soSo,For a TM wave and p-polarized wave incident, h is parallel to the interface, soSo,
2.5. Design and Fabrication of IR Narrowband Filters
3. Test and Analysis
3.1. Spectral Test
3.2. SEM Test
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
Abbreviations
| List of symbols | |
| E | Electric field intensity vector |
| H | Magnetic field intensity vector |
| B | Magnetic induction intensity vector |
| ω | Angular frequency of plane wave |
| λ | Wavelength of electromagnetic wave |
| r | Coordinate vector |
| N | Complex refractive index |
| k | Extinction coefficient |
| Abbreviations | |
| IR | Infrared |
| COVID-19 | Coronavirus Disease 2019 |
| PVD | Physical vapor deposition |
References
- Ristau, D.; Ehlers, H.; Schlichting, S.; Lappschies, M. State of the art in deterministic production of optical thin films. Proc. SPIE Adv. Opt. Thin Film. III 2008, 7101, 71010C. [Google Scholar]
- Dobrowolski, J.A. Optical properties of films and coatings. In Handbook of Optics; McGraw-Hill: New York, NY, USA, 2010; Chapter IV; pp. 7.15–7.53. [Google Scholar]
- Macleod, H.A. Thin-Film Optical Filters, 4th ed.; CRC Press: Boca Raton, FL, USA; Taylor & Francis: Abingdon, UK, 2010. [Google Scholar]
- Thoeni, W. Deposition of optical coatings: Process control and automation. Thin Solid Film. 1982, 88, 385–397. [Google Scholar] [CrossRef]
- Wilbrandt, S.; Kaiser, N.; Stenzel, O. In-situ broadband monitoring of heterogeneous optical coatings. Thin Solid Film. 2006, 502, 153–157. [Google Scholar] [CrossRef]
- Ristau, D. Characterization and monitoring. In Optical Interference Coatings; Springer: Berlin/Heidelberg, Germany, 2003; pp. 181–205. [Google Scholar]
- Tikhonravov, A.V.; Trubetskov, M.K.; Amotchkina, T.V. Statistical approach to choosing a strategy of monochromatic monitoring of optical coating production. Appl. Opt. 2006, 45, 7863–7870. [Google Scholar] [CrossRef] [PubMed]
- Tikhonravov, A.V.; Trubetskov, M.K. Elimination of cumulative effect of thickness errors in monochromatic monitoring of optical coating production: Theory. Appl. Opt. 2007, 46, 2084–2090. [Google Scholar] [CrossRef] [PubMed]
- van der Laan, C.J. Optical monitoring of nonquarterwave stacks. Appl. Opt. 1986, 25, 753–760. [Google Scholar] [CrossRef]
- Tikhonravov, A.V.; Trubetskov, M.; Amotchkina, T.V. Computational experiments on optical coating production using monochromatic monitoring strategy aimed at eliminating a cumulative effect of thickness errors. Appl. Opt. 2007, 46, 6936–6944. [Google Scholar] [CrossRef]
- Zhao, F. Monitoring of periodic multilayers by the level method. Appl. Opt. 1985, 24, 3339–3342. [Google Scholar] [CrossRef] [PubMed]
- Willey, R.R.; Machado, D.E. Variation of band-edge position with errors in the monitoring of layer termination level for long- and short-wave pass filters. Appl. Opt. 1999, 38, 5447–5451. [Google Scholar] [CrossRef]
- Sullivan, B.T.; Dobrowolski, J.A. Deposition error compensation for optical multilayer coatings I Theoretical description. Appl. Opt. 1992, 31, 3821–3835. [Google Scholar] [CrossRef] [PubMed]
- Lee, C.-C.; Wu, K.; Kuo, C.-C.; Chen, S.-H. Improvement of the optical coating process by cutting layers with sensitive monitoring wavelengths. Opt. Express 2005, 13, 4854–4861. [Google Scholar] [CrossRef] [PubMed]
- Badoil, B.; Lemarchand, F.; Cathelinaud, M.; Lequime, M. Interest of broadband optical monitoring for thin-film filter manufacturing. Appl. Opt. 2007, 46, 4294–4303. [Google Scholar] [CrossRef] [PubMed]
- Tikhonravov, A.; Trubetskov, M.; Amotchkina, T. Optical monitoring strategies for optical coating manufacturing. In Electronic and Optical Materials; Woodhead Publishing: Sawston, UK, 2013; pp. 62–93. [Google Scholar]
- Ristau, D.; Ehlers, H.; Gross, T.; Lappschies, M. Optical broadband monitoring of conventional and ion processes. Appl. Opt. 2006, 45, 1495–1501. [Google Scholar] [CrossRef]
- Wilbrandt, S.; Stenzel, O.; Kaiser, N.; Trubetskov, M.K.; Tikhonravov, A.V. In situ optical characterization and reengineering of interference coatings. Appl. Opt. 2008, 47, C49–C54. [Google Scholar] [CrossRef]
- Waldner, S.; Benz, R.; Biedermann, P.; Jaunzens, A. Broadband optical monitoring combined with additional rate measurement for accurate and robust coating processes. In Optical Interference Coatings; Optical Society of America: Washington, DC, USA, 2010; paper TuC10. [Google Scholar]
- Zöller, A.; Boos, M.; Hagedorn, H.; Klug, W.; Schmidt, C. High accurate in-situ optical thickness monitoring. In Optical Interference Coatings; Optical Society of America: Washington, DC, USA, 2004. [Google Scholar]
- Holm, C. Optical thin film production with continuous reoptimization of layer thicknesses. Appl. Opt. 1979, 18, 1978–1982. [Google Scholar] [CrossRef]
- Zöller, A.; Boos, M.; Hagedorn, H.; Romanov, B. Computer simulation of coating processes with monochromatic monitoring. Proc. SPIE Adv. Opt. Thin Film. III 2008, 7101, 71010G. [Google Scholar]
- Gilo, M.; Cohen, D. Comparison of broad-band and single wavelength monitoring for IR coatings. In Optical Interference Coatings; Optical Society of America: Washington, DC, USA, 2013. [Google Scholar]
- Zöller, A.; Boos, M.; Götzelmann, R.; Hagedorn, H.; Klug, W. Substantial progress in optical monitoring by intermittent measurement technique. Proc. SPIE Adv. Opt. Thin Film. II 2005, 59630, 59630D. [Google Scholar]
- Tikhonravov, A.V.; Trubetskov, M.K.; Amotchkina, T.V.; Pervak, V. Estimations of production yields for selection of a practical optimal optical coating design. Appl. Opt. 2011, 50, C141–C147. [Google Scholar] [CrossRef]
- Chun, B.J.; Hwangbo, C.K.; Kim, J.S. Optical monitoring of nonquarterwave layers of dielectric multilayer filters using optical admittance. Opt. Express 2006, 14, 2473–2480. [Google Scholar] [CrossRef]
- Amotchkina, T.V.; Schlichting, S.; Ehlers, H.; Trubetskov, M.K.; Tikhonravov, A.V.; Ristau, D. Computational manufacturing as a key element in the design-production chain for modern multilayer coatings. Appl. Opt. 2012, 51, 7604–7615. [Google Scholar] [CrossRef]
- Friedrich, K.; Wilbrandt, S.; Stenzel, O.; Kaiser, N.; Hoffmann, K.H. Computational manufacturing of optical interference coatings: Method, simulation results, and comparison with experiment. Appl. Opt. 2010, 49, 3150–3162. [Google Scholar] [CrossRef] [PubMed]

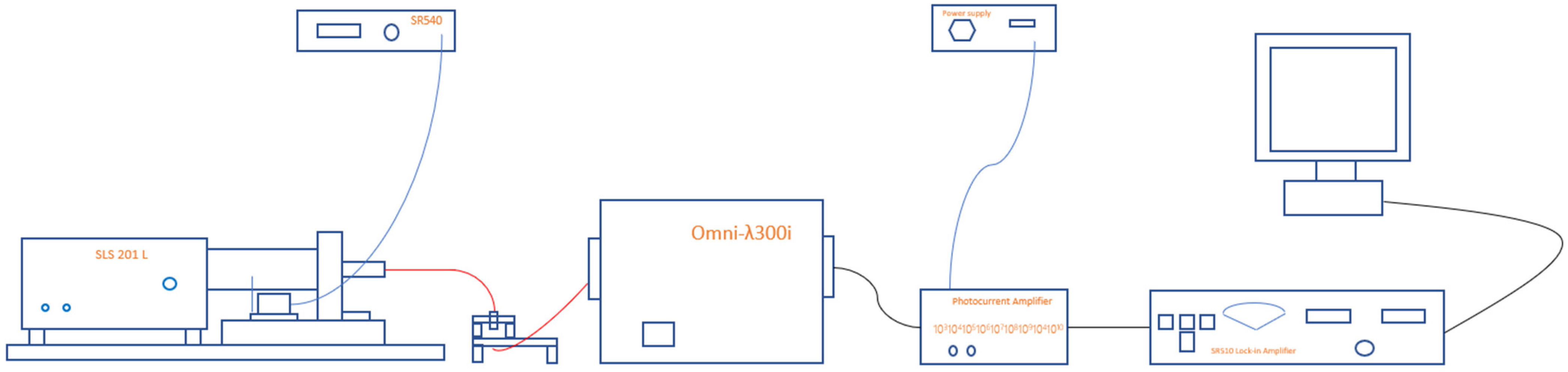

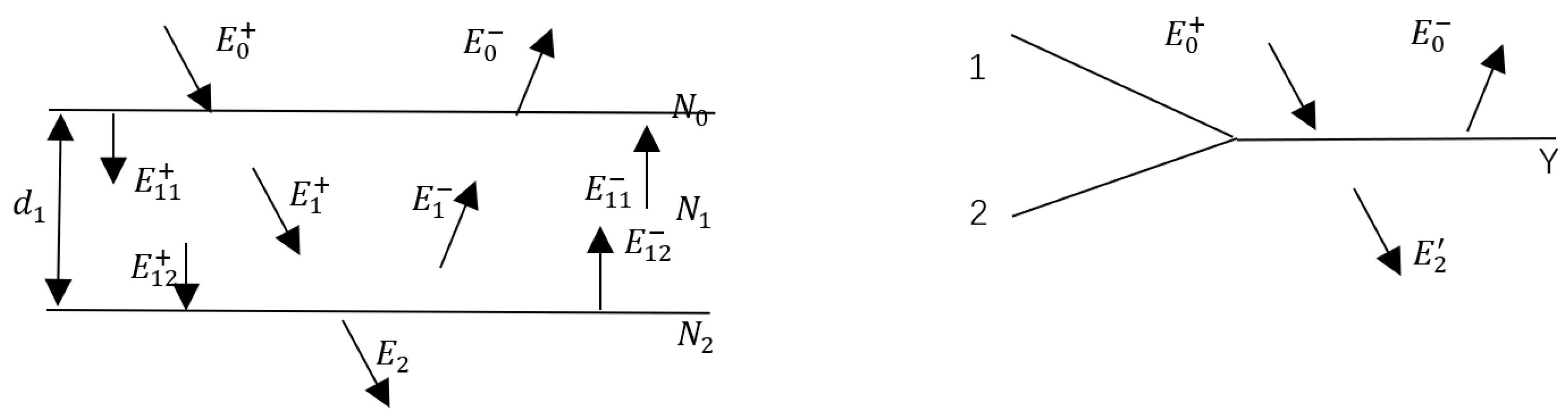


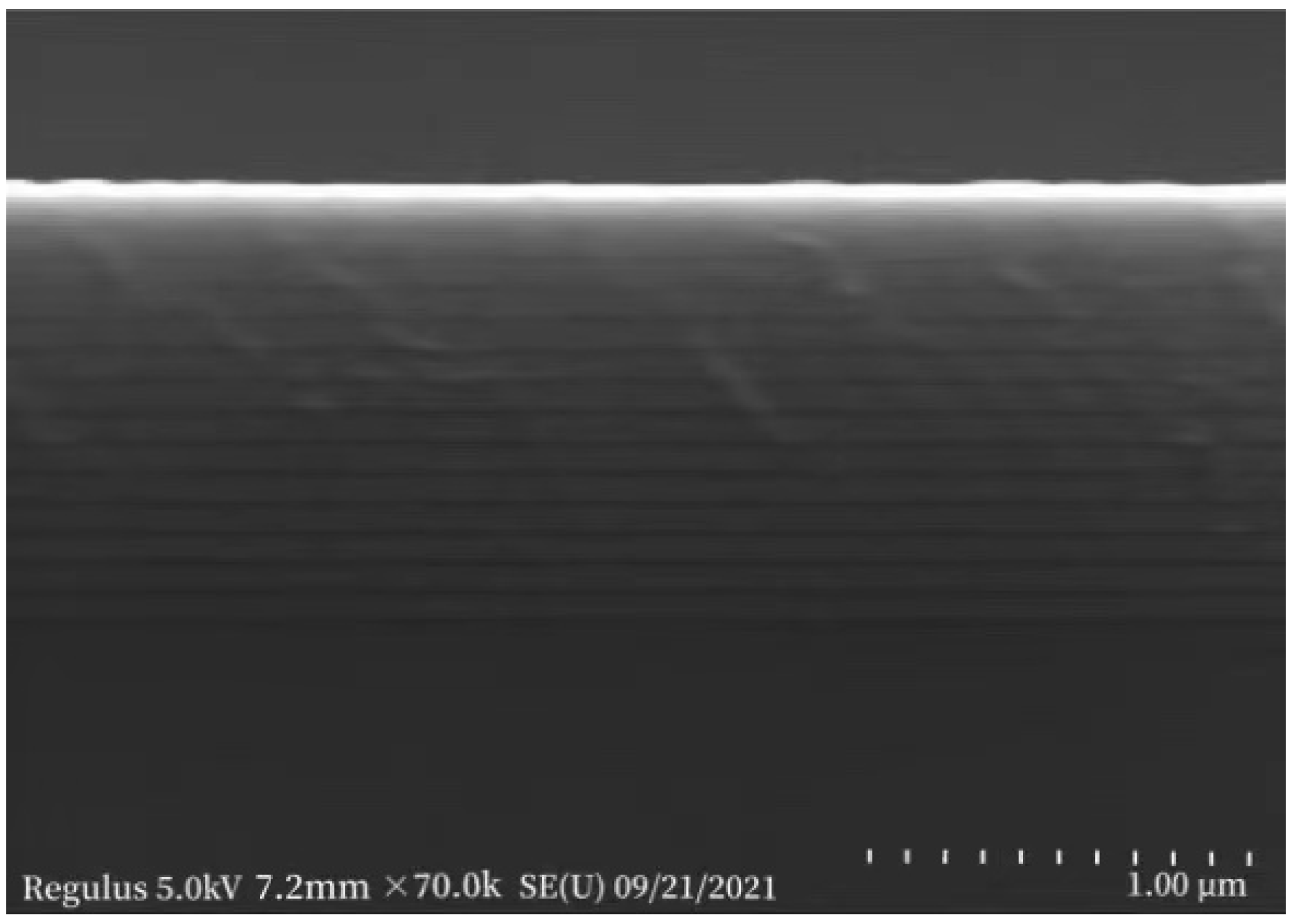
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Dong, S.; Fu, X.; Li, C. Noble Infrared Optical Thickness Monitoring System Based on the Algorithm of Phase-Locked Output Current–Reflectivity Coefficient. Coatings 2022, 12, 782. https://doi.org/10.3390/coatings12060782
Dong S, Fu X, Li C. Noble Infrared Optical Thickness Monitoring System Based on the Algorithm of Phase-Locked Output Current–Reflectivity Coefficient. Coatings. 2022; 12(6):782. https://doi.org/10.3390/coatings12060782
Chicago/Turabian StyleDong, Suotao, Xiuhua Fu, and Cheng Li. 2022. "Noble Infrared Optical Thickness Monitoring System Based on the Algorithm of Phase-Locked Output Current–Reflectivity Coefficient" Coatings 12, no. 6: 782. https://doi.org/10.3390/coatings12060782






