Improved Electrical Characteristics of AlGaN/GaN High-Electron-Mobility Transistor with Al2O3/ZrO2 Stacked Gate Dielectrics
Abstract
1. Introduction
2. Experimental Study
3. Results and Discussion
| Group | This Work | [5] | [21] | [23] | [25] | [12] |
|---|---|---|---|---|---|---|
| Gate oxide (nm)/ Oxidation technique | Al2O3/ZrO2 (1/12) RF co-sputter | SiNx/HfO2 (5/25) PEALD+ and RF sputter | Al2O3, Ga2O3/Gd2O3 (5/10) N2O plasma and electron-beam evaporation | Al2O3/ZrO2 (2/2) ALD++ | Y2O3/HfO2 (1/12) PEALD+ | Al2O3/ HfO2 (2/3) ALD++ |
| Mode | D | E | E | D | D | D |
| Gate length (µm) | 1 | 2 | 2 | 2 | 1 | 1 |
| Maximum IDS (mA/mm) | 847 | 600 | 364 | 540 | 600 | 800 |
| Ron (Ω∙mm) | 3.82 | ~8.8 | - | 6.6 | 10.7 | ~5.0 |
| Peak gm (mS/mm) | 181@VDS = 4 V | 170@VDS = 10 V | 105@VDS = 8 V | 94 | 4.8@VDS = 0.05 V | 150@VDS = 10 V |
| Subthreshold swing (mV/dec) | 95 | 85 | - | - | 70 | - |
| ION/IOFF | 3.3 × 107 | 109 | - | 109 | 109 | - |
| Dit (cm−2) | 2.44 × 1011 | - | - | - | ~1012 | - |
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Mishra, U.K.; Parikh, P.; Wu, Y.-F. AlGaN/GaN HEMTs—An overview of device operation and applications. Proc. IEEE 2002, 90, 1022–1031. [Google Scholar] [CrossRef]
- Mukhopadhyay, P.; Banerjee, U.; Bag, A.; Ghosh, S.; Biswas, D. Influence of growth morphology on electrical and thermal modeling of AlGaN/GaN HEMT on sapphire and silicon. Solid-State Electron. 2015, 104, 101–108. [Google Scholar] [CrossRef]
- Hu, J.; Zhang, Y.; Sun, M.; Piedra, D.; Chowdhury, N.; Palacios, T. Materials and processing issues in vertical GaN power electronics. Mater. Sci. Semicond. Process. 2018, 78, 75–84. [Google Scholar] [CrossRef]
- Lee, K.-W.; Chou, D.-W.; Wu, H.-R.; Huang, J.-J.; Wang, Y.-H.; Houng, M.-P.; Chang, S.-J.; Su, Y.-K. GaN MOSFET with liquid phase deposited oxide gate. Electron. Lett. 2002, 38, 829–830. [Google Scholar] [CrossRef]
- Choi, W.; Seok, O.; Ryu, H.; Cha, H.Y.; Seo, K.S. High-voltage and low-leakage-current gate recessed normally-off GaN MIS-HEMTs with dual gate insulator employing PEALD-SiNx/RF-sputtered-HfO2. IEEE Electron Device Lett. 2014, 35, 175–177. [Google Scholar] [CrossRef]
- Sato, T.; Okayasu, J.; Takikawa, M.; Suzuki, T. AlGaN-GaN metal-insulator-semiconductor high-electron-mobility transistors with very high-κ oxynitride TaOxNy gate dielectric. IEEE Electron Device Lett. 2013, 34, 375–377. [Google Scholar] [CrossRef]
- Tang, Z.; Jiang, Q.; Lu, Y.; Huang, S.; Yang, S.; Tang, X.; Chen, K.J. 600-V Normally Off SiNx/AlGaN/GaN MIS-HEMT with Large Gate Swing and Low Current Collapse. IEEE Electron Device Lett. 2013, 34, 1373–1375. [Google Scholar] [CrossRef]
- Corrion, A.L.; Shinohara, K.; Regan, D.; Milosavljevic, I.; Hashimoto, P.; Willadsen, P.J.; Schmitz, A.; Kim, S.J.; Butler, C.M.; Brown, D.; et al. High-speed AlN/GaN MOS-HFETs with scaled ALD Al2O3 gate insulators. IEEE Electron Device Lett. 2011, 32, 1062–1064. [Google Scholar] [CrossRef]
- Shrestha, P.; Guidry, M.; Romanczyk, B.; Hatui, N.; Wurm, C.; Krishna, A.; Pasayat, S.S.; Karnaty, R.R.; Keller, S.; Buckwalter, J.F.; et al. High Linearity and High Gain Performance of N-Polar GaN MIS-HEMT at 30 GHz. IEEE Electron Device Lett. 2020, 41, 681–684. [Google Scholar] [CrossRef]
- Rzin, M.; Routoure, J.-M.; Guillet, B.; Mechin, L.; Morales, M.; Lacam, C.; Gamarra, P.; Ruterana, P.; Medjdoub, F. Impact of Gate–Drain Spacing on Low-Frequency Noise Performance of In Situ SiN Passivated InAlGaN/GaN MIS-HEMTs. IEEE Trans. Electron Devices 2017, 64, 2820–2825. [Google Scholar] [CrossRef]
- Chiu, H.C.; Wang, H.Y.; Peng, L.Y.; Wang, H.C.; Kao, H.L.; Hu, C.W.; Xuan, R. RF performance of in situ SiNx gate dielectric AlGaN/GaN MISHEMT on 6-in silicon-on-insulator substrate. IEEE Trans. Electron Devices 2017, 64, 4065–4070. [Google Scholar] [CrossRef]
- Yue, Y.; Hao, Y.; Zhang, J.; Ni, J.; Mao, W.; Feng, Q.; Liu, L. AlGaN/GaN MOS-HEMT with HfO2 dielectric and Al2O3 interfacial passivation layer grown by atomic layer deposition. IEEE Electron Device Lett. 2008, 29, 838–840. [Google Scholar] [CrossRef]
- Wu, T.Y.; Lin, S.K.; Sze, P.W.; Huang, J.J.; Chien, W.C.; Hu, C.C.; Tsai, M.J.; Wang, Y.H. AlGaN/GaN MOSHEMTs with liq-uid-phase-deposited TiO2 as gate dielectric. IEEE Trans. Electron Devices 2009, 56, 2911–2916. [Google Scholar] [CrossRef]
- Byun, Y.C.; Lee, J.G.; Meng, X.; Lee, J.S.; Lucero, A.T.; Kim, S.J.; Young, C.D.; Kim, M.J.; Kim, J. Low temperature (100 °C) atomic layer deposited-ZrO2 for recessed gate GaN HEMTs on Si. Appl. Phys. Lett. 2017, 111, 082905. [Google Scholar] [CrossRef]
- Yang, S.-K.; Mazumder, S.; Wu, Z.-G.; Wang, Y.-H. Performance Enhancement in N2 Plasma Modified AlGaN/AlN/GaN MOS-HEMT Using HfAlOX Gate Dielectric with Γ-Shaped Gate Engineering. Materials 2021, 14, 1534. [Google Scholar] [CrossRef]
- Turchenko, V.A.; Trukhanov, A.V.; Bobrikov, I.A.; Trukhanov, S.V.; Balagurov, A.M. Study of the crystalline and mag-netic structures of BaFe11.4Al0.6O19 in wide temperature range. J. Surf. Investig. X-Ray Synchrotron Neutron Tech. 2015, 9, 17–23. [Google Scholar] [CrossRef]
- Botzakaki, M.A.; Xanthopoulos, N.; Makarona, E.; Tsamis, C.; Kennou, S.; Ladas, S.; Georga, S.N.; Krontiras, C.A. ALD de-posited ZrO2 ultrathin layers on Si and Ge substrates: A multiple technique characterization. Microelectron. Eng. 2013, 112, 208–212. [Google Scholar] [CrossRef]
- Zhang, F.; Sun, G.; Zheng, L.; Liu, S.; Liu, B.; Dong, L.; Wang, L.; Zhao, W.; Liu, X.; Yan, G.; et al. Interfacial study and energy-band alignment of annealed Al2O3 films prepared by atomic layer deposition on 4H-SiC. J. Appl. Phys. 2013, 113, 044112. [Google Scholar] [CrossRef]
- Hao, S.-Z.; Zhou, D.; Pang, L.-X.; Dang, M.-Z.; Sun, S.-K.; Zhou, T.; Trukhanov, S.; Trukhanov, A.; Sombra, A.S.B.; Li, Q.; et al. Ultra-low temperature co-fired ceramics with adjustable microwave dielectric properties in the Na2O-Bi2O3-MoO3 ternary system: A comprehensive study. J. Mater. Chem. C 2022, 10, 2008–2016. [Google Scholar] [CrossRef]
- Almessiere, M.A.; Algarou, N.A.; Slimani, Y.; Sadaqat, A.; Baykal, A.; Manikandan, A.; Trukhanov, S.V.; Trukhanov, A.V.; Ercan, I. Investigation of exchange coupling and microwave properties of hard/soft (SrNi0.02Zr0.01Fe11.96O19)/(CoFe2O4)x nanocomposites. Mater. Today Nano 2022, 18, 100186. [Google Scholar] [CrossRef]
- Chiu, H.C.; Wu, J.H.; Yang, C.W.; Huang, F.H.; Kao, H.C. Low-frequency noise in enhancement-mode GaN MOS-HEMTs by using stacked Al2O3/Ga2O3/Gd2O3 gate dielectric. IEEE Electron Device Lett. 2012, 33, 958–960. [Google Scholar] [CrossRef]
- Hove, M.V.; Kang, X.; Stoffels, S.; Wellekens, D.; Ronchi, N.; Venegas, R.; Geens, K.; Decoutere, S. Fabrication and performance of Au-free AlGaN/GaN-on silicon power devices with Al2O3 and Si3N4/Al2O3 gate dielectrics. IEEE Trans. Electron Devices 2013, 60, 3071–3078. [Google Scholar] [CrossRef]
- Hatano, M.; Taniguchi, Y.; Kodama, S.; Tokuda, H.; Kuzuhara, M. Reduced gate leakage and high thermal stability of Al-GaN/GaN MIS-HEMTs using ZrO2/Al2O3 gate dielectric stack. Appl. Phys. Express 2014, 7, 044101. [Google Scholar] [CrossRef]
- Watanabe, K.; Terashima, D.; Nozaki, M.; Yamada, T.; Nakazawa, S.; Ishida, M.; Anda, Y.; Ueda, T.; Yoshigoe, A.; Hosoi, T.; et al. SiO2/AlON stacked gate dielectrics for AlGaN/GaN MOS heterojunction field-effect transistors. Jpn. J. Appl. Phys. 2018, 57, 06KA03. [Google Scholar] [CrossRef]
- Shi, Y.T.; Xu, W.Z.; Zeng, C.K.; Ren, F.F.; Ye, J.D.; Zhou, D.; Chen, D.J.; Zhang, R.; Zheng, Y.; Lu, H. High-k HfO2-based AlGaN/GaN MIS-HEMTs with Y2O3 interfacial layer for high gate controllability and interface quality. IEEE J. Electron Devices Soc. 2020, 8, 15–19. [Google Scholar] [CrossRef]
- Asubar, J.T.; Yatabe, Z.; Gregusova, D.; Hashizume, T. Controlling surface/interface states in GaN-based transistors: Surface model, insulated gate, and surface passivation. J. Appl. Phys. 2021, 129, 121102. [Google Scholar] [CrossRef]
- Wang, Y.; Wang, M.; Xie, B.; Wen, C.P.; Wang, J.; Hao, Y.; Wu, W.; Chen, K.J.; Shen, B. High-performance normally-off Al2O3/GaN MOSFET using a wet etching-based gate recess technique. IEEE Electron Device Lett. 2013, 34, 1370–1372. [Google Scholar] [CrossRef]
- Marso, M.; Heidelberger, G.; Indlekofer, K.M.; Bernát, J.; Fox, A.; Kordoš, P.; Lüth, H. Origin of improved RF performance of AlGaN/GaN MOSHFETs compared to HFETs. IEEE Trans. Electron Devices 2006, 53, 1517–1523. [Google Scholar] [CrossRef]
- Gregušová, D.; Stoklas, R.; Eickelkamp, M.; Fox, A.; Novák, J.; Vescan, A.; Grützmacher, D.; Kordoš, P. Characterization of AlGaN/GaN MISHFETs on a Si substrate by static and high-frequency measurements. Semicond. Sci. Technol. 2009, 24, 075014. [Google Scholar] [CrossRef]
- Shoucair, F.S.; Ojala, P.K. High-temperature electrical characteristics of GaAs MESFET’s (25–400 °C). IEEE Trans. Electron Devices 1992, 39, 1551–1557. [Google Scholar] [CrossRef]
- Maeda, N.; Tsubaki, K.; Saitoh, T.; Kobayashi, N. High-temperature electron transport properties in AlGaN/GaN hetero-structures. Appl. Phys. Lett. 2001, 79, 1634–1636. [Google Scholar] [CrossRef]







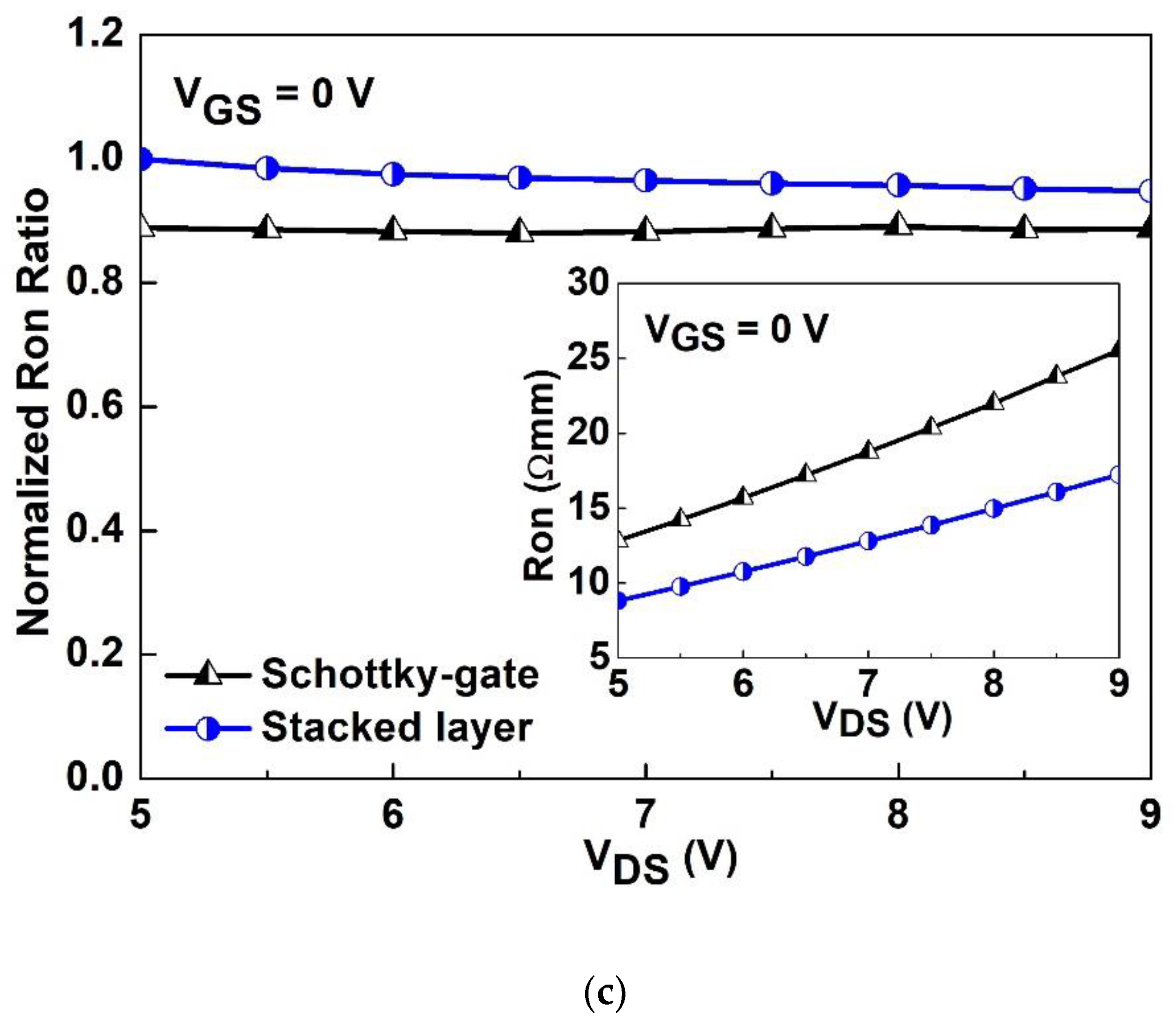







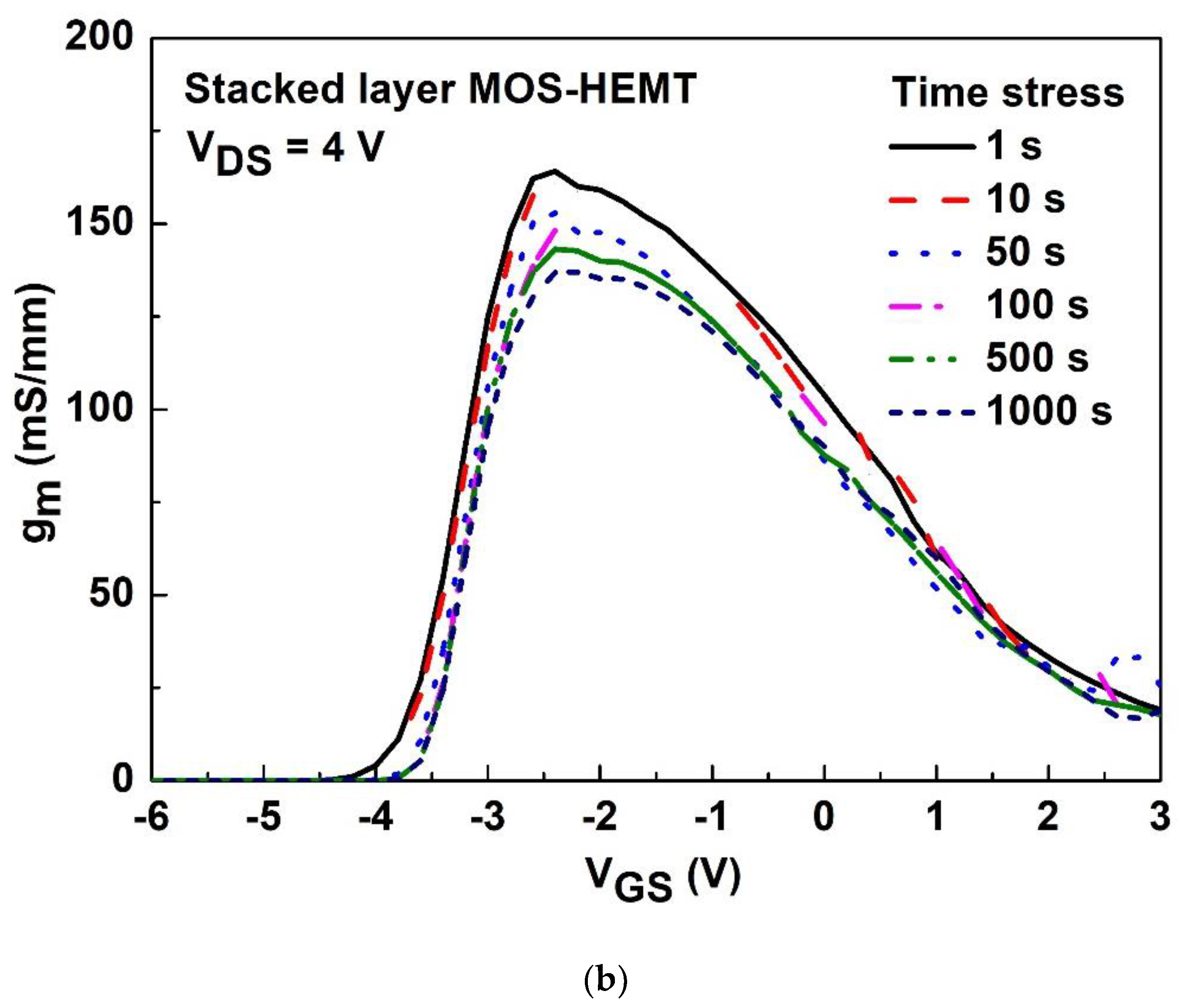

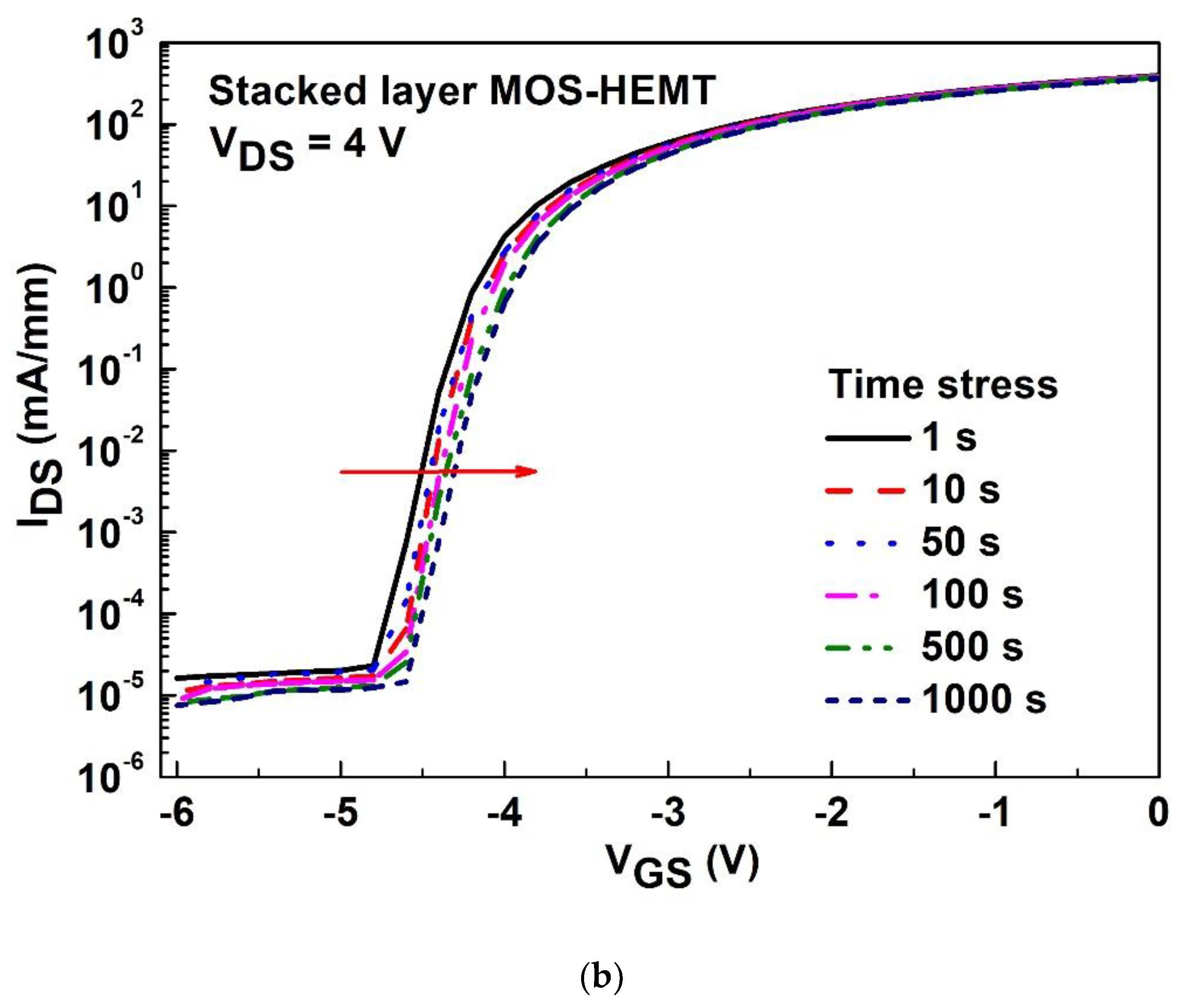
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Huang, C.-Y.; Mazumder, S.; Lin, P.-C.; Lee, K.-W.; Wang, Y.-H. Improved Electrical Characteristics of AlGaN/GaN High-Electron-Mobility Transistor with Al2O3/ZrO2 Stacked Gate Dielectrics. Materials 2022, 15, 6895. https://doi.org/10.3390/ma15196895
Huang C-Y, Mazumder S, Lin P-C, Lee K-W, Wang Y-H. Improved Electrical Characteristics of AlGaN/GaN High-Electron-Mobility Transistor with Al2O3/ZrO2 Stacked Gate Dielectrics. Materials. 2022; 15(19):6895. https://doi.org/10.3390/ma15196895
Chicago/Turabian StyleHuang, Cheng-Yu, Soumen Mazumder, Pu-Chou Lin, Kuan-Wei Lee, and Yeong-Her Wang. 2022. "Improved Electrical Characteristics of AlGaN/GaN High-Electron-Mobility Transistor with Al2O3/ZrO2 Stacked Gate Dielectrics" Materials 15, no. 19: 6895. https://doi.org/10.3390/ma15196895
APA StyleHuang, C.-Y., Mazumder, S., Lin, P.-C., Lee, K.-W., & Wang, Y.-H. (2022). Improved Electrical Characteristics of AlGaN/GaN High-Electron-Mobility Transistor with Al2O3/ZrO2 Stacked Gate Dielectrics. Materials, 15(19), 6895. https://doi.org/10.3390/ma15196895






