Reset-First and Multibit-Level Resistive-Switching Behavior of Lanthanum Nickel Oxide (LaNiO3−x) Thin Films
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Catalano, S.; Gibert, M.; Fowlie, J.; Iniguez, J.; Triscone, J.-M.; Kreisel, J. Rare-earth nickelates RNiO3: Thin films and heterostructures. Rep. Prog. Phys. 2018, 81, 046501. [Google Scholar] [CrossRef]
- Alonso, J.A.; Martinez-Lope, M.J.; Casais, M.T.; Aranda, M.A.; Fernandez-Diaz, M.T. Metal-insulator transitions, structural and microstructural evolution of RNiO3 (R = Sm, Eu, Gd, Dy, Ho, Y) perovskites: Evidence for room-temperature charge disproportionation in monoclinic HoNiO3 and YNiO3. J. Am. Chem. Soc. 1999, 121, 4754–4762. [Google Scholar] [CrossRef]
- Mott, N.F. Metal-insulator transition. Rev. Mod. Phys. 1968, 40, 677. [Google Scholar] [CrossRef]
- Liu, J. Mott Transition and Electronic Structure in Complex Oxide Heterostructures. Ph.D. Thesis, University of Arkansas, Fayetteville, AR, USA, 2012. [Google Scholar]
- Wang, Y.; Kang, K.-M.; Kim, M.; Lee, H.-S.; Waser, R.; Wouters, D.; Dittmann, R.; Yang, J.J.; Park, H.-H. Mott-transition-based RRAM. Mater. Today 2019, 28, 63–80. [Google Scholar] [CrossRef]
- Dobin, A.Y.; Nikolaev, K.R.; Krivorotov, I.N.; Wentzcovitch, R.M.; Dahlberg, E.D.; Goldman, A.M. Electronic and crystal structure of fully strained LaNiO3 films. Phys. Rev. B 2003, 68, 113408. [Google Scholar] [CrossRef]
- Scherwitzl, R.; Gariglio, S.; Gabay, M.; Zubko, P.; Gibert, M.; Triscone, J.M. Metal-insulator transition in ultrathin LaNiO3 films. Phys. Rev. Lett. 2011, 106, 246403. [Google Scholar] [CrossRef]
- Wong, J.C.; Cheng, X.; Musavigharavi, P.; Xiang, F.; Hamilton, A.R.; Valanoor, N.; Sando, D. Understanding the Role of Defective Phases on the Conductivity Behavior of Strained Epitaxial LaNiO3 Thin Films. ACS Appl. Electron. Mater. 2022, 4, 1196–1205. [Google Scholar] [CrossRef]
- Sreedhar, K.; Honig, J.M.; Darwin, M.; McElfresh, M.; Shand, P.M.; Xu, J.; Crooker, B.C.; Spalek, J. Electronic properties of the metallic perovskite LaNiO3: Correlated behavior of 3d electrons. Phys. Rev. B Condens. Matter 1992, 46, 6382–6386. [Google Scholar] [CrossRef]
- Zhu, M.; Komissinskiy, P.; Radetinac, A.; Vafaee, M.; Wang, Z.; Alff, L. Effect of composition and strain on the electrical properties of LaNiO3 thin films. Appl. Phys. Lett. 2013, 103, 141902. [Google Scholar] [CrossRef]
- Chen, M.S.; Wu, T.B.; Wu, J.M. Effect of textured LaNiO3 electrode on the fatigue improvement of Pb(Zr0.53Ti0.47)O3 thin films. Appl. Phys. Lett. 1996, 68, 1430–1432. [Google Scholar] [CrossRef]
- Zhang, H.; Chen, X.; Wang, T.; Wang, F.; Shi, W. Structure and electrical properties of BiFeO3 thin films grown on LaNiO3 electrode by chemical solution deposition. J. Alloys Compd. 2010, 500, 46–48. [Google Scholar] [CrossRef]
- Wang, Y.G.; Tang, X.G.; Liu, Q.X.; Jiang, Y.P.; Feng, Z.Y. Ferroelectric and ferromagnetic properties of SrTi0.9Fe0.1O3−δ thin films. Solid State Commun. 2015, 202, 24–27. [Google Scholar] [CrossRef]
- Malashevich, A.; Ismail-Beigi, S. First-principles study of oxygen-deficient LaNiO3 structures. Phys. Rev. B 2015, 92, 144102. [Google Scholar] [CrossRef]
- Sanchez, R.; Causa, M.; Caneiro, A.; Butera, A.; Vallet-Regi, M.; Sayagués, M.; González-Calbet, J.; Garcia-Sanz, F.; Rivas, J. Metal-insulator transition in oxygen-deficient LaNiO3−x perovskites. Phys. Rev. B 1996, 54, 16574. [Google Scholar] [CrossRef] [PubMed]
- Abbate, M.; Zampieri, G.; Prado, F.; Caneiro, A.; Gonzalez-Calbet, J.M.; Vallet-Regi, M. Electronic structure and metal-insulator transition in LaNiO3−δ. Phys. Rev. B 2002, 65. [Google Scholar] [CrossRef]
- Wong, H.S.P.; Lee, H.-Y.; Yu, S.; Chen, Y.-S.; Wu, Y.; Chen, P.-S.; Lee, B.; Chen, F.T.; Tsai, M.-J. Metal–Oxide RRAM. Proc. IEEE 2012, 100, 1951–1970. [Google Scholar] [CrossRef]
- Zahoor, F.; Azni Zulkifli, T.Z.; Khanday, F.A. Resistive Random Access Memory (RRAM): An Overview of Materials, Switching Mechanism, Performance, Multilevel Cell (mlc) Storage, Modeling, and Applications. Nanoscale Res. Lett. 2020, 15, 90. [Google Scholar] [CrossRef] [PubMed]
- Meena, J.S.; Sze, S.M.; Chand, U.; Tseng, T.-Y. Overview of emerging nonvolatile memory technologies. Nano Scale Res. Lett. 2014, 9, 526. [Google Scholar] [CrossRef]
- Wang, L.; Yang, C.; Wen, J.; Gai, S. Emerging Nonvolatile Memories to Go Beyond Scaling Limits of Conventional CMOS Nanodevices. J. Nanomater. 2014, 2014, 927696. [Google Scholar] [CrossRef]
- Lee, G.H.; Hwang, S.; Yu, J.; Kim, H. Architecture and Process Integration Overview of 3D NAND Flash Technologies. Appl. Sci. 2021, 11, 6703. [Google Scholar] [CrossRef]
- Quan, X.-T.; Zhu, H.-C.; Cai, H.-T.; Zhang, J.-Q.; Wang, X.-J. Resistive Switching Behavior in Amorphous Aluminum Oxide Film Grown by Chemical Vapor Deposition. Chin. Phys. Lett. 2014, 31, 078101. [Google Scholar] [CrossRef]
- Rodrigues, A.; Santos, Y.; Rodrigues, C.; Macêdo, M. Al2O3 thin film multilayer structure for application in RRAM devices. Solid-State Electron. 2018, 149, 1–5. [Google Scholar] [CrossRef]
- Lin, Y.S.; Zeng, F.; Tang, S.G.; Liu, H.Y.; Chen, C.; Gao, S.; Wang, Y.G.; Pan, F. Resistive switching mechanisms relating to oxygen vacancies migration in both interfaces in Ti/HfOx/Pt memory devices. J. Appl. Phys. 2013, 113, 064510. [Google Scholar] [CrossRef]
- Raghavan, N.; Fantini, A.; Degraeve, R.; Roussel, P.J.; Goux, L.; Govoreanu, B.; Wouters, D.J.; Groeseneken, G.; Jurczak, M. Statistical insight into controlled forming and forming free stacks for HfOx RRAM. Microelectron. Eng. 2013, 109, 177–181. [Google Scholar] [CrossRef]
- Ku, B.; Abbas, Y.; Sokolov, A.S.; Choi, C. Interface engineering of ALD HfO2-based RRAM with Ar plasma treatment for reliable and uniform switching behaviors. J. Alloys Compd. 2018, 735, 1181–1188. [Google Scholar] [CrossRef]
- Lei, X.-Y.; Liu, H.-X.; Gao, H.-X.; Yang, H.-N.; Wang, G.-M.; Long, S.-B.; Ma, X.-H.; Liu, M. Resistive switching characteristics of Ti/ZrO2/Pt RRAM device. Chin. Phys. B 2014, 23, 117305. [Google Scholar] [CrossRef]
- Hussain, F.; Imran, M.; Khalil, R.A.; Sattar, M.A.; Niaz, N.A.; Rana, A.M.; Ismail, M.; Khera, E.A.; Rasheed, U.; Mumtaz, F. A first-principles study of Cu and Al doping in ZrO2 for RRAM device applications. Vacuum 2019, 168, 108842. [Google Scholar] [CrossRef]
- Wang, S.-Y.; Lee, D.-Y.; Huang, T.-Y.; Wu, J.-W.; Tseng, T.-Y. Controllable oxygen vacancies to enhance resistive switching performance in a ZrO2-based RRAM with embedded Mo layer. Nanotechnology 2010, 21, 495201. [Google Scholar] [CrossRef]
- Kim, T.; Son, H.; Kim, I.; Kim, J.; Lee, S.; Park, J.K.; Kwak, J.Y.; Park, J.; Jeong, Y. Reversible switching mode change in Ta2O5-based resistive switching memory (ReRAM). Sci. Rep. 2020, 10, 11247. [Google Scholar] [CrossRef]
- Sedghi, N.; Li, H.; Brunell, I.F.; Dawson, K.; Guo, Y.; Potter, R.J.; Gibbon, J.T.; Dhanak, V.R.; Zhang, W.D.; Zhang, J.F.; et al. Enhanced switching stability in Ta2O5 resistive RAM by fluorine doping. Appl. Phys. Lett. 2017, 111, 092904. [Google Scholar] [CrossRef]
- Xu, N.; Liu, L.; Sun, X.; Liu, X.; Han, D.; Wang, Y.; Han, R.; Kang, J.; Yu, B. Characteristics and mechanism of conduction/set process in TiN/ZnO/Pt resistance switching random-access memories. Appl. Phys. Lett. 2008, 92, 232112. [Google Scholar] [CrossRef]
- Simanjuntak, F.M.; Panda, D.; Wei, K.-H.; Tseng, T.-Y. Status and prospects of ZnO-based resistive switching memory devices. Nanoscale Res. Lett. 2016, 11, 368. [Google Scholar] [CrossRef] [PubMed]
- Asamitsu, A.; Tomioka, Y.; Kuwahara, H.; Tokura, Y. Current switching of resistive states in magnetoresistive manganites. Nature 1997, 388, 50. [Google Scholar] [CrossRef]
- Lashkare, S.; Chouhan, S.; Chavan, T.; Bhat, A.; Kumbhare, P.; Ganguly, U. PCMO RRAM for Integrate-and-Fire Neuron in Spiking Neural Networks. IEEE Electron Device Lett. 2018, 39, 484–487. [Google Scholar] [CrossRef]
- Panwar, N.; Ganguly, U. Variability assessment and mitigation by predictive programming in Pr0.7Ca0.3MnO3 based RRAM. In Proceedings of the 2015 73rd Annual Device Research Conference (DRC), Columbus, OH, USA, 21–24 June 2015; pp. 141–142. [Google Scholar]
- Kaith, P.; Garg, P.; Bera, A. Multilevel resistive switching in solution-processed CuFe2O4/TiO2 heterostructure. Appl. Phys. Lett. 2023, 122, 133301. [Google Scholar] [CrossRef]
- Wang, S.; Ning, X.; Hao, A.; Chen, R. Metal nanoparticles layer boosted resistive switching property in NiFe2O4-based memory devices. J. Alloys Compd. 2022, 908, 164569. [Google Scholar] [CrossRef]
- Rajarathinam, S.; Ganguly, U.; Venkataramani, N. Impact of oxygen partial pressure on resistive switching characteristics of PLD deposited ZnFe2O4 thin films for RRAM devices. Ceram. Int. 2022, 48, 7876–7884. [Google Scholar] [CrossRef]
- Ge, S.; Wang, Y.; Xiang, Z.; Cui, Y. Reset Voltage-Dependent Multilevel Resistive Switching Behavior in CsPb1–xBixI3 Perovskite-Based Memory Device. ACS Appl. Mater. Interfaces 2018, 10, 24620–24626. [Google Scholar] [CrossRef]
- Tian, Q.; Zhang, X.; Zhao, X.; Wang, Z.; Lin, Y.; Xu, H.; Liu, Y. Dual Buffer Layers for Developing Electrochemical Metallization Memory With Low Current and High Endurance. IEEE Electron Device Lett. 2021, 42, 308–311. [Google Scholar] [CrossRef]
- Mandal, S.; El-Amin, A.; Alexander, K.; Rajendran, B.; Jha, R. Novel synaptic memory device for neuromorphic computing. Sci. Rep. 2014, 4, 5333. [Google Scholar] [CrossRef]
- Park, S.; Noh, J.; Choo, M.L.; Sheri, A.M.; Chang, M.; Kim, Y.B.; Kim, C.J.; Jeon, M.; Lee, B.G.; Lee, B.H.; et al. Nanoscale RRAM-based synaptic electronics: Toward a neuromorphic computing device. Nanotechnology 2013, 24, 384009. [Google Scholar] [CrossRef] [PubMed]
- Shi, J.; Ha, S.D.; Zhou, Y.; Schoofs, F.; Ramanathan, S. A correlated nickelate synaptic transistor. Nat. Commun. 2013, 4, 2676. [Google Scholar] [CrossRef] [PubMed]
- Safi, I. Recent aspects concerning DC reactive magnetron sputtering of thin films: A review. Surf. Coat. Technol. 2000, 127, 203–218. [Google Scholar] [CrossRef]
- Davidse, P.; Maissel, L. Dielectric thin films through rf sputtering. J. Appl. Phys. 1966, 37, 574–579. [Google Scholar] [CrossRef]
- Vossen, J. Control of film properties by rf-sputtering techniques. J. Vac. Sci. Technol. 1971, 8, S12–S30. [Google Scholar] [CrossRef]
- Effects of applied electrical field on electronic structures in LaNiO3 conductive metallic oxide film: An optical spectroscopic study. Appl. Phys. Lett. 2010, 97. [CrossRef]
- Zhou, Q.; Cannata, J.M.; Meyer, R.J.; Van Tol, D.J.; Tadigadapa, S.; Hughes, W.J.; Shung, K.K.; Trolier-McKinstry, S. Fabrication and characterization of micromachined high-frequency tonpilz transducers derived by PZT thick films. IEEE Trans. Ultrason. Ferroelectr. Freq. Control. 2005, 52, 350–357. [Google Scholar] [CrossRef]
- Yan, H.; Zhang, D.; Xu, J.; Lu, Y.; Liu, Y.; Qiu, K.; Zhang, Y.; Luo, Y. Solution growth of NiO nanosheets supported on Ni foam as high-performance electrodes for supercapacitors. Nanoscale Res. Lett. 2014, 9, 1–7. [Google Scholar] [CrossRef]
- Qiao, L.; Bi, X. Direct observation of Ni3+ and Ni2+ in correlated LaNiO3−δ films. EPL (Europhys. Lett.) 2011, 93, 57002. [Google Scholar] [CrossRef]
- Qiao, L.; Bi, X. Direct observation of oxygen vacancy and its effect on the microstructure, electronic and transport properties of sputtered LaNiO3−δ films on Si substrates. Thin Solid Films 2010, 519, 943–946. [Google Scholar] [CrossRef]
- Mickevičius, S.; Grebinskij, S.; Bondarenka, V.; Vengalis, B.; Šliužienė, K.; Orlowski, B.A.; Osinniy, V.; Drube, W. Investigation of epitaxial LaNiO3−x thin films by high-energy XPS. J. Alloys Compd. 2006, 423, 107–111. [Google Scholar] [CrossRef]
- Misra, D.; Kundu, T.K. Oxygen vacancy induced metal-insulator transition in LaNiO3. Eur. Phys. J. B 2016, 89. [Google Scholar] [CrossRef]
- Bagdzevicius, S.; Maas, K.; Boudard, M.; Burriel, M. Interface-type resistive switching in perovskite materials. J. Electroceramics 2017, 39, 157–184. [Google Scholar] [CrossRef]
- Moon, K.; Lim, S.; Park, J.; Sung, C.; Oh, S.; Woo, J.; Lee, J.; Hwang, H. RRAM-based synapse devices for neuromorphic systems. Faraday Discuss. 2019, 213, 421–451. [Google Scholar] [CrossRef]
- Choi, J.-M.; Park, E.-J.; Woo, J.-J.; Kwon, K.-W. A highly linear neuromorphic synaptic device based on regulated charge trap/detrap. IEEE Electron Device Lett. 2019, 40, 1848–1851. [Google Scholar] [CrossRef]
- Chen, P.-Y.; Lin, B.; Wang, I.-T.; Hou, T.-H.; Ye, J.; Vrudhula, S.; Seo, J.-S.; Cao, Y.; Yu, S. Mitigating effects of non-ideal synaptic device characteristics for on-chip learning. In Proceedings of the 2015 IEEE/ACM International Conference on Computer-Aided Design (ICCAD), Austin, TX, USA, 2–6 November 2015; pp. 194–199. [Google Scholar]
- Li, Y.; Xuan, Z.; Lu, J.; Wang, Z.; Zhang, X.; Wu, Z.; Wang, Y.; Xu, H.; Dou, C.; Kang, Y.; et al. One Transistor One Electrolyte-Gated Transistor Based Spiking Neural Network for Power-Efficient Neuromorphic Computing System. Adv. Funct. Mater. 2021, 31, 2100042. [Google Scholar] [CrossRef]
- Wu, W.; Wu, H.; Gao, B.; Yao, P.; Zhang, X.; Peng, X.; Yu, S.; Qian, H. A methodology to improve linearity of analog RRAM for neuromorphic computing. In Proceedings of the 2018 IEEE Symposium on VLSI Technology, Honolulu, HI, USA, 18–22 June 2018; pp. 103–104. [Google Scholar]
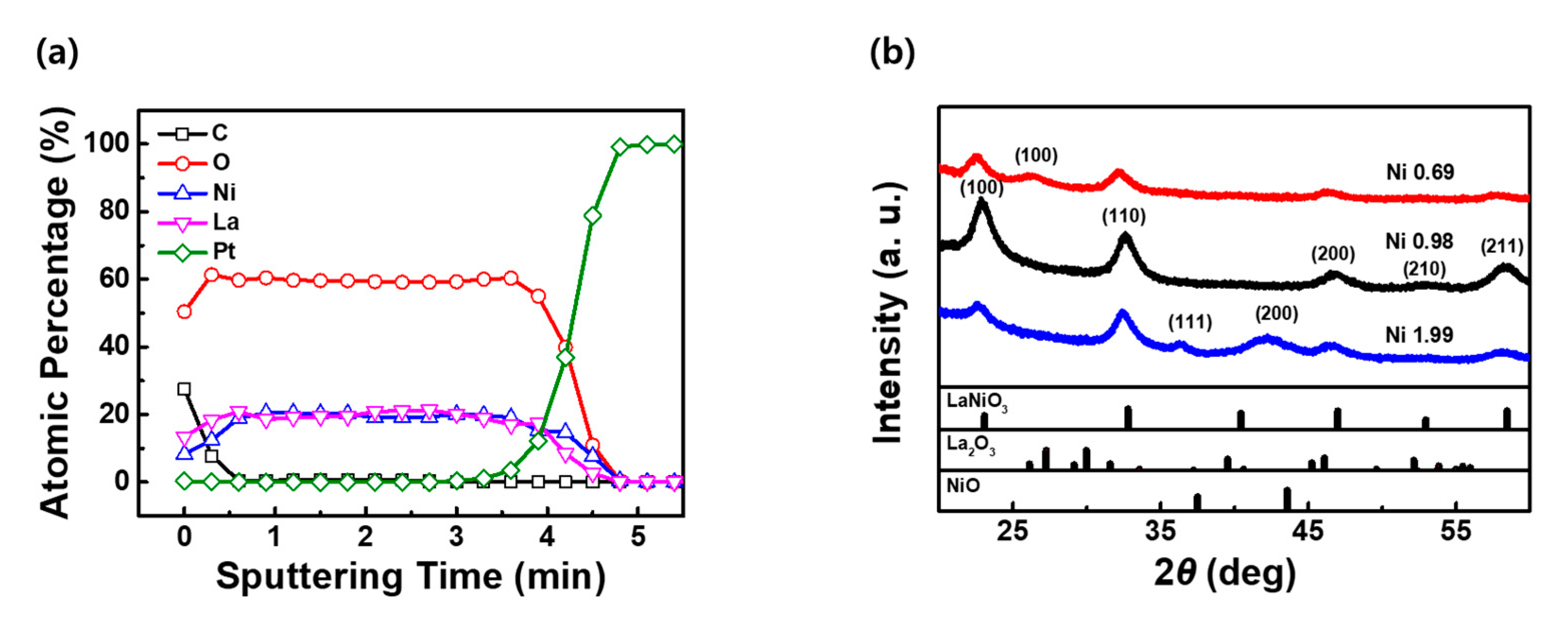
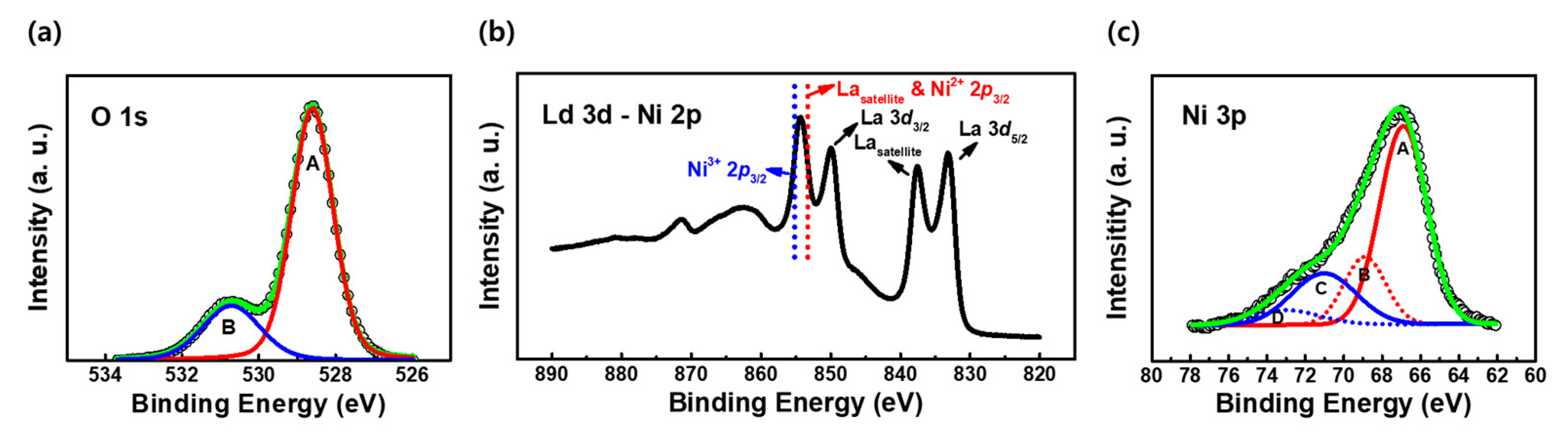
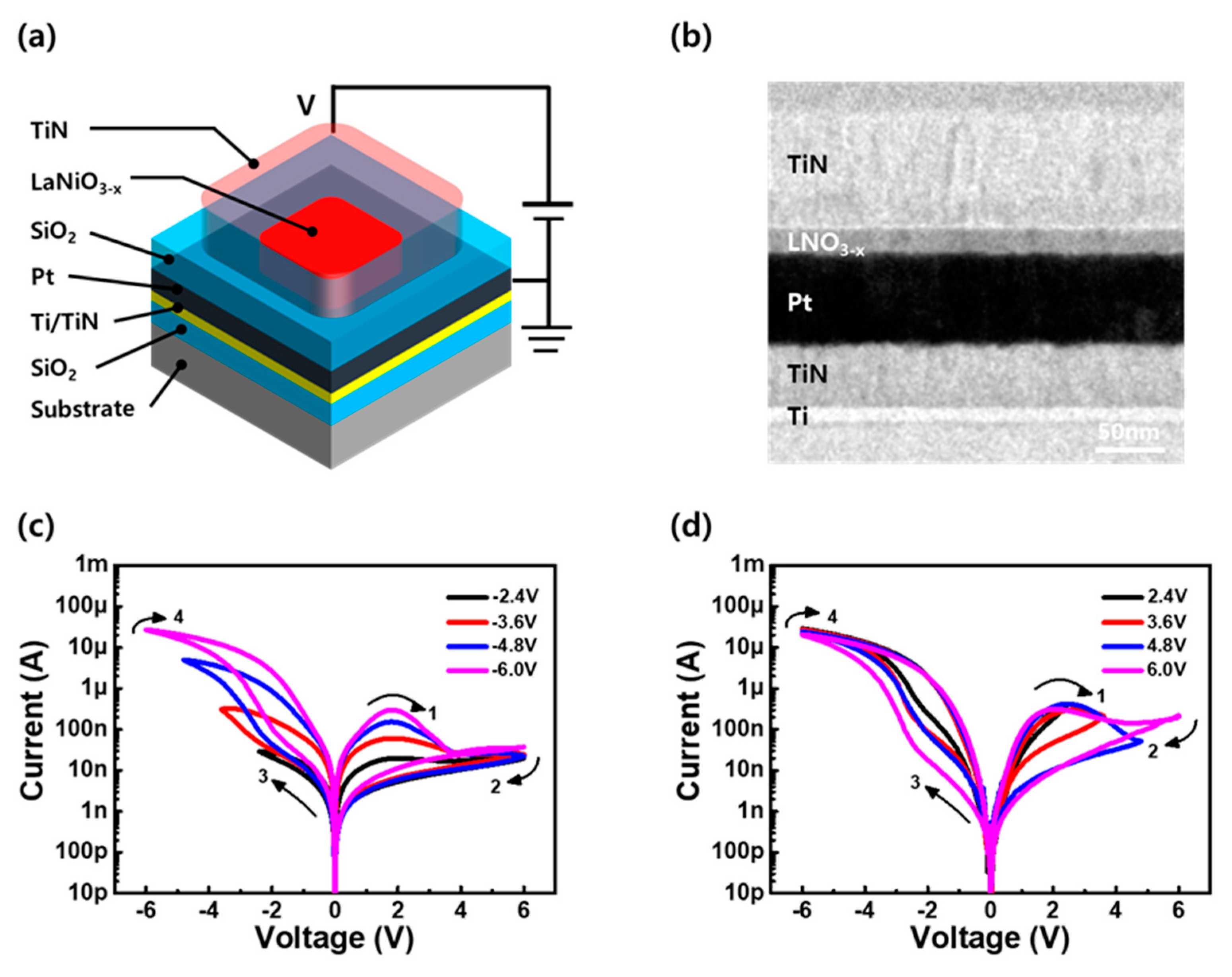
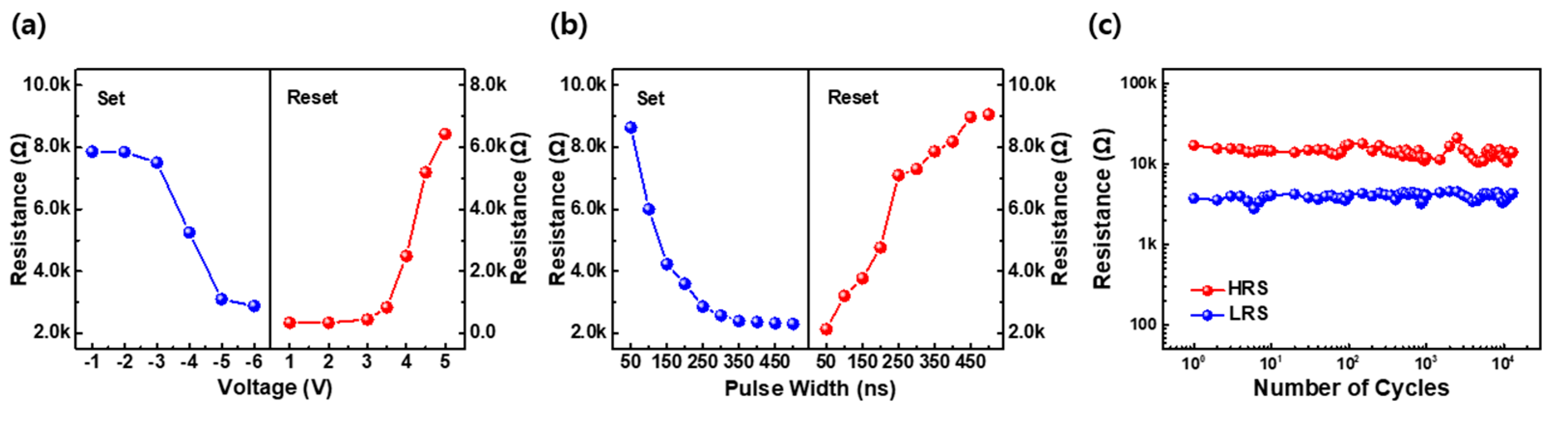

Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kim, D.; Lee, J.; Kim, J.; Sohn, H. Reset-First and Multibit-Level Resistive-Switching Behavior of Lanthanum Nickel Oxide (LaNiO3−x) Thin Films. Materials 2023, 16, 4992. https://doi.org/10.3390/ma16144992
Kim D, Lee J, Kim J, Sohn H. Reset-First and Multibit-Level Resistive-Switching Behavior of Lanthanum Nickel Oxide (LaNiO3−x) Thin Films. Materials. 2023; 16(14):4992. https://doi.org/10.3390/ma16144992
Chicago/Turabian StyleKim, Daewoo, Jeongwoo Lee, Jaeyeon Kim, and Hyunchul Sohn. 2023. "Reset-First and Multibit-Level Resistive-Switching Behavior of Lanthanum Nickel Oxide (LaNiO3−x) Thin Films" Materials 16, no. 14: 4992. https://doi.org/10.3390/ma16144992
APA StyleKim, D., Lee, J., Kim, J., & Sohn, H. (2023). Reset-First and Multibit-Level Resistive-Switching Behavior of Lanthanum Nickel Oxide (LaNiO3−x) Thin Films. Materials, 16(14), 4992. https://doi.org/10.3390/ma16144992




