Tuning the Optical and Electrical Properties of ALD-Grown ZnO Films by Germanium Doping
Abstract
1. Introduction
2. Materials and Methods
2.1. Fabrication of the Thin Films
Atomic Layer Deposition
2.2. Film Characterization
2.2.1. Scanning Electron Microscopy (SEM)
2.2.2. Spectroscopic Ellipsometry
2.2.3. X-ray Photoelectron Spectroscopy (XPS)
2.2.4. Electrical Properties
2.2.5. Optical Properties
2.2.6. Kelvin Probe Force Microscopy (KPFM)
3. Results and Discussion
3.1. Discussion on Physical and Electrical Properties
3.2. Discussion on Optical Prpoerties and Electronic States
3.3. Discussion on the Surface States
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Bagnall, D.M.; Chen, Y.F.; Zhu, Z.; Yao, T.; Koyama, S.; Shen, M.Y.; Goto, T. Optically Pumped Lasing of ZnO at Room Temperature. Appl. Phys. Lett. 1997, 70, 2230–2232. [Google Scholar] [CrossRef]
- Wenas, W.W.; De, A.; Yamada, A.; Konagai, M.; Takahashi, K. Optimization of ZnO for Front and Rear Con-tacts in A-Si Solar Cells. Sol. Energy Mater. Sol. Cells 1994, 34, 313–319. [Google Scholar] [CrossRef]
- Nakamura, M.; Yamaguchi, K.; Kimoto, Y.; Yasaki, Y.; Kato, T.; Sugimoto, H. Cd-Free Cu(In,Ga)(Se,S) 2 Thin-Film Solar Cell With Record Efficiency of 23.35%. IEEE J. Photovolt. 2019, 9, 1863–1867. [Google Scholar] [CrossRef]
- Sahayaraj, S.; Brammertz, G.; Vermang, B.; Mule, A.; Schnabel, T.; Meuris, M.; Vleugels, J.; Poortmans, J. Doping of Cu2ZnSnSe4 Solar Cells with Na+ or K+ Alkali Ions. J. Mater. Chem. A Mater. 2018, 6, 2653–2663. [Google Scholar] [CrossRef]
- Qiu, C.; Wu, Y.; Song, J.; Wang, W.; Li, Z. Efficient Planar Perovskite Solar Cells with ZnO Electron Transport Layer. Coatings 2022, 12, 1981. [Google Scholar] [CrossRef]
- Cao, J.; Wu, B.; Chen, R.; Wu, Y.; Hui, Y.; Mao, B.; Zheng, N. Efficient, Hysteresis-Free, and Stable Perovskite Solar Cells with ZnO as Electron-Transport Layer: Effect of Surface Passivation. Adv. Mater. 2018, 30, 1705596. [Google Scholar] [CrossRef]
- Janotti, A.; Van de Walle, C.G. Fundamentals of Zinc Oxide as a Semiconductor. Rep. Prog. Phys. 2009, 72, 126501. [Google Scholar] [CrossRef]
- Look, D.C. Recent Advances in ZnO Materials and Devices. Mater. Sci. Eng. B 2001, 80, 383–387. [Google Scholar] [CrossRef]
- Tasaki, S.; Tatami, J.; Nakano, H.; Wakihara, T.; Komeya, K.; Meguro, T. Fabrication of ZnO Ce-ramics Using ZnO/Al2O3 Nanocomposite Particles Prepared by Mechanical Treatment. J. Ceram. Soc. Jpn. 2010, 118, 118–121. [Google Scholar] [CrossRef]
- Hu, J.; Gordon, R.G. Textured Aluminum-Doped Zinc Oxide Thin Films from Atmospheric Pressure Chemi-cal-Vapor Deposition. J. Appl. Phys. 1992, 71, 880–890. [Google Scholar] [CrossRef]
- Kim, H.; Piqué, A.; Horwitz, J.S.; Murata, H.; Kafafi, Z.H.; Gilmore, C.M.; Chrisey, D.B. Effect of Aluminum Doping on Zinc Oxide Thin Films Grown by Pulsed Laser Deposition for Organic Light-Emitting Devices. Thin Solid Films 2000, 377–378, 798–802. [Google Scholar] [CrossRef]
- Salem, K.E.; Mokhtar, A.M.; Soliman, I.; Ramadan, M.; Shaheen, B.S.; Allam, N.K. Ge-Doped ZnO Nanorods Grown on FTO for Photoelectrochemical Water Splitting with Exceptional Photoconversion Efficiency. Int. J. Hydrogen Energy 2021, 46, 209–220. [Google Scholar] [CrossRef]
- Bouzid, H.; Ali, A.M.; Faisal, M.; Ismail, A.A. Germanium-Catalyzed Growth of Zinc Oxide Nanorods by Thermal Evaporation for Enhanced Photonic Efficiencies. J. Mol. Catal. A Chem. 2014, 390, 83–90. [Google Scholar] [CrossRef]
- Hoffman, R.L. ZnO Thin-Film Transistors. In Zinc Oxide Bulk, Thin Films and Nanostructures; Elsevier: Amsterdam, The Netherlands, 2006; pp. 415–442. [Google Scholar]
- Minami, T.; Nishi, Y.; Miyata, T. Efficiency Enhancement Using a Zn1−xGex-O Thin Film as an n-Type Win-dow Layer in Cu2O-Based Heterojunction Solar Cells. Appl. Phys. Express 2016, 9, 052301. [Google Scholar] [CrossRef]
- George, S.M. Atomic Layer Deposition: An Overview. Chem. Rev. 2010, 110, 111–131. [Google Scholar] [CrossRef] [PubMed]
- Chalker, P.R.; Marshall, P.A.; King, P.J.; Dawson, K.; Romani, S.; Williams, P.A.; Ridealgh, J.; Rosseinsky, M.J. Atomic Layer Deposition of Germanium-Doped Zinc Oxide Films with Tuneable Ultraviolet Emission. J. Mater. Chem. 2012, 22, 12824. [Google Scholar] [CrossRef]
- Knura, R.; Skibińska, K.; Sahayaraj, S.; Marciszko-Wiąckowska, M.; Gwizdak, J.; Wojnicki, M.; Żabiński, P.; Sapeta, G.; Iwanek, S.; Socha, R.P. Evaluation of the Electronic Properties of Atomic Layer Deposition-Grown Ge-Doped Zinc Oxide Thin Films at Elevated Temperatures. Electronics 2024, 13, 554. [Google Scholar] [CrossRef]
- Kim, S.; Lee, S.; Ham, S.-Y.; Ko, D.-H.; Shin, S.; Jin, Z.; Min, Y.-S. A Kinetic Study of ZnO Atomic Layer Depo-sition: Effects of Surface Hydroxyl Concentration and Steric Hindrance. Appl. Surf. Sci. 2019, 469, 804–810. [Google Scholar] [CrossRef]
- Tan, S.T.; Chen, B.J.; Sun, X.W.; Fan, W.J.; Kwok, H.S.; Zhang, X.H.; Chua, S.J. Blueshift of Optical Band Gap in ZnO Thin Films Grown by Metal-Organic Chemical-Vapor Deposition. J. Appl. Phys. 2005, 98, 013505. [Google Scholar] [CrossRef]
- Wei, S.H. Overcoming the Doping Bottleneck in Semiconductors. Comput. Mater. Sci. 2004, 30, 337–348. [Google Scholar] [CrossRef]
- Jefferson, P.H.; Hatfield, S.A.; Veal, T.D.; King, P.D.C.; McConville, C.F.; Zúñiga–Pérez, J.; Muñoz–Sanjosé, V. Bandgap and Effective Mass of Epitaxial Cadmium Oxide. Appl. Phys. Lett. 2008, 92, 022101. [Google Scholar] [CrossRef]
- Burstein, E. Anomalous Optical Absorption Limit in InSb. Phys. Rev. 1954, 93, 632–633. [Google Scholar] [CrossRef]
- Moss, T.S. The Interpretation of the Properties of Indium Antimonide. Proc. Phys. Soc. Sect. B 1954, 67, 775–782. [Google Scholar] [CrossRef]
- Sernelius, B.E.; Berggren, K.-F.; Jin, Z.-C.; Hamberg, I.; Granqvist, C.G. Band-Gap Tailoring of ZnO by Means of Heavy Al Doping. Phys. Rev. B 1988, 37, 10244–10248. [Google Scholar] [CrossRef] [PubMed]
- Syrbu, N.N.; Tiginyanu, I.M.; Zalamai, V.V.; Ursaki, V.V.; Rusu, E.V. Exciton Polariton Spectra and Carrier Effective Masses in ZnO Single Crystals. Phys. B Condens. Matter 2004, 353, 111–115. [Google Scholar] [CrossRef]
- Ye, J.D.; Gu, S.L.; Zhu, S.M.; Liu, S.M.; Zheng, Y.D.; Zhang, R.; Shi, Y. Fermi-Level Band Filling and Band-Gap Renormalization in Ga-Doped ZnO. Appl. Phys. Lett. 2005, 86, 192111. [Google Scholar] [CrossRef]
- Jia, J.; Takasaki, A.; Oka, N.; Shigesato, Y. Experimental Observation on the Fermi Level Shift in Polycrystal-line Al-Doped ZnO Films. J. Appl. Phys. 2012, 112, 013718. [Google Scholar] [CrossRef]
- Whalley, L.D.; Frost, J.M.; Morgan, B.J.; Walsh, A. Impact of Nonparabolic Electronic Band Structure on the Optical and Transport Properties of Photovoltaic Materials. Phys. Rev. B 2019, 99, 085207. [Google Scholar] [CrossRef]
- Walsh, A.; Da Silva, J.L.F.; Wei, S.-H. Origins of Band-Gap Renormalization in Degenerately Doped Semi-conductors. Phys. Rev. B 2008, 78, 075211. [Google Scholar] [CrossRef]
- Sans, J.A.; Sánchez-Royo, J.F.; Segura, A.; Tobias, G.; Canadell, E. Chemical Effects on the Optical Band-Gap of Heavily Doped ZnO:MIII (M = Al, Ga, In): An Investigation by Means of Photoelectron Spectroscopy, Optical Measurements under Pressure, and Band Structure Calculations. Phys. Rev. B 2009, 79, 195105. [Google Scholar] [CrossRef]
- Klein, A.; Körber, C.; Wachau, A.; Säuberlich, F.; Gassenbauer, Y.; Schafranek, R.; Harvey, S.P.; Mason, T.O. Surface Potentials of Magnetron Sputtered Transparent Conducting Oxides. Thin Solid Film. 2009, 518, 1197–1203. [Google Scholar] [CrossRef]
- Moormann, H.; Kohl, D.; Heiland, G. Work Function and Band Bending on Clean Cleaved Zinc Oxide Sur-faces. Surf. Sci. 1979, 80, 261–264. [Google Scholar] [CrossRef]
- Jacobi, K.; Zwicker, G.; Gutmann, A. Work Function, Electron Affinity and Band Bending of Zinc Oxide Sur-faces. Surf. Sci. 1984, 141, 109–125. [Google Scholar] [CrossRef]
- Moulder, J.F.; Chastain, J. (Eds.) Handbook of X-Ray Photoelectron Spectroscopy: A Reference Book of Standard Spectra for Identification and Interpretation of XPS Data; Perkin-Elmer Corporation: Eden Prairie, MN, USA, 1992. [Google Scholar]
- Rumble, J.R.; Bickham, D.M.; Powell, C.J. The NIST X-ray Photoelectron Spectroscopy Database. Surf. Interface Anal. 1992, 19, 241–246. [Google Scholar] [CrossRef]
- Viñes, F.; Iglesias-Juez, A.; Illas, F.; Fernández-García, M. Hydroxyl Identification on ZnO by Infrared Spec-troscopies: Theory and Experiments. J. Phys. Chem. C 2014, 118, 1492–1505. [Google Scholar] [CrossRef]
- Banger, K.K.; Yamashita, Y.; Mori, K.; Peterson, R.L.; Leedham, T.; Rickard, J.; Sirringhaus, H. Low-Temperature, High-Performance Solution-Processed Metal Oxide Thin-Film Transistors Formed by a ‘Sol–Gel on Chip’ Process. Nat. Mater. 2011, 10, 45–50. [Google Scholar] [CrossRef]
- Choi, Y.-J.; Kang, K.-M.; Park, H.-H. Anion-Controlled Passivation Effect of the Atomic Layer Deposited ZnO Films by F Substitution to O-Related Defects on the Electronic Band Structure for Transparent Contact Layer of Solar Cell Applications. Sol. Energy Mater. Sol. Cells 2015, 132, 403–409. [Google Scholar] [CrossRef]
- Gao, Q.; Dai, Y.; Li, C.; Yang, L.; Li, X.; Cui, C. Correlation between Oxygen Vacancies and Dopant Concen-tration in Mn-Doped ZnO Nanoparticles Synthesized by Co-Precipitation Technique. J. Alloys Compd. 2016, 684, 669–676. [Google Scholar] [CrossRef]
- Li, Y.; Chen, J.; Cai, P.; Wen, Z. An Electrochemically Neutralized Energy-Assisted Low-Cost Acid-Alkaline Electrolyzer for Energy-Saving Electrolysis Hydrogen Generation. J. Mater. Chem. A Mater. 2018, 6, 4948–4954. [Google Scholar] [CrossRef]
- Yan, Z.; Bao, J.; Yue, X.-Y.; Li, X.-L.; Zhou, Y.-N.; Wu, X.-J. Impacts of Preparation Conditions on Photoelectric Properties of the ZnO:Ge Transparent Conductive Thin Films Fabricated by Pulsed Laser Deposition. J. Alloys Compd. 2020, 812, 152093. [Google Scholar] [CrossRef]
- Zhao, W.; Zhou, Q.; Zhang, X.; Wu, X. A Study on Ti-Doped ZnO Transparent Conducting Thin Films Fabri-cated by Pulsed Laser Deposition. Appl. Surf. Sci. 2014, 305, 481–486. [Google Scholar] [CrossRef]

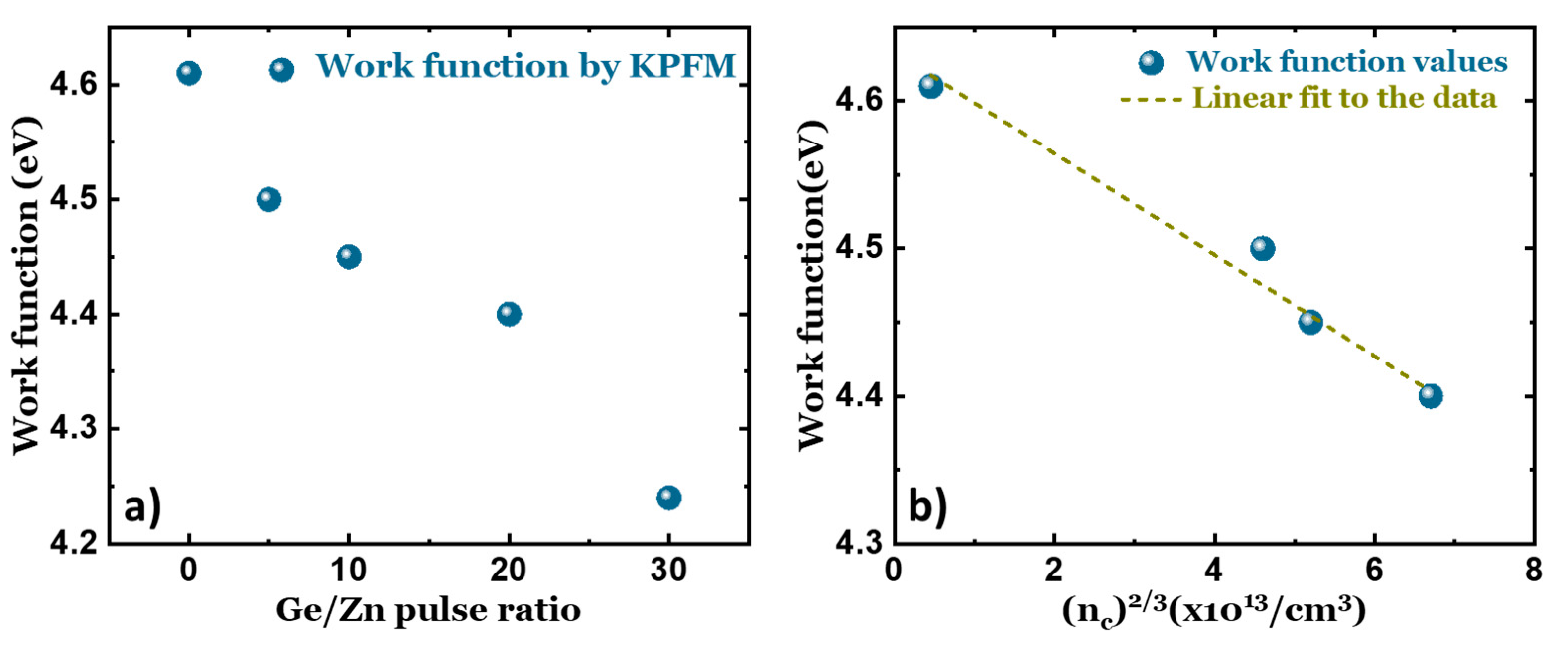


Pulse Ratio (%) | Chemical Composition (at. %) | Atomic Ratio (%) | ||
|---|---|---|---|---|
| O | Zn | Ge | ||
| 0 | 69.9 ± 0.8 | 30.1 ± 0.8 | - | - |
| 5 | 70.4 ± 0.8 | 27.8 ± 0.8 | 1.8 ± 0.2 | 6.1 |
| 10 | 69.4 ± 1.3 | 27.5 ± 1.5 | 3.1 ± 0.5 | 10.1 |
| 20 | 70.8 ± 0.8 | 23.7 ± 0.6 | 5.5 ± 0.4 | 18.8 |
| 30 | 70.1 ± 0.6 | 23.0 ± 0.1 | 6.8 ± 0.4 | 22.8 |
| Pulse Ratio (%) | Electrical Properties | Thickness (nm) | Refractive Index (n) | ||
|---|---|---|---|---|---|
| Conductivity (×103 S·m) | Carrier Density (1020/cm3) | Mobility (cm2/Vs) | |||
| 0 | 9.5 | 0.1 | 20 | 97 | 1.98 |
| 5 | 37 | 3.1 | 7 | 97.3 | 1.92 |
| 10 | 22 | 3.7 | 3.8 | 99.4 | 1.86 |
| 20 | 2.2 | 5.5 | 0.75 | 86.2 | 1.82 |
| 30 | - | - | - | 65 | 1.76 |
| Sample | 0% Ge:ZnO | 5% Ge:ZnO | 10% Ge:ZnO | 20% Ge:ZnO | 30% Ge:ZnO |
|---|---|---|---|---|---|
| Band gap | 3.26 eV | 3.45 eV | 3.60 eV | 3.65 eV | 3.82 eV |
| Sample | Zn 2p | Ge 3d | O 1s | ||||||
|---|---|---|---|---|---|---|---|---|---|
| A (eV) | B (eV) | C (eV) | A(eV) | B(eV) | A (eV) | B (eV) | C (eV) | D (eV) | |
| 30% Ge:ZnO | 1019.2 3.1% | 1021.5 61.69 | 1022.5 35.3% | 30.6 10% | 32.2 90% | 528.8 3.5% | 530.8 54.4% | 532.1 34.1% | 532.9 8% |
| 20% Ge:ZnO | 1019.2 3.2% | 1021.8 63.8% | 1022.5 33% | 30.3 12.2% | 32.1 88.8% | 528.7 3.1% | 530.7 55.7% | 531.7 33.6% | 532.8 7.5% |
| 10% Ge:ZnO | 1019.1 3.1% | 1021.7 66.7% | 1022.4 30.2% | 29.8 14.4% | 32.1 85.6% | 528.6 2.6% | 530.6 56.1% | 531.6 33% | 532.8 6.9% |
| 5% Ge:ZnO | 1019.1 2.9% | 1021.5 73.7% | 1022.3 23.4% | 29.3 26.2% | 32.0 73.8% | 528.5 2.3% | 530.5 62.6% | 531.8 26.5% | 532.7 8.2% |
| 0% Ge:ZnO | 1018.8 3.2% | 1021.5 77.7% | 1022.2 19.1% | - | - | 528.3 2.5% | 530.4 63.2% | 531.7 23.8% | 532.7 11.1% |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2024 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Sahayaraj, S.; Knura, R.; Skibińska, K.; Starowicz, Z.; Bulowski, W.; Gawlińska-Nęcek, K.; Panek, P.; Wojnicki, M.; Iwanek, S.; Majchrowicz, Ł.; et al. Tuning the Optical and Electrical Properties of ALD-Grown ZnO Films by Germanium Doping. Materials 2024, 17, 2906. https://doi.org/10.3390/ma17122906
Sahayaraj S, Knura R, Skibińska K, Starowicz Z, Bulowski W, Gawlińska-Nęcek K, Panek P, Wojnicki M, Iwanek S, Majchrowicz Ł, et al. Tuning the Optical and Electrical Properties of ALD-Grown ZnO Films by Germanium Doping. Materials. 2024; 17(12):2906. https://doi.org/10.3390/ma17122906
Chicago/Turabian StyleSahayaraj, Sylvester, Rafał Knura, Katarzyna Skibińska, Zbigniew Starowicz, Wojciech Bulowski, Katarzyna Gawlińska-Nęcek, Piotr Panek, Marek Wojnicki, Sylwester Iwanek, Łukasz Majchrowicz, and et al. 2024. "Tuning the Optical and Electrical Properties of ALD-Grown ZnO Films by Germanium Doping" Materials 17, no. 12: 2906. https://doi.org/10.3390/ma17122906
APA StyleSahayaraj, S., Knura, R., Skibińska, K., Starowicz, Z., Bulowski, W., Gawlińska-Nęcek, K., Panek, P., Wojnicki, M., Iwanek, S., Majchrowicz, Ł., & Socha, R. P. (2024). Tuning the Optical and Electrical Properties of ALD-Grown ZnO Films by Germanium Doping. Materials, 17(12), 2906. https://doi.org/10.3390/ma17122906









