Calibration of Polarization Fields and Electro-Optical Response of Group-III Nitride Based c-Plane Quantum-Well Heterostructures by Application of Electro-Modulation Techniques
Abstract
:1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. PIN-Diodes Based on InGaN/GaN DHS with 5.5% In
3.2. PIN-Diodes Based on InAlN/GaN DHS with 15, 18, 21% In
3.3. Results of Comparative Studies of Polarization Fields by Electroreflectance (ER) Spectroscopy and Capacitance-Voltage Measurements (CVM)
3.4. Comments on Formalism of Polarization Field Determination
3.5. Electrooptical Response of PIN-Diodes Sensed by Electroluminescence (EL) Spectroscopy
4. Conclusions
Funding
Acknowledgments
Conflicts of Interest
References
- Senoh, M.; Nakamura, S.; Mukai, T. High-power InGaN/GaN double-heterostructure violet light emitting diodes. Appl. Phys. Lett. 1993, 62, 2390–2392. [Google Scholar]
- Kuball, M.; Jeon, E.-S.; Song, Y.-K.; Nurmikko, A.V.; Kozodoy, P.; Abare, A.; Keller, S.; Coldren, L.A.; Mishra, U.K.; DenBaars, S.P.; et al. Gain spectroscopy on InGaN/GaN quantum well diodes. Appl. Phys. Lett. 1997, 70, 2580–2582. [Google Scholar] [CrossRef]
- Ambacher, O. Growth and applications of Group III-nitrides. J. Phys. D Appl. Phys. 1998, 31, 2653–2710. [Google Scholar] [CrossRef]
- Ye, P.D.; Yang, B.; Ng, K.K.; Bude, J.; Wilk, G.D.; Halder, S.; Hwang, J.C.M. GaN metal-oxide-semiconductor high-electron-mobility-transistor with atomic layer deposited Al2O3 as gate dielectric. Appl. Phys. Lett. 2005, 86, 063501. [Google Scholar] [CrossRef] [Green Version]
- Kaplar, R.J.; Kurtz, S.R.; Koleske, D.D. Novel optical probes of InGaN/GaN light-emitting diodes: 1. Electroreflectance Stark spectroscopy, and 2. Time-resolved emission. Phys. Status Solidi (C) 2005, 2, 2866–2870. [Google Scholar] [CrossRef]
- Ruterana, P.; Albrecht, M.; Neugebauer, J. (Eds.) Nitride Semiconductors: Handbook on Materials and Device; John Wiley & Sons: Hoboken, NJ, USA, 2003. [Google Scholar]
- Schubert, E.F. Light-Emitting Diodes; Cambridge University Press: Cambridge, UK, 2006. [Google Scholar]
- Farrell, R.M.; Neufeld, C.J.; Cruz, S.C.; Lang, J.R.; Iza, M.; Keller, S.; Nakamura, S.; DenBaars, S.P.; Mishra, U.K.; Speck, J.S. High quantum efficiency InGaN/GaN multiple quantum well solar cells with spectral response extending out to 520 nm. Appl. Phys. Lett. 2011, 98, 201107. [Google Scholar] [CrossRef]
- Morkoç, H. Handbook of Nitride Semiconductors and Devices, Materials Properties, Physics and Growth; John Wiley & Son: Hoboken, NJ, USA, 2009. [Google Scholar]
- Wu, J. When group-III nitrides go infrared: New properties and perspectives. J. Appl. Phys. 2009, 106, 11101. [Google Scholar] [CrossRef]
- Sizov, D.; Bhat, R.; Zah, C.E. Gallium Indium Nitride-Based Green Lasers. J. Lightwave Technol. 2012, 5, 679. [Google Scholar] [CrossRef]
- Willner, A.E.; Byer, R.L.; Chang-Hasnain, C.J.; Forrest, S.R.; Kressel, H.; Kogelnik, H.; Tearney, G.J.; Townes, C.H.; Zervas, M.N. Optics and Photonics: Key Enabling Technologies. Proc. IEEE 2012, 100, 1604–1643. [Google Scholar] [CrossRef]
- DenBaars, S.P.; Feezell, D.; Kelchner, K.; Pimputkar, S.; Pan, C.-C.; Yen, C.-C.; Tanaka, S.; Zhao, Y.; Pfaff, N.; Farrell, R.; et al. Development of gallium-nitride-based light-emitting diodes (LEDs) and laser diodes for energy-efficient lighting and displays. Acta Mater. 2013, 61, 945–951. [Google Scholar] [CrossRef]
- Hatakeyama, Y.; Nomoto, K.; Terano, A.; Kaneda, N.; Tsuchiya, T.; Mishima, T.; Nakamura, T. High-Breakdown-Voltage and Low-Specific-on-Resistance GaN p–n Junction Diodes on Free-Standing GaN Substrates Fabricated Through Low-Damage Field-Plate Process. Jpn. J. Appl. Phys. 2013, 52, 28007. [Google Scholar] [CrossRef]
- Krishnamoorthy, S.; Akyol, F.; Park, P.S.; Rajan, S. Low resistance GaN/InGaN/GaN tunnel junctions. Appl. Phys. Lett. 2013, 102, 113503. [Google Scholar] [CrossRef]
- Kneissl, M.; Rass, J. (Eds.) III-Nitride Ultraviolet Emitters: Technology and Applications; Springer: Berlin/Heidelberg, Germany, 2016. [Google Scholar]
- Huang, J.J.; Kuo, H.C.; Shen, S.C. Nitride Semiconductor Light-Emitting Diodes (LEDs): Materials, Technologies and Applications; Woodhead Publishing: Sawston, UK, 2016. [Google Scholar]
- Ferreyra, R.A.; Zhu, C.; Teke, A.; Morkoç, H. Group III Nitrides. In Springer Handbook of Electronic and Photonic Materials; Kasap, S., Capper, P., Eds.; Springer: Berlin/Heidelberg, Germany, 2017. [Google Scholar]
- Bernardini, F.; Fiorentini, V.; Vanderbilt, D. Spontaneous polarization and piezoelectric constants of III-V nitrides. Phys. Rev. B 1997, 56, R10024. [Google Scholar] [CrossRef] [Green Version]
- Takeuchi, Y.; Sota, S.; Katsuragawa, M.; Komori, M.; Takeuchi, H.; Amano, H.; Akasaki, I. Theoretical Study of Orientation Dependence of Piezoelectric Effects in Wurtzite Strained GaInN/GaN Heterostructures and Quantum Wells. Jpn. J. Appl. Phys. 1997, 36, 382. [Google Scholar] [CrossRef]
- Yu, E.T.; Dang, X.Z.; Asbeck, P.M.; Lau, S.S.; Sullivan, G.J. Spontaneous and piezoelectric polarization effects in III–V nitride heterostructures. J. Vac. Sci. Technol. B 1999, 17, 1742. [Google Scholar] [CrossRef] [Green Version]
- Bernardini, F.; Fiorentini, V.; Vanderbilt, D. Accurate calculation of polarization-related quantities in semiconductors. Phys. Rev. B 2001, 63, 193201. [Google Scholar] [CrossRef] [Green Version]
- Zoroddu, A.; Bernardini, F.; Fiorentini, V.; Ruggerone, P. First-principles prediction of structure, energetics, formation enthalpy, elastic constants, polarization, and piezoelectric constants of AlN, GaN, and InN: Comparison of local and gradient-corrected density-functional theory. Phys. Rev. B 2001, 64, 045208. [Google Scholar] [CrossRef] [Green Version]
- Bernardini, F.; Fiorentini, V. Nonlinear macroscopic polarization in III-V nitride alloys. Phys. Rev. B 2001, 64, 129903. [Google Scholar] [CrossRef] [Green Version]
- Bernardini, F.; Fiorentini, V.; Ambacher, O. Evidence for nonlinear macroscopic polarization in III–V nitride alloy heterostructures. Appl. Phys. Lett. 2002, 80, 1204–1206. [Google Scholar]
- Ambacher, O.; Miskys, C.; Eickhoff, M.; Bernardini, F.; Tilak, V.; Eastman, L.F.; Majewski, J.; Link, A.; Hermann, M.; Stutzmann, M.; et al. Pyroelectric properties of Al(In)GaN/GaN hetero- and quantum well structures. J. Phys. Condens. Matter 2002, 14, 3399–3434. [Google Scholar] [CrossRef]
- Li, J.M.; Lü, Y.W.; Li, D.B.; Han, X.X.; Zhu, Q.S.; Liu, X.L.; Wang, Z.G. Effect of spontaneous and piezoelectric polarization on intersubband transition in AlxGa1−xN–GaN quantum well. J. Vac. Sci. Technol. B Microelectron. Nanometer Struct. 2004, 22, 2568. [Google Scholar] [CrossRef]
- Brown, I.H.; Pope, I.A.; Smowton, P.M.; Blood, P.; Thomson, J.D.; Chow, W.W.; Bour, D.P.; Kneissl, M. Determination of the piezoelectric field in InGaN quantum wells. Appl. Phys. Lett. 2005, 86, 131108. [Google Scholar] [CrossRef] [Green Version]
- Feneberg, M.; Thonke, K. Polarization fields of III-nitrides grown in different crystal orientations. J. Phys. Condens. Matter 2007, 19, 403201. [Google Scholar] [CrossRef] [PubMed]
- Schwarz, U.T.; Kneissl, M. Nitride emitters go nonpolar. Phys. Status Solidi (RRL)-Rapid Res. Lett. 2007, 1, A44–A46. [Google Scholar] [CrossRef]
- Xu, D.; He, H.; Pandey, R.; Karna, S.P. Stacking and electric field effects in atomically thin layers of GaN. J. Phys. Condens. Matter 2013, 25, 345302. [Google Scholar] [CrossRef] [PubMed]
- Ibbetson, J.P.; Fini, P.T.; Ness, K.D.; DenBaars, S.P.; Speck, J.S.; Mishra, U.K. Polarization effects, surface states, and the source of electrons in AlGaN/GaN heterostructure field effect transistors. Appl. Phys. Lett. 2000, 77, 250–252. [Google Scholar] [CrossRef]
- Hanada, T. Basic Properties of ZnO, GaN, and Related Materials. In Oxide and Nitride Semiconductors; Yao, T., Hong, S.K., Eds.; Springer: Berlin/Heidelberg, Germany, 2009. [Google Scholar]
- Dreyer, C.E.; Janotti, A.; Van De Walle, C.G.; Vanderbilt, D. Correct Implementation of Polarization Constants in Wurtzite Materials and Impact on III-Nitrides. Phys. Rev. X 2016, 6, 021038. [Google Scholar] [CrossRef]
- Kisielowski, C.; Krüger, J.; Ruvimov, S.; Suski, T.; Ager, J.W., III; Jones, E.; Liliental-Weber, Z.; Rubin, M.; Weber, E.R.; Bremser, M.D.; et al. Strain-related phenomena in GaN thin films. Phys. Rev. B 1996, 54, 17745. [Google Scholar] [CrossRef] [Green Version]
- Lorenz, K.; Franco, N.; Alves, E.; Watson, I.M.; Martin, R.W.; O’Donnell, K.P. Anomalous Ion Channeling in AlInN/GaN Bilayers: Determination of the Strain State. Phys. Rev. Lett. 2006, 97, 085501. [Google Scholar] [CrossRef] [Green Version]
- Lorenz, K.; Franco, N.; Alves, E.; Pereira, S.; Watson, I.; Martin, R.; O’Donnell, K. Relaxation of compressively strained AlInN on GaN. J. Cryst. Growth 2008, 310, 4058–4064. [Google Scholar] [CrossRef]
- Wright, A.F. Elastic properties of zinc-blende and wurtzite AlN, GaN, and InN. J. Appl. Phys. 1997, 82, 2833–2839. [Google Scholar] [CrossRef]
- Böttger, H.; Bryksin, V.V. Hopping conductivity in ordered and disordered solids (I). Phys. Status Solidi (b) 1976, 78, 9–56. [Google Scholar] [CrossRef]
- Takeuchi, T.; Sota, S.; Katsuragawa, M.; Komori, M.; Takeuchi, H.; Amano, H.; Akasaki, I. Quantum-Confined Stark Effect due to Piezoelectric Fields in GaInN Strained Quantum Wells. Jpn. J. Appl. Phys. 1997, 36, L382. [Google Scholar] [CrossRef]
- Wetzel, C.; Takeuchi, T.; Amano, H.; Akasaki, I. Piezoelectric Stark-like Ladder in GaN/GaInN/GaN Heterostructures. Jpn. J. Appl. Phys. 1999, 38, L163. [Google Scholar] [CrossRef] [Green Version]
- Dong, L.; Yadav, S.; Ramprasad, R.; Alpay, S.P. Band gap tuning in GaN through equibiaxial in-plane strains. Appl. Phys. Lett. 2010, 96, 202106. [Google Scholar] [CrossRef] [Green Version]
- Yan, Q.; Rinke, P.; Janotti, A.; Scheffler, M.; Van De Walle, C.G. Effects of strain on the band structure of group-III nitrides. Phys. Rev. B 2014, 90, 125118. [Google Scholar] [CrossRef] [Green Version]
- Roumeliotis, G.G. MSc-thesis (English) III-Nitride Emitters and Converters: Built-in Polarization-Induced Electric Fields, Built-in Potential, and Effective Doping Concentration. Master’s Thesis, National Technical University of Athens, Interdisciplinary Interdepartmental Postgraduate Program Materials Science and Technology, Athens, Greece, 2017. [Google Scholar]
- Susilo, N.; Roumeliotis, G.; Narodovitch, M.; Witzigmann, B.; Rychetsky, M.; Neugebauer, S.; Gutmann, M.; Enslin, J.; Dadgar, A.; Niermann, T.; et al. Accurate determination of polarization fields in (0001) c-plane InAlN/GaN heterostructures with capacitance-voltage-measurements. J. Phys. D Appl. Phys. 2018, 51, 485103. [Google Scholar] [CrossRef]
- Rychetsky, M.; Koslow, I.; Avinc, B.; Rass, J.; Wernicke, T.; Bellmann, K.; Sulmoni, L.; Hoffmann, V.; Weyers, M.; Wild, J.; et al. Determination of polarization fields in group III-nitride heterostructures by capacitance-voltage-measurements. J. Appl. Phys. 2016, 119, 095713. [Google Scholar] [CrossRef]
- Gessmann, T.; Graff, J.W.; Waldron, E.L.; Schubert, E.F.; Li, Y.-L. Ohmic contact technology in III nitrides using polarization effects of cap layers. J. Appl. Phys. 2002, 92, 3740–3744. [Google Scholar] [CrossRef]
- Schubert, E.F.; Kopf, R.F.; Kuo, J.M.; Luftman, H.S.; Garbinski, P.A. Spatial resolution of the capacitance-voltage profiling technique on semiconductors with quantum confinement. Appl. Phys. Lett. 1990, 57, 497–499. [Google Scholar] [CrossRef]
- Schubert, E.F.; Kuo, J.M.; Kopf, R.F. Theory and experiment of capacitance-voltage profiling on semiconductors with quantum-confinement. J. Electron. Mater. 1990, 19, 521–531. [Google Scholar] [CrossRef]
- Rimmer, J.S.; Hamilton, B.; Peaker, A.R. Capacitance-Voltage Profiling of Multilayer Semiconductor Structures in Low-Dimensional Structures in Semiconductors; Springer: Berlin/Heidelberg, Germany, 1991; pp. 139–146. [Google Scholar]
- Iniewski, K. Optimization of the capacitance–voltage profiling method based on inverse modeling. J. Vac. Sci. Technol. B Microelectron. Nanometer Struct. 1992, 10, 480. [Google Scholar] [CrossRef]
- Sundaram, M.; Gossard, A.C. Capacitance-voltage profiling through graded heterojunctions: Theory and experiment. J. Appl. Phys. 1993, 73, 251–260. [Google Scholar] [CrossRef]
- Tschirner, B.M.; Morier-Genoud, F.; Martin, D.; Reinhart, F.K. Capacitance-voltage profiling of quantum well structures. J. Appl. Phys. 1996, 79, 7005–7013. [Google Scholar] [CrossRef]
- Bobylev, B.; Kovalevskaja, T.; Marchishin, I.; Ovsyuk, V. Capacitance-voltage profiling of multiquantum well structures. Solid State Electron. 1997, 41, 481–486. [Google Scholar] [CrossRef]
- Reynolds, N.D.; Panda, C.D.; Essick, J.M. Capacitance-voltage profiling: Research-grade approach versus low-cost alternatives. Am. J. Phys. 2014, 82, 196–205. [Google Scholar] [CrossRef] [Green Version]
- Aghaei, S.; Hehta, M.; Andrei, P.; Hagmann, M.J. Challenges and opportunities in atomistic dopant profiling using capacitance-voltage measurements. In Proceedings of the 25th Annual SEMI Advanced Semiconductor Manufacturing Conference (ASMC 2014), Institute of Electrical and Electronics Engineers, Saratoga Springs, NY, USA, 19–21 May 2014; pp. 130–135. [Google Scholar]
- Biswas, D.; Panda, S. An effective approach for the minimization of errors in capacitance-voltage carrier profiling of quantum structures. J. Appl. Phys. 2014, 115, 134308. [Google Scholar] [CrossRef]
- Watanabe, M.O.; Ohba, Y. Interface properties for GaAs/InGaAlP heterojunctions by the capacitance-voltage profiling technique. Appl. Phys. Lett. 1987, 50, 906–908. [Google Scholar] [CrossRef]
- Knübel, A.; Polyakov, V.M.; Kirste, L.; Aidam, R. Nonuniformity of electron density in In-rich InGaN films deduced from electrolyte capacitance-voltage profiling. Appl. Phys. Lett. 2010, 96, 82106. [Google Scholar] [CrossRef]
- Wang, X.-H.; Zhao, M.; Liu, X.-Y.; Pu, Y.; Zheng, Y.-K.; Wei, K. The physical process analysis of the capacitance—Voltage characteristics of AlGaN/AlN/GaN high electron mobility transistors. Chin. Phys. B 2010, 19, 97302. [Google Scholar]
- Suzuki, M.; Uenoyama, T.; Yanase, A. First-principles calculations of effective-mass parameters of A1N and GaN. Phys. Rev. B 1995, 52, 8132–8139. [Google Scholar] [CrossRef] [PubMed]
- Suzuki, M.; Uenoyama, T. First principles calculation of effective mass parameters of GaN. Solid State Electron. 1997, 41, 271–274. [Google Scholar] [CrossRef]
- Yeo, Y.C.; Chong, T.C.; Li, M.F. Electronic band structures and effective-mass parameters of wurtzite GaN and InN. J. Appl. Phys. 1998, 83, 1429–1436. [Google Scholar] [CrossRef]
- Vurgaftman, I.; Meyer, J.R. Band parameters for nitrogen-containing semiconductors. J. Appl. Phys. 2003, 94, 3675–3696. [Google Scholar] [CrossRef]
- Sze, S.M.; Ng, K.K. Physics of Semiconductor Devices; John Wiley & Sons: Hoboken, NJ, USA, 2006. [Google Scholar]
- Peter, Y.U.; Cardona, M. Fundamentals of Semiconductors: Physics and Materials Properties; Springer: Berlin/Heidelberg, Germany, 2010. [Google Scholar]
- Shan, W.; Schmidt, T.J.; Song, J.J.; Goldenberg, B.; Yang, X.H.; Hwang, S.J. Temperature dependence of interband transitions in GaN grown by metalorganic chemical vapor deposition. Appl. Phys. Lett. 1995, 66, 985–987. [Google Scholar] [CrossRef]
- Moses, P.G.; Miao, M.; Yan, Q.; Van De Walle, C. Hybrid functional investigations of band gaps and band alignments for AlN, GaN, InN, and InGaN. J. Chem. Phys. 2011, 134, 84703. [Google Scholar] [CrossRef]
- Yamaguchi, S.; Sakai, H.; Kaneko, Y.; Nakagawa, S.; Yamaoka, Y.; Takeuchi, T.; Wetzel, C.; Amano, H.; Akasaki, I.; Yamada, N. Determination of piezoelectric fields in strained GaInN quantum wells using the quantum-confined Stark effect. Appl. Phys. Lett. 1998, 73, 1691–1693. [Google Scholar]
- Jho, Y.D.; Yahng, J.S.; Oh, E.; Kim, D.S. Field-dependent carrier decay dynamics in strained InxGa1−xN/GaN quantum wells. Phys. Rev. B 2002, 66, 035334. [Google Scholar] [CrossRef]
- Goossen, K.W.; Caridi, E.A.; Chang, T.Y.; Stark, J.B.; Miller, D.A.B.; Morgan, R.A. Observation of room-temperature blue shift and bistability in a strained InGaAs-GaAs (111) self-electro-optic effect device. Appl. Phys. Lett. 1990, 56, 715–717. [Google Scholar] [CrossRef]
- Pabla, A.S.; Sanchez-Rojas, J.L.; Woodhead, J.; Grey, R.; David, J.P.R.; Rees, G.J.; Hill, G.; Pate, M.A.; Robson, P.N.; Hogg, R.A.; et al. Tailoring of internal fields in InGaAs/GaAs multiwell structures grown on (111)B GaAs. Appl. Phys. Lett. 1993, 63, 752–754. [Google Scholar] [CrossRef]
- David, J.P.R.; Sale, T.E.; Pabla, A.S.; Rodríguez-Gironés, P.J.; Woodhead, J.; Grey, R.; Rees, G.J.; Robson, P.N.; Skolnick, M.; Hogg, R.A. Excitation power and barrier width dependence of photoluminescence in piezoelectric multiquantum well p-i-n structures. Appl. Phys. Lett. 1996, 68, 820–822. [Google Scholar] [CrossRef]
- Li, C.F.; Huang, Y.S.; Malikova, L.; Pollak, F.H. Temperature dependence of the energies and broadening parameters of the interband excitonic transitions in wurtzite GaN. Phys. Rev. B 1997, 55, 9251–9254. [Google Scholar] [CrossRef]
- Shokhovets, S.; Goldhahn, R.; Gobsch, G. Study of the linear electro-optic effect in α-GaN by electroreflectance. Mater. Sci. Eng. B 2002, 93, 215–218. [Google Scholar] [CrossRef]
- Wickenden, A.E.; Koleske, D.D.; Al-Kuhaili, M.; Glosser, R.; Henry, R.L. Electroreflectance of hexagonal gallium nitride at the fundamental and E 1 spectral regions. Appl. Phys. Lett. 2003, 82, 1203–1205. [Google Scholar]
- Kaplar, R.J. Electroreflectance studies of Stark shifts and polarization-induced electric fields in InGaN/GaN single quantum wells. J. Appl. Phys. 2004, 95, 4905. [Google Scholar] [CrossRef]
- Yoon, J.W.; Kim, S.S.; Cheong, H.S.; Seo, H.C.; Kwon, S.Y.; Kim, H.J.; Shin, Y.R.; Yoon, E.J.; Park, Y.S. Electroreflectance and Photoluminescence Study on InGaN Alloys. J. Korean Phys. Soc. 2006, 49, 2143–2146. [Google Scholar]
- Drabinska, A.; Korona, K.P.; Pakula, K.; Baranowski, J.M. Electroreflectance and photoreflectance spectra of tricolor III-nitride detector structures. Phys. Status Solidi (a) 2007, 204, 459–465. [Google Scholar] [CrossRef]
- Avakyants, L.P.; Badgutdinov, M.L.; Bokov, P.Y.; Chervyakov, A.V.; Shirokov, S.S.; Yunovich, A.E.; Bogdanov, A.A.; Vasil’Eva, E.D.; Nikolaev, D.A.; Feopentov, A.V. Electroreflectance spectra of InGaN/AlGaN/GaN quantum-well heterostructures. Semiconductors 2007, 41, 1060–1066. [Google Scholar] [CrossRef]
- Kudrawiec, R.; Siekacz, M.; Kryśko, M.; Cywiński, G.; Misiewicz, J.; Skierbiszewski, C. Contactless electroreflectance of InGaN layers with indium content ≤36%: The surface band bending, band gap bowing, and Stokes shift issues. J. Appl. Phys. 2009, 106, 113517. [Google Scholar] [CrossRef]
- Avakyants, L.; Bokov, P.; Chervyakov, A.; Chuas, A.; Yunovich, A.; Vasileva, E.; Yavich, B. Electroreflectance diagnostics of InGaN/AlGaN/GaN based LEDs structures. Phys. Status solidi (c) 2009, 6, 2852–2854. [Google Scholar] [CrossRef]
- Tawfik, W.Z.; Ryu, H.-Y.; Lee, J.K. Electroreflectance spectroscopy of compressively strained InGaN/GaN multi-quantum well structures. Curr. Appl. Phys. 2014, 14, 1504–1508. [Google Scholar] [CrossRef]
- Aspnes, D.; Bottka, N. Chapter 6 Electric-Field Effects on the Dielectric Function of Semiconductors and Insulators. Semicond. Semimet. 1972, 9, 457–543. [Google Scholar]
- Aspnes, D. Third-derivative modulation spectroscopy with low-field electroreflectance. Surf. Sci. 1973, 37, 418–442. [Google Scholar] [CrossRef]
- Aspnes, D.E. Modulation Spectroscopy/Electric Field Effects on the Dielectric Function of Semiconductors. In Handbook on Semiconductors; Moss, T.S., Balkanski, M., Eds.; North Holland Publishing: Amsterdam, The Netherlands, 1980. [Google Scholar]
- Klipstein, P.C.; Tapster, P.R.; Apsley, N.; Skolnick, M.; Kerr, T.M.; Woodbridge, K.; A Anderson, D. Electroreflectance spectroscopy from quantum well structures in an electric field. J. Phys. C Solid State Phys. 1986, 19, 857–871. [Google Scholar] [CrossRef]
- Klipstein, P.C.; Apsley, N. A theory for the electroreflectance spectra of quantum well structures. J. Phys. C Solid State Phys. 1986, 19, 6461–6478. [Google Scholar] [CrossRef]
- Thorn, A.P.; Shields, A.J.; Klipstein, P.C.; Apsley, N.; Kerr, T.M. The electro-reflectance lineshape for a quantum well: The dependence on angle of incidence and temperature. J. Phys. C Solid State Phys. 1987, 20, 4229–4239. [Google Scholar] [CrossRef]
- Pollak, F.H.; Shen, H. Modulation spectroscopy of semiconductors: Bulk/thin film, microstructures, surfaces/interfaces and devices. Mater. Sci. Eng. R: Rep. 1993, 10, 275. [Google Scholar] [CrossRef]
- Pollak, F.H. Modulation Spectroscopy of Semiconductor and Semiconductor Microstructures. In Optical Properties of Semiconductors; Balkanski, M., Ed.; North Holland Publishing: Amsterdam, The Netherlands, 1994; Volume 2. [Google Scholar]
- Pollak, F.H. Study of semiconductor surfaces and interfaces using electromodulation. Surf. Interface Anal. 2001, 31, 938–953. [Google Scholar] [CrossRef]
- Misiewicz, J.; Kudrawiec, R. Contactless electroreflectance spectroscopy of optical transitions in low dimensional semiconductor structures. Opto Electron. Rev. 2012, 20, 101–119. [Google Scholar] [CrossRef]
- Aspnes, D.E. Band nonparabolicities, broadening, and internal field distributions: The spectroscopy of Franz-Keldysh oscillations. Phys. Rev. B 1974, 10, 4228–4238. [Google Scholar] [CrossRef]
- Shen, H.; Pollak, F.H. Generalized Franz-Keldysh theory of electromodulation. Phys. Rev. B 1990, 42, 7097–7102. [Google Scholar] [CrossRef] [PubMed]
- Batchelor, R.A.; Hamnett, A. A Franz-Keldysh model for photoreflectance from GaAs/GaAlAs heterojunction structures. J. Appl. Phys. 1992, 71, 2414–2422. [Google Scholar] [CrossRef]
- Shen, H.; Dutta, M.; Chang, W.; Moerkirk, R.; Kim, D.M.; Chung, K.W.; Ruden, P.P.; Nathan, M.I.; Stroscio, M.A. Direct measurement of piezoelectric field in a [111]B grown InGaAs/GaAs heterostructure by Franz–Keldysh oscillations. Appl. Phys. Lett. 1992, 60, 2400–2402. [Google Scholar] [CrossRef]
- Wetzel, C.; Takeuchi, T.; Amano, H.; Akasaki, I. Piezoelectric Franz–Keldysh effect in strained GaInN/GaN heterostructures. J. Appl. Phys. 1999, 85, 3786–3791. [Google Scholar] [CrossRef] [Green Version]
- Shen, H.; Wraback, M.; Zhong, H.; Tyagi, A.; DenBaars, S.P.; Nakamura, S.; Speck, J.S. Determination of polarization field in a semipolar InGaN/GaN single quantum well using Franz–Keldysh oscillations in electroreflectance. Appl. Phys. Lett. 2009, 94, 241906. [Google Scholar] [CrossRef]
- Adachi, S. III-V Ternary and Quaternary Compounds in Springer Handbook of Electronic and Photonic Materials; Kasap, S., Capper, P., Eds.; Springer: Berlin/Heidelberg, Germany, 2017. [Google Scholar]
- Börnstein, L. Group III Condensed Matter Semiconductors Group IV Elements, IV-IV and III-V Compounds. Part b-Electronic, Transport, Optical and Other Properties; Madelung, O., Rössler, U., Schulz, M., Eds.; Springer: Berlin/Heidelberg, Germany, 2002; Volume 41. [Google Scholar]
- Wilkins, N. Infra-red interference measurements on oxide films on zirconium. Corros. Sci. 1964, 4, 17–24. [Google Scholar] [CrossRef]
- Kallergi, N.; Roughani, B.; Aubel, J.; Sundaram, S. Correlation of interference effects in photoreflectance spectra with GaAs homolayer thickness. J. Appl. Phys. 1990, 68, 4656–4661. [Google Scholar] [CrossRef]
- Clark, T.J.; Banash, M.A.; Cruse, R.W.; Fech, J.; Mininni, R.M.; Rohman, S.J. The use of infrared interference spectra to measure ceramic coating thickness in a CVD reactor. Thin Solid Films 1995, 254, 7–9. [Google Scholar] [CrossRef]
- Losurdo, M.; Bergmair, M.; Bruno, G.; Cattelan, D.; Cobet, C.; de Martino, A.; Fleischer, K.; Dohcevic-Mitrovic, Z.; Esser, N.; Galliet, M.; et al. Spectroscopic ellipsometry and polarimetry for materials and systems analysis at the nanometer scale: state-of-the-art, potential, and perspectives. J. Nanopart. Res. 2009, 11, 1521–1554. [Google Scholar] [CrossRef] [Green Version]
- Leung, M.M.Y.; Djuriŝić, A.B.; Li, E.H. Refractive index of InGaN/GaN quantum well. J. Appl. Phys. 1998, 84, 6312–6317. [Google Scholar] [CrossRef] [Green Version]
- Yang, T.; Goto, S.; Kawata, M.; Uchida, K.; Niwa, A.; Gotoh, J. Optical Properties of GaN Thin Films on Sapphire Substrates Characterized by Variable-Angle Spectroscopic Ellipsometry. Jpn. J. Appl. Phys. 1998, 37, L1105–L1108. [Google Scholar] [CrossRef]
- Goldhahn, R.; Scheiner, J.; Shokhovets, S.; Frey, T.; Köhler, U.; As, D.J.; Lischka, K. Refractive index and gap energy of cubic InxGa1−xN. Appl. Phys. Lett. 2000, 76, 291–293. [Google Scholar] [CrossRef]
- Laws, G.M.; Larkins, E.C.; Harrison, I.; Molloy, C.; Somerford, D. Improved refractive index formulas for the AlxGa1−xN and InyGa1−yN alloys. J. Appl. Phys. 2001, 89, 1108–1115. [Google Scholar] [CrossRef]
- Moustakas, T.D.; Paiella, R. Optoelectronic device physics and technology of nitride semiconductors from the UV to the terahertz. Rep. Prog. Phys. 2017, 80, 106501. [Google Scholar] [CrossRef]
- Park, S.-H.; Ahn, D.; Kim, J.-W. Optical gain in quantum well structures with zero internal field. Appl. Phys. Lett. 2008, 92, 171115. [Google Scholar] [CrossRef]
- Wernicke, T.; Schade, L.; Netzel, C.; Rass, J.; Hoffmann, V.; Ploch, S.; Knauer, A.; Weyers, M.; Schwarz, U.; Kneissl, M. Indium incorporation and emission wavelength of polar, nonpolar and semipolar InGaN quantum wells. Semicond. Sci. Technol. 2012, 27, 024014. [Google Scholar] [CrossRef]
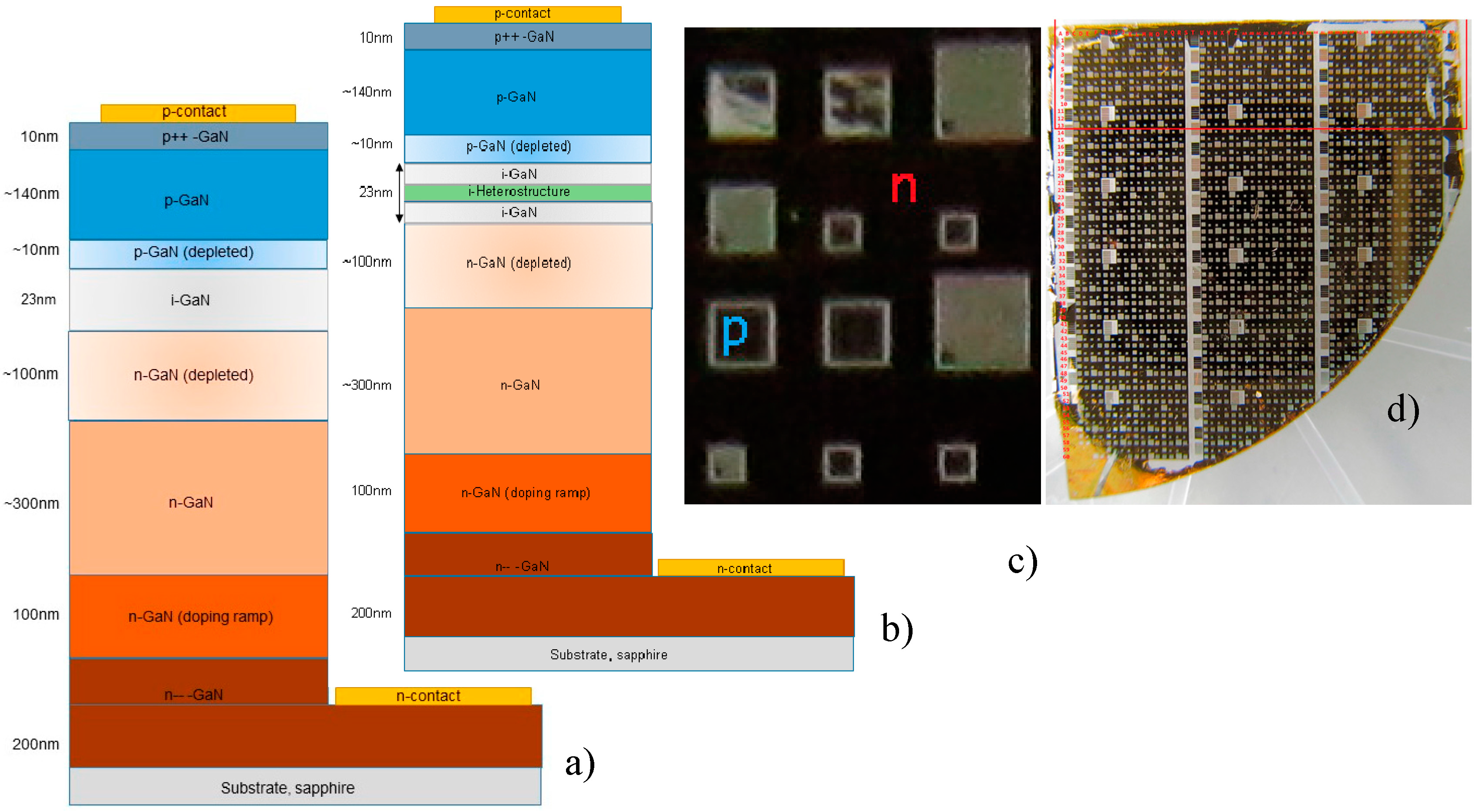










© 2019 by the author. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Papadimitriou, D.N. Calibration of Polarization Fields and Electro-Optical Response of Group-III Nitride Based c-Plane Quantum-Well Heterostructures by Application of Electro-Modulation Techniques. Appl. Sci. 2020, 10, 232. https://doi.org/10.3390/app10010232
Papadimitriou DN. Calibration of Polarization Fields and Electro-Optical Response of Group-III Nitride Based c-Plane Quantum-Well Heterostructures by Application of Electro-Modulation Techniques. Applied Sciences. 2020; 10(1):232. https://doi.org/10.3390/app10010232
Chicago/Turabian StylePapadimitriou, Dimitra N. 2020. "Calibration of Polarization Fields and Electro-Optical Response of Group-III Nitride Based c-Plane Quantum-Well Heterostructures by Application of Electro-Modulation Techniques" Applied Sciences 10, no. 1: 232. https://doi.org/10.3390/app10010232
APA StylePapadimitriou, D. N. (2020). Calibration of Polarization Fields and Electro-Optical Response of Group-III Nitride Based c-Plane Quantum-Well Heterostructures by Application of Electro-Modulation Techniques. Applied Sciences, 10(1), 232. https://doi.org/10.3390/app10010232



