First Demonstration of L-Band High-Power Limiter with GaN Schottky Barrier Diodes (SBDs) Based on Steep-Mesa Technology
Abstract
:1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Outlook
5. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- White, J.F. Microwave Semiconductor Engineering; Springer: Heidelberg, The Netherlands, 2012; pp. 245–313. [Google Scholar]
- Sardi, A.; Alkurt, F.Ö.; Özkaner, V.; Karaaslan, M.; Ünal, E.; Mohamed, T. Investigation of microwave power limiter for Industrial Scientific Medical band (ISM) applications. Int. J. RF Microw. Comput. Aided Eng. 2020, 30, e22180. [Google Scholar] [CrossRef]
- Fan, G.Q.; Xing, H.Y.; Hu, H.Q. K-Ka band schottky diode limiter. In Proceedings of the 2013 IEEE International Conference on Applied Superconductivity and Electromagnetic Devices, Beijing, China, 25–27 October 2013. [Google Scholar]
- Yang, L.; Yang, L.-A.; Rong, T.; Li, Y.; Jin, Z.; Hao, Y. Codesign of Ka-Band Integrated GaAs PIN Diodes Limiter and Low Noise Amplifier. IEEE Access 2019, 7, 88275–88281. [Google Scholar] [CrossRef]
- Seong-Sik, Y.; Tak-Young, K.; Kong, D.K.; Kim, S.S.; Yeom, K.W. A Novel Analysis of a $Ku$-Band Planar p-i-n Diode Limiter. IEEE Trans. Microw. Theory Tech. 2009, 57, 1447–1460. [Google Scholar] [CrossRef]
- Wang, H.; Zou, H.; Zhou, Y.; Li, H. Electro-thermal coupled modeling of PIN diode limiter used in high-power microwave effects simulation. J. Electromagn. Waves Appl. 2015, 29, 615–625. [Google Scholar] [CrossRef]
- “Limiter Diodes”, Skyworks, Woburn, MA, USA. 2011. Available online: http://www.skyworksinc.com (accessed on 9 February 2021).
- Mishra, U.K.; Shen, L.; Kazior, T.E.; Wu, Y.F. GaN-Based RF Power Devices and Amplifiers. Proc. IEEE 2008, 96, 287–305. [Google Scholar] [CrossRef]
- Deng, S.; Gao, C.; Chen, S.; Sun, J.; Wu, K. Research on Linearity Improvement of Silicon-Based p-i-n Diode Limiters. IEEE Microw. Wirel. Compon. Lett. 2020, 30, 62–65. [Google Scholar] [CrossRef]
- Liu, X.; Chiu, H.-C.; Wang, H.Y.; Hu, C.; Wang, H.C.; Kao, H.L.; Chien, F.T. 2.4 kV Vertical GaN PN Diodes on Free Standing GaN Wafer Using CMOS-Compatible Contact Materials. IEEE J. Electron Devices Soc. 2018, 6, 825–829. [Google Scholar] [CrossRef]
- Zhang, Y.; Sun, M.; Piedra, D.; Azize, M.; Zhang, X.; Fujishima, T.; Palacios, T. GaN-on-Si Vertical Schottky and p-n Diodes. IEEE Electron. Device Lett. 2014, 35, 618–620. [Google Scholar]
- Fu, H.; Fu, K.; Alugubelli, S.R.; Cheng, C.-Y.; Huang, X.; Chen, H.; Yang, T.-H.; Yang, C.; Zhou, J.; Montes, J.; et al. High Voltage Vertical GaN p-n Diodes with Hydrogen-Plasma Based Guard Rings. IEEE Electron. Device Lett. 2019, 41, 127–130. [Google Scholar] [CrossRef]
- Li, L.; Kishi, A.; Liu, Q.; Itai, Y.; Fujihara, R.; Ohno, Y.; Ao, J.-P. GaN Schottky Barrier Diode with TiN Electrode for Microwave Rectification. IEEE J. Electron, Devices Soc. 2014, 2, 168–173. [Google Scholar] [CrossRef]
- Han, S.; Yang, S.; Sheng, K. High-Voltage and High-Ion/Ioff Vertical GaN-on-GaN Schottky Barrier Diode with Nitridation-Based Termination. IEEE Electron. Device Lett. 2018, 39, 572–575. [Google Scholar] [CrossRef]
- Sun, Y.; Kang, X.; Zheng, Y.; Lu, J.; Tian, X.; Wei, K.; Wu, H.; Wang, W.; Liu, X.; Zhang, G. Review of the Recent Progress on GaN-Based Vertical Power Schottky Barrier Diodes (SBDs). Electronics 2019, 8, 575. [Google Scholar] [CrossRef] [Green Version]
- Kang, X.; Wang, X.; Huang, S.; Zhang, J.; Fan, J.; Yang, S.; Wang, Y.; Zheng, Y.; Wei, K.; Zhi, J.; et al. Recess-free AlGaN/GaN lateral Schottky barrier controlled Schottky rectifier with low turn-on voltage and high reverse blocking. In Proceedings of the 2018 IEEE 30th International Symposium on Power Semiconductor Devices and ICs (ISPSD), Chicago, IL, USA, 13–17 May 2018. [Google Scholar]
- Joseph, S.D.; Hsu, S.S.H.; Alieldin, A.; Song, C.; Liu, Y.; Huang, Y. High-Power Wire Bonded GaN Rectifier for Wireless Power Transmission. IEEE Access 2020, 8, 82035–82041. [Google Scholar] [CrossRef]
- Dang, K.; Zhang, J.; Zhou, H.; Huang, S.; Zhang, T.; Bian, Z.; Zhang, Y.; Wang, X.; Zhao, S.; Wei, K.; et al. A 5.8-GHz High-Power and High-Efficiency Rectifier Circuit with Lateral GaN Schottky Diode for Wireless Power Transfer. IEEE Trans. Power Electron. 2020, 35, 2247–2252. [Google Scholar] [CrossRef]
- Liang, S.; Song, X.; Zhang, L.; Lv, Y.; Wang, Y.; Wei, B.; Guo, Y.; Gu, G.; Wang, B.; Cai, S.; et al. A 177–183 GHz High-Power GaN-Based Frequency Doubler with Over 200 mW Output Power. IEEE Electron. Device Lett. 2020, 41, 669–672. [Google Scholar] [CrossRef]
- Sun, Y.; Kang, X.; Zheng, Y.; Wei, K.; Li, P.; Wang, W.; Liu, X.; Zhang, G. Optimization of Mesa Etch for a Quasi-Vertical GaN Schottky Barrier Diode (SBD) by Inductively Coupled Plasma (ICP) and Device Characteristics. Nanomaterials 2020, 10, 657. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Fu, K.; Fu, H.; Huang, X.; Yang, T.H.; Cheng, C.Y.; Peri, P.R.; Chen, H.; Montes, J.; Yang, C.; Zhou, J.; et al. Reverse Leakage Analysis for As-grown and Regrown Vertical GaN-on-GaN Schottky Barrier Diodes. IEEE J. Electron. Devices Soc. 2020, 8, 74–83. [Google Scholar] [CrossRef]
- Arehart, A.R.; Moran, B.; Speck, J.S.; Mishra, U.K.; DenBaars, S.P.; Ringel, S.A. Effect of threading dislocation density on Ni/n-GaN Schottky diode I-V characteristics. J. Appl. Phys. 2006, 100, 023709. [Google Scholar] [CrossRef]
- Luongo, G.; Di Bartolomeo, A.; Giubileo, F.; Chavarin, C.A.; Wenger, C. Electronic properties of graphene/p-silicon Schottky junction. J. Phys. D 2018, 51, 255305. [Google Scholar] [CrossRef]
- Surdi, H.; Ahmad, M.F.; Koeck, F.; Nemanich, R.J.; Goodnick, S.; Thornton, T.J. RF Characterization of Diamond Schottky p-i-n Diodes for Receiver Protector Applications. IEEE Microw. Wirel. Compon. Lett. 2020, 30, 1141–1144. [Google Scholar] [CrossRef]
- Katko, A.R.; Hawkes, A.M.; Barrett, J.P.; Cummer, S.A. RF Limiter Metamaterial Using p-i-n Diodes. IEEE Antennas Wirel. Propag. Lett. 2011, 10, 1571–1574. [Google Scholar] [CrossRef]
- Bera, S.C.; Basak, K.; Jain, V.; Singh, R.V.; Garg, V.K. Schottky diode-based microwave limiter with adjustable threshold power level. Microw. Opt. Technol. Lett. 2010, 52, 1671–1673. [Google Scholar] [CrossRef]
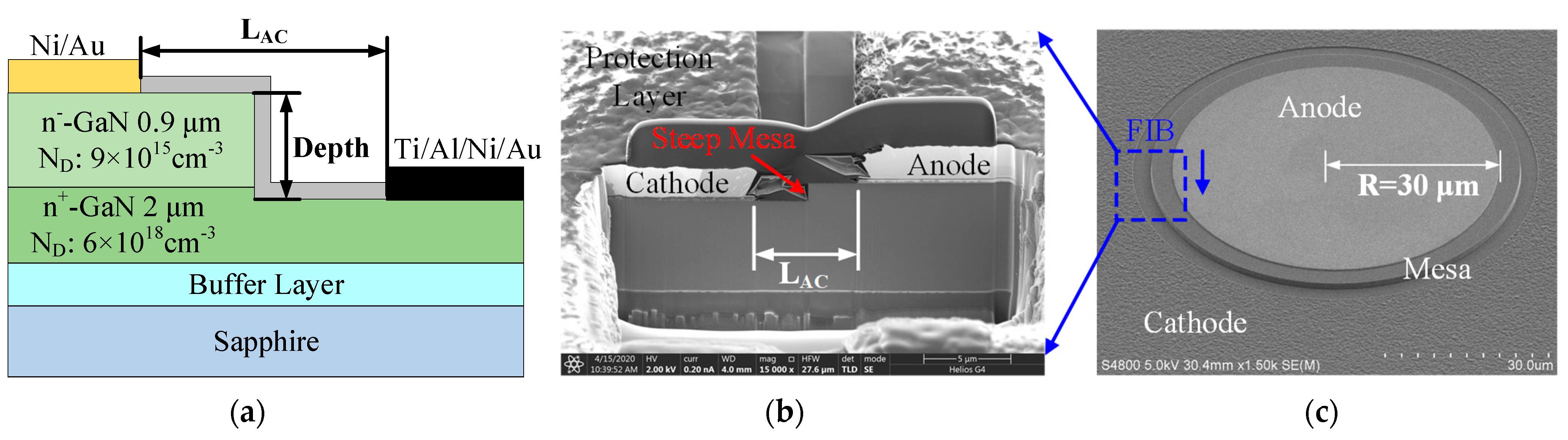

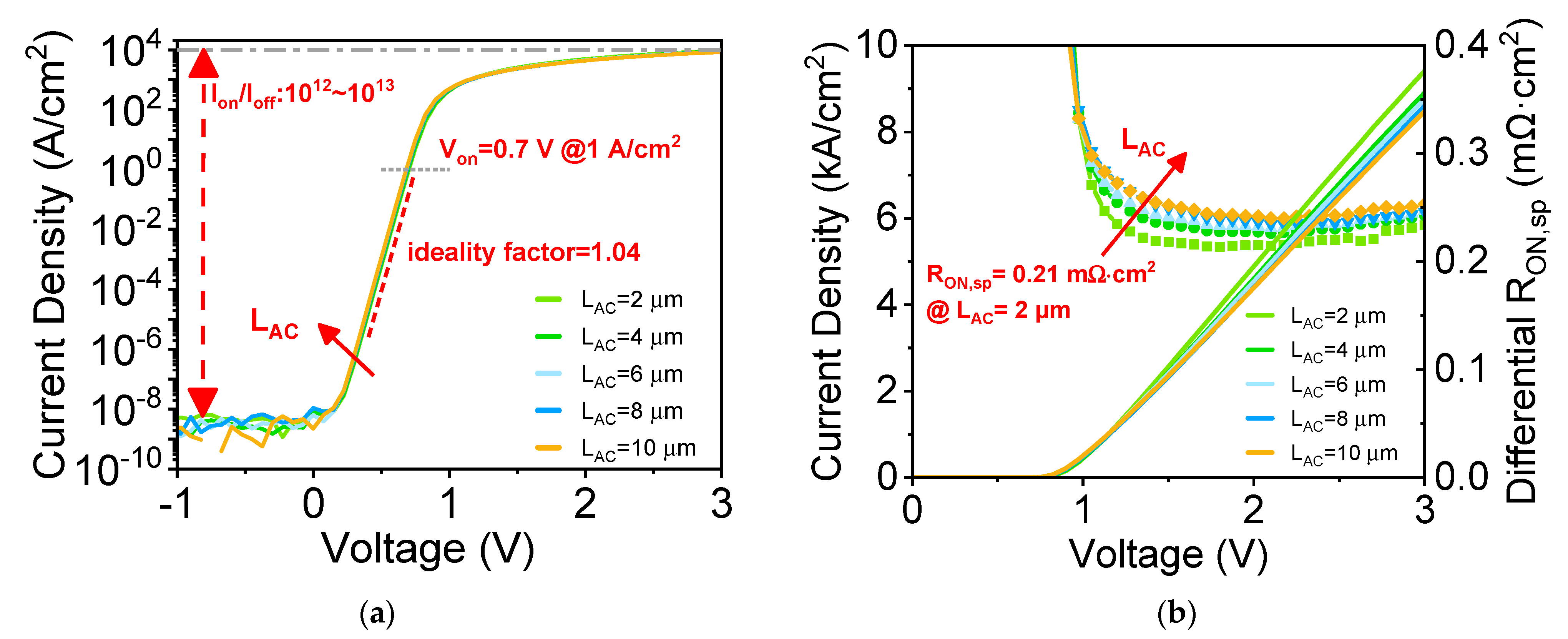




Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Sun, Y.; Kang, X.; Deng, S.; Zheng, Y.; Wei, K.; Xu, L.; Wu, H.; Liu, X. First Demonstration of L-Band High-Power Limiter with GaN Schottky Barrier Diodes (SBDs) Based on Steep-Mesa Technology. Electronics 2021, 10, 433. https://doi.org/10.3390/electronics10040433
Sun Y, Kang X, Deng S, Zheng Y, Wei K, Xu L, Wu H, Liu X. First Demonstration of L-Band High-Power Limiter with GaN Schottky Barrier Diodes (SBDs) Based on Steep-Mesa Technology. Electronics. 2021; 10(4):433. https://doi.org/10.3390/electronics10040433
Chicago/Turabian StyleSun, Yue, Xuanwu Kang, Shixiong Deng, Yingkui Zheng, Ke Wei, Linwang Xu, Hao Wu, and Xinyu Liu. 2021. "First Demonstration of L-Band High-Power Limiter with GaN Schottky Barrier Diodes (SBDs) Based on Steep-Mesa Technology" Electronics 10, no. 4: 433. https://doi.org/10.3390/electronics10040433






