Silicon-On-Nothing Micro-Pirani Gauge for Interior-Pressure Measurement †
Abstract
:1. Introduction
2. Materials and Methods
2.1. Geometry and Materials
2.2. Manufactering
3. Results
3.1. Open Cavity Characterization
3.2. Sealed Cavity Characterization
4. Discussion
Author Contributions
Acknowledgments
Conflicts of Interest
References
- Cheung, K. Modelling a MEMS Thermal Conductivity Pressure Sensor for the Evaluation of Glass Frit Vacuum package. J. Nano-to-Macro Energy Transp. 2004. December. Available online: http://mit.sustech.edu/NR/rdonlyres/Mechanical-Engineering/2-57Fall-2004/0F5D19BC-5AE0-4B99-BA3A-661D9F0F6E9C/0/cheung_sensor.pdf.
- Reggiani, S.; Valdinoci, M.; Colalongo, L.; Rudan, M.; Baccarani, G.; Stricker, A.D.; Illien, F.; Felber, N.; Fichtner, W.; Zullino, L. Electron and hole mobility in silicon at large operation Temperatures. I. Bulk mobility. AIEEE Trans. Electron Devices 2002, 49, 490–499. [Google Scholar] [CrossRef]

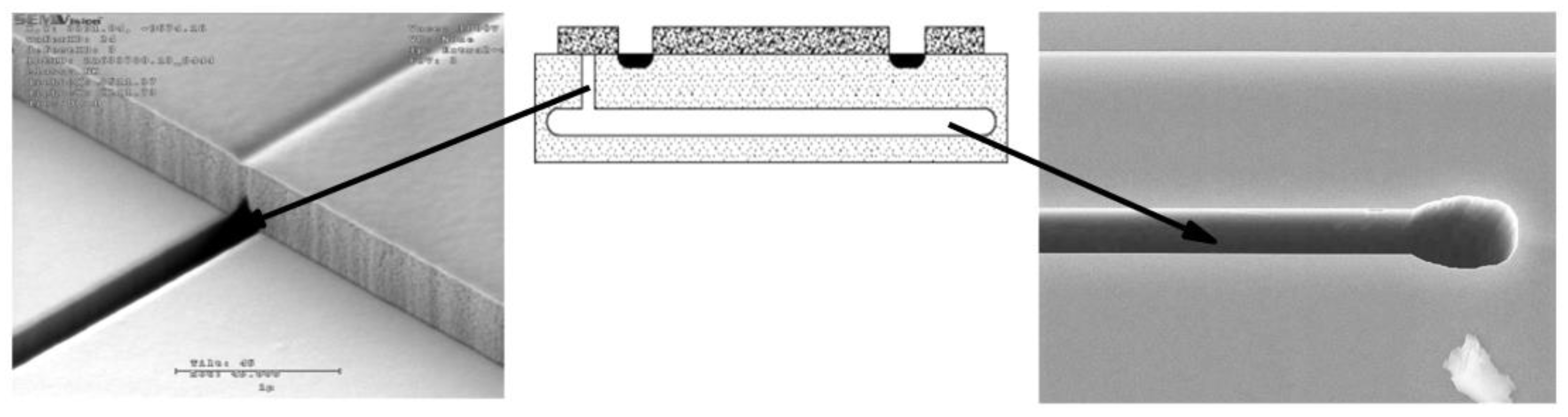



Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2018 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kravchenko, A.; Komenko, V.; Fischer, W.-J. Silicon-On-Nothing Micro-Pirani Gauge for Interior-Pressure Measurement. Proceedings 2018, 2, 1079. https://doi.org/10.3390/proceedings2131079
Kravchenko A, Komenko V, Fischer W-J. Silicon-On-Nothing Micro-Pirani Gauge for Interior-Pressure Measurement. Proceedings. 2018; 2(13):1079. https://doi.org/10.3390/proceedings2131079
Chicago/Turabian StyleKravchenko, Andrey, Vladislav Komenko, and Wolf-Joachim Fischer. 2018. "Silicon-On-Nothing Micro-Pirani Gauge for Interior-Pressure Measurement" Proceedings 2, no. 13: 1079. https://doi.org/10.3390/proceedings2131079



