Optimization of the Geometry of a Microelectromechanical System Testing Device for SiO2—Polysilicon Interface Characterization †
Abstract
:1. Introduction
2. Materials and Methods
- The failure-governing principal stress component at the interface should be as high as possible, ideally close to 1 GPa, in order to speed up the fatigue tests.
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Frangi, A.; Cercignani, C.; Mukherjee, S.; Aluru, N. Advances in Multiphysics Simulation and Experimental Testing of Mems, 1st ed.; Imperial College Press: London, UK, 2008. [Google Scholar]
- Tsuchiya, T. Mechanical reliability of silicon microstructures. J. Micromech. Microeng. 2021, 32, 013003. [Google Scholar] [CrossRef]
- Younis, M.I. MEMS Linear and Nonlinear Statics and Dynamics, 1st ed.; Springer: New York, NY, USA, 2011. [Google Scholar]
- Gad-el-Hak, M.; Seemann, W. MEMS Handbook, 1st ed.; CRC Press: Boca Raton, FL, USA, 2002. [Google Scholar]
- Corigliano, A.; Ardito, R.; Comi, C.; Frangi, A.; Ghisi, A.; Mariani, S. Mechanics of Microsystems, 1st ed.; Wiley: Chichester, UK, 2018. [Google Scholar]
- Saleem, M.; Nawaz, H. A Systematic Review of Reliability Issues in RF-MEMS Switches. Micro Nanosyst. 2019, 11, 11–33. [Google Scholar] [CrossRef]
- Rajagopalan, J. Microelectromechanical Systems (MEMS)-Based Testing of Materials. In Handbook of Mechanics of Materials, 2nd ed.; Schmauder, S., Chen, C.S., Chawla, K., Chawla, N., Chen, W., Kagawa, Y., Eds.; Springer: Singapore, 2019; pp. 1955–1979. [Google Scholar]
- Bhalerao, K.; Soboyejo, A.B.O.; Soboyejo, W.O. Modeling of fatigue in polysilicon MEMS structures. J. Mater. Sci. 2003, 38, 4157–4161. [Google Scholar] [CrossRef]
- Muhlstein, C.L.; Ritchie, R.O. High-cycle fatigue of micron-scale polycrystalline silicon films: Fracture mechanics analyses of the role of the silica/silicon interface. Int. J. Fract. 2003, 120, 449–474. [Google Scholar] [CrossRef]
- Ritchie, R.O.; Kruzic, J.J.; Muhlstein, C.L.; Nalla, R.K.; Stach, E.A. Characteristic dimensions and the micro-mechanisms of fracture and fatigue in “nano” and “bio” materials. Int. J. Fract. 2004, 128, 1–15. [Google Scholar] [CrossRef]
- Osterberg, P.M.; Senturia, S.D. M-TEST: A test chip for MEMS material property measurement using electrostatically actuated test structures. J. Microelectromech. Syst. 1997, 6, 107–118. [Google Scholar] [CrossRef]
- Mitul, B.M.; Suresh, K.S. Interfacial fracture toughness measurement for thin film interfaces. Eng. Fract. Mech. 2004, 71, 1219–1234. [Google Scholar]
- Tuck, K.; Jungen, A.; Geisberger, A.; Ellis, M.; Skidmore, G. A Study of Creep in Polysilicon MEMS Devices. J. Eng. Mater. Technol. 2005, 127, 90–96. [Google Scholar] [CrossRef]
- Chen, K.-S.; Ayon, A.A.; Zhang, X.; Spearing, S.M. Effect of process parameters on the surface morphology and mechanical performance of silicon structures after deep reactive ion etching (DRIE). J. Microelectromech. Syst. 2002, 11, 264–275. [Google Scholar] [CrossRef]
- Gao, X.; Joyce, J.A.; Roe, C. An investigation of the loading rate dependence of the Weibull stress parameters. Eng. Fract. Mech. 2008, 75, 1451–1467. [Google Scholar] [CrossRef]
- Mariani, S.; Martini, R.; Corigliano, A.; Beghi, M. Overall elastic domain of thin polysilicon films. Comput. Mater. Sci. 2011, 50, 2993–3004. [Google Scholar] [CrossRef]
- Mariani, S.; Martini Ghisi, A.R.; Corigliano, A.; Beghi, M. Overall elastic properties of polysilicon films: A statistical investigation of the effects of polycrystal morphology. Int. J. Multiscale Comput. Eng. 2011, 9, 327–346. [Google Scholar] [CrossRef]
- Mirzazadeh, R.; Eftekhar Azam, S.; Mariani, S. Micromechanical characterization of polysilicon films through on-chip tests. Sensors 2016, 16, 1191. [Google Scholar] [CrossRef] [PubMed]
- Mirzazadeh, R.; Mariani, S. Uncertainty quantification of microstructure-governed properties of polysilicon MEMS. Micromachines 2017, 8, 248. [Google Scholar] [CrossRef] [PubMed]
- Mirzazadeh, R.; Eftekhar Azam, S.; Mariani, S. Mechanical characterization of polysilicon MEMS: A hybrid TMCMC/POD-kriging approach. Sensors 2018, 18, 1243. [Google Scholar] [CrossRef]
- Mariani, S.; Ghisi, A.; Mirzazadeh, R.; Eftekhar Azam, S. On-Chip testing: A miniaturized lab to assess sub-micron uncertainties in polysilicon MEMS. Micro Nanosyst. 2018, 10, 84–93. [Google Scholar] [CrossRef]
- Quesada Molina, J.P.; Mariani, S. Hybrid model-based and data-driven solution for uncertainty quantification at the microscale. Micro Nanosyst. 2022, 14, 281–286. [Google Scholar] [CrossRef]
- Zhang, M.; Lu, F.; Shao, J. Research on MEMS failure modes and failure mechanisms. In Proceedings of the 2017 Second International Conference on Reliability Systems Engineering (ICRSE), Beijing, China, 10–12 July 2017. [Google Scholar]
- Muhlstein, C.L.; Brown, S.B.; Ritchie, R.O. High-cycle fatigue and durability of polycrystalline silicon thin films in ambient air. Sens. Actuator A Phys. 2001, 94, 177–188. [Google Scholar] [CrossRef]
- Muhlstein, C.L.; Howe, R.T.; Ritchie, R.O. Fatigue of polycrystalline silicon for microelectromechanical system applications: Crack growth and stability under resonant loading conditions. Mech. Mater. 2004, 36, 13–33. [Google Scholar] [CrossRef]
- Ballarini, R.; Kahn, H.; Boer, M.P.; Dugger, M. MEMS Structures for On-chip Testing of Mechanical and Surface Properties of Thin Films. Compr. Struct. Integr. 2007, 8, 325–356. [Google Scholar]
- COMSOL Multiphysics®, v.6.0; COMSOL AB: Stockholm, Sweden. Available online: www.comsol.com(accessed on 30 September 2023).
- Mariani, S.; Ghisi, A.; Corigliano, A.; Martini, R.; Simoni, B. Two-scale simulation of drop-induced failure of polysilicon MEMS sensors. Sensors 2011, 11, 4972–4989. [Google Scholar] [CrossRef] [PubMed]
- Mariani, S.; Martini, R.; Ghisi, A.; Corigliano, A.; Simoni, B. Monte Carlo simulation of micro-cracking in polysilicon MEMS exposed to shocks. Int. J. Fract. 2011, 167, 83–101. [Google Scholar] [CrossRef]
- Mulay, S.; Becker, G.; Vayrette, R.; Raskin, J.-P.; Pardoen, T.; Galceran, M.; Godet, S.; Noels, L. Multiscale modelling framework for the fracture of thin brittle polycrystalline films: Application to polysilicon. Comput. Mech. 2015, 55, 73–91. [Google Scholar] [CrossRef]
- Hintsala, E.D.; Bhowmick, S.; Yueyue, X.; Ballarini, R.; Asif, S.A.S.; Gerberich, W.W. Temperature dependent fracture initiation in microscale silicon. Scr. Mater. 2017, 130, 78–82. [Google Scholar] [CrossRef]
- Geraci, G.; Aliabadi, M.H. Micromechanical boundary element modelling of transgranular and intergranular cohesive cracking in polycrystalline materials. Eng. Fract. Mech. 2017, 176, 351–374. [Google Scholar] [CrossRef]
- Bernal, R.A. On the application of Weibull statistics for describing strength of micro and nanostructures. Mech. Mater. 2021, 162, 104057. [Google Scholar] [CrossRef]
- Brezmes, A.O.; Reuther, G.; Gneupel, A.; Breitkopf, C. Characterization of critical conditions for fracture during wafer testing by FEM and experiments. Mater. Sci. Semicond. Process. 2017, 67, 124–140. [Google Scholar] [CrossRef]
- Buchheit, T.E.; Phinney, L.M. Fracture strength characterization for 25 micron and 125 micron thick SOI-MEMS structures. J. Micromech. Microeng. 2015, 25, 075018. [Google Scholar] [CrossRef]
- Chen, M.; Pethö, L.; Sologubenko, A.; Ma, H.; Michler, J.; Spolenak, R.; Wheeler, J. Achieving micron-scale plasticity and theoretical strength in Silicon. Nat. Commun. 2020, 11, 2681. [Google Scholar] [CrossRef]
- Somà, A.; Pistorio, F.; Saleem, M.M. Study of notched MEMS specimen: Elasto-plastic modeling and experimental testing. J. Micromech. Microeng. 2022, 32, 025006. [Google Scholar] [CrossRef]
- Kozhushko, V.V.; Hess, P. Comparison of mode-resolved fracture strength of silicon with mixed-mode failure of diamond crystals. Eng. Fract. Mech. 2010, 77, 193–200. [Google Scholar] [CrossRef]
- DelRio, F.W.; Cook, R.F.; Boyce, B.L. Fracture strength of micro- and nano-scale silicon components. Appl. Phys. Rev. 2015, 2, 021303. [Google Scholar] [CrossRef]
- Masolin, A.; Bouchard, P.-O.; Martini, R.; Bernacki, M. Thermo-mechanical and fracture properties in single-crystal silicon. J. Mater. Sci. 2013, 48, 979–988. [Google Scholar] [CrossRef]

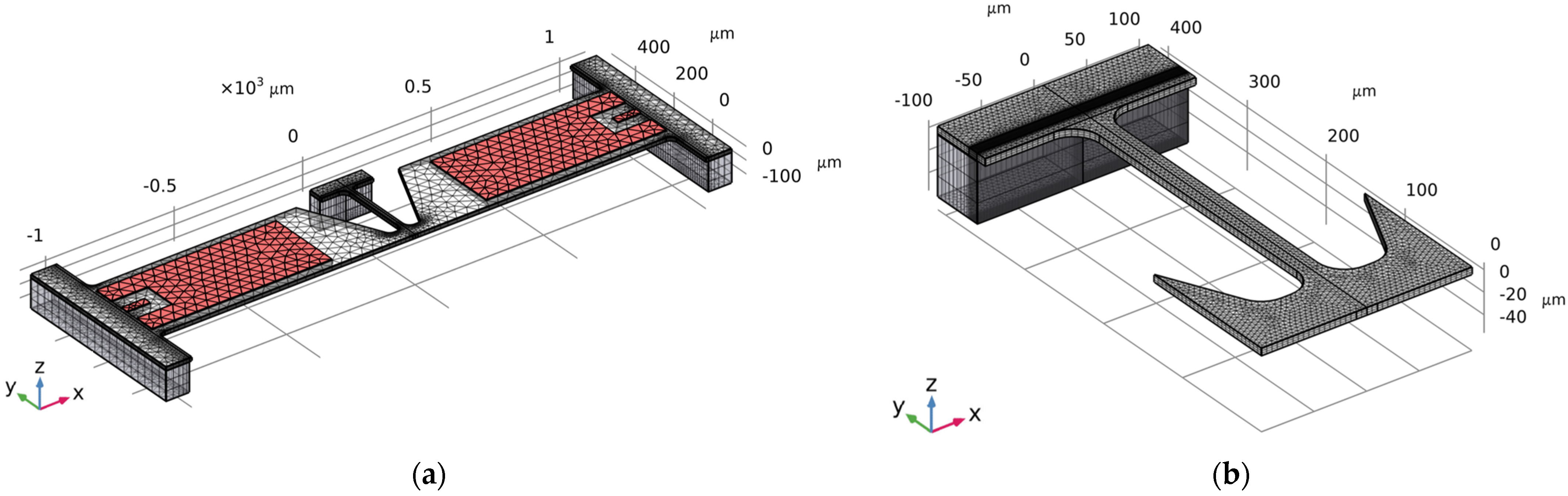

| Material | Thickness (µm) | Mass Density (kg/m3) | Young’s Modulus (GPa) | Poisson’s Ratio | Shear Modulus (GPa) |
|---|---|---|---|---|---|
| Single-Crystal Silicon | 110 | 2330 | 130 | 0.278 | 79.6 |
| Silicon Oxide | 1 | 2200 | 70 | 0.17 | 29.9 |
| Polycrystalline Silicon | 13 | 2320 | 160 | 0.22 | 65.6 |
| PZT | 2 | 7600 | 70 | 0.33 | 26.3 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Calegaro, D.; Mariani, S.; Merli, M.; Ferrari, G. Optimization of the Geometry of a Microelectromechanical System Testing Device for SiO2—Polysilicon Interface Characterization. Eng. Proc. 2023, 58, 82. https://doi.org/10.3390/ecsa-10-16033
Calegaro D, Mariani S, Merli M, Ferrari G. Optimization of the Geometry of a Microelectromechanical System Testing Device for SiO2—Polysilicon Interface Characterization. Engineering Proceedings. 2023; 58(1):82. https://doi.org/10.3390/ecsa-10-16033
Chicago/Turabian StyleCalegaro, Daniel, Stefano Mariani, Massimiliano Merli, and Giacomo Ferrari. 2023. "Optimization of the Geometry of a Microelectromechanical System Testing Device for SiO2—Polysilicon Interface Characterization" Engineering Proceedings 58, no. 1: 82. https://doi.org/10.3390/ecsa-10-16033







